
Введение в Силовые электронные устройства
Работа твердотельных реле и твердотельных модулей неотделима от их внутренних силовых электронных устройств, поэтому необходимо ввести некоторые базовые знания о силовых электронных устройствах. Из этой статьи вы узнаете, что такое силовые электронные устройства? Как они работают? Каковы их основные характеристики? Как их использовать?
Вы можете быстро перейти к интересующим вас главам через Каталог ниже и Быстрый навигатор в правой части браузера.
содержание
§1. Что такое Силовое электронное устройство?
В силовом оборудовании или энергосистеме основная схема используется для реализации изменения или управления электрической энергией, а Силовое электронное устройство (PED) является ядром основной схемы. Ранее силовые электронные устройства включали силовые вакуумные устройства (такие как ртутные дуговые выпрямители, тиратроны) и силовые полупроводниковые устройства (такие как силовые диоды, тиристоры). Из-за очевидных преимуществ силовых полупроводниковых устройств в стоимости и производительности они постепенно вытеснили силовые вакуумные устройства, поэтому так называемые силовые электронные устройства в настоящее время обычно относятся к силовым полупроводниковым устройствам с кремнием в качестве основного материала.
По сравнению с информационными полупроводниковыми устройствами (или информационными электронными устройствами, IED), которые также используют кремний в качестве основного материала, силовые электронные устройства обладают следующими характеристиками:
● Силовые электронные устройства обладают большой вычислительной мощностью, но из-за больших потерь мощности они должны быть оснащены радиатором для охлаждения.
● Силовые электронные устройства часто требуют, чтобы информационные электронные устройства подавали управляющие сигналы.
● Силовые электронные устройства обычно работают в режиме переключения, а не в режиме усиления, чтобы снизить их энергопотребление.
Из-за характеристик полупроводников силовые электронные устройства неизбежно будут производить определенные потери мощности во время работы. Эти потери мощности не только снизят эффективность преобразования электрической энергии, но и приведут к необратимому повреждению силовых электронных устройств из-за перегрева. Основные потери силовых электронных устройств можно разделить на потери во включенном состоянии, потери в выключенном состоянии и потери при переключении. Потери во включенном состоянии - это потери, вызванные падением напряжения во включенном состоянии, и если частота переключения силового электронного устройства невелика, потери во включенном состоянии будут составлять большую долю от общих потерь. Потери в нерабочем состоянии - это потери, вызванные током утечки в нерабочем состоянии, а потери в нерабочем состоянии обычно составляют очень небольшую долю от общих потерь и часто игнорируются. Потери при переключении относятся к потерям, возникающим в процессе переключения силовых электронных устройств, и на потери при переключении в значительной степени влияет частота переключения - чем выше частота переключения, тем больше доля потерь при переключении в общих потерях.

Из-за различий в используемых материалах и конструкциях производительность различных типов силовых электронных устройств может быть совершенно разной. Поэтому, прежде чем выбирать силовые электронные устройства, вы должны сначала понять их категории и характеристики, чтобы в полной мере использовать их преимущества.
В зависимости от степени контроля силовые электронные устройства можно разделить на неуправляемый тип, полууправляемый тип и полностью управляемый тип.
В соответствии с сигналом схемы привода силовые электронные устройства можно разделить на тип привода по току и тип привода по напряжению. Рабочее состояние устройств, управляемых током, контролируется входным током, таких как тиристор, GTO, GTR и т.д. Рабочее состояние устройств, управляемых напряжением, контролируется эффектом электрического поля, создаваемого входным напряжением, таких как MOSFET, JFET, IGBT и т.д.
В зависимости от носителя, участвующего в процессе проводимости, силовые электронные устройства можно разделить на однополярный тип и биполярный тип. Когда работают устройства униполярного типа, в процессе проводимости участвует только один тип носителя (свободный электрон или дырка), такой как MOSFET, JFET, SIT и т. Д. Когда работают устройства биполярного типа, свободные электроны и дырки совместно участвуют в процессе проводимости, такие как тиристор, GTO, GTR, IGBT, SITH, СИМИСТОР, RCT, LTT и т. Д.
Большинство устройств, управляемых напряжением, имеют однополярный тип, а большинство устройств, управляемых током, - биполярный тип. Устройства, управляемые напряжением, обычно имеют характеристики высокого входного сопротивления, низкой мощности возбуждения, простой схемы возбуждения и высокой рабочей частоты. Устройства, управляемые током, обычно имеют эффект модуляции проводимости, поэтому падение напряжения во включенном состоянии и потери на проводимость невелики, но рабочая частота низкая, требуемая мощность возбуждения большая, а схема возбуждения более сложная.
§2. Что такое Неуправляемое устройство?
2.1 Введение в Неуправляемые устройства

Неуправляемые устройства относятся к устройствам, которые нельзя включать и выключать с помощью управляющих сигналов, поэтому схема привода не требуется. Неуправляемые устройства обычно относятся к силовым диодам, и их основная структура и принцип работы очень похожи на диоды. Силовой диод инкапсулирован PN-переходом большой площади и подводящими проводами на обоих концах. В зависимости от формы силовые диоды можно разделить на болтовые и плоские. В зависимости от носителей, участвующих в процессе проводимости, силовые диоды можно разделить на однополярные силовые диоды и биполярные силовые диоды. Силовые диоды широко используются в энергетическом оборудовании в различных областях из-за их простой конструкции и низкой цены. Особенно быстродействующие восстановительные диоды и барьерные диоды Шоттки занимают незаменимое место в выпрямителях и инверторах низкого напряжения, промежуточной частоты и высокочастотных полей. С развитием технологий модульности и интеграции модульные силовые диоды становятся все более распространенными на рынке((нажмите, чтобы просмотреть дополнительные модули силовых диодов)).
2.2 Как работает силовой диод?
Сущность силового диода заключается в PN-переходе, образованном контактом между полупроводником P-типа и полупроводником N-типа. Поэтому, чтобы понять принцип работы силового диода, необходимо понять основные характеристики и принцип работы PN-перехода.
2.2.1 Базовая структура PN-перехода

Силовой диод состоит из полупроводника P-типа и полупроводника N-типа. Полупроводники N-типа и полупроводники P-типа состоят из легированных собственных полупроводников - концентрация свободных электронов в полупроводниках N-типа высока; концентрация дырок в полупроводниках P-типа высока. Область соединения между полупроводником P-типа и полупроводником N-типа называется PN-переходом. Свободные электроны и дырки также называются свободными носителями (именуемыми носителями). Движение и рекомбинация свободных электронов в полупроводнике неизбежно приведут к образованию и рекомбинации дырок. С макроскопической точки зрения этот процесс больше похож на отрицательно заряженные свободные электроны и положительно заряженные дырки, движущиеся в противоположных направлениях в полупроводнике одновременно. Движение свободных электронов и дырок в полупроводниках очень быстрое и случайное, поэтому практически невозможно предсказать траекторию определенного свободного электрона или дырки и точно знать их положение в определенный момент. Однако движение большого количества дырок и свободных электронов не лишено правил.
Мажоритарные носители в полупроводниках будут диффундировать из областей с высокой концентрацией в области с низкой концентрацией - свободные электроны мажоритарных носителей (nn) в N-области диффундируют из области с высокой концентрацией N через PN-переход в область с низкой концентрацией P; в то же время дырки мажоритарных носителей (pp) в области P диффундируют из области P с высокой концентрацией через PN-переход в область N с низкой концентрацией. Носители вблизи PN-перехода истощаются из-за диффузионного движения, оставляя только пространственные заряды (положительные и отрицательные ионы), которые не могут быть перемещены, поэтому эта область называется областью пространственного заряда (также известной как область истощения). Поскольку в области пространственного заряда нет свободно движущихся носителей, он похож на изолятор. Пространственный заряд в области пространственного заряда будет генерировать встроенное электрическое поле для предотвращения прохождения носителей через PN-переход (встроенное электрическое поле будет сформировано в течение нескольких наносекунд после изготовления PN-перехода). Тем не менее, все еще очень мало носителей, которые проходят через PN-переход и становятся неосновными носителями в противоположной области - свободные электроны становятся неосновными носителями в P-области (pn); дырки становятся неосновными носителями в N-области (np). Это явление называется эффектом квантового туннелирования. Разница в концентрации носителей по обе стороны области пространственного заряда создает встроенную разность потенциалов (также называемую встроенным потенциалом или контактной разностью потенциалов). Неосновные носители будут продолжать диффундировать в область с более низкой концентрацией. Среднее расстояние, которого могут достичь неосновные носители в процессе диффузии и рекомбинации, называется диффузионной длиной. На длину диффузии влияет время жизни неосновного носителя - чем больше время жизни неосновного носителя, тем больше длина диффузии. При достижении края диффузионной области неосновные носители пройдут через PN-переход и вернутся в исходную область под действием встроенного электрического поля.
* Монокристаллический полупроводник и Поликристаллический полупроводник
Монокристаллический полупроводник относится к полупроводнику с чистым химическим составом, без примесей и дефектов решетки, то есть к собственному полупроводнику, такому как кремний (Si), германий (Ge), арсенид галлия (GaAs) и т.д. Структура монокристаллических полупроводников очень правильная, а их макроскопические свойства анизотропны (в разных направлениях их физические свойства различны). Монокристаллические полупроводники являются материалами для большинства полупроводниковых приборов.
Поликристаллический полупроводник относится к полупроводниковому материалу, состоящему из большого количества крошечных монокристаллических полупроводниковых частиц с различной ориентацией. Структура поликристаллических полупроводников не обладает регулярностью, и их макроскопические свойства часто изотропны (в разных направлениях их физические свойства одинаковы). Поликристаллические полупроводники могут быть использованы для изготовления матриц узкопленочных транзисторных переключателей для солнечных элементов, жидкокристаллических дисплеев и затворных материалов для МОП-транзисторов.
* Теория энергетических зон

Теория энергетических зон - это теория, которая использует квантовую механику для изучения движения электронов внутри твердого тела. В системе координат с энергией в качестве ординаты энергия электронов в кристалле может быть представлена горизонтальной линией - чем больше энергия, тем выше положение линии. Энергетические уровни, которые очень близки друг к другу в пределах определенного энергетического диапазона, образуют энергетическую полосу. Вертикальное расстояние между самым высоким уровнем энергии и самым низким уровнем энергии в энергетической полосе называется шириной энергетической полосы. Положение и ширина энергетической полосы зависят от типа кристалла (например, металла, полупроводника, изолятора), температуры и т.д. Энергетическая зона полупроводника показана на рисунке 3.2а.
Полная полоса: Это относится к энергетической полосе, которая полностью занята электронами при T = 0K. Электроны в полной полосе являются валентными электронами (то есть электронами, которые связаны валентными связями на атомах кристалла и не могут свободно перемещаться), поэтому он не обладает никакой проводимостью.
Пустая полоса: Это относится к энергетической полосе, которая не занята электронами при T = 0K. В пустой полосе нет электронов, поэтому она не обладает никакой проводимостью. Пустая зона становится зоной проводимости, когда в ней есть электроны.
Зона проводимости: Это относится к энергетической зоне, которая не полностью занята электронами при T > 0K. Электроны в зоне проводимости являются свободными электронами, поэтому она обладает проводимостью.
Валентная зона: Это относится к энергетической зоне, занимаемой валентными электронами, когда T > 0K. Электроны в валентной зоне являются валентными электронами, поэтому она не обладает никакой проводимостью.
Запрещенная зона: Это относится к диапазону энергий между верхней частью валентной зоны и нижней частью зоны проводимости. В запрещенной зоне нет энергетического уровня общих электронов (то есть электронов, разделяемых несколькими атомами в кристалле), но есть энергетические уровни не разделяемых электронов (то есть локализованных электронов в примесях и дефектах). Ширина запрещенной зоны (запрещенная зона) отражает степень связывания валентных электронов или силу валентной связи, то есть минимальную среднюю энергию, необходимую для собственного возбуждения. Средняя линия запрещенной зоны - это уровень Ферми.
Ширина запрещенной зоны обычных металлических материалов, как правило, очень мала (зона проводимости и валентная зона даже перекрывают друг друга), и их электроны могут легко получать энергию и переходить в зону проводимости при комнатной температуре, поэтому их проводимость высокая. Ширина запрещенной зоны изоляционных материалов, как правило, очень велика (обычно превышает 9 электрон-вольт или 9 эВ), и их электроны с трудом переходят в зону проводимости, поэтому их проводимость очень низкая. Ширина запрещенной зоны полупроводниковых материалов находится между проводниками и изоляторами (около 1-3 эВ, например, при комнатной температуре ширина запрещенной зоны германия составляет 0,67 эВ, а ширина запрещенной зоны кремния составляет 1,12 эВ), поэтому просто дайте соответствующую энергию возбуждения (разрыв валентной связи для перехода валентного электрона в зону проводимости для генерации свободных электронов и дырок) или изменение запрещенной зоны (уменьшение энергии, необходимой для электронных переходов) может сделать полупроводник проводящим.
* Собственное возбуждение и свободные носители
Внутреннее возбуждение означает, что при определенных условиях возбуждения электроны во внутреннем полупроводнике пересекают запрещенную зону из зоны с более низкой энергией (полная зона или валентная зона) в зону с более высокой энергией (пустая зона или зона проводимости) и становятся свободными электронами. Следует отметить, что свободные электроны в зоне проводимости собственного полупроводника относятся к приблизительно свободным электронам в твердом теле, которые могут свободно перемещаться по всему твердому телу, но не могут выходить из твердого тела. Положительно заряженная вакансия образуется из-за отсутствия электрона в нижней энергетической полосе, которая называется дыркой. Свободные электроны в зоне проводимости и дырки в валентной зоне в совокупности называются электронно-дырочными парами. В собственных полупроводниках свободные электроны и дырки, генерируемые собственным возбуждением, могут свободно перемещаться, поэтому их называют свободными носителями, и их концентрации равны друг другу, и по мере повышения температуры их концентрация будет увеличиваться экспоненциально. Направленное движение свободных электронов и дырок будет формировать поток электронов и поток дырок. Свободные электроны в зоне проводимости попадут в дырки, в результате чего электронно-дырочные пары исчезнут. Этот процесс называется рекомбинацией. Энергия, генерируемая при рекомбинации, высвобождается в виде электромагнитного излучения (испускающий фотон) или тепловой вибрации решетки (испускающий фонон). При определенной температуре генерация и рекомбинация электронно-дырочных пар происходят одновременно и достигают динамического равновесия. В это время собственный полупроводник имеет определенную концентрацию носителей и, следовательно, обладает определенной электропроводностью. За счет собственного возбуждения генерируется больше электронно-дырочных пар, тем самым увеличивая концентрацию носителей, что может эффективно увеличить проводимость полупроводника. В соответствии с этим принципом могут быть изготовлены полупроводниковые устройства, такие как полупроводниковые термисторы и полупроводниковые фоторезисторы. Проводимость собственных полупроводников при комнатной температуре невелика, а концентрация носителей чувствительна к изменениям температуры, поэтому трудно эффективно контролировать полупроводниковые характеристики их полупроводников с помощью температуры.
Методы внутреннего возбуждения обычно можно разделить на внутреннее тепловое возбуждение, внутреннее световое возбуждение и внутреннее возбуждение ударной ионизации.
Внутреннее тепловое возбуждение: Это относится к инфракрасным фотонам, излучаемым тепловым движением молекул при повышении температуры, что заставляет валентные электроны получать достаточно энергии, чтобы освободиться от оков валентных связей и стать свободными электронами. Энергия, необходимая для собственного теплового возбуждения, равна запрещенной зоне. Эффективность теплового возбуждения при комнатной температуре обычно очень ограничена, поскольку требуется очень высокая температура, чтобы достаточное количество носителей могло перейти в зону проводимости.
Внутреннее световое возбуждение: Это относится к фотонам, излучаемым светом (обычно относящимся к видимому свету или ультрафиолетовому свету), который заставляет валентные электроны получать достаточно энергии, чтобы освободиться от оков валентных связей и стать свободными электронами. Энергия, необходимая для собственного светового возбуждения, больше, чем собственное тепловое возбуждение. Поскольку фотоны видимого света имеют более высокую энергию, чем инфракрасные фотоны, обычно генерируемые тепловым движением, энергия электронов после возбуждения собственным светом обычно находится в более высоком положении в зоне проводимости. Поскольку импульсом фотона можно пренебречь, собственное световое возбуждение не изменяет импульс электрона, поэтому этот процесс также называется вертикальным переходом. Но если задействован фонон (относящийся к простой гармонической вибрации кристаллической решетки), импульс электрона изменится, поэтому его также называют не вертикальным переходом.
Ударная ионизация Внутреннее возбуждение: Это относится к столкновению и ионизации валентных электронов электронами высокой энергии (то есть свободными электронами, ускоряемыми электрическим полем), чтобы стать свободными электронами. Средняя энергия, необходимая для собственного возбуждения ударной ионизации, примерно в 1,5 раза превышает ширину запрещенной зоны. Электроны, образующиеся при собственном возбуждении ударной ионизации, представляют собой ионизированные электроны, которые являются действительно свободными электронами, которые могут покидать твердое тело, и их энергия превышает свободные электроны с самым высоким уровнем энергии в зоне проводимости.
* Уровень Ферми и распределение Ферми-Дирака
Уровень Ферми - это энергетический уровень, который имеет 50%-ную вероятность быть занятым электронами при любой температуре - ниже уровня Ферми, чем дальше расстояние, тем больше вероятность быть занятым электронами; выше уровня Ферми, чем дальше расстояние, тем меньше вероятность быть занятым электронами. будучи занятым электронами. Для полупроводников, особенно собственных полупроводников, уровень Ферми находится на средней линии запрещенной зоны. Когда температура T = 0K, полная полоса заполнена электронами (вероятность заполнения электронами равна 1), а в пустой зоне вообще нет электронов (вероятность заполнения электронами равна 0), тогда их уровень Ферми находится точно на средней линии запрещенной зоны (вероятность заполнения электронами равно 1/2). Даже при повышении температуры T> 0K собственное возбуждение приведет к образованию электронно-дырочных пар, но поскольку число электронов, увеличенных в зоне проводимости, равно числу электронов, уменьшенных в валентной зоне, уровень Ферми все еще находится на средней линии запрещенной зоны (вероятность заполнения электронами равно 1/2). Следовательно, положение уровня Ферми собственного полупроводника не меняется с температурой и всегда находится на средней линии запрещенной зоны. Распределение электронов Ферми-Дирака можно рассчитать по уровню Ферми и температуре, как показано на рисунке 3.2b.
* Легирование полупроводников
Как правило, собственный полупроводник будет легирован для введения новых уровней энергии для увеличения его проводимости. Легированный полупроводник более восприимчив к внешним воздействиям (таким как свет, повышение температуры и т.д.).
При легировании кристалла кремния (или кристалла германия) элементом фосфора (или элементом сурьмы) атом фосфора (или атом сурьмы) займет положение атома кремния. Затем к положению в запрещенной зоне, которое находится очень близко к зоне проводимости, будет добавлен набор полных энергетических уровней. Электроны на этих энергетических уровнях могут легко переходить в зону проводимости, становясь свободными электронами. Поэтому элемент фосфора (или элемент сурьмы) называется донорной примесью (или примесью N-типа), а полупроводник, легированный примесью N-типа, называется полупроводником N-типа.
При легировании кристалла кремния (или кристалла германия) элементом бора (или элементом индия) атом бора (или атом индия) займет положение атома кремния. Затем к положению в запрещенной зоне, которое находится очень близко к валентной зоне, будет добавлен набор пустых энергетических уровней. Электроны в валентной зоне могут легко переходить на эти энергетические уровни и оставлять дырки в валентной зоне. Поэтому элемент бора (или элемент индия) называют акцепторными примесями (или примесями Р-типа), а полупроводники, легированные примесями Р-типа, называются полупроводниками Р-типа.
2.2.2 Однонаправленная проводимость PN-перехода

Суть принципа работы силового диода заключается в однонаправленной проводимости PN-перехода. В случае постоянных внешних условий (температура, излучение и т.д.) внешняя цепь будет дополнять носители, потребляемые во время работы силового диода, поэтому на проводимость силового диода в основном влияет его внутренняя концентрация носителей.
Состояние прямой проводимости: Если на силовой диод подается напряжение прямого смещения, основные носители переместятся ближе к PN-переходу, что сузит область пространственного заряда и ослабит встроенное электрическое поле, но PN-переход все равно будет поддерживать состояние динамического равновесия. Только когда напряжение прямого смещения больше, чем встроенное электрическое поле, динамическое равновесие может быть нарушено, и генерируется наложенное электрическое поле в направлении, противоположном дрейфовому току. Идентификатор диффузионного тока больше идентификатора дрейфового тока. Ток, протекающий через PN-переход, является прямым током, ЕСЛИ. Из-за встроенной разности потенциалов, когда силовой диод находится в состоянии прямой проводимости, на обоих его концах будет генерироваться падение напряжения во включенном состоянии, что приводит к тому, что силовой диод находится в состоянии низкого импеданса. Падение напряжения силового диода во включенном состоянии не является фиксированным значением, оно пропорционально протекающему току.
Состояние обратного отключения: Если на силовой диод подается напряжение обратного смещения, основные несущие будут удаляться от PN-перехода, что расширит область пространственного заряда и усилит встроенное электрическое поле. Динамическое равновесие PN-перехода нарушается, и генерируется наложенное электрическое поле в том же направлении, что и дрейфовый ток. Идентификатор дрейфового тока больше идентификатора диффузионного тока. Ток, протекающий через PN-переход, представляет собой обратный ток насыщения Isat. Поскольку число неосновных несущих слишком мало, ток обратного насыщения силового диода обычно незначителен, что приводит к тому, что силовой диод находится в состоянии с высоким импедансом.
Состояние обратного пробоя: Если напряжение обратного смещения на силовом диоде продолжает увеличиваться до определенного критического значения, количество несущих в силовом диоде быстро увеличивается, что приводит к значительному увеличению обратного тока IR. В состоянии обратного пробоя силовой диод находится в состоянии без импеданса, а его обратный ток IR и обратное напряжение UR очень велики. Обратный пробой PN-перехода в основном делится на лавинный пробой и пробой стабилитрона. Обе эти поломки приведут к повышению температуры PN-перехода и в конечном итоге приведут к тепловому пробою, что приведет к необратимому повреждению PN-перехода. Если меры по охлаждению выполнены достаточно хорошо, даже если силовой диод поврежден в обратном направлении, но PN-переход не разрушен, то после ограничения или замыкания обратного напряжения PN-переход все равно может быть восстановлен в исходное состояние.
* Диффузионный ток и Дрейфовый ток
Диффузионное движение относится к перемещению основных носителей из области с высокой концентрацией в область с низкой концентрацией. Диффузионное движение определяется градиентом концентрации. Дрейфовое движение относится к движению неосновных носителей, возвращающихся в исходную область под действием встроенного электрического поля. Дрейфовое движение определяется встроенным электрическим полем. Диффузионное движение и дрейфовое движение являются основными движениями носителей в PN-переходе. Ток, генерируемый диффузионным движением, называется идентификатором диффузионного тока, а ток, генерируемый дрейфовым движением, называется идентификатором дрейфового тока. Когда нет приложенного напряжения (или напряжение прямого смещения меньше, чем встроенное электрическое поле), диффузионное движение приведет к усилению встроенного электрического поля и увеличению дрейфового тока; дрейфовое движение приведет к ослаблению встроенного электрического поля и увеличению диффузионного тока. чтобы увеличить. Наконец, диффузионный ток равен дрейфовому току, и PN-переход будет находиться в состоянии динамического равновесия, когда общий ток равен нулю.
* Диффузионный ток и Дрейфовый ток
Лавинный пробой обычно происходит в низколегированном PN-переходе с широким обедненным слоем. Из-за широкого обедненного слоя, когда обратное смещение велико, свободные электроны в полупроводнике будут непрерывно ускоряться под действием силы электрического поля и получать большое количество кинетических энергий. Эти электроны высокой энергии сталкиваются с валентными электронами, освобождая их от оков валентных связей и генерируя новые электронно-дырочные пары. Эти вновь сгенерированные свободные электроны продолжают повторять этот процесс под действием силы электрического поля, заставляя свободные носители в полупроводнике быстро увеличиваться подобно лавине, что приводит к резкому увеличению дрейфового тока. Суть лавинного пробоя заключается в возбуждении ударной ионизации, поэтому напряжение лавинного пробоя обычно высокое (обычно выше 6 В). Напряжение лавинного пробоя увеличивается с повышением температуры, главным образом потому, что неравномерное тепловое движение носителей увеличивается с повышением температуры, поэтому требуется большее обратное напряжение для обеспечения достаточно большого электрического поля, чтобы заставить носители совершать движение с направленным ускорением.
Пробой Стабилитрона обычно происходит в высоколегированном PN-переходе с узким обедненным слоем. Из-за узкого обедненного слоя не хватает места для ускорения свободных электронов, поэтому лавинного пробоя не произойдет. В то же время, из-за узкого обедненного слоя, даже если обратное смещение невелико, в PN-переходе все равно может генерироваться сильное электрическое поле, вытягивающее электроны из валентной связи и генерирующее новые электронно-дырочные пары. Это явление также называется возбуждением, вызванным полем. Возбуждение, вызванное полем, значительно увеличит количество носителей в полупроводнике, тем самым значительно увеличив дрейфовый ток. Напряжение пробоя стабилитрона обычно низкое (обычно менее 4 В). Напряжение пробоя Стабилитрона уменьшается с повышением температуры, главным образом потому, что электроны в валентной связи становятся более активными с повышением температуры, поэтому силе электрического поля легче их вытащить.
2.2.3 Емкостный эффект PN-перехода
Величина заряда в PN-переходе изменяется в зависимости от приложенного напряжения, проявляя эффект емкости. Эта емкость называется переходной емкостью CJ (также известной как дифференциальная емкость). В соответствии с различным механизмом генерации и функцией емкость перехода CJ может быть разделена на барьерную емкость CB и диффузионную емкость CD, и они соответствуют формуле расчета CJ = CB + CD. Как барьерная емкость, так и диффузионная емкость являются нелинейными емкостями.
1- Барьерная Емкость
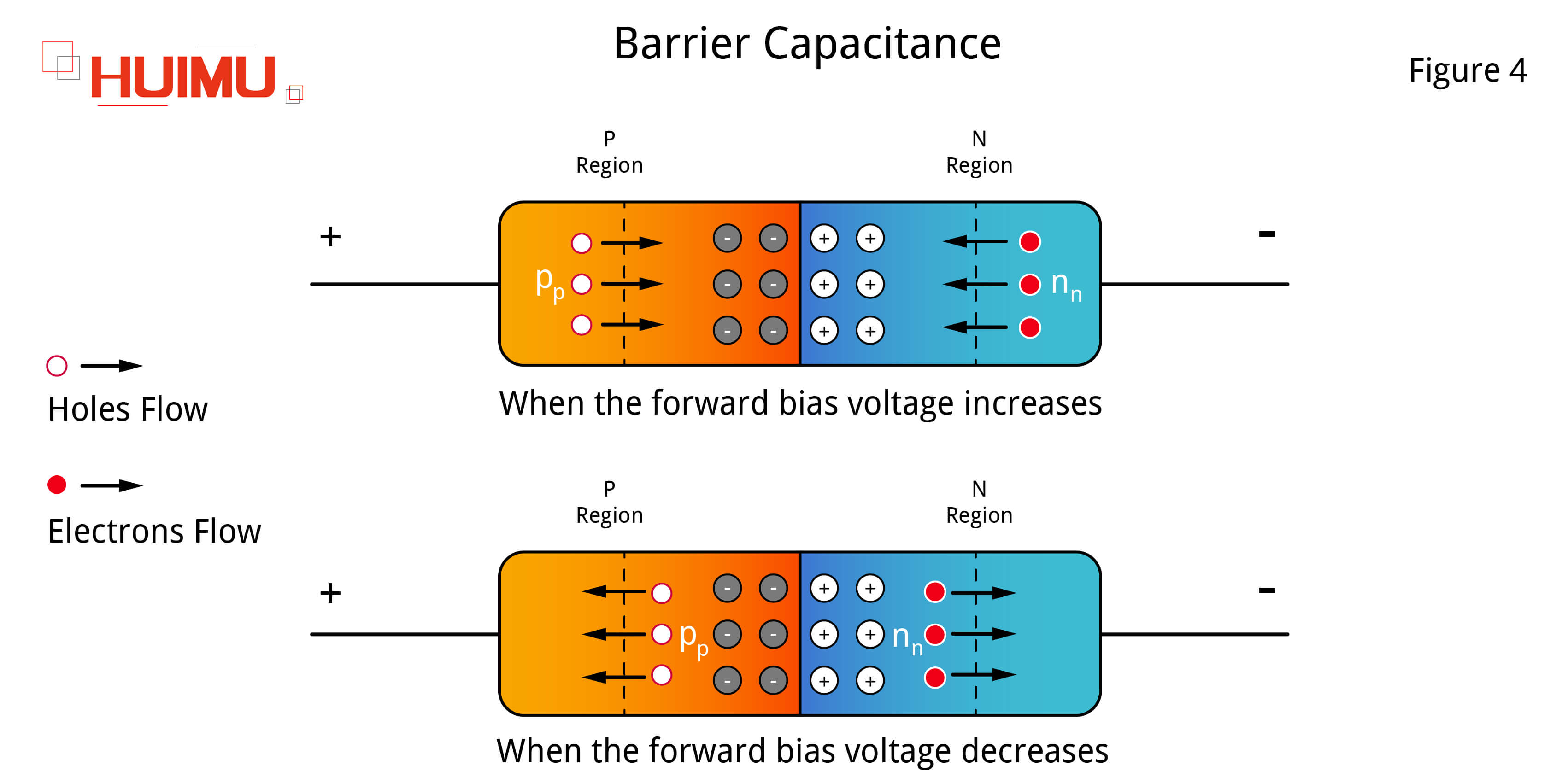
Узкий слой ионов в области пространственного заряда (обедненный слой) образует барьерную область. Количество пространственных зарядов в области барьера изменяется с приложенным напряжением смещения, что эквивалентно эффекту заряда и разряда конденсатора - когда напряжение прямого смещения увеличивается, площадь барьера уменьшается, что эквивалентно накоплению свободных электронов или дырок в области барьера; когда прямое смещение уменьшается, площадь барьера увеличивается, что эквивалентно удалению свободных электронов или дырок из области барьера. Эквивалентная емкость барьерной области называется барьерной емкостью CB. Если частота приложенного напряжения смещения выше, эффект барьерной емкости более очевиден. Независимо от низкочастотной или высокочастотной работы барьерная емкость может ухудшить однонаправленную проводимость полупроводникового устройства или даже выйти из строя. На самом деле максимальная рабочая частота полупроводникового устройства часто определяется барьерной емкостью. Стоит отметить, что барьерная емкость - это эффект емкости, связанный с основной несущей (pp и nn), и ни прямое смещение, ни обратное смещение нельзя игнорировать. При прямом смещении, когда прямое напряжение низкое, барьерная емкость намного больше, чем диффузионная емкость, поэтому барьерная емкость является основной составляющей емкости перехода, CJ ≈ CB.
2- Диффузионная Емкость

Когда PN-переход смещен вперед, встроенное электрическое поле ослабляется, и дрейфовое движение неосновных носителей ослабляется. Диффузионный ток больше дрейфового тока. Следовательно, носители, которые диффундируют в противоположную область, будут накапливаться на границе барьера, образуя определенную концентрацию неравновесных неосновных носителей (pn и np) - чем ближе к PN-переходу, тем выше концентрация; чем дальше от PN-перехода, тем ниже концентрация. Величина заряда таких неравновесных неосновных носителей изменяется с прямым смещением, что эквивалентно эффекту заряда и разряда конденсатора - когда прямое смещение увеличивается, неравновесные неосновные носители увеличиваются, что эквивалентно зарядке конденсатора; когда прямое смещение уменьшается, неравновесные неосновные носители уменьшаются, что эквивалентно разрядке конденсатора. Эквивалентная емкость на границе барьерной области называется диффузионной емкостью CD. Диффузионная емкость оказывает большое влияние на скорость переключения PN-перехода при работе на низких частотах и может быть проигнорирована при работе на высоких частотах. При прямом смещении, если прямое напряжение высокое, диффузионная емкость намного больше барьерной емкости, поэтому диффузионная емкость является основной составляющей емкости перехода, CJ ≈ CD. При обратном смещении неравновесных неосновных носителей слишком мало, и диффузионной емкостью можно пренебречь, поэтому барьерная емкость является основной составляющей емкости перехода, CJ ≈ CB.
2.3 Основные параметры силовых диодов
1- Максимальный прямой Средний ток IFM(AV)
Максимальный прямой средний ток IF (AV) представляет собой номинальный ток силового диода, который относится к среднему значению полуволнового синусоидального тока максимальной частоты мощности, который может протекать через силовой диод при указанной температуре корпуса TC и условиях рассеивания тепла. Если оно превышает значение IF(AV), диод перегорает. Поскольку форма волны некоторых силовых диодов не обязательно является полусинусоидальной, а некоторые силовые диоды не имеют характеристик сопротивления, IF (AV) определяется в соответствии с тепловым эффектом тока, то есть найдите резистор с аналогичным выделением тепла в соответствии с принципом равного эффективного значения. Учитывая, что условия рассеивания тепла будут влиять на способность силового диода выдерживать ток, рекомендуется оставить определенный запас, чтобы избежать повреждения силового диода из-за проблем с рассеиванием тепла.
2- Пороговое напряжение UTO
Автоматическое пороговое напряжение (также известное как напряжение мертвой зоны) - это наименьшее прямое напряжение, при котором может быть включен силовой диод. Пороговое напряжение - это наименьшее прямое падение напряжения силового диода. Пороговое напряжение кристалла германия составляет около 0,1 В; пороговое напряжение кристалла кремния составляет около 0,5 В.
3- Падение напряжения во включенном состоянии UCO
Падение напряжения во включенном состоянии UCO (также известное как напряжение проводимости) представляет собой прямое падение напряжения, когда силовой диод включен и работает стабильно. В идеале падение напряжения силового диода во включенном состоянии равно встроенному потенциалу. Встроенный потенциал связан со степенью легирования полупроводника и приблизительно равен половине запрещенной зоны. Падение напряжения силового диода во включенном состоянии пропорционально протекающему току. Падение напряжения во включенном состоянии кристаллов германия обычно составляет около 0,1-0,3 В; падение напряжения во включенном состоянии кремниевых кристаллов обычно составляет около 0,5-0,8 В.
4- Максимальное Прямое Падение напряжения UFM
Максимальное прямое падение напряжения UFM - это прямое падение напряжения, соответствующее максимальному прямому среднему току IFM (AV) при заданной температуре.
5- Обратный Ток Насыщения Isat
При подаче соответствующего обратного напряжения будет генерироваться очень небольшой ток утечки, который называется обратным током насыщения Isat. Обратный ток насыщения генерируется дрейфовым движением неосновных носителей, поэтому на него сильно влияет температура.
6- Обратное повторяющееся пиковое напряжение URRM
Обратное повторяющееся пиковое напряжение URRM (также известное как максимальное обратное напряжение URM) представляет собой номинальное напряжение силового диода, которое относится к самому высокому обратному напряжению, которое силовой диод может выдержать при многократном приложении. Если оно превысит это значение, силовой диод будет перевернут и поврежден. Принимая во внимание перенапряжение в цепи и другие факторы, при использовании силовых диодов обычно должен быть двойной запас. Например, силовой диод с номинальным напряжением 1000 В может использоваться только в качестве силового диода напряжением 500 В.
7- Время обратного восстановления trr
Обратный процесс восстановления вызван емкостным эффектом силового диода. Когда переключатель переходит из включенного состояния в выключенное, силовому диоду необходимо сбросить заряд, накопленный в емкости перехода, прежде чем блокировать обратный ток. Это время разряда называется обратным временем восстановления trr, то есть временем с момента, когда прямой ток проводимости равен нулю, до момента, когда он переходит в полностью выключенное состояние. Время обратного восстановления силовых диодов разных спецификаций различно, поэтому при проектировании схемы необходимо полностью учитывать это, иначе это может вызвать ненужные проблемы. Например, время обратного восстановления силового диода равно Trr. Если непрерывная ШИМ-волна с периодом T1 (T1<Trr) проходит через силовой диод, ШИМ-волна не может быть заблокирована, когда силовой диод имеет обратное смещение.
8- Максимальная Рабочая Температура Соединения TJM
Температура перехода TJ относится к средней температуре PN-перехода. Максимальная рабочая температура перехода TJM относится к самой высокой средней температуре, которую PN-переход может выдержать без повреждений (обычно самая высокая температура перехода германиевых транзисторов составляет около 75 °C, а самая высокая температура перехода кремниевых транзисторов составляет около 150°C). Температура оказывает очень значительное влияние на рабочие характеристики силовых диодов, поэтому необходимо обеспечить достаточные условия отвода тепла, чтобы избежать повреждения силового диода из-за перегрева.
9- Максимальная Рабочая частота fM
Максимальная рабочая частота fM - это верхняя частота выключения диода. Если частота слишком высока, силовой диод легко потеряет свою способность блокировать обратный ток из-за емкостного эффекта. В то же время, если частота слишком высока, это также приведет к перегоранию силового диода из-за увеличения энергопотребления во включенном состоянии.
10- Ток перенапряжения IFSM
Ток перенапряжения IFSM относится к максимальной непрерывной перегрузке по току в течение одного или нескольких циклов частоты мощности, которые может выдержать силовой диод.
2.4 Основные характеристики силовых диодов
2.4.1 Статические характеристики силовых диодов

Статическая характеристика силового диода в основном относится к вольт-амперной характеристической кривой силового диода, показанной на рисунке 6.
Когда напряжение прямого смещения подается на оба конца силового диода, силовой диод включается не сразу. Только когда прямое напряжение превышает пороговое напряжение на силовом диоде, силовой диод будет включен. В это время прямой ток IF начинает значительно увеличиваться, пока силовой диод не перейдет в стабильное состояние проводимости, и в это время напряжение проводимости диода составляет UCO. Если прямой ток достигает IFM, соответствующее падение напряжения равно UFM, и силовой диод перегорает из-за чрезмерного тока.
Когда на оба конца силового диода подается напряжение обратного смещения, силовой диод не будет проводить ток, но будет генерировать ток небольшого постоянного значения, то есть ток обратной утечки. Когда обратное напряжение достигнет обратного UBR силового диода, силовой диод будет обратно разрушен, и обратный ток в это время станет очень большим.
2.4.2 Динамические характеристики силовых диодов
Динамические характеристики силового диода относятся к его характеристикам переключения, то есть к вольт-амперной характеристике силового диода во время перехода между включенным и выключенным состояниями. Из-за емкости перехода вольт-амперные характеристики силовых диодов меняются со временем.
1- Процесс включения

Динамическая характеристика силового диода в процессе включения показана на рисунке 7. Когда напряжение изменяется с нулевого смещения на прямое смещение, прямой ток IF силового диода увеличится с 0 до IF1. Из-за большого di/dt под действием индуктивности линии на обоих концах силового диода будет генерироваться прямое пиковое напряжение UFP. Через определенный промежуток времени прямое напряжение UF будет постепенно падать от ДО стабильного напряжения UF1 (то есть падение напряжения во включенном состоянии). В этом процессе время, когда прямой ток возрастает с 0 до IF1, называется прямым временем восстановления tfr.
2- Процесс отключения

Динамическая характеристика силового диода в процессе выключения показана на рисунке 8. Из-за емкости перехода, даже если прямое смещение преобразуется в обратное смещение, силовой диод не будет отключен немедленно, но потребуется некоторое время, чтобы восстановить способность обратной блокировки.
Когда силовой диод переключается с прямого смещения на обратное смещение при tF, а прямой ток IF быстро уменьшается и падает до 0 при t0, а разница / dt велика. От t0 до t1 ток не только не исчезает, но становится обратным током IR и быстро увеличивается, пока не достигнет максимального значения IRP. Этот период времени называется временем задержки td. От t1 до t2 обратный ток начинает резко падать до очень малого значения. Этот период времени называется временем падения tf. Начиная с t2 обратный ток начинает медленно уменьшаться, пока не упадет до 0 (на самом деле, обратный ток утечки все еще очень мал). Время от t0 до t2 называется временем обратного восстановления trr, в течение которого силовой диод имеет обратную проводимость. Время обратного восстановления trr определяет рабочую частоту силового диода. Если рабочая частота внешней цепи слишком высока, силовой диод не может перейти в состояние обратного отключения при обратном смещении, и возникает большой обратный ток, что эквивалентно потере силовым диодом своей способности к обратному блокированию.
Перед тем, как обратный ток возрастет до максимального значения, напряжение на силовом диоде быстро падает от падения напряжения в состоянии включения UF1 до 0. В то же время, поскольку tf обычно очень короткий, diR/dt очень большой. Под действием индуктивности линии на обоих концах силового диода быстро генерируется обратное пиковое напряжение URP, а затем оно начинает падать до стабильного значения UR1. Обратное пиковое напряжение обычно очень велико и может вывести из строя силовой диод. Следовательно, увеличение доли tf в trr поможет уменьшить обратное пиковое напряжение. Коэффициент восстановления (Sr =tf/td) обычно используется для выражения мягкости характеристик обратного восстановления силового диода.
2.5 Основные типы силовых диодов
1- Диод Общего Назначения
Диоды общего назначения (GPD), также известные как выпрямительные диоды, имеют длительное время восстановления, высокий номинальный прямой ток и номинальное обратное напряжение. Они в основном используются в выпрямительных цепях с низкой частотой переключения (ниже 1 кГц) и, как правило, не могут использоваться в цепях средней и высокой частоты.
2- Диод Быстрого Восстановления
Внутренняя структура диода быстрого восстановления (FRD) отличается от структуры диода общего назначения. Он добавляет базовую область I между кремниевыми материалами P-типа и N-типа, образуя структуру P-I-N. Поскольку базовая область очень тонкая, а заряд обратного восстановления невелик, это не только значительно снижает trr и переходное падение прямого напряжения, но и улучшает его способность выдерживать обратное напряжение. Время восстановления диода быстрого восстановления очень короткое (trr> 100 нс, обычно несколько сотен нс), его прямое падение напряжения составляет около 0,6 В, прямой ток составляет от нескольких ампер до нескольких тысяч ампер, а обратное пиковое напряжение может достигать от нескольких сотен до нескольких тысяч вольт. Сверхбыстрые восстановительные диоды, также известные как эпитаксиальные диоды быстрого восстановления (FRED), имеют дополнительно уменьшенный заряд обратного восстановления, поэтому они имеют более короткое время восстановления (trr<100 нс, всего 20 ~ 30 нс). Прямое падение напряжения у сверхбыстрых восстановительных диодов также очень низкое (около 0,9 В), но их способность выдерживать обратное напряжение обычно невелика (менее 1200 В).
3-Барьерный диод Шоттки
Барьерный диод Шоттки (SBD) - это разновидность силового диода, основанного на барьере, образованном контактом между металлом и полупроводником. По сравнению с диодами общего назначения и диодами с быстрым восстановлением, барьерные диоды Шоттки обладают преимуществами короткого времени обратного восстановления, отсутствия очевидного превышения прямого напряжения и высокого обратного выдерживаемого напряжения, но их обратный ток утечки велик. Прямое падение напряжения барьерных диодов Шоттки зависит от обратного выдерживающего напряжения - если обратное выдерживающее напряжение увеличивается, прямое падение напряжения значительно увеличится. Но когда обратное выдерживающее напряжение низкое, прямое падение напряжения барьерных диодов Шоттки значительно ниже, чем у диодов общего назначения и диодов с быстрым восстановлением, поэтому потери при переключении и потери во включенном состоянии очень низкие. Поэтому барьерные диоды Шоттки обычно используются в выпрямительных цепях напряжением ниже 200 В. Однако следует отметить, что барьерные диоды Шоттки очень чувствительны к температуре, поэтому их рабочая температура должна быть строго ограничена.
§3. Что такое транзистор?
Прежде чем представить устройства с половинным управлением и устройства с полным управлением, необходимо кратко представить транзисторы с биполярным переходом (BJT).
3.1 Введение в транзисторы

Транзистор (также известный как полупроводниковый транзистор или транзистор с биполярным переходом, BJT) представляет собой биполярное устройство с тремя выводами и двумя PN-переходами. Транзистор является одним из основных компонентов полупроводниковых приборов, а также одним из основных компонентов. С момента своего появления в 1940-х годах транзистор полностью изменил структуру электронных схем, вызвал революцию в полупроводниковых устройствах и способствовал появлению интегральных схем и крупномасштабных интегральных схем. Транзистор имеет функцию усиления тока и может управлять большим изменением тока коллектора при очень небольшом изменении тока базы, поэтому он часто используется в качестве бесконтактного переключателя в электронных схемах. Частота переключения транзистора высока, а механический срок службы отсутствует, поэтому он имеет значительное преимущество перед электромагнитными реле и механическими переключателями.
3.2 Как работает транзистор?
3.2.1 Базовая структура транзисторов

Транзистор представляет собой трехслойную полупроводниковую структуру, которая имеет на один PN-переход больше, чем силовой диод. Эти два близко расположенных PN-перехода делят транзистор на три части с различными площадями и концентрациями легирования: базовая область очень тонкая (3-30 мкм) и концентрация легирования низкая; площадь эмиттерной области мала, а концентрация легирования высока; площадь коллекторной области большая, а концентрация легирования низкая. концентрация допинга низкая. PN-переход между коллекторной областью и базовой областью называется коллекторным переходом J1. PN-переход между областью эмиттера и базовой областью называется эмиттерным переходом J2.
В зависимости от материала транзисторы можно разделить на кремниевые транзисторы и германиевые транзисторы. В соответствии с составом легирования транзисторы можно разделить на PNP-транзисторы и NPN-транзисторы - при прямом смещении область эмиттера PNP-транзисторов испускает отверстия, и ее направление совпадает с направлением тока, поэтому стрелка в электрическом символе идет от эмиттера к базе; при прямом смещении эмиттер NPN-транзисторов испускает свободные электроны, и его направление противоположно направлению тока, поэтому стрелка в электрическом символе идет от базы к эмиттеру.
3.2.2 Принцип работы транзисторов

Возьмем в качестве примера NPN-транзистор. NPN-транзистор можно рассматривать как два эквивалентных диода (VD1 и VD2), как показано на рис. 11, а. Поскольку N-область VD1 имеет низкую концентрацию легирования и большую площадь, она не подвержена лавинному пробою, поэтому может выдерживать большое обратное напряжение. Но при прямом смещении прямой ток VD1 очень мал, поэтому VD1 очень подходит для работы в режиме обратного отключения. VD1 будет генерировать обратный ток насыщения ICBO, когда VD1 работает в обратном состоянии, но концентрация легирования в N-области и P-области очень низкая, поэтому ICBO очень мал. Поскольку область N+ VD2 имеет высокую концентрацию легирования и небольшую площадь, она подвержена лавинному пробою, поэтому ее способность выдерживать обратное напряжение очень низкая. Но при прямом смещении VD1 может генерировать очень большой прямой ток, поэтому VD2 очень подходит для работы в состоянии прямой проводимости. Когда VD2 работает в прямом состоянии, он будет генерировать два тока, один из которых представляет собой ток IEP, генерируемый потоком дырок в области P, а другой - ток IEN, генерируемый потоком электронов в области N +. Поскольку концентрация легирования в P-области VD1 ниже, чем в N+-области, IEN больше, чем IEP. Когда мы знаем принцип работы этих двух эквивалентных диодов, легко понять принцип работы NPN-транзистора.
Подключите NPN-транзистор с помощью общего метода подключения эмиттера - источник питания коллектора EC и сопротивление коллектора RC подключены последовательно к коллектору и эмиттеру; источник питания базы EB и сопротивление базы RB подключены последовательно к базе и эмиттеру. В этой схеме ток поступает в NPN-транзистор из коллектора и базы и вытекает из NPN-транзистора из эмиттера - общий ток, поступающий из коллектора, равен току коллектора IC; общий ток, поступающий из базы, равен базовому току IB; общий ток, вытекающий из эмиттера, является током эмиттера IE. Линейная зависимость между IC и IE является общим коэффициентом усиления по току базы α, а линейная зависимость между IC и IB является общим коэффициентом усиления по току эмиттера β. Стоит отметить, что из-за разницы в концентрации легирования коллекторный переход J1 не подходит для прямого смещения, а эмиттерный переход J2 не подходит для обратного смещения. Если коллектор и эмиттер соединены обратным образом, вероятность пробоя NPN-транзистора значительно возрастет.
Состояние отключения: Структура NPN позволяет всегда иметь PN-переход в состоянии обратного смещения. Когда на базу не подается напряжение, даже если на коллектор и эмиттер подается большое напряжение (меньше напряжения пробоя BVCEO), NPN-транзистор не может быть включен (но существует небольшой ток утечки ICEO).
Активное состояние: VD1 и VD2 должны работать одновременно, чтобы включить NPN-транзистор, поэтому к базе необходимо приложить определенное напряжение, чтобы сделать J1 смещенным в обратном направлении (UBC<0) j2="" ube="">UTO). Когда NPN-транзистор включен, его внутренний ток немного отличается от того, когда эквивалентные диоды работали отдельно, как показано на рис. 11, б. Свободные электроны, инжектированные из области N+ в область P, не полностью рекомбинируют с дырками в области P. Из-за обратного смещения J2 часть свободных электронов пройдет через P-область и будет непосредственно инжектирована в N-область, и будет генерировать обратный ток ICN. Когда NPN-транзистор работает в активном состоянии, небольшое изменение тока базы IB of вызовет большое изменение тока коллектора IC. Это явление называется эффектом модуляции проводимости. Это явление подобно тому, как крошечный входной ток усиливается в огромный выходной ток, поэтому активное состояние также известно как состояние усиления.
Состояние насыщения: С увеличением IB концентрация дырок в области P уменьшается, IEP уменьшается, а область обеднения J1 продолжает увеличиваться. В то же время, поскольку свободных электронов, инжектируемых из области N+ в область P, становится все меньше и меньше, IBN упал почти до минимального значения, и эффект усиления IB на IC начал ослабевать. Когда IB и IC больше не имеют линейной зависимости, NPN-транзистор начинает переходить в состояние насыщения. В это время, по мере увеличения IB, IC медленно увеличивается, и глубина насыщения NPN-транзистора также начинает углубляться. Когда почти все свободные электроны в N+-области инжектируются в N-область, потенциал основания совпадает с потенциалом коллектора (UBC=0). В это время NPN-транзистор находится в состоянии глубокого насыщения, и IC полностью не подвержен влиянию IB. Следует отметить, что по мере увеличения области истощения J1 вероятность лавинного разрушения на J1 также возрастает.
* Формула расчета транзистора
IC = ICN + ICBO, (1)
IB = IBN + IEP - ICBO, (2)
IE = IC + IB = ICN + IBN + IEP, (3)
потому что IC > 0, тогда мы получаем IE / IC = IB / IC + 1; (4)
α = ICN / IE = (IC - ICBO) / IE, (5)
β = ICN / (IB + ICBO) = (IC - ICBO) / (IB + ICBO), (6)
потому что IC > IB >> ICEO >> ICBO ≈ 0, если игнорировать весь ток утечки, мы можем получить α ≈ IC / IE, β ≈ IC / IB, (7)
тогда мы сможем получить 1/α = 1/β + 1, (8)
таким образом, соотношение между α и β равно: α = β / (1 + β), β = α / (1 - α). (9)
* Ток утечки

Как ток обратного насыщения коллекторного перехода ICBO, так и ток проникновения ICEO являются неизбежными токами утечки в транзисторе. Открыв эмиттер транзистора (IE=0) и подав напряжение на коллектор и базу, можно измерить значение ICBO, как показано на рисунке 12, а. Открыв базу транзистора (IB=0) и подав напряжение на коллектор и эмиттер, можно измерить значение ICEO, как показано на рисунке 12, b.
Механизм генерации обратного тока насыщения ICBO коллекторного перехода показан на рисунке 11, а.
Механизм генерации тока проникновения ICEO заключается в следующем: под действием внешнего электрического поля основные носители в области коллектора удаляются от PN-перехода, расширяя область пространственного заряда, и встроенное электрическое поле коллекторного перехода J1 усиливается, что способствует дрейфовое движение; большинство носителей в области эмиттера перемещаются ближе к PN-переходу, сужая область пространственного заряда, а встроенное электрическое поле эмиттерного перехода J2 ослабляется, что не способствует дрейфовому движению. Следовательно, под действием встроенного электрического поля неосновные носители в базовой области дрейфуют в коллекторную область через J1. В то же время неосновные носители в коллекторной области дрейфуют в базовую область через J1, часть которых участвует в рекомбинации базовой области, а другая часть диффундирует в эмиттерную область через J2. Из-за низкой концентрации легирования базовой области доля неосновных носителей, участвующих в рекомбинации базовой области, очень мала. Нетрудно обнаружить, что этот процесс очень похож на механизм генерации IEN при включении транзистора. Следовательно, существует линейная зависимость между ICEO и ICBO, ICEO = (1 + β) * ICBO. Однако из-за низкой концентрации легирования в коллекторной области и базовой области значение ICEO очень низкое и обычно может быть проигнорировано. ICEO кремниевых транзисторов обычно составляет менее 100нА; ICEO германиевых транзисторов обычно составляет менее 100 мкА.
* Эффект Модуляции Проводимости
Проводимость (G) является обратной величиной сопротивления, а единица измерения - Siemens (S). Эффект модуляции проводимости (также известный как эффект модуляции проводимости базовой области или эффект Вебстера) является одной из основных характеристик биполярных транзисторов (BPT), который относится к явлению, при котором проводимость базовой области значительно увеличивается (или удельное сопротивление базовой области значительно уменьшается), когда рабочий ток биполярного транзистора велика. За исключением ОБОИХ, другие биполярные транзисторы, такие как SCR, GTO, GTR и паразитные транзисторы в IGBT, обладают эффектом модуляции проводимости. В дополнение к эффекту Вебстера, когда рабочий ток биполярного транзистора велик, эффект раннего (явление, при котором изменения напряжения на коллекторном переходе приводят к изменениям ширины базовой области) и эффект Кирка (явление, при котором ширина базовой области увеличивается) также появится.
3.3 Основные параметры транзисторов
1- Коэффициент усиления по Общему Базовому Току α
Коэффициент усиления по току общей базы α (полное название - "коэффициент усиления по прямому току гибридного параметра, общая база" HFB), который определяется коэффициентом полезного действия эмиттера и коэффициентом переноса базовой области, α = FE * FB. Когда база смещена к нулю (UBC = 0), коэффициент усиления α0 от короткого замыкания базы определяется коэффициентом полезного действия эмиттера, коэффициентом переноса базовой области, коэффициентом полезного действия коллектора и коэффициентом лавинного умножения, α0 = FE * FB * FC * M.
Коэффициент полезного действия эмиттера FE представляет собой отношение электронного тока IEN, вводимого в базовую область, к току эмиттера IE, FE = IEN / IE = IEN / (IEN + IEP) = 1/ [1 + (IEP / IEN)]. Уменьшая концентрацию легирования базовой области, общее количество примесей в базовой области намного меньше, чем общее количество примесей в эмиттерной области, что может эффективно увеличить количество неосновных носителей, вводимых в базовую область из эмиттерной области. Чем ближе отношение IEP к IEN к 0, тем выше эффективность излучения транзистора.
Коэффициент переноса базовой области FB представляет собой отношение электронного тока ICN, который достигает коллекторной области, к электронному току IEN, вводимому в базовую область, FB = ICN / IEN. За счет уменьшения ширины базовой области время, в течение которого несущие из области излучателя остаются в базовой области, может быть эффективно сокращено, тем самым увеличивая количество неосновных несущих, которые проходят через базовую область. Чем меньше ширина базовой области, тем меньше рекомбинационные потери электронов из области эмиттера в базовой области.
Коэффициент полезного действия коллектора FC представляет собой отношение тока коллектора IC к электронному току ICN, который достигает области коллектора, FC =IC/ICN.
Коэффициент лавинного умножения M используется для описания эффекта лавинного умножения, когда обратное напряжение коллекторного перехода увеличивается до уровня, близкого к напряжению лавинного пробоя. Обычно оно оценивается по следующей формуле, M = 1 / [1 - (V / VB) ^n], n определяется материалом PN-перехода (кремний: n=1,5-4; германий: n=2,5- 8); VB - напряжение обратного пробоя коллектор J1; V - это напряжение на коллекторном соединении. Когда абсолютное значение V стремится к абсолютному значению VB, M стремится к бесконечности, и в PN-переходе произойдет лавинный пробой.
Как правило, hFB(α) используется для выражения общего базового усиления по постоянному току, hFB(α) = IC / IE, и его диапазон обычно составляет 0,95-0,99; hfb(α) используется для выражения общего базового усиления по переменному току, hfb(α) = ΔIC / ΔIE. В общем случае hfb(α) ≈ hFB(α).
2- Коэффициент усиления по Току Общего Эмиттера β
Коэффициент усиления по току общего эмиттера β (полное название - "коэффициент усиления по прямому току гибридного параметра, общий эмиттер" HFE) представляет собой отношение тока коллектора к току базы, и его значение обычно намного больше 1. Как правило, hFE(β) используется для выражения общего коэффициента усиления постоянного тока эмиттера, hFE(β) = IC / IB, который может быть измерен непосредственно мультиметром; hfe(β) используется для выражения общего коэффициента усиления переменного тока эмиттера, hfe(β) = ΔIC / ΔIB. Коэффициент усиления по току (или коэффициент усиления по прямому току) транзистора обычно относится к общему коэффициенту усиления по току β эмиттера.
3- Коэффициент усиления по току Общего коллектора γ
Коэффициент усиления по току общего коллектора γ (полное название - "коэффициент усиления по прямому току гибридного параметра, общий коллектор" HFC) представляет собой отношение тока эмиттера к току базы. Как правило, hFE(γ) используется для выражения коэффициента усиления постоянного тока общего коллектора, hFC(γ) = IE / IB; hfc(γ) используется для выражения коэффициента усиления переменного тока общего коллектора, hfc(γ) = ΔIE / ΔIB. Этот параметр редко используется в обычное время.
4- Пороговое напряжение UTO
Пороговое напряжение TO - это напряжение, которое запускает проводимость эмиттерного перехода транзистора.
5- Характеристическая частота fT
Характеристическая частота fT также называется произведением коэффициента усиления на полосу пропускания, которое может быть определено как рабочая частота транзистора при β=1. Если рабочая частота f0 и коэффициент усиления β высокочастотного тока известны, можно получить характеристическую частоту fT, fT=β* f0. По мере увеличения рабочей частоты увеличение будет уменьшаться. Если рабочая частота транзистора равна характеристической частоте (f0 = fT), транзистор полностью теряет функцию усиления тока; если рабочая частота транзистора превышает характеристическую частоту (f0> fT), транзистор не будет работать нормально.
6- Максимальное Рабочее напряжение UCEM
максимальное рабочее напряжение UCEM - это номинальное напряжение транзистора. При превышении максимального рабочего напряжения UCEM транзистор выйдет из строя.
7- Максимальный Допустимый Ток Коллектора ICM
Максимально допустимый ток коллектора ICM - это номинальный ток транзистора. Обычно указывается, что ток коллектора IC, соответствующий моменту, когда коэффициент усиления по току β падает наполовину от максимального значения, равен ICM. Для обеспечения безопасности использования, как правило, необходимо оставлять двойной запас.
8- Максимальная Рассеиваемая мощность коллектора PCM
Максимальная рассеиваемая коллектором мощность PCM - это мощность, при которой транзистор достигает самой высокой температуры перехода при самой высокой рабочей температуре (обычно 25°C). Когда транзистор достигнет максимальной температуры перехода, его внутренняя структура PN-перехода будет безвозвратно разрушена.
3.4 Основные характеристики транзисторов
Взаимосвязь между параметрами транзистора при стабильной работе (эти параметры обычно имеют фиксированные значения или изменяются медленно) называется статическими характеристиками. Взаимосвязь между параметрами транзистора во время процесса включения и процесса выключения (эти параметры обычно резко меняются) называется динамическими характеристиками. Если во входном сигнале транзистора присутствует только сигнал постоянного тока, это называется работой по постоянному току (или статической работой). Если во входном сигнале транзистора присутствует сигнал переменного тока, это называется работой переменного тока (или динамической работой).
Для NPN-транзистора (соединение с общим эмиттером) его входом является база, а выходом - коллектор, поэтому его входной ток равен IB, входное напряжение равно UBE, а выходной ток равен IC (выход из сопротивления RC в выходной цепи), выходное напряжение равно UCE.
3.4.1 Статические характеристики транзисторов
Статические характеристики транзистора делятся на входные характеристики (соотношение между входным током и входным напряжением), выходные характеристики (соотношение между выходным током и выходным напряжением), температуру (влияние температуры на входные характеристики и выходные характеристики) и безопасную рабочую зону (стабильные условия работы транзистора).
1- Входные характеристики

The input characteristic of the transistor is similar to the forward input characteristic of the power diode, as shown in Figure 13.
Входная характеристика транзистора аналогична прямой входной характеристике силового диода, как показано на рисунке 13.
Когда UCE имеет фиксированное значение и UBE>UTO, базовый ток IB увеличивается с увеличением UBE.
Когда UCE увеличивается, UTO увеличивается, и кривая входных характеристик смещается вправо. Это связано с тем, что с увеличением UCE часть носителей, которые должны быть введены в базовую область из области эмиттера, проходят через базовую область и непосредственно вводятся в коллекторную область, поэтому концентрация носителей в базовой области слишком мала, чтобы открыть эмиттерный переход (то есть диффузионный ток эмиттерного перехода меньше или равен дрейфовому току). Следовательно, необходимо увеличить UBE, чтобы заставить больше носителей вводиться в базовую область из области эмиттера (то есть пороговое напряжение увеличивается), и кривая входной характеристики также перемещается вправо. Когда UCE увеличивается до определенной степени, большинство носителей, которые могут быть введены в базовую область из области эмиттера, собираются в коллекторную область, поэтому, даже если UCE продолжает увеличиваться, входные характеристики транзистора вряд ли могут быть изменены.
2- Выходные характеристики
Прежде чем представить выходные характеристики транзистора, необходимо ввести понятие линии нагрузки постоянного тока. Линия нагрузки постоянного тока представляет собой вольт-амперную характеристическую кривую нагрузки коллектора RC (сопротивление выходного терминала), когда транзистор работает в статическом состоянии, IC = (EC - UCE) / RC. Когда транзистор переходит в выключенное состояние, это эквивалентно переходу коллекторной цепи в выключенное состояние. В это время UCE=0, напряжение на RC равно напряжению источника питания EC. Когда транзистор переходит во включенное состояние, ICM - это возможное максимальное значение выходного тока IC, то есть максимальный ток, протекающий через RC. Отметьте эти две точки в прямоугольной системе координат с IC в качестве оси Y и UCE в качестве оси X и нарисуйте отрезок линии, то есть линию нагрузки постоянного тока. Пересечение линии нагрузки постоянного тока с осью Y называется точкой насыщения, а пересечение с осью X называется точкой отсечения. Наклон линии нагрузки постоянного тока - это значение сопротивления RC.
Пересечение линии нагрузки постоянного тока и кривой выходных характеристик транзистора называется рабочей точкой покоя, или точкой добротности. Когда транзистор работает в статической рабочей точке, независимо от того, как изменяется сигнал переменного тока во входном сигнале, можно гарантировать, что транзистор будет работать в стабильном состоянии усиления (то есть переход эмиттера смещен в прямом направлении, а переход коллектора смещен в обратном направлении), и никаких нелинейных искажений не произойдет. При выборе точки добротности старайтесь держаться подальше от области насыщения (чтобы избежать искажения насыщения) и области отсечки (чтобы избежать искажения отсечки) транзистора, чтобы получить наилучший эффект усиления.

Поскольку транзистор в основном выводит ток через обратный ток коллекторного перехода J1, его выходная характеристическая кривая очень похожа на статическую характеристическую кривую при обратном смещении силового диода, как показано на рисунке 14. По сравнению с силовыми диодами транзисторы имеют три рабочих состояния. Чтобы интуитивно понять взаимосвязь между выходным током IC и входным током IB, ось X можно расширить влево, а левую часть оси X можно рассматривать как положительную полуось X IB. Точки Q проецируются на второй квадрант, который делит характеристическую кривую IC и IB на четыре участка: 0, A, B и C. Эти участки соответствуют рабочей области транзистора.
Область отключения (секция 0): Когда UBE≤UTO или IB=0, эмиттерный переход находится в выключенном состоянии. В это время, даже если коллекторный переход имеет обратное смещение (UBC<0), .="" ic="0)," ube="">0), транзистор не будет включен. Следовательно, условие отключения транзистора равно IC * IB = 0.
Активная область (раздел A): Когда эмиттерный переход смещен в прямом направлении и превышает пороговое напряжение (UBE>UTO>0), IB>0, если коллекторный переход смещен в обратном направлении (UBC≤0), транзистор работает в активной области (область усиления). В это время значение IC не имеет ничего общего с UCE, а зависит только от IB, и существует линейная зависимость между IB и IC, IC = β * IB.
Область насыщения (секция B и секция C): По мере увеличения тока базы количество дырок в базовой области уменьшается, и количество носителей, вводимых в базовую область из области эмиттера, также уменьшается, а обедненный слой базовой области расширяется. Когда достигается граница насыщения, способность транзистора к усилению начинает ослабевать (β' = ΔIC / ΔIB < β), IB и IC больше не имеют линейной зависимости, и транзистор начинает входить в состояние квазинасыщения (состояние мелкого насыщения, раздел B). Когда количество отверстий в базовой области падает до критического значения, потенциал базовой области совпадает с потенциалом коллекторной области, то есть коллекторный переход J1 находится в нулевом смещении (UBC=0), и базовый ток полностью теряет эффект усиления (β' = ΔIC / ΔIB =0), и транзистор переходит в состояние полного насыщения (состояние глубокого насыщения, раздел C).
Когда транзистор слабо насыщен, базовый ток IB мал, а падение напряжения проводимости велико, то есть эквивалентное сопротивление транзистора велико, поэтому легко выйти из состояния насыщения. Когда транзистор глубоко насыщен, базовый ток IB велик, а падение напряжения проводимости невелико, то есть эквивалентное сопротивление транзистора невелико, и по мере увеличения IB насыщение транзистора будет продолжать углубляться, поэтому трудно выйти из состояния насыщения. В реальной работе, когда IB(sat) = EC / (β * ICM), можно считать, что транзистор вошел в состояние глубокого насыщения, которое является состоянием насыщения в обычном значении. Иногда для того, чтобы разогнать транзистор до состояния глубокого насыщения, применяется базовый ток, который в несколько раз превышает IB (sat). Следует отметить, что на рабочее состояние транзистора также влияет выходное сопротивление RC - чем меньше выходное сопротивление RC, тем больше ток насыщения IC, и тем больше падение напряжения насыщения UCE, и тем больше ток запуска насыщения IB. По мере уменьшения выходного сопротивления RC ток насыщения IC будет приближаться к ICM, что приведет к легкому сгоранию транзистора. Если выходное сопротивление RC близко к 0, даже если транзистор перегорел, он не может перейти в состояние насыщения. Следовательно, большее выходное сопротивление может повысить вероятность перехода транзистора в состояние насыщения.
3- Температура

Повышение температуры вызовет собственное тепловое возбуждение полупроводника, что увеличит концентрацию носителей внутри полупроводника и увеличит его проводимость. Увеличение проводимости приведет к увеличению тока утечки, снижению порогового напряжения, увеличению коэффициента усиления по току и т.д. Следовательно, входная характеристическая кривая транзистора будет перемещаться вправо при повышении температуры, а выходная характеристическая кривая транзистора будет перемещаться вверх при повышении температуры. Повышение температуры также увеличит вероятность теплового пробоя транзистора, поэтому при фактическом использовании транзистор должен иметь достаточные условия рассеивания тепла.
4- Безопасная Рабочая Зона

Если известна модель транзистора, то также известны и его параметры PCM. Через PCM=IC * UCE можно нарисовать кривую PCM. Кривые ICM, UCEM, PCM могут определять безопасную рабочую зону (SOA) транзистора, в этой области транзистор может стабильно работать без повреждений. Зона за пределами безопасной рабочей зоны является опасной зоной. В опасной зоне температура транзистора значительно возрастет, что сделает его более восприимчивым к тепловому пробою. Поэтому следует избегать использования транзистора во взрывоопасных зонах.
3.4.2 Динамические характеристики транзисторов

1- Процесс включения
При выполнении условия включения (UBE> AUTO) транзистор будет включен. Процесс включения транзистора делится на время задержки td, время нарастания tr и время диффузии ts.
Время задержки td - это время, затраченное от 10% IB1 до 10% IC1. Этот период времени - это время, необходимое для зарядки барьерного конденсатора.
Время нарастания tr - это время, необходимое для перехода IC с 10% IC1 до 90% IC1. В течение этого периода времени IC резко вырос.
Время диффузии ts - это время, необходимое для перехода IC от 90% IC1 к 100% IC1. Этот период времени - это время, необходимое для зарядки диффузионного конденсатора.
Формула расчета времени включения: ton=td + tr + ts
2- Процесс отключения
При выполнении условия отключения (IB=0) транзистор будет выключен. Процесс выключения транзистора делится на время хранения ts, время спада tf и время задержки tt.
Время хранения ts - это время, затраченное от 90% IB1 до 90% IC1. Этот период времени представляет собой время, необходимое для удаления носителей, хранящихся в базовой области во время насыщенной проводимости.
Время падения tf - это время, необходимое для падения IC с 90% IC1 до 10% IC1. В течение этого периода времени IC резко снизился.
Время задержки tt - это время, необходимое для снижения IC с 10% IC1 до ICEO. Этот период времени представляет собой время, необходимое для рекомбинации оставшихся носителей.
Формула расчета времени отключения: toff = ts + tf + tt
§4. Что такое полууправляемое устройство?
4.1 Введение в полууправляемые устройства

Полууправляемое устройство (также известное как тиристор или управляемый кремнием выпрямитель SCR) представляет собой биполярное устройство, которое может быть включено, но не выключено с помощью управляющего сигнала (триггера затвора). Тиристор появился на свет в 1956 году и получил очень широкий спектр применения в 1960-х и 1970-х годах. Однако с появлением полностью управляемых устройств в 1980-х годах статус тиристоров был постепенно заменен. Однако, поскольку тиристор может выдерживать очень большие напряжения и токи, а также имеет простую конструкцию и надежную работу, он по-прежнему сохраняет важное положение в приложениях большой емкости. Тиристор имеет три вывода. По своей форме тиристор можно разделить на болтовой тип (обычно болт представляет собой анод, который может быть плотно соединен с радиатором и прост в установке) и плоский тип (плоский тиристор может быть зажат двумя радиаторами). В дополнение к срабатыванию затвора тиристор также будет включен по следующим причинам: Анодное напряжение повышается до очень высокого значения и вызывает лавинный эффект, то есть PN-переход с обратным смещением в середине разрушается; скорость нарастания анодного напряжения dv/dt слишком высока, то есть влияние емкости перехода на PN-переход; температура перехода высокая; срабатывание света. В целом, только срабатывание затвора является наиболее точным, быстрым и надежным методом управления. Однако, в связи с развитием полупроводниковых технологий, модульные тиристоры в настоящее время распространены (нажмите, чтобы просмотреть больше тиристорных модулей).
4.2 Как работает тиристор?
4.2.1 Базовая структура тиристоров
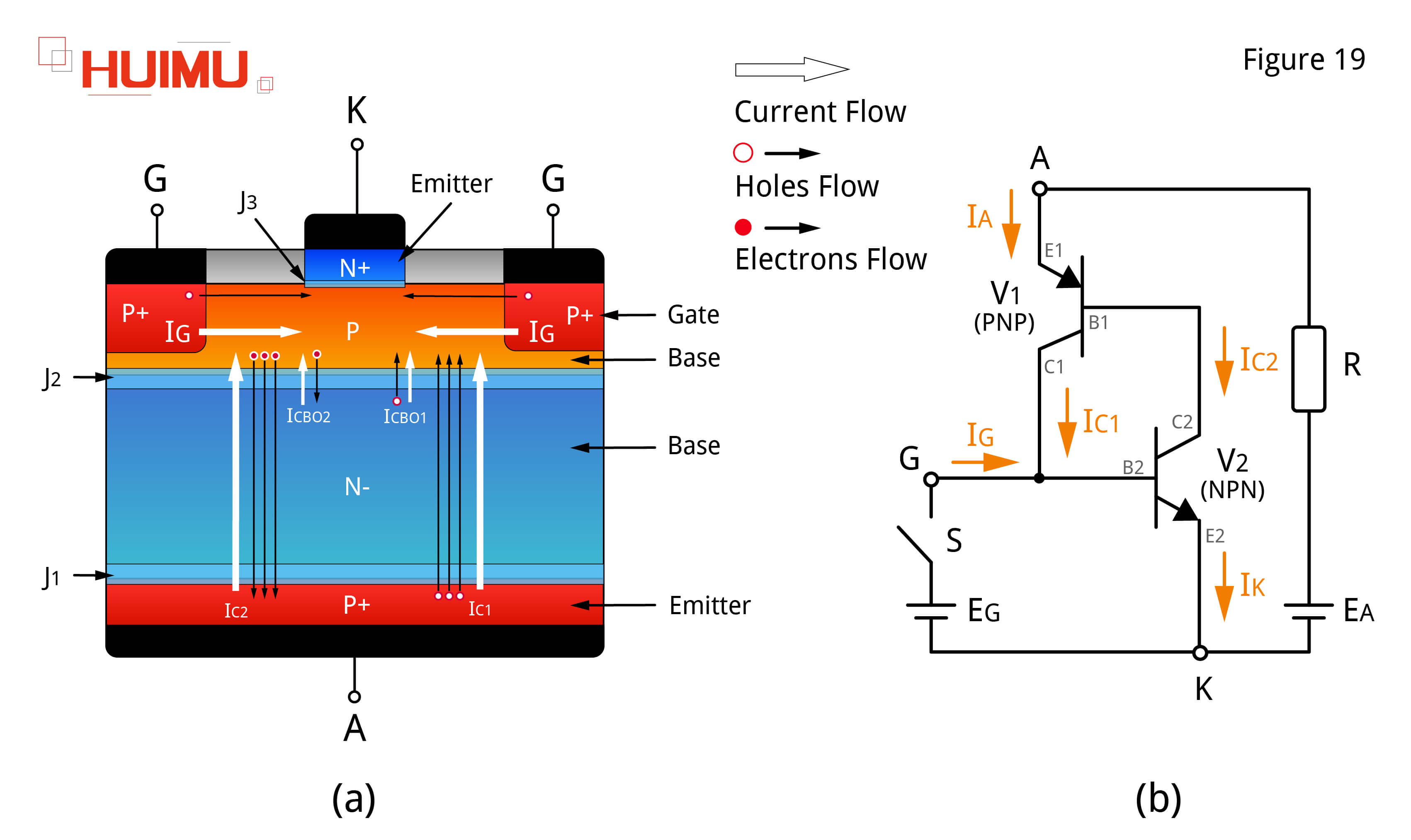
Тиристор имеет четырехслойную структуру P-N-P-N, которая имеет на один PN-переход больше, чем транзистор. Тиристор имеет три вывода - анод A, катод K и затвор G. Степень легирования полупроводника P-типа и полупроводника N-типа тиристора различна. Внутренняя структура тиристора может быть эквивалентна двум транзисторам V1 и V2, как показано на рисунке 19, a. V1 представляет собой PNP-транзистор (P+|N-|P). Область P+ - это область эмиттера, N- область - базовая область, а область P - область коллектора. V2 представляет собой NPN-транзистор (N+|P|N-). Область N+ - это область эмиттера, область P - это базовая область, а область N - это область коллектора. Как и в случае с транзистором, при использовании тиристора будьте осторожны, чтобы не соединить катод и анод в обратном направлении, чтобы предотвратить сгорание тиристора.
4.2.2 Принцип работы тиристоров
Эквивалентная рабочая схема тиристора показана на рис. 19, б. V1 и V2 являются эквивалентными транзисторами. Анод и катод тиристора подключены к выходной цепи, а затвор тиристора подключен к входной цепи. EA - это источник питания в выходной цепи, а EG - источник питания во входной цепи. R - выходное сопротивление. IC1 - это ток коллектора V1, а IC2 - ток коллектора V2. Ток, протекающий через анод, представляет собой анодный ток IA, ток, протекающий через катод, представляет собой катодный ток IK, а ток, протекающий через затвор, представляет собой ток затвора IG. α1 - это общий коэффициент усиления по базовому току V1, а α2 - общий коэффициент усиления по базовому току V2. Идея включения тиристора аналогична идее включения транзистора, то есть как заставить PN-переход J2 генерировать больший обратный ток.
Состояние отключения: Когда на катод и анод тиристора подается напряжение прямого смещения UAK, а на затвор не подается напряжение, это эквивалентно тому, что коллектор и база V1 и V2 открыты, а тиристор находится в выключенном состоянии. Из-за влияния напряжения прямого смещения слой обеднения J1 и J3 становится уже, а слой обеднения J2 становится шире, поэтому в J2 имеется ток обратного насыщения ICBO - Этот ток состоит из двух частей, одна из которых - ток дырки ICBO1 (общий базовый ток V1), а другой - ток свободных электронов ICBO2 (общий базовый ток V2). Эти два тока будут протекать через J1 и J3, образуя ток утечки тиристора, который немного больше суммы токов утечки двух эквивалентных транзисторов. Следует отметить, что в состоянии положительной блокировки α1 + α2 очень малы.
Состояние проводимости: Когда к затвору тиристора прикладывается прямое смещение, область P + вводит большое количество отверстий в область основания P - одна ее часть входит в область N +, создавая прямую проводимость J3, и большое количество свободных электронов вводится в основание P область из области N +, и концентрация неосновных носителей в области P-основания увеличивается, что приводит к увеличению ICBO2; другая его часть поступает в N-область, что приводит к увеличению концентрации неосновных носителей в N-области, поэтому ICBO1 увеличивается. Оба этих тока утечки уменьшат неосновные носители в N-области и сузят обедненный слой J1. Когда задается достаточно большое смещение затвора вперед, чтобы сделать обедненный слой J1 суженным до определенной степени, динамический баланс J1 нарушается, и большое количество отверстий вводится в N-область из области P+, которая перетекает в область P в виде обратный ток и формирует ток IC1, а затем вытекает из тиристора из области N+ в виде прямого тока; аналогично, свободные электроны в области N+ перетекают из области P в область P+ и образуют ток IC2. Следует отметить, что когда IC1 и IC2 не установлены, базовая проводимость очень мала, поэтому α1 + α2 очень малы. Однако, когда IC1 и IC2 установлены, из-за эффекта модуляции проводимости проводимость базовой области V1 и V2 увеличивается, что приводит к увеличению IC1 и IC2. Положительная обратная связь между этими двумя токами заставляет α1 + α2 быстро увеличиваться и приближаться к 1, в результате чего падение напряжения во включенном состоянии резко падает, а анодный ток IA резко возрастает, и, наконец, включается тиристор.
* Формула расчета тиристора
IC1 = α1 * IA + ICBO1, (10)
IC2 = α2 * IK + ICBO2, (11)
IK = IA + IG, (12)
IA = IC1 + IC2, (13)
IA = (α2 * IG + ICBO1 + ICBO2) /[1 - (α1 + α2) ]. (14)
Это видно из формулы 14:
Когда α1+α2 подходы 0, IA будет иметь тенденцию к утечке тока;
Когда α1+α2 подходы 1, IA будет стремиться к бесконечности.
4.3 Основные параметры тиристоров
4.3.1 Статические параметры (Напряжение)
1- Прямое неповторяющееся Пиковое напряжение UDSM / Обратное Неповторяющееся Пиковое напряжение URSM
Когда затвор открыт, прямое неповторяющееся пиковое напряжение UDSM (также известное как максимальное переходное напряжение в нерабочем состоянии) представляет собой пиковое напряжение в нерабочем состоянии, определяемое точкой резкого изгиба прямой вольт-амперной характеристической кривой; обратное неповторяющееся пиковое напряжение URSM (также известное как максимальное обратное переходное напряжение) - это пиковое напряжение в выключенном состоянии, определяемое точкой резкого изгиба обратной вольт-амперной характеристической кривой.
2- Напряжение прямого поворота UBO
Напряжение прямого поворота UBO относится к пиковому напряжению, которое заставляет тиристор переходить из выключенного состояния во включенное, когда между анодом и катодом тиристора подается прямое синусоидальное полуволновое напряжение, а затвор открыт при номинальной температуре перехода (100 ℃).
3- Обратное Пробивное напряжение UBR
Обратное напряжение пробоя UBR относится к пиковому напряжению, которое вызывает резкое увеличение обратного тока утечки тиристора, когда между анодом и катодом тиристора подается обратное синусоидальное полуволновое напряжение при номинальной температуре перехода (100 ℃).
4- Прямое Выключенное Повторяющееся Пиковое напряжение UDRM / Обратное Выключенное Повторяющееся Пиковое напряжение URRM
Прямое повторяющееся пиковое напряжение в выключенном состоянии UDRM (также известное как повторяющееся пиковое напряжение в выключенном состоянии) - это прямое пиковое напряжение, которое разрешается повторно подавать на устройство, когда затвор открыт и температура перехода номинальная. Частота повторения составляет 50 раз в секунду, а продолжительность каждого раза составляет не более 10 мс. Как правило, UDRM определяется как 90% от UDSM. И UDRM должен быть на 100 В меньше, чем UBO.
Обратное повторяющееся пиковое напряжение в выключенном состоянии URRM (также известное как обратное повторяющееся пиковое напряжение) - это обратное пиковое напряжение, которое разрешается повторно подавать на устройство, когда затвор открыт и температура перехода номинальная. Частота повторения составляет 50 раз в секунду, а продолжительность каждого раза составляет не более 10 мс. Как правило, URRM определяется как 90% от URSM. Напряжение URRM должно быть ниже, чем UBR.
UDRM и URRM будут уменьшаться с повышением температуры. Во время тестирования и использования температура должна строго регулироваться. Обычно меньшее значение UDRM и URRM принимается за номинальное напряжение тиристора.
5-Вентильное Пусковое напряжение UGT
Напряжение запуска затвора UGT относится к минимальному постоянному напряжению затвора, необходимому для перехода тиристора из выключенного состояния во включенное состояние, когда между анодом и катодом тиристора прикладывается определенное значение прямого напряжения при заданной температуре окружающей среды. UGT обычно составляет около 1,5 В.
6- Прямое Среднее Падение напряжения UF
Прямое среднее падение напряжения UF (также известное как среднее напряжение во включенном состоянии или падение напряжения во включенном состоянии) относится к среднему значению падения напряжения между анодом и катодом тиристора, когда ток во включенном состоянии тиристора равен номинальному току при указанной температуре окружающей среды и стандартном условия рассеивания тепла. МКФ обычно составляет 0,4-1,2 В.
7- Пиковое напряжение UT в включенном состоянии
Пиковое напряжение UT во включенном состоянии относится к переходному пиковому напряжению, когда ток тиристора во включенном состоянии является заданным кратным номинальному току.
4.3.2 Статические параметры (Текущие)
1- Номинальный ток включения IT
Номинальный ток в включенном состоянии относится к максимальному значению тока синусоидальной полуволны частоты мощности, допускаемому для прохождения через тиристор при условии заданной температуры окружающей среды (40 °C) и заданных условиях охлаждения, когда угол проводимости составляет не менее 170°, нагрузка является резистивной, и стабильная температура соединения не превышает номинальную температуру соединения. Однонаправленный тиристор использует номинальный средний ток в состоянии IT (AV) в качестве номинального тока; двунаправленный тиристор использует номинальный эффективный ток в состоянии IT (RMS) в качестве номинального тока. Если форма сигнала тока не является синусоидальной полуволной частоты мощности, хотя тиристор представляет собой полупроводник без той же вольт-амперной характеристической кривой, что и сопротивление, резистор с тем же эффективным значением (тот же эффект нагрева) может использоваться в качестве эталона для определения номинального тока тиристора (1,5в 2 раза больше эквивалентного результата расчета сопротивления).
2- Ток утечки в выключенном состоянии IDRM / Обратный Ток утечки IRRM
IDRM и IRRM - соответствующие токи утечки UDRM и URRM соответственно, обычно менее 100 мкА.
3-Вентильный Пусковой ток IGT
Ток срабатывания затвора IGT относится к минимальному постоянному току затвора, необходимому для перехода тиристора из выключенного состояния во включенное состояние, когда между анодом и катодом тиристора прикладывается определенное значение прямого напряжения при заданной температуре окружающей среды. Напряжение обычного тиристора обычно составляет несколько миллиампер; IGT высокочувствительных тиристоров обычно составляет несколько микроампер.
4- Удерживающий ток IH
Ток удержания IH - это минимальный ток, необходимый для поддержания проводимости тиристора. IH обычно составляет от десятков до сотен миллиампер. Когда затвор срабатывает, даже если сигнал затвора удален, тиристор все еще включен, и тиристор можно отключить только путем уменьшения анодного тока. Когда анодный ток будет меньше IH, тиристор будет выключен. Чем выше температура перехода, тем меньше IH, тем меньше вероятность отключения тиристора.
5- Ток фиксации IL
Ток блокировки IL относится к минимальному току, необходимому для поддержания тиристора включенным после того, как тиристор только что переключился из выключенного состояния во включенное и сигнал затвора удален. Для одного и того же тиристора IL обычно примерно в 2-4 раза превышает IH.
6- Пусковой ток ITSM
Пусковой ток ITSM относится к неповторяющемуся максимальному прямому току перегрузки, когда температура перехода тиристора, вызванная аномальной схемой, превышает номинальную температуру перехода в течение полупериода синусоидальной волны частоты мощности. Обычно при прямой волне тиристор может выдерживать ток перегрузки, в 6 раз превышающий номинальный ток. В течение срока службы тиристора, если превышен предел количества скачков напряжения, тиристор может быть необратимо поврежден.
7- Ток прямого поворота IBO
Ток прямого включения IBO относится к пиковому току, который может перевести тиристор из выключенного состояния во включенное, когда затвор открыт при номинальной температуре перехода (100 ℃).
4.3.3 Динамические Параметры
1- Время включения tgt
Время включения tgt относится к времени задержки переключения тиристора из выключенного состояния во включенное, когда подается достаточное количество сигналов запуска. Во время процесса включения выходное напряжение UAK тиристора будет постепенно уменьшаться до падения напряжения во включенном состоянии UF, а анодный ток IA будет постепенно увеличиваться до номинального тока во включенном состоянии IT.
2- Время выключения tq
Время выключения tq относится к интервалу времени с момента, когда ток тиристора во включенном состоянии падает до нуля, до тех пор, пока тиристор не начнет выдерживать указанное напряжение в выключенном состоянии. tq обычного тиристора составляет около нескольких сотен миллисекунд. Tq связан не только с внутренней структурой трубки, но также связан с температурой, dv /dt, di / dt и т.д. tq обычно можно уменьшить, увеличив обратное напряжение. Если анодное напряжение повторно подается во время tq, тиристор можно включить снова, но как только tq пройдет, тиристор будет выключен независимо от того, как увеличить анодное напряжение (при условии, что тиристор не сломан).
tgt и tq определяют рабочую частоту тиристора. Для цепей с высокой рабочей частотой следует выбирать тиристор с малым tq (если tq мал, tgt будет меньше). Этот параметр является основным отличием обычных тиристоров от быстрых тиристоров.
3- Критическая Скорость нарастания напряжения в выключенном состоянии dv/dt
Критическая скорость нарастания напряжения в выключенном состоянии dv/dt относится к максимальной скорости нарастания приложенного напряжения тиристора из выключенного состояния во включенное, когда затвор открыт при номинальной температуре перехода. Когда ток зарядки соединительного конденсатора велик, если скорость нарастания напряжения слишком велика, зарядный ток станет достаточно большим, чтобы вызвать случайное включение тиристора. dv/dt тиристора малого тока (50-100 А) обычно составляет 225 В/мкс, а dv/dt тиристора большого тока (выше 200 А) обычно превышает 50 В/мкс.
4- Критическая Скорость Нарастания тока в рабочем состоянии di/dt
Критическая скорость нарастания тока во включенном состоянии di/dt относится к максимальной скорости нарастания тока во включенном состоянии, которую тиристор может выдержать без повреждения, когда затвор закрыт при номинальной температуре перехода. Тиристор будет производить большие потери мощности в момент включения, и из-за ограниченной скорости расширения проводимости эти потери всегда сосредоточены в области катода вблизи затвора. Если ток возрастает слишком быстро, даже если токопроводящий ток невелик, это легко приведет к локальному перегреву тиристора, что приведет к необратимому повреждению затвора и перегоранию тиристора. Чем больше номинальный ток тиристора, тем более заметна эта проблема.
4.4 Основные характеристики тиристоров
4.4.1 Статические характеристики тиристоров

Статическими характеристиками тиристора являются вольт-амперные характеристики выходного тока и выходного напряжения, как показано на рисунке 20. UK - это напряжение, приложенное к аноду и катоду тиристора, IA - анодный ток, а IG - ток запуска.
1- Прямые статические характеристики
Состояние прямой блокировки: Когда IG = 0, даже если UAK> 0, существует лишь небольшой ток прямой утечки. α1 + α2 также очень малы. В это время тиристор находится в состоянии прямой блокировки. Но когда UAK ≥ UBO или IA ≥ IBO, α1 + α2 приближается к 1, и тиристор перейдет в состояние прямой проводимости.
Состояние прямой проводимости: Обычная ситуация прямой проводимости заключается в том, что при условии IG> 0, когда UAK ≥ UGT, проводимость базовой области тиристора значительно увеличивается, α1 + α2 приближается к 1, ток IA, протекающий через тиристор, будет приближаться к бесконечности (фактическое значение IA определяется внешняя цепь), и, наконец, достигается насыщенная проводимость. При одних и тех же внешних условиях, чем больше буровая установка, тем меньше UGT. Следует отметить, что как только тиристор включен, затвор теряет свою функцию управления. Только когда выходной ток IA тиристора уменьшается до определенного значения, близкого к 0, тиристор может быть выключен.
2- Обратные Статические Характеристики
Обратные статические характеристики тиристоров аналогичны обратным статическим характеристикам силовых диодов. Когда на тиристор подается обратное напряжение, независимо от того, имеет ли затвор пусковой ток или нет, тиристор не включается, и существует только очень небольшой обратный ток утечки. В это время тиристор находится в состоянии обратной блокировки. Однако, когда обратное напряжение достигает напряжения обратного пробоя UBR, это вызовет лавинный пробой тиристора.
4.4.2 Динамические характеристики тиристоров

1- Процесс включения
Когда UAK1 подается на выходной вывод тиристора, тиристор в это время находится в выключенном состоянии, и UAK составляет 100% UAK1. Когда UG ≥ UGT, пройдет некоторое время, прежде чем тиристор перейдет в проводящее состояние. Когда тиристор включен, напряжение на его выходных клеммах UAK будет поддерживать очень малое значение, то есть падение напряжения во включенном состоянии.
Процесс включения тиристора делится на время задержки td, время нарастания tr и время диффузии ts.
Время задержки td - это время, необходимое для увеличения IA с прямого тока утечки до 10% IA1, а UAK - для уменьшения со 100% UAK1 до 90% UAK1. Время задержки обычно составляет 0,5-1,5 мкс. Время задержки уменьшается по мере увеличения тока затвора.
Время нарастания tr - это время, необходимое для повышения IA с 10% IA1 до 90% IA1, а UAK - для снижения с 90% UAK1 до 10% UAK1. На время нарастания влияют характеристики самого тиристора, импеданс внешней цепи, температура, анодное напряжение и т.д. Время нарастания обычно составляет 0,5-3 мкс. За счет увеличения IA время задержки td и время нарастания tr могут быть значительно сокращены.
Время диффузии ts - это время, необходимое для увеличения IA с 90% IA1 до 100% IA1, а UAK - для снижения с 10% UAK1 до падения напряжения во включенном состоянии. Время диффузии зависит от площади поперечного сечения катода.
Обычно, когда IA достигает 90% IA1, можно считать, что тиристор включен. Следовательно, формула для расчета времени включения такова: tgt = td + tr.
2- Процесс отключения
Путем уменьшения UAK до 0 или приложения достаточно большого обратного напряжения UAK2, IA постепенно уменьшается, и тиристор переводится из включенного состояния в выключенное состояние. Процесс выключения тиристора делится на время восстановления обратной блокировки trr и время восстановления прямой блокировки tgr.
Во время процесса отключения из-за индуктивности внешней цепи в тиристоре появляется обратный ток восстановления IR. Когда IR постепенно достигнет пикового значения IRP, будет сгенерирован соответствующий URP, а затем IR будет быстро затухать. Время от падения IA до нуля до падения IR до обратного тока утечки тиристора называется временем восстановления обратной блокировки trr.
Время от окончания процесса обратного восстановления до полного восстановления способности тиристора к прямой блокировке называется временем восстановления прямой блокировки tgr (или временем восстановления затвора). Во время tgr, поскольку на PN-переходе рядом с затвором остается небольшое количество носителей, они все еще могут запускать механизм положительной обратной связи внутри тиристора. Если на тиристор подается прямое напряжение, тиристор снова будет проводить прямое напряжение. Во время этого процесса включения сигнал запуска затвора не требуется.
Формула расчета времени отключения tq такова: tq = trr + tgr.
The calculation formula of the turn-off time tq is: tq = trr + tgr.
4.5 Последовательное и параллельное подключение тиристоров
1- Последовательное соединение тиристоров
Путем последовательного подключения нескольких тиристоров можно увеличить общую емкость по напряжению. На самом деле, невозможно умножить значение выдерживаемого напряжения тиристора на число, чтобы получить общее значение выдерживаемого напряжения. Вместо этого оно должно быть добавлено к напряжению, фактически переносимому каждым тиристором. Это происходит главным образом потому, что напряжение, распределенное на каждом тиристоре, неравномерно (делится на статическое неравномерное напряжение и динамическое неравномерное напряжение).
Статическое неравномерное напряжение: Хотя ток утечки, протекающий через последовательно соединенные тиристоры, одинаков, из-за их дисперсии статических вольт-амперных характеристик напряжения, назначенные каждому тиристору, не одинаковы. В крайних случаях определенный тиристор может выдерживать все напряжения, в то время как другие тиристоры могут выдерживать только очень малые напряжения. Статическое неравномерное напряжение можно уменьшить, выбрав тиристоры с очень похожими параметрами и характеристиками. Метод выравнивания сопротивления также может быть использован для уменьшения статической неравномерности, то есть тиристор рассматривается как резистор с высоким сопротивлением (около 1 мом), и каждый тиристор подключен параллельно с резистором с низким сопротивлением для регулировки эквивалентного сопротивления каждой параллельной цепи. когда их эквивалентные значения сопротивления очень близки, то напряжение, распределенное на каждом тиристоре, также будет очень близким.
Динамическое неравномерное напряжение: Динамическое неравномерное напряжение вызвано разницей в динамических параметрах и динамических характеристиках тиристора. Выбирая тиристоры, динамические параметры и характеристики которых максимально согласованы, можно уменьшить динамическую неравномерность напряжения. Он также может быть вызван сильным импульсом затвора, чтобы значительно уменьшить разницу во времени включения тиристора. Также возможно использовать RC-параллельные ответвления для динамического выравнивания напряжения, то есть для поглощения перенапряжения через RC-цепь, так что напряжение, которое каждый тиристор выдерживает в динамических условиях, очень близко.
2- Параллельное соединение тиристоров
Подключив несколько тиристоров параллельно, можно увеличить общую токовую мощность. Из-за различных параметров и характеристик каждого тиристора также необходимо учитывать их неравномерное распределение тока. Путем выбора тиристоров с согласованными характеристиками и параметрами, насколько это возможно, можно уменьшить динамический неравномерный ток и статический неравномерный ток. Также возможно уменьшить динамический неравномерный ток с помощью реактора с разделением тока (его потери меньше, чем сопротивление). Также возможно использовать запуск сильного импульса затвора, чтобы значительно уменьшить разницу во времени включения тиристоров, так что каждый тиристор может быть эффективно запущен за короткое время для достижения цели динамического распределения тока. Однако, поскольку текущая емкость тиристора становится все больше и больше, обычно нет необходимости управлять тиристором параллельно.
3- Последовательное и параллельное подключение тиристоров
Когда тиристоры необходимо подключать последовательно и параллельно одновременно, обычно рекомендуется подключать последовательно, во-первых, и параллельно, во-вторых, чтобы гарантировать, что параметры и характеристики каждого тиристора максимально согласованы.
4.6 Основные типы тиристоров
1- Тиристор с Быстрой Коммутацией
Быстродействующий тиристор (FST) обладает превосходными динамическими характеристиками. По сравнению с обычными тиристорами, FST обладает преимуществами короткого времени включения (обычно 4-8 мкс), короткого времени выключения (обычно 10-60 мкс) и большого допуска dv /dt и di / dt. Обычные тиристоры могут работать только при напряжении 50 Гц, в то время как FAT может работать в цепях с более высокими частотами (выше 400 Гц). Высокочастотные тиристоры (HFT) имеют более короткое время переключения и более высокую скорость переключения, чем FAT, и подходят для работы в высокочастотных цепях (выше 10 кГц). Из-за высокой рабочей частоты нельзя игнорировать нагревательный эффект потери при переключении FAT и HFT, поэтому их номинальное напряжение и номинальный ток обычно невелики.
2- Двунаправленный Триодный тиристор

Двунаправленный тиристор (также известный как двунаправленный триодный тиристор, триодный переключатель переменного тока, симистор) можно рассматривать как пару антипараллельно соединенных однонаправленных тиристоров (SCR). Двунаправленный тиристор является распространенным основным устройством в твердотельных реле и модулях переменного тока (нажмите, чтобы просмотреть больше твердотельных реле переменного тока). Прямая характеристика двунаправленного тиристора такая же, как и у однонаправленного тиристора, но его обратная характеристика отличается от характеристики однонаправленного тиристора. Двунаправленный тиристор не обладает способностью обратной блокировки. На оси координат хорошо видно, что характеристическая кривая двунаправленного тиристора центрально симметрична. Двунаправленный тиристор имеет полюс T1 (основной электрод, соединенный с полупроводниковым материалом P-типа), полюс T2 (основной электрод, соединенный с полупроводниковым материалом N-типа) и полюс G затвора. Номинальный ток двунаправленного тиристора - это номинальный эффективный ток IT в включенном состоянии (среднеквадратичный). В параметрах двунаправленного тиристора нет прямого пикового напряжения и обратного пикового напряжения, а только максимальное пиковое напряжение. Другие параметры двунаправленного тиристора такие же, как и у однонаправленного тиристора.
3- Тиристор с Обратным Проводом

Конструктивная идея обратного проводящего тиристора (RCT) аналогична идее двунаправленного тиристора, но в обратном проводящем тиристоре используется силовой диод для антипараллельного соединения, так что эмиттерный переход анода и катода находятся в состоянии короткого замыкания. Благодаря этой специальной конструкции тиристор с обратной проводимостью обладает преимуществами низкого напряжения во включенном состоянии, короткого времени выключения, высокой номинальной температуры перехода, высокого сопротивления напряжению, высокой термостойкости и т.д. Например, время выключения (несколько микросекунд) и частота питания (десятки кГц) тиристора с обратной проводимостью, очевидно, лучше, чем у тиристора с быстрым переключением. Тиристор с обратной проводимостью можно рассматривать как органическую комбинацию тиристора и силового диода свободного хода, которая может упростить конструкцию схемы и широко используется в таких приложениях, как импульсные источники питания и ИБП.
4- Тиристор с Легким Срабатыванием

Тиристор со световым срабатыванием (также известный как LTT, или тиристор со световым управлением) представляет собой тиристор, в область затвора которого встроен фотоэлектрический силовой диод, и который использует силу светового сигнала для замены тока запуска затвора. Таким образом, световой триггер является своего рода триггером затвора. Чтобы улучшить чувствительность запуска тиристора, управляемого светом, область затвора часто использует усиленную структуру затвора или структуру затвора с двойным усилением. Световой триггер обеспечивает электрическую изоляцию между основной цепью и цепью управления и позволяет избежать влияния электромагнитных помех. Маломощные тиристоры, управляемые светом, часто используются в электрической изоляции для подачи сигналов запуска для мощных тиристоров. Мощные управляемые светом тиристоры могут обеспечить хорошую изоляцию между схемой управления и основной цепью и используются в высоковольтном силовом оборудовании (например, для высоковольтной передачи постоянного тока).
§5. Что такое Полностью управляемое устройство?
5.1 Введение в Полностью управляемые устройства
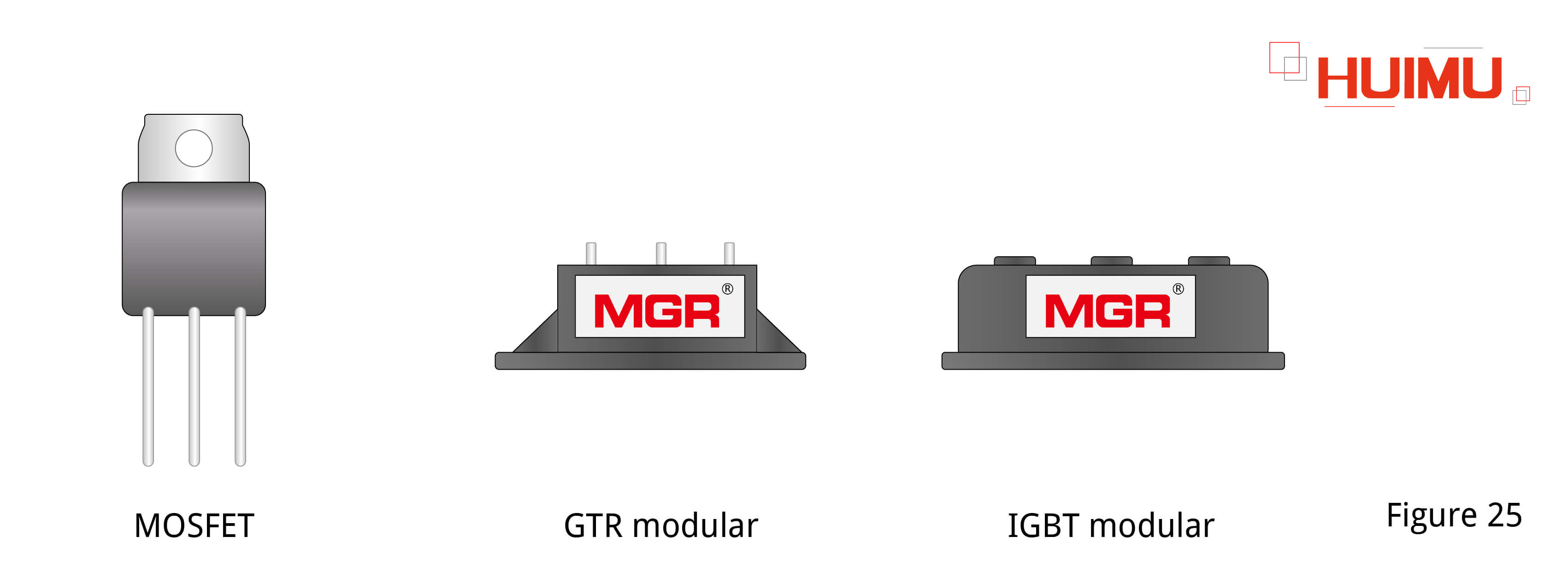
Полностью управляемое устройство (также называемое самоотключающимся устройством) - это устройство, которым можно управлять с помощью управляющего сигнала для включения и выключения. С момента появления полностью управляемых устройств в 1980-х годах технология силовой электроники вступила в новую эру. Существует много типов полностью управляемых устройств, большинство из которых используют композитные конструкции, каждая со своими характеристиками, которые могут удовлетворить потребности различных областей. Полностью управляемые устройства в основном включают вентильные тиристоры (GTO), транзисторы с биполярным переходом (включая GTR и т.д.), полевые транзисторы EFT (включая MOSFET, JFET и т.д.) и составные устройства (включая IGBT, MCT, SIT, SITH, IGCT и т.д.). Следующее содержание даст краткое представление о них.
5.2 Вентильный отключающий тиристор
5.2.1 Введение в GTO

Тиристор с отключением затвора (GTO) является производным устройством тиристора, которое появилось вскоре после появления тиристора. Обычный тиристор (SCR) является полууправляемым устройством, и сигнал затвора больше не имеет никакого эффекта после включения SCR. GTO - это полностью управляемое устройство, которое можно отключить, подав отрицательный импульсный сигнал на затвор.
5.2.2 Как работает GTO?
5.2.2.1 Базовая структура ГТО

Хотя структура GTO аналогична SCR, GTO имеет еще одну буферную область N+, поэтому время включения GTO короче, чем SCR, но в то же время его способность к обратному блокированию слабее, чем SCR. GTO - это многоблочное силовое интегрированное устройство, состоящее из десятков или даже сотен блоков GTO с общим анодом. Катоды и вентили этих блоков GTO соединены параллельно внутри устройства. Катодная область каждого блока GTO в этой интегрированной структуре невелика, а расстояние между затвором и катодом значительно сокращено, что делает базовую область P2 малой по боковому сопротивлению и может потреблять больший ток от затвора, что делает коллектор V1 легко отключаемым, и, наконец, позволяет легко отключить тиристор. Эта интегрированная структура также увеличивает скорость включения GTO быстрее, чем у SCR, и имеет более высокую несущую способность di / dt и несущую способность при перегрузке - SCR имеет только один блок, как только di / dt слишком велик, его легко повредить локальной перегрузкой и перегревом; любая локальная зона GTO состоит из нескольких небольших блоков GTO, и перегрузка и перегрев, вызванные di / dt, будут распределены на эти небольшие блоки GTO. Объем GTO намного меньше, чем у SCR, поэтому его плотность емкости выше, чем у SCR. В то же время GTO не требует схемы коммутации, поэтому его можно использовать в приложениях с частотой выше 1 кГц, в то время как SCR можно использовать только в приложениях с частотой до 1 кГц. Но обратная блокирующая способность GTO слабее, чем SCR, обычно 20-30 В. Благодаря этим преимуществам GTO широко используется в приложениях с высокой мощностью, превышающей мегаваттный уровень.
Как правило, силовой диод будет подключен антипараллельно к GTO для оптимизации его коммутационных характеристик. Для облегчения проектирования и использования силовой диод обычно интегрируется в GTO для формирования GTO с обратной проводимостью, который немного похож на тиристор с обратной проводимостью. GTO с обратной проводимостью больше не способен выдерживать обратное напряжение. Если это нужно
5.2.2.2 Принцип работы GTO

Принцип включения GTO аналогичен принципу включения тиристора. Область N+ способствует снижению проводимости, чтобы ускорить процесс положительной обратной связи. Α1 GTO спроектирован так, чтобы быть небольшим, что делает глубину насыщения GTO меньше, чем SCR, поэтому ее легче отключить - когда SCR включен, α1 + α2 ≥ 1,15; когда GTO включен, α1 + α2 ≈ 1,05, что близко к критическому насыщению. Такая конструкция делает эквивалентный транзистор V2 более чувствительным к сигналу управления затвором, что облегчает включение и выключение V2, но в то же время увеличивает падение напряжения GTO во включенном состоянии. Во время процесса выключения в затвор пропускается достаточно большой отрицательный ток, чтобы потреблять дырки в области основания P и вводить большое количество свободных электронов в область N-основания, при этом дырки области P +, вводимые в область основания, уменьшаются, IC1 постепенно уменьшается, и IC2 также уменьшается. После серии процессов положительной обратной связи, когда анодный ток IA меньше, чем ток удержания IH, GTO отключается из-за выхода из насыщения.
* Формула расчета GTO
The calculation formula of GTO is the same as the calculation formula of thyristor.
IC1 = α1 * IA + ICBO1, (10)
IC2 = α2 * IK + ICBO2, (11)
IK = IA + IG, (12)
IA = IC1 + IC2, (13)
IA = (α2 * IG + ICBO1 + ICBO2) /[1 - (α1 + α2) ]. (14)
|IGRP|>(α1 + α2-1) * IATO/α2, (15)
βoff=IATO/|IGRP|. (16)
Это видно из формулы 14:
Когда α1+α2 подходы 0, IA будет иметь тенденцию к утечке тока;
Когда α1+α2 подходы 1, IA будет стремиться к бесконечности.
5.2.3 Основные параметры ГТО
Большинство параметров GTO совпадают с основными параметрами SCR.
1- Время включения, тонна
Время включения ton представляет собой сумму времени задержки td и времени нарастания tr.
2- Время выключения toff
Время отключения toff представляет собой сумму времени хранения ts и времени отключения tf.
3- Максимальный Управляемый Анодный Ток IATO
Максимальный управляемый анодный ток IATO равен номинальному току GTO. Если анодный ток IA больше, чем IATO, α1 + α2 не могут соответствовать условию, немного превышающему 1, что приведет к углублению насыщения, так что GTO не может быть отключен нормально.
4- Коэффициент усиления при отключении тока βoff
Коэффициент усиления при отключении тока βoff представляет собой отношение максимального управляемого анодного тока IATO к пиковому отрицательному импульсному току затвора IGRP. βoff=IATO/IGRP. Поскольку отсечение GTO слишком мало (обычно 3-8), GTO можно отключить только путем подачи очень большого отрицательного тока на затвор, что эквивалентно использованию сильного тока для управления сильным током. Например, для GTO с номинальным током 1000A требуется ток отключения затвора 300A. Этот основной недостаток ограничивает применение GTO.
5.2.4 Основные характеристики ГТО
5.2.4.1 Статические характеристики ГТО
Статические характеристики GTO такие же, как и статические характеристики SCR, но ток блокировки IL (2A) GTO больше, чем у SCR (100-500 мА).
5.2.4.2 Динамические характеристики ГТО
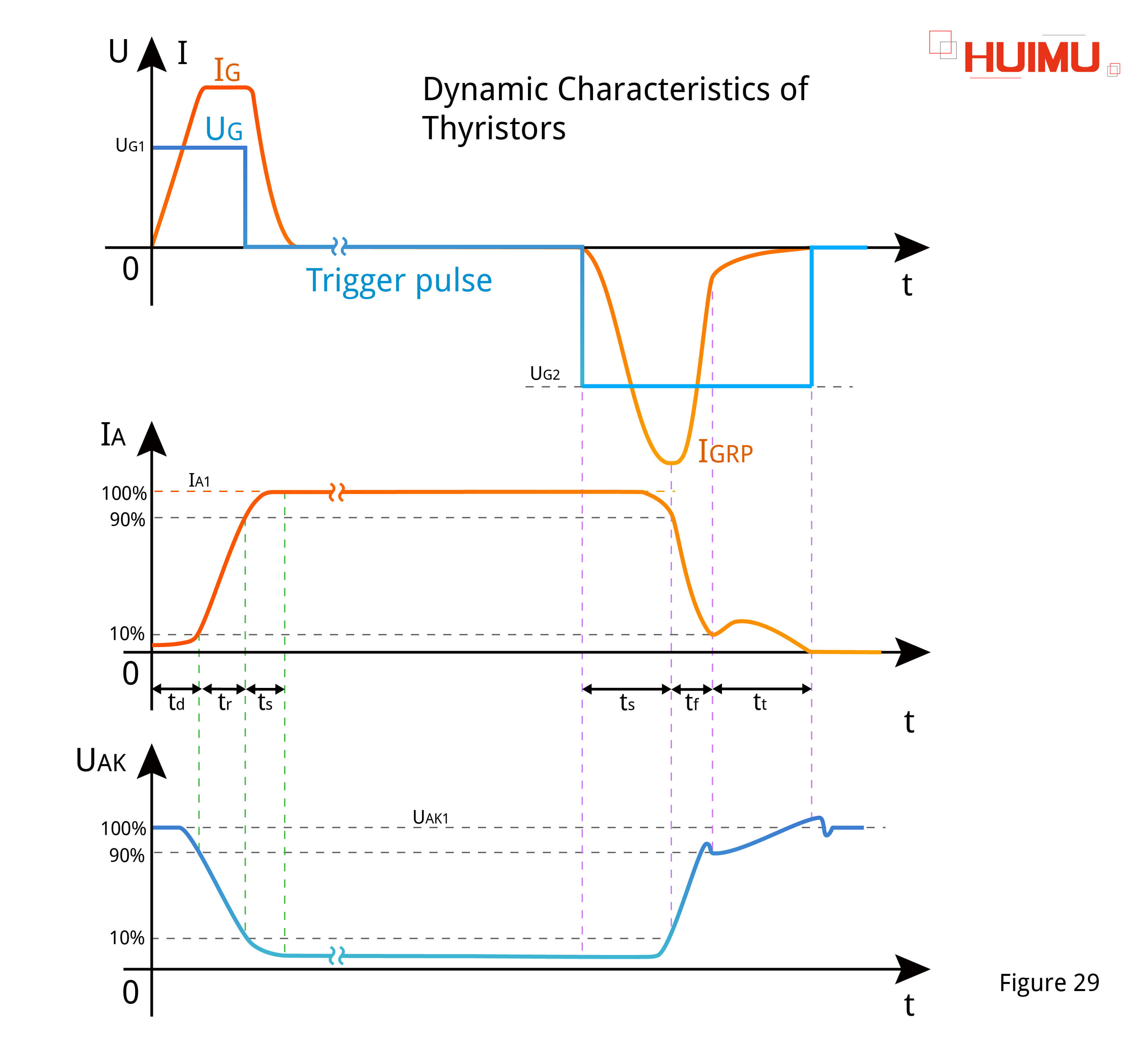
1- Процесс включения
Аналогично процессу включения SCR, когда UAK=100% UAK1 и UG ≥ UGT, GTO перейдет в проводящее состояние, и его выходной терминал будет генерировать небольшое падение напряжения во включенном состоянии. Однако из-за многоблочной структуры GTO ток срабатывания затвора IGT выше, чем у SCR. Время задержки td GTO составляет около 1-2 мкс. Время нарастания tr GTO увеличивается с увеличением анодного тока во включенном состоянии.
2- Процесс отключения
В отличие от SCR, когда на затвор подается отрицательное импульсное напряжение для обеспечения достаточно большого отрицательного импульсного тока, GTO вступает в процесс отключения. Процесс выключения GTO делится на время хранения ts, время падения tf и время задержки tt.
Время хранения ts - это время, необходимое для уменьшения IA со 100% IA1 до 90% IA1. Когда подается сигнал отключения UG2, ток отрицательного затвора быстро возрастает от 0 до IGRP. di/dt тока отрицательного затвора зависит от индуктивности цепи и анодного напряжения. Ток отрицательного затвора извлекает носители, сохраненные во время насыщенной проводимости, из области базы P GTO, так что эквивалентный транзистор V2 выходит из насыщения. В течение этого периода GTO не полностью вышел из насыщения, поэтому UAK и IA остаются неизменными.
Время падения tf - это время, необходимое для уменьшения IA с 90% IA1 до 10% IA1. Когда отрицательный импульсный ток достигает IGRP, анодный ток IA начинает быстро падать, а анодное напряжение UAK начинает расти. По мере уменьшения проводимости базовой области, α1 + α2≤1, GTO начинает входить в выключенное состояние. Поскольку время падения tf очень короткое (около 2 мкс), а скорость падения IA очень велика, на выходной клемме GTO возникнет скачкообразное напряжение.
Время задержки tt - это время, необходимое для уменьшения IA с 10% IA1 до 0. В течение этого периода оставшиеся носители будут рекомбинировать, UAK постепенно повышается до UAK1, а IA постепенно уменьшается до 0. Из-за схемы демпфирования на выходной клемме GTO произойдет переходное превышение. Если скорость нарастания напряжения UAK слишком велика, GTO может включиться снова. Поддерживая надлежащий отрицательный импульс затвора, можно эффективно сократить время задержки tt.
Обычно время падения tf меньше времени хранения ts, а время хранения ts меньше времени задержки tt, то есть tf<ts<tt. Когда IA падает до 10% IA1, можно считать, что GTO отключен, поэтому формула расчета времени отключения такова: toff = ts + tf.
5.3 Гигантский транзистор
5.3.1 Введение в ГТП
<
Гигантский транзистор (GTR) появился на свет в 1970-х годах, который представляет собой разновидность транзистора с биполярным переходом, способного выдерживать высокое напряжение и большой ток, поэтому GTR также известен как power BJT. Время переключения GTR намного короче, чем у тиристора и GTO (обычно несколько микросекунд), поэтому GTR имеет более высокую рабочую частоту - рабочая частота тиристора обычно составляет десятки Гц; рабочая частота GTO обычно составляет несколько сотен Гц; рабочая частота GTR обычно составляет 1-20 кГц. Мощность GTR очень велика, например, 1800 В/800 А/2 кГц, 1400 В/600 А /5 кГц и 600 В/3 А/100 кГц. Поскольку GTR обладает преимуществами низкого напряжения насыщения, хорошими характеристиками переключения, широкой безопасной рабочей зоной, большой мощностью и высокой способностью к самоотключению и т.д., Поэтому GTR заменяет тиристоров и широко используется в областях средней мощности и средней частоты, таких как силовые расходные материалы, управление двигателем и общие инверторы. Однако мощность привода, требуемая ГТП, велика, а конструкция его схемы привода очень сложна. В то же время GTR имеет низкое сопротивление импульсному току и легко повреждается при повторном пробое. Поэтому GTR постепенно заменяется силовыми МОП-транзисторами и IGBT.
В соответствии с различными структурами, ГТП могут быть разделены на тип NPN и тип PNP (в следующем содержании в качестве примера приведены ГТП типа NPN). В соответствии с различными конструктивными формами ГТП можно разделить на ГТП однотрубного типа, ГТП дарлингтонского типа (ГТП с составными трубами) и ГТП модульного типа. Однотрубный GTR имеет низкое падение напряжения насыщения и немного высокую скорость переключения, но коэффициент усиления по току β невелик (обычно около 10), пропускная способность по току невелика, а мощность привода велика. Обычно он используется в инверторных цепях малой мощности. Преимущества Darlington type GTR заключаются в большом коэффициенте усиления по току β (обычно до десятков или сотен раз), большой емкости по току, небольшом энергопотреблении, но его падение напряжения насыщения велико, а скорость выключения низкая.
GTR типа Darlington содержит несколько блоков (каждый блок состоит из трубки Дарлингтона), и эти блоки соединены параллельно с помощью технологии интегральных схем. Модуль GTR помещает две или более (4, 6 или даже 7) однотрубных штампов типа GTR или типа Darlington GTR в однотрубный корпус. Трубки GTR в модуле GTR могут образовывать одномостовой рычаг, однофазный мост, трехфазный мост и трехфазный мост с выпускной трубой. Модуль GTR обладает преимуществами изоляции корпуса, прост в проектировании и установке. В настоящее время однотрубные ГТП и немодульные ГТП типа Дарлингтона редко используются в инверторных схемах, в то время как модули ГТП по-прежнему широко используются.
* Метро Дарлингтон

Трубка Дарлингтона также называется составной трубкой. Путем последовательного соединения двух транзисторов с образованием эквивалентного транзистора выходной сигнал первого транзистора используется в качестве базового сигнала второго транзистора. Тип эквивалентного транзистора такой же, как и у первого транзистора. Оба транзистора работают в области усиления с помощью соответствующего внешнего напряжения, поэтому коэффициент усиления по току этого эквивалентного транзистора является произведением коэффициентов усиления по току двух транзисторов. Трубки Дарлингтона обычно используются для усиления очень крошечных сигналов в высокочувствительных усилительных схемах, таких как мощные коммутационные схемы, усилители мощности и регулируемые источники питания.
5.3.2 Как работают ГТП?
5.3.2.1 Базовая структура ГТП

Структура GTR аналогична структуре BJT. NPN-тип GTR разделен на эмиттерную область, базовую область и коллекторную область двумя PN-переходами (коллекторный переход J1 и эмиттерный переход J2) - эмиттерная область имеет небольшую площадь и высокую концентрацию легирования; базовая область имеет небольшую толщину (5-20 мкм) и низкую концентрацию легирования; коллекторная область разделена разделенная на две части область дрейфа N-коллектора имеет большую площадь и низкую концентрацию легирования, а область подложки N+ имеет небольшую площадь и высокую концентрацию легирования.
5.3.2.2 Принцип действия ГТП
Принцип работы и формула расчета GTR такие же, как принцип работы и формула расчета BJT. Однако следует отметить, что во время процесса включения область N+ подложки будет вводить большое количество свободных электронов в область N-дрейфа, чтобы увеличить обратный ток J1.
5.3.3 Основные параметры ГТП
Большинство параметров GTR совпадают с основными параметрами BJT.
1- Пробивное напряжение BV

Когда напряжение UCE, подаваемое на выход GTR, превышает указанное значение, GTR будет отключен, и это напряжение называется напряжением пробоя BV. Напряжение пробоя связано не только с характеристиками GTR, но и со способом подключения внешней цепи, как показано на рисунке 33.
BVCBO - это обратное напряжение пробоя между коллектором и базой, когда эмиттер открыт;
BVCEO - это напряжение пробоя между коллектором и эмиттером, когда база открыта;
BVCER - это напряжение пробоя между коллектором и эмиттером, когда эмиттер и база соединены резистором;
BVCES - это напряжение пробоя между коллектором и эмиттером, когда эмиттер и база закорочены;
BVCEX - это напряжение пробоя между коллектором и эмиттером, когда эмиттерный переход имеет обратное смещение.
Эти пробивные напряжения имеют следующую зависимость:
BVCBO>BVCEX>BVCES>BVCER>BVCEO
Для обеспечения безопасности в реальном процессе рекомендуется, чтобы максимальное рабочее напряжение было намного ниже, чем BVCEO.
2- Максимальное напряжение коллектор-эмиттер UCEM
Максимальное напряжение коллектор-эмиттер UCEM - это номинальное напряжение GTR. Для обеспечения безопасного использования максимальное рабочее напряжение UCEM будет ниже, чем напряжение пробоя BVCEO.
3-Секундный Пробойный Блок питания PSB
Второй пробой в основном происходит в случае высокого напряжения и низкого тока, и соответствующая вторая способность выдерживать пробой называется второй пробивной мощностью PSB.
5.3.4 Основные характеристики ГТП
5.3.4.1 Статические характеристики ГТП

Статические характеристики GTR аналогичны статическим характеристикам BJT. Разница заключается в том, что слаботочный BJT будет работать в области усиления, в то время как GTR работает только в области насыщения и области отключения (то есть GTR имеет только включенное состояние и выключенное состояние, а dose не имеет состояния усиления). Это связано с тем, что, когда GTR работает в режиме усиления, его ток очень велик, а потребляемая мощность также велика, что приведет к легкому перегоранию GTR из-за сильного нагрева. Однако в процессе переключения (процесс переключения назад и вперед из включенного состояния в выключенное состояние) ГТП должен пересекать область усиления. Обычно этот процесс выполняется очень быстро, чтобы избежать повреждения ГТП.
5.3.4.2 Динамические характеристики ГТП

Динамические характеристики GTR аналогичны динамическим характеристикам BJT.
1- Процесс включения
При подаче прямого базового тока IB1 GTR перейдет в проводящее состояние. Процесс включения делится на время задержки td и время нарастания tr.
Формула расчета времени включения: ton = td + tr
2- Процесс отключения
Отключив базовый ток IB, можно отключить GTR. А обратный ток может ускорить процесс отключения. Процесс отключения делится на время хранения ts и время отключения tf.
Формула расчета времени отключения: toff=ts + tf
* Как ускорить процесс включения ГТП
● Добавьте ускоряющий конденсатор. Путем параллельного подключения конденсатора на обоих концах базового сопротивления GTR и использования функции, заключающейся в том, что напряжение на конденсаторе не может внезапно измениться в момент коммутации, для улучшения коммутационных характеристик GTR. Конечно, также может быть выбрана быстроразъемная трубка GTR с относительно небольшой емкостью перехода.
● Увеличьте скорость привода. Когда GTR включен, обеспечивая ток прямого привода с определенной амплитудой и крутым передним краем, td и tr могут быть уменьшены, чтобы ускорить процесс включения GTR и сократить время включения ton. Однако ток возбуждения не может быть слишком большим, в противном случае время диффузии ts ГТП будет увеличено из-за перенасыщения.
* Как ускорить процесс отключения ГТП
● Уменьшите глубину насыщения. За счет уменьшения глубины насыщения во время процесса включения можно уменьшить количество носителей, хранящихся на базе, чтобы сократить время хранения ts ГТП.
● Примените отрицательный ток привода IB2. Когда ГТП выключен, путем подачи отрицательного возбуждающего тока с определенной амплитудой и превышением скорости скорость извлечения носителей из базы может быть ускорена, чтобы сократить время хранения ts ГТП.
● Подайте обратное базовое напряжение UB2. Когда GTR выключен, рассеивание накопленного заряда может быть ускорено за счет увеличения обратного базового напряжения, чтобы сократить время хранения ts GTR. Но обратное базовое напряжение не должно быть слишком большим, чтобы избежать пробоя эмиттерного перехода.
3- Явление секундного сбоя ГТП

Первая поломка: Когда напряжение коллектора превышает напряжение пробоя BVCEO, GTR будет выведен из строя - IC быстро увеличивается, а выходное напряжение UCE GTR останется на определенном значении (то есть, поддерживающее напряжение BVsus). Когда происходит первая поломка, до тех пор, пока внешняя цепь может ограничить ток после поломки, GTR не будет поврежден. После того, как напряжение на коллекторе будет снижено до уровня ниже BVCEO, GTR вернется в нормальное состояние, и его рабочие характеристики не изменятся. Таким образом, первая поломка является обратимой и не может привести к повреждению ГТП.
Вторая поломка: При возникновении первой поломки, если немедленно не будут приняты меры по ограничению тока, ток коллектора IC достигнет критической точки ISB второй поломки, что приведет к увеличению локальной плотности тока в ГТП. Локальная область будет нагреваться и еще больше увеличивать локальную плотность тока. После серии положительных обратных связей, хотя температура поверхности GTR невелика, локальная область внутри нее повреждается из-за высокой температуры, и между коллектором и эмиттером образуется канал с низким сопротивлением, и напряжение на коллекторе UCE падает, а ток коллектора IC резко возрастает. Это явление называется вторым пробоем. Вторая поломка необратима, она приведет к необратимому повреждению ГТП и значительно ухудшит его рабочие характеристики.
4- Безопасная рабочая зона ГТП

Максимальное напряжение UCEM, максимальный ток коллектора ICM, максимальная рассеиваемая мощность PCM и вторая мощность пробоя PSB составляют вторую критическую линию пробоя. Область, отмеченная тенью на второй критической линии пробоя, является безопасной рабочей зоной.
5.4 Силовой МОП-транзистор
5.4.1 Введение в МОП-транзистор

Полевой транзистор (полевой транзистор) представляет собой однополярное устройство, управляемое напряжением. Принцип работы полевого транзистора заключается в основном в использовании электрического поля для формирования проводящего канала в полупроводнике для управления проводимостью полупроводника. Полевой транзистор можно разделить на переходный полевой транзистор (JFET, также известный как статический индукционный транзистор, SIT) и полевой транзистор с изолированным затвором.
Полевой транзистор металл-оксид-полупроводник (MOSFET) представляет собой полевой транзистор с изолированным затвором, изготовленный из металла, оксида и полупроводника. МОП-транзистор - очень важное силовое электронное устройство. MOSFET имеет высокое входное сопротивление (около 107-1015 Ом), низкий уровень шума, низкое энергопотребление, большой динамический диапазон, хорошие температурные характеристики, простоту интеграции, отсутствие второго пробоя, простую схему привода, малую мощность привода, быструю скорость переключения, высокую рабочую частоту, хорошую термостабильность (лучше, чем GTR), широкая безопасная рабочая зона, а смещение затвора может быть положительным, отрицательным или нулевым. Благодаря этим преимуществам МОП-транзисторы широко используются в схемах, таких как усиление сигнала, преобразование импеданса, переменные резисторы, источники постоянного тока, электронные переключатели и т.д. По сравнению с другими силовыми электронными устройствами, из-за малой емкости по току и низкого выдерживаемого напряжения МОП-транзистора, для формирования силового МОП-транзистора с высокой мощностью обычно используется многоблочный интегрированный механизм, который в основном используется в высокочастотном силовом электронном оборудовании мощностью менее 1 кВт. МОП-транзисторы в основном используются в твердотельных реле постоянного тока (нажмите, чтобы просмотреть больше твердотельных реле постоянного тока).
5.4.2 Как работает МОП-транзистор?
5.4.2.1 Базовая структура МОП-транзистора
МОП-транзистор имеет четыре вывода - затвор (G), сток (D), источник (Ы) и корпус (B). Основной структурой МОП-транзистора является подложка (также называемая корпусом или основанием), основным материалом которой является кремний. Между источником и стоком имеется оксидный изолирующий слой (также называемый оксидным слоем затвора или изолирующим слоем затвора), материалом которого обычно является SiO2. Затвор находится на изоляционном слое затвора, материалом которого раньше был алюминий (алюминиевый затвор), но теперь это поликремний (поликремниевый затвор). Внутреннее сопротивление затвора МОП-транзистора чрезвычайно велико (до нескольких сотен мегаом), поэтому между затвором, источником, стоком и подложкой нет проводимости. При фактическом использовании силовой диод обычно подключается параллельно между стоком и источником МОП-транзистора, чтобы избежать мгновенного обратного тока в цепи от разрушения МОП-транзистора. Как правило, силовой диод непосредственно встроен в МОП-транзистор.
В зависимости от материала подложки MOSFET можно разделить на N-MOSFET (или N-MOS) и P-MOSFET (или P-MOS). N-MOS использует подложку P-типа, и ее источник должен быть подключен к самому низкому потенциалу схемы; P-MOS использует подложку N-типа, и ее источник должен быть подключен к самому высокому потенциалу схемы.
В зависимости от наличия проводящего канала между источником и стоком, когда напряжение на затворе равно нулю, МОП-транзисторы можно разделить на МОП-транзисторы усилительного типа и МОП-транзисторы обедненного типа.
исимости от того, находятся ли источник и сток в одной плоскости, структуру МОП-транзистора можно разделить на вертикальную структуру и горизонтальную структуру.
Существует множество типов ответвлений и производных устройств MOSFET, которые не могут быть перечислены здесь. Ниже приводится введение в LDMOSFET, CMOS и VDMOSFET.
1- LDMOSFET

Источник (Ы) и сток (D) LDMOSFET находятся в одной плоскости, поэтому требуется отдельный корпус (B). Возьмем в качестве примера N-канальный LDMOSFET (как показано на рисунке 39). Его подложка представляет собой область Р-подложки, а носителями, участвующими в проводимости, являются свободные электроны. В области P-substate (P- Sub) есть две области с высокой степенью легирования N+, одна из которых называется областью источника, а другая - областью стока. Эти два региона совершенно одинаковы, и теоретически поменять их местами не составляет труда. Поскольку источник (Ы) и сток (D) находятся в одной плоскости, может произойти сдвиг порогового напряжения, вызванный эффектом тела. Следовательно, путем добавления высоколегированной области P+ к области P-подложки тело (B) подключается к источнику (источникам) из области P+, так что потенциал тела равен потенциалу источника, и можно избежать эффекта тела. Проводящий канал в LDMOSFET сформирован в подложке - когда напряжение на затворе усиленного N-канального LDMOSFET равно 0, между источником и стоком нет канала, как показано на рисунке 39, а; когда напряжение на затворе обедненного N-канального LDMOSFET равно 0, между источником и стоком имеется канал, как показано на рисунке 39, b. За счет увеличения бокового размера (горизонтальной области) длина канала LDMOSFET увеличивается. Однако увеличение горизонтальной площади приведет к увеличению сопротивления включению LDMOSFET.
* Длина и ширина проводящего канала
Расстояние между областью источника и областью стока называется длиной проводящего канала. Ничья = Leff + 2 * LD. Ldrawn - это общая длина канала, Leff - эффективная длина канала, а LD - длина боковой диффузии. Расстояние от затвора до нижней части проводящего канала называется шириной проводящего канала. Длина (L) и ширина (W) проводящего канала определяют сопротивление канала МОП-транзистора.
* Эффект тела
Эффект тела относится к тому, что ширина обедненной области в проводящем канале становится шире после того, как напряжение подложки ниже напряжения источника, что приведет к более высокому пороговому напряжению.
2- CMOS

КМОП - один из наиболее часто используемых процессов в интегральных схемах. Он может интегрировать несколько NMOS и P-MOS на одном кремниевом чипе. P-MOS непосредственно встроен в N-MOS, поэтому подложка P-MOS также называется N-Well. КМОП обладает преимуществами высокой эффективности, низкого энергопотребления, высокого импеданса и способности обрабатывать сложную логику.
3- VDMOSFET
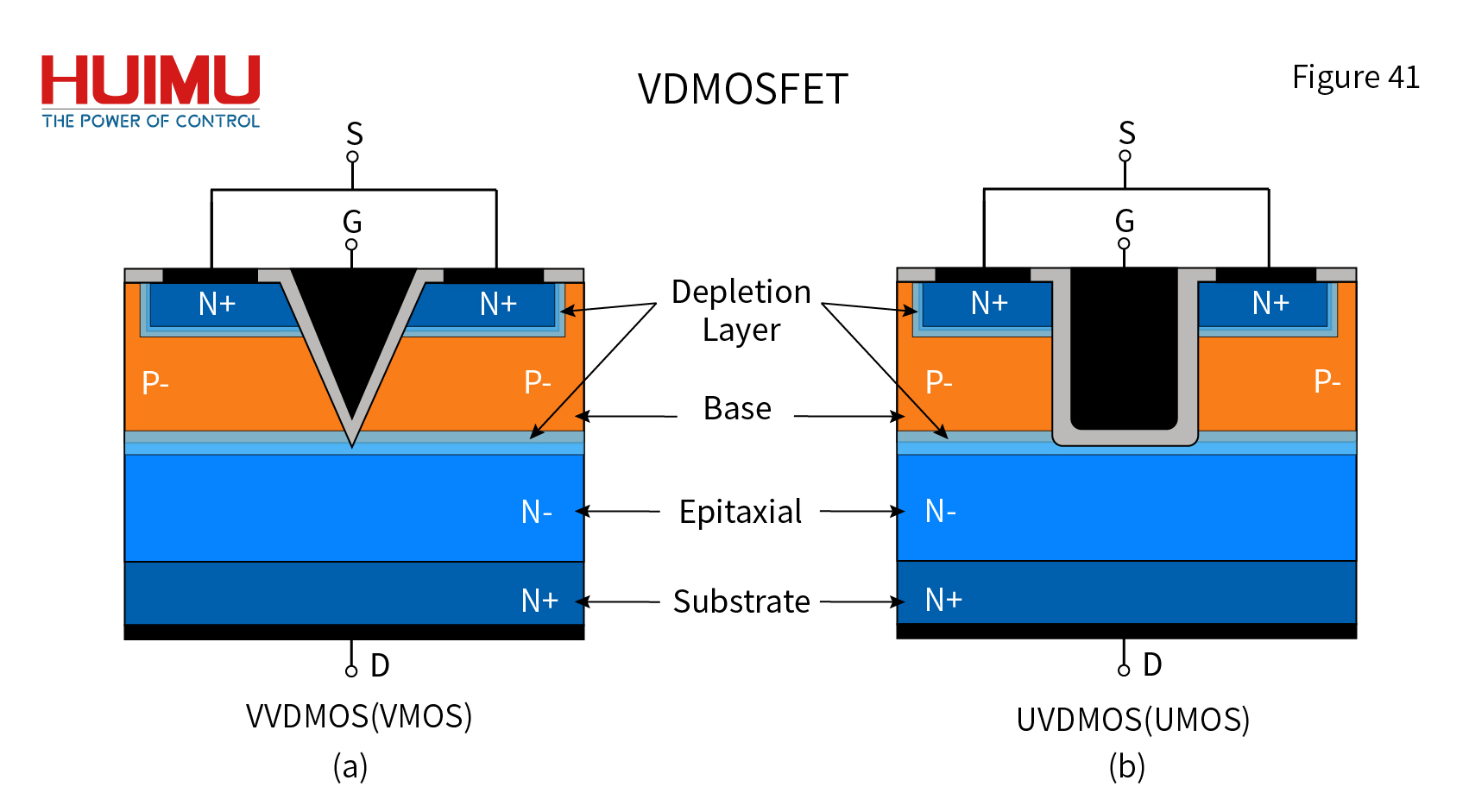
Вертикальный МОП-транзистор с двойным рассеянием (VDMOSFET) является наиболее распространенным силовым МОП-транзистором (на рисунке 41 показан усовершенствованный N-канальный VDMOSFET). Источник и сток VDMOSFET не находятся в одной плоскости, поэтому отдельный корпус (B) не требуется. За счет увеличения вертикального размера (вертикальной площади) без увеличения горизонтальной площади длина канала VDMOSFET увеличивается. Следовательно, для МОП-транзисторов с одинаковым сопротивлением включения VDMOSFET обладает более высокой способностью выдерживать ток, чем LDMOSFET. Поскольку между P-областью и N-областью VDMOSFET имеется дополнительный слой N-эпитаксиальной области с низкой концентрацией легирования, который увеличивает эквивалентное сопротивление VDMOSFET, поэтому VDMOSFET может выдерживать более высокое напряжение. Хотя из-за эффекта модуляции проводимости, когда ток, протекающий через PN-переход, постепенно увеличивается, внутреннее сопротивление N-эпитаксиальной области будет уменьшаться, но способность VDMOSFET выдерживать напряжение все еще больше, чем у LDMOSFET. Кроме того, N-область и P-область образуют паразитный силовой диод, который может эффективно защищать VDMOSFET от обратного пробоя напряжения. Поэтому большинство силовых МОП-транзисторов имеют вертикальную структуру, чтобы лучше выдерживать напряжение и ток.
В зависимости от формы канавчатого затвора VDMOSFET можно разделить на VVDMOS (также известный как v-образный вертикальный МОП-транзистор с двойным рассеянием или v-образный вертикальный МОП-транзистор с двойным рассеянием, VMOS) и UVDMOS (также известный как u-образный вертикальный МОП-транзистор с двойным рассеянием или u-образный вертикальный канальный МОП-транзистор с двойным рассеянием, UMOS). UMOS обладает лучшей способностью выдерживать напряжение, чем VMOS. Поскольку VMOS очень широко используется в области силовой электроники, обычно силовой MOSFET относится к VMOS.
5.4.2.3 Принцип работы МОП-транзистора
Принцип работы МОП-транзистора заключается в изменении проводимости внутри полупроводника путем приложения внешнего электрического поля. Принцип работы P-MOSFET точно такой же, как и у N-MOSFET. Кроме того, принципы работы VDMOSFET и LDMOSFET схожи, но боковая структура облегчает четкое наблюдение за изменениями тока внутри MOSFET. Итак, ниже в качестве примера приведен N-канальный LDMOSFET, чтобы представить принцип работы MOSFET.
1- МОП-транзистор го типа с усилением

Когда напряжение на затворе не подается (UGS=0), нет проводящего канала между областью источника и областью стока МОП-транзистора усилительного типа, и проводящий канал будет сформирован только после подачи определенного напряжения на затворе. Следовательно, МОП-транзистор усилительного типа представляет собой нормально замкнутое (NC) устройство.
Стадия слоя накопления: Когда UGS<0, на затворе будет генерироваться электрическое поле, перпендикулярное поверхности полупроводника, которое будет притягивать дырки в P-области к нижней части изолирующего слоя и отталкивать свободные электроны в P-области, а затем формировать слой накопления. Даже если между источником и стоком подается положительное напряжение, ток не может протекать непосредственно от стока к источнику (ток утечки не учитывается), поэтому МОП-транзистор находится в выключенном состоянии.
Стадия обедненного слоя: Когда 0<UGS<UT, на затворе будет генерироваться электрическое поле, перпендикулярное поверхности полупроводника, которое будет притягивать свободные электроны в P-области к нижней части изолирующего слоя и отталкивать дырки в P-области, а затем формировать обедненный слой. Однако, поскольку свободных электронов, накопленных в нижней части изолирующего слоя, слишком мало, чтобы образовать проводящий канал, МОП-транзистор все еще находится в выключенном состоянии.
Стадия инверсионного слоя: Когда UGS≥UT, свободных электронов, накопленных в нижней части изолирующего слоя, достаточно, чтобы сформировать узкий слой N-типа (то есть проводящий канал N-типа). Поскольку тип проводящего канала N-типа противоположен типу P-области, его также называют инверсионным слоем. Наличие проводящего канала позволяет току протекать из области стока в область источника, поэтому МОП-транзистор находится во включенном состоянии. С увеличением UGS, чем сильнее электрическое поле, формируемое затвором, тем больше свободных электронов притягивается к нижней части изолирующего слоя, тем шире проводящий канал, тем меньше сопротивление канала и тем больше ток стока ID. Следует отметить, что падение напряжения, генерируемое ID тока стока вдоль канала, делает напряжение между каждой точкой в канале и затвором больше не равным - чем ближе к области источника, тем больше падение напряжения и тем шире канал; чем ближе к области стока, тем меньше падение напряжения и тем уже канал. Падение напряжения на конце, ближайшем к области стока, является наименьшим (его значение равно UGD= UGS - UDS), канал является самым узким. И по мере увеличения UDS канал вблизи области слива становится все уже и уже.
Этап области отключения: Когда включен МОП-транзистор, если UDS продолжает увеличиваться до тех пор, пока UGD = UGS - UDS = UT, ширина канала конца, ближайшего к области стока, становится равной 0, и сильный инверсионный канал не может быть сформирован, то есть канал перекрывается. Точка на канале с шириной 0 называется точкой отсечки, а область истощения между точкой отсечки и областью слива называется областью отсечки. Если UDS продолжит увеличиваться, точка отсечки переместится в область источника. Поскольку увеличение UDS почти применяется к области отсечки, область отсечки также будет продолжать расширяться. После отключения канала, даже если напряжение стока продолжает увеличиваться, ток стока остается на постоянном значении (то есть ток насыщенного стока ID (sat)), и МОП-транзистор находится в состоянии насыщения. ID тока насыщенного стока (sat) не зависит от UDS, но определяется UGS - ID (sat) имеет отношение к квадрату UGS, который представляет собой характеристики передачи по квадратичному закону MOSFET.
МОП-транзистор 2-разрядного типа

Когда напряжение на затворе не подается (UGS=0), между областью источника и областью стока обедненного МОП-транзистора имеется проводящий канал. Когда подается напряжение прямого затвора, ширина проводящего канала будет увеличиваться. При подаче напряжения обратного затвора ширина проводящего канала будет уменьшаться. Когда напряжение обратного затвора достигает определенного значения, проводящий канал исчезает. Следовательно, истощающий N-MOSFET является нормально разомкнутым (NO) устройством.
Состояние проводимости: Когда UGS≥0, электрическое поле, генерируемое на затворе, будет притягивать больше электронов в N-канал и отталкивать дырки в N-канале. По мере увеличения UGS канал становится шире, сопротивление канала становится меньше, а ID увеличивается.
Состояние отключения: Когда UGS<0, электрическое поле, генерируемое на затворе, будет притягивать больше дырок в N-канал и отталкивать электроны в N-канале, делая канал более узким, а сопротивление канала больше. Когда UGS достигает напряжения отключения UPO, электроны в N-канале истощаются, проводящий канал исчезает, а ID стремится к нулю.
5.4.3 Основные параметры МОП-транзистора
Большинство параметров MOSFET совпадают с основными параметрами BJT.
1- Транспроводимость Gfs
Вообще говоря, отношение входного тока к входному напряжению называется допуском. Из-за передаточных характеристик MOSFET его входное напряжение затвора-источника UGS не влияет на изменение входного тока затвора-источника IGS, но влияет на изменение ID тока стока, поэтому отношение ID тока стока к UGS напряжения затвора-источника называется транскондуктивностью.
2- Паразитная Емкость

Внутри МОП-транзистора имеется три внутренних паразитных емкости: паразитная емкость затвора-источника CGS, паразитная емкость затвора-стока CGD (также известная как емкость Миллера) и паразитная емкость стока-источника CDS. Эти паразитные емкости будут влиять на динамические характеристики МОП-транзистора: если паразитная емкость мала, ток переключения и мощность возбуждения малы, а скорость переключения высокая; если паразитная емкость велика, ток переключения и мощность возбуждения велики, а скорость переключения низкая. Производители МОП-транзисторов обычно указывают параметры емкости МОП-транзистора, которые соответствуют следующим расчетным формулам:
Входная емкость МОП-транзистора: СНПЧ = CGS + CGD
Выходная емкость МОП-транзистора: Coss = CDS + CGD
Емкость обратной передачи МОП-транзистора: Crss = CGD
3- Сток-источник включен-сопротивление RDS (включено)
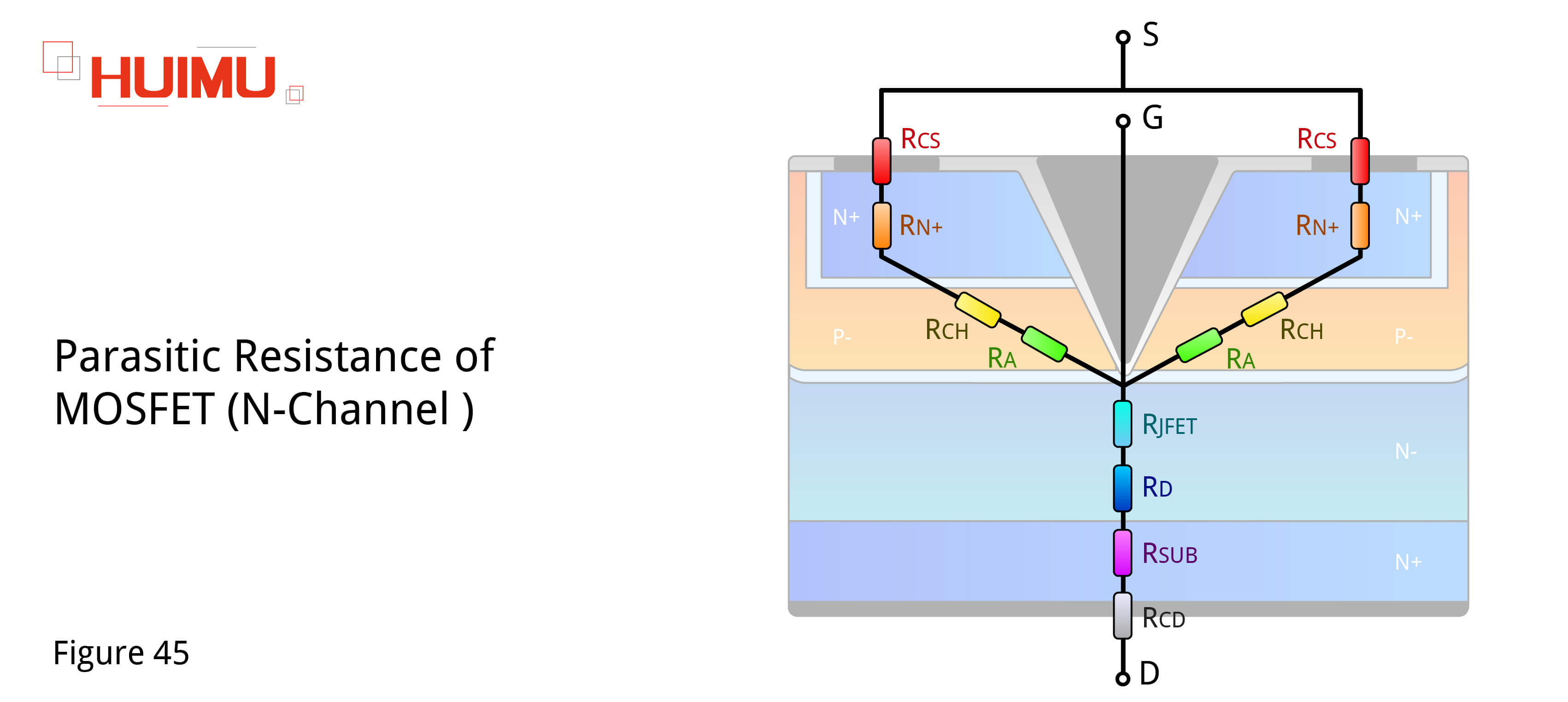
RDS включенного сопротивления стока-источника (вкл.) относится к включенному сопротивлению между стоком и источником МОП-транзистора, когда он включен при определенных условиях. RDS(вкл.) определяется паразитным сопротивлением MOSFET, RDS(вкл.) = RCS + RN+ + RCH + RA + RJFET + RD + RSUB + УЗО. RCS - контактное сопротивление между областью источника N+ и электродом источника; RN+ - сопротивление между областью источника N+ и каналом; RCH - сопротивление канала; RA - сопротивление слоя накопления; RJFET - сопротивление эквивалентного JFET; RD - сопротивление области дрейфа; RSUB - сопротивление области подложки; УЗО - контактное сопротивление между областью подложки и электродом стока. На входное сопротивление стока-истока RDS (вкл.) влияет температура перехода МОП-транзистора и напряжение затвора-истока (управляющее напряжение) UGS. Чем выше температура перехода, тем больше RDS(вкл.); наоборот, тем меньше RDS(вкл.). Чем выше напряжение затвор-источник, тем меньше RDS (вкл.); наоборот, тем больше RDS (вкл.).
4- Максимальный ток стока IDM
Максимальный ток стока IDM - это номинальный ток МОП-транзистора. Максимальный ток стока относится к току стока, который позволяет МОП-транзистору достигать самой высокой температуры перехода, когда температура корпуса находится на определенном значении. Максимальный ток стока связан не только со структурой МОП-транзистора, но также со способом упаковки МОП-транзистора и температурой окружающей среды.
5- Максимальное напряжение стока-источника BVDSS
Максимальное напряжение сток-исток BVDSS - это номинальное напряжение МОП-транзистора. Максимальное напряжение сток-источник относится к максимальному напряжению, которое может быть приложено, когда сток и источник MOSFET не подвергаются лавинному пробою при температуре окружающей среды 25°C. В реальной эксплуатации измеренное значение напряжения стока-источника при токе стока 250 мкА обычно принимается за максимальное напряжение стока-источника BVDSS.
6- Максимальное напряжение затвора-источника UGSM
Максимальное напряжение затвора-источника (также известное как максимальное управляющее напряжение) относится к максимальному входному напряжению, которое может привести к необратимому повреждению изолирующего слоя затвора МОП-транзистора за очень короткое время. Обычно рекомендуется, чтобы напряжение возбуждения не превышало ±20 В.
7- Частота Переключения
Время переключения MOSFET составляет от 10 до 100 мкс, а рабочая частота может достигать более 100 кГц (даже до нескольких МГц), что является самым высоким показателем среди основных мощных электронных устройств. Хотя MOSFET вряд ли нуждается во входном токе, когда он статичен, он будет заряжать и разряжать паразитную емкость, когда он динамичен (процесс переключения), поэтому определенная мощность привода все равно требуется. Чем выше частота переключения МОП-транзистора, тем больше требуемая мощность привода.
5.4.4 Основные характеристики МОП-транзистора

Возьмем в качестве примера усовершенствованный N-MOSFET. VDD - источник выходной мощности MOSFET; UP - источник управляющего сигнала MOSFET; UGS - напряжение между затвором и источником; UDS - падение выходного напряжения MOSFET; ID - ток стока; RS - внутреннее сопротивление схемы привода; RG - внутреннее сопротивление затвора; RL - нагрузка на сток; RF - сопротивление обнаружения, используемое для определения тока стока.
5.4.4.1 Статические характеристики МОП-транзистора
1- Input Characteristics

Из-за передаточных характеристик МОП-транзистора изменение напряжения между затвором и источником МОП-транзистора не повлияет на ток между затвором и источником, но это повлияет на идентификатор тока стока. Когда ID велик, зависимость между ID и UGS является приблизительно линейной, а ее наклон равен Gfs транзистора MOSFET.
2- Выходные характеристики

Статическая выходная характеристическая кривая MOSFET аналогична статической выходной характеристической кривой GTR. Статическую выходную характеристику МОП-транзистора можно разделить на область отсечки, область насыщения и область ненасыщения. МОП-транзистор обычно работает только в состоянии переключения (то есть быстрого переключения между областью отключения и областью ненасыщения), чтобы предотвратить перегорание МОП-транзистора из-за чрезмерного энергопотребления при работе в области насыщения.
Область отсечения: Аналогична области отсечения BJT. Несмотря на то, что UDS очень высок, ток утечки ID=0 (ток утечки не учитывается).
Область насыщения: Аналогична активной области BJT. ID не зависит от UDS, но увеличивается с увеличением UGS. В области насыщения напряжение и ток, которые выдерживает МОП-транзистор, велики, поэтому его энергопотребление очень велико.
Область ненасыщения: Аналогична области насыщения BJT. Идентификатор увеличивается с увеличением UDS. В ненасыщенном состоянии МОП-транзистор выдерживает большой ток и очень малое напряжение, поэтому его потребляемая мощность невелика. Поскольку МОП-транзистор ведет себя как управляемый напряжением резистор в области ненасыщения, эта область также известна как омическая область или область переменного сопротивления.
5.4.4.2 Динамические характеристики МОП-транзистора

В процессе переключения МОП-транзистора нельзя игнорировать влияние внутренней паразитной емкости на время его переключения.
1- Процесс включения
Чтобы переключить МОП-транзистор во включенное состояние, к его затвору должен быть применен источник питания с крутым входом UP1. Из-за наличия внутреннего сопротивления RS схемы возбуждения и паразитной емкости CGS затвора-источника напряжение UGS затвора MOSFET не может формировать импульсную форму волны такой крутой, как UP1, но повышается с определенным наклоном. Когда ток возбуждения начинает заряжать CGS так, что UGS достигает UT, МОП-транзистор переходит во включенное состояние, и ID тока стока начинает расти. Когда CGS полностью заряжен, UGS поддерживается на уровне UGS1, а ID поддерживается на уровне ID1. В это время паразитная емкость CDS стока-источника начинает разряжаться, а UDS начинает уменьшаться. Когда UDS достигает минимального значения, ток возбуждения начинает заряжать паразитную емкость CGD затвора-стока, и UGS снова повышается, пока не останется на уровне UGS2. Как правило, время от увеличения UGS до 10% UGS2 до ID, увеличивающегося до 10% ID1, называется временем задержки включения td(on). Время, необходимое для увеличения ID с 10% ID1 до 90% ID1, называется временем нарастания tr. Время включения ton МОП-транзистора представляет собой сумму времени задержки включения td(вкл.) и времени нарастания tr.
Формула расчета времени включения: ton = td(вкл.) + tr
2- Процесс отключения
Когда управляющий импульсный сигнал UP1 удален, из-за RS и CGD UGS уменьшается с определенным наклоном. Когда CGD разряжается, UGS остается на уровне UGS1, в это время CDS начинает заряжаться, а UDS начинает расти. Когда CDS полностью заряжен, UDS остается на уровне 100% UDS1, в это время CGS начинает разряжаться, и UGS снова падает. Когда UGS падает ниже UT, MOSFET переходит в выключенное состояние, а ID падает до 0. Поскольку МОП-транзистор не обладает эффектом хранения неосновных носителей, процесс его отключения происходит очень быстро (около десятков наносекунд). Как правило, время от 90% UGS2 до 90% ID1 называется временем задержки выключения td(выкл.). Время, необходимое для того, чтобы ID упал с 90% ID1 до 10% ID1, называется временем падения tf. Время выключения ton МОП-транзистора представляет собой сумму времени задержки выключения td(выкл.) и времени отключения tf.
Формула расчета времени выключения: toff = td(выкл.) + tf
* Как ускорить процесс переключения МОП-транзистора
● Использование схемы привода с низким внутренним сопротивлением и индуктивностью может ускорить процесс включения МОП-транзистора.
● Улучшите способность MOSFET заряжать и разряжать паразитную емкость во время процесса включения и выключения, что может эффективно сократить время задержки, так что не возникает переходных ошибок.
5.4.5 Последовательное и параллельное подключение МОП-транзистора
Поскольку скорость переключения МОП-транзистора очень высока, а его динамические характеристики имеют определенную степень дисперсии, невозможно использовать общие схемы выравнивания напряжения. Если МОП-транзисторы подключены последовательно, во время процесса переключения рабочее состояние каждого МОП-транзистора отличается, и его способность выдерживать напряжение не может оставаться неизменной, поэтому легко вызвать перегорание МОП-транзистора с низким выдерживаемым напряжением из-за перенапряжения. Поэтому МОП-транзисторы не подходят для последовательного подключения.
Сопротивление включения МОП-транзистора имеет положительный температурный коэффициент - чем выше температура, тем больше сопротивление включения. В практических приложениях несколько МОП-транзисторов могут использоваться параллельно, например, выходная цепь инверторного сварочного аппарата будет подключать десятки МОП-транзисторов параллельно, чтобы увеличить его пропускную способность по току. Когда один из МОП-транзисторов пропускает слишком большой ток, чем больше сопротивление включения, тем больше тока будет поступать в другие МОП-транзисторы с меньшим сопротивлением включения, и, наконец, ток, протекающий в каждом МОП-транзисторе, имеет тенденцию быть сбалансированным. Следующие методы могут эффективно уменьшить явление неравномерного тока: Выберите МОП-транзисторы с небольшой погрешностью параметров; проводка и компоновка схемы должны быть симметричными; следует учитывать потери в линии (сопротивление самого провода будет потреблять ток), а также индуктивность и емкость провода при высокой частоте. Следует отметить, что подключение небольшого индуктора в цепи источника может действовать как реактор с разделением тока, который может эффективно уменьшить динамический неравномерный ток, но он недействителен для статического неравномерного тока.
5.5 Биполярный транзистор с изолированным затвором
5.5.1 Введение в IGBT

Биполярный транзистор с изолированным затвором (IGBT или IGT) представляет собой составное устройство Bi-MOS с высоким входным сопротивлением силового MOSFET и высокой токовой емкостью BJT. IGBT широко используется во многих областях, таких как преобразователи, инверторы, системы широтно-импульсной модуляции (ШИМ), источники бесперебойного питания (ИБП), импульсные источники питания (SMPS), резонансные преобразователи, промышленные двигатели, новые энергетические транспортные средства и т.д. IGBT обладает преимуществами высокого входного сопротивления, низкого уровня шума, быстрой скорости переключения, простой схемы возбуждения, низкой мощности возбуждения, низкого напряжения во включенном состоянии, низких потерь при переключении, широкой безопасной рабочей зоны, небольшого размера, высокой плотности тока, высокой емкости по току, высокого напряжения выносливости, сильной устойчивости к воздействию импульсного тока, и никакого второго срыва. По сравнению с силовым MOSFET, IGBT имеет недостатки, заключающиеся в низкой скорости переключения и простоте защелкивания. IGBT в основном используется в областях, где выдерживаемое напряжение превышает 600 В, ток превышает 10 А, а частота превышает 1 кГц.
5.5.2 Как работает IGBT?
5.5.2.1 Базовая структура IGBT

Структура IGBT очень похожа на структуру Power MOSFET - затвор (G) IGBT соответствует затвору (G) MOSFET; эмиттер (E) IGBT соответствует источнику (источникам) MOSFET; коллектор (C) IGBT соответствует к стоку (D) МОП-транзистора. Однако IGBT имеет инжекционный слой P + в области подложки, который превращает IGBT в структуру P-N-P-N, подобную тиристору. В зависимости от того, содержит ли он буферный слой N +, IGBT можно разделить на сквозной тип (PT) и Непроходной тип (NPT). IGBT типа PT обладает преимуществами низких потерь при переключении, низких потерь при включении и большой емкости по току, но его температурные характеристики не так хороши, как у NPT, и он не подходит для параллельного подключения. Прямое пробивное напряжение IGBT типа PT выше, чем обратное пробивное напряжение, поэтому оно больше подходит для цепей постоянного тока; прямое пробивное напряжение IGBT типа NPT такое же, как и обратное пробивное напряжение, поэтому оно больше подходит для цепей переменного тока. Поскольку скорость переключения P-канального IGBT в 2-3 раза ниже, чем у N-канального IGBT, безопасная рабочая зона (SOA) P-канального IGBT меньше, чем у N-канального IGBT, а стоимость P-канального IGBT выше, чем у N-канального IGBT, поэтому P-канальный IGBT редко используется в реальных условиях. Ниже в основном представлены N-канальные IGBT типа PT.

Эквивалентная принципиальная схема N-канального IGBT типа PT представляет собой схему, состоящую из N-MOSFET с паразитным усилением, паразитного JFET, паразитного PNP-транзистора V1 (P + N- P) и паразитного NPN-транзистора V2 (N + P N-), а также эквивалентного расширенного сопротивление R2, как показано на рисунке 51, а. В этой схеме V1 является основным выходным каналом; V2 формируется с образованием MOSFT; JFET в основном формируется областью N-дрейфа; R2 в основном формируется эквивалентным сопротивлением области P-основания V2. Паразитный JFET может быть дополнительно упрощен как эквивалентное сопротивление модуляции R1, которое в основном формируется эквивалентным сопротивлением области N-дрейфа. И затем эквивалентная принципиальная схема IGBT может быть упрощена, как показано на рисунке 51, b. Четырехслойную полупроводниковую структуру (P-N-P-N) IGBT можно рассматривать как паразитный тиристорный SCR, а эквивалентная принципиальная схема IGBT может быть дополнительно упрощена как показано на рисунке 51, c. Если IGBT рассматривать как МОП-транзистор с большой коммутационной способностью по току, области P + и N + можно рассматривать как силовой диод VD1, а эквивалентная схема IGBT может быть дополнительно упрощена, как показано на рисунке 51, d. Упрощенная эквивалентная принципиальная схема помогает интуитивно понять принцип работы IGBT.
5.5.2.2 Принцип работы IGBT
Проще говоря, принцип работы IGBT - это тиристор с приводом от напряжения.

Состояние прямой блокировки: Когда на IGBT подается прямое напряжение, а затвор и эмиттер замыкаются коротким замыканием, IGBT переходит в состояние прямой блокировки. В это время PN-переходы J1 и J3 смещены в прямом направлении, а PN-переход J2 смещен в обратном направлении. Обратное напряжение заставляет обедненный слой с обеих сторон J2 распространяться на область основания P и область N-дрейфа.
Состояние обратной блокировки: Когда на IGBT подается обратное напряжение, PN-переход J1 смещается в обратном направлении, и обратное напряжение заставляет слой истощения J1 распространяться в область N-буфера. За счет увеличения ширины области N-буфера можно улучшить способность IGBT к обратной блокировке, но это также увеличит прямое падение напряжения IGBT. Обратное выдерживаемое напряжение IGBT обычно составляет всего несколько десятков вольт, поэтому, чтобы предотвратить работу IGBT в состоянии обратной блокировки, к IGBT параллельно подключается источник питания. Конечно, для удобства IGBT и FRED будут упакованы вместе, образуя IGBT-модуль с обратной проводимостью.

Состояние проводимости: Когда прямое напряжение подается на IGBT и определенное напряжение подается на затвор, область основания P образует область N подканалов, позволяя переносить электроны из области N + эмиттера в область N-дрейфа. Этот поток электронов уменьшит потенциал области основания N и обеспечит базовый ток IB1 для V1. Если падение напряжения, генерируемое этим потоком электронов, составляет около 0,7 В, то PN-переход J1 будет смещен вперед, и IGBT начнет включаться. Область N-дрейфа IGBT очень широка, а концентрация легирования низкая, поэтому область N-дрейфа имеет очень низкую проводимость. Когда IGBT работает при высоком токе, из-за эффекта модуляции проводимости концентрация носителей в области N-основания увеличивается, а его проводимость увеличивается, что приведет к снижению напряжения насыщения между коллектором и эмиттером и общего энергопотребления IGBT в режиме включения. При наличии электронного тока IN и тока дырки IP IGBT полностью включается. Когда IGBT находится во включенном состоянии, ток его коллектора должен быть ограничен, чтобы избежать эффекта защелкивания.
Состояние отключения: Когда напряжение UGE на затворе ниже порогового напряжения UT или к затвору подается напряжение обратного смещения, N-подканал исчезает, базовый ток в IGBT отключается, а затем исчезают IN и IP, IGBT переходит в состояние отключения. Однако из-за эффекта неосновной несущей выходной ток IGBT не будет немедленно уменьшен до нуля, но будет генерироваться остаточный ток, подобный BJT, характеристики которого связаны с UCE, IC и TC. Эффект неосновной несущей увеличит время переключения и потери при переключении IGBT.
* Эффект защелкивания
Обычно R2 закорачивает базу и эмиттер V2, чтобы предотвратить работу V2. Когда ток, протекающий через R2, слишком велик, так что прямое падение напряжения на R2 достаточно для обеспечения пускового тока IB2 для V2, тогда V1 и V2 образуют эквивалентный тиристорный SCR (P + N- P N+). Из-за механизма положительной обратной связи внутри эквивалентного тиристора V1 и V2 войдут в состояние глубокого насыщения, поэтому канал IGBT трудно отключить напряжением затвора, и IGBT может быть отключен только при подаче очень большого обратного напряжения. Это явление называется эффектом защелкивания, который можно разделить на статическое защелкивание и динамическое защелкивание. Статическая защелка вызвана чрезмерным током коллектора IC, когда эквивалентный тиристор полностью включен. Динамическое защелкивание вызвано большим током смещения, вызванным чрезмерным di/dt и dv/dt во время процесса переключения IGBT. Ток коллектора, вызывающий динамическую защелку, меньше, чем ток статической защелки. Эффект защелкивания заставляет V1 и V2 образовывать структуру Дарлингтона, поэтому IC и энергопотребление IGBT значительно увеличатся, что приведет к повреждению IGBT. Чтобы избежать эффекта защелкивания, обычно принимаются следующие меры:
● Уменьшите R2, изменив внутреннюю структуру и легирование IGBT, чтобы предотвратить включение V2.
● Путем оптимизации ширины и легирования N-буферного слоя для уменьшения коэффициента усиления по току α V1 (обычно менее 0,5) для подавления работы V2.
5.5.3 Основные параметры IGBT
Большинство параметров IGBT совпадают с основными параметрами MOSFET.
1- Ток фиксации IL
Ток фиксации IL относится к значению тока коллектора, который вызовет эффект фиксации IGBT. Ток фиксации IL обычно более чем в 5 раз превышает ICM (постоянный ток). Ток фиксации IL раньше был одной из основных причин ограничения текущей емкости IGBT. Однако с развитием технологии нет необходимости учитывать статическую защелку при проектировании и использовании IGBT, но по-прежнему необходимо предотвращать динамическую защелку.
5.5.4 Основные характеристики IGBT
5.5.4.1 Статические характеристики IGBT
1- Входные характеристики

Статическая входная характеристическая кривая IGBT аналогична статической входной характеристической кривой MOSFET.
2- Выходные характеристики

Статические выходные характеристики IGBT можно разделить на область прямой блокировки, активную область, область насыщения и область обратной блокировки. IGBT обычно работает только в состоянии переключения (то есть быстрого переключения между областью прямой блокировки и областью насыщения), чтобы предотвратить перегорание IGBT из-за чрезмерного энергопотребления при работе в активной области.
Область прямой блокировки: Аналогична области отсечения BJT. Когда UGE < UT, внутренний МОП-канал IGBT перекрывается, и между коллектором и эмиттером возникает ток утечки ICEO.
Активная область: Аналогична активной области (области усиления) BJT. Когда UGE ≥ UT и UCE > UGE - UT, IGBT работает в активной области и создает падение напряжения во включенном состоянии на 0,7 В. В активной области ток электронов, поступающий в область N оснований, контролируется напряжением затвора UGE, которое ограничивает базовый ток IB1 от V1, а затем ток отверстия IP ограничен, поэтому ток коллектора IC перейдет в состояние насыщения (аналогично состоянию насыщения МОП-транзистора). В активной области напряжение и ток, которые выдерживает IGBT, очень велики, и потребляемая мощность IGBT также очень велика, поэтому IGBT должен пересечь эту область как можно скорее.
Область насыщения: Аналогична области насыщения BJT. Область насыщения IGBT также известна как омическая область или область переменного сопротивления. Когда UGE ≥ UT и UCE ≤ UGE - UT, ток коллектора IC больше не контролируется напряжением затвора UGE, а определяется внешней цепью.
Область обратной блокировки: Аналогично состоянию обратной блокировки силового диода.
* Разница между областью насыщения MOSFET и областью насыщения IGBT
Падение напряжения насыщения после полного включения IGBT в основном зависит от модуляции проводимости, в то время как падение напряжения включения MOSFET в основном зависит от тока стока (характеристики сопротивления). Следовательно, область насыщения MOSFET относится к насыщению по току, а область насыщения IGBT относится к насыщению по напряжению.
5.4.2 Динамические характеристики IGBT

Динамические характеристики IGBT аналогичны комбинации MOSFET и BJT.
1- Процесс включения
Процесс включения IGBT аналогичен процессу включения MOSFET. Как правило, время, затрачиваемое от увеличения UGS до 10% UGS1 до увеличения IC до 10% IC1, называется временем задержки включения td(on). Время, необходимое для увеличения IC с 10% IC1 до 90% IC1, называется временем нарастания tr. Время включения ton IGBT - это сумма td(вкл.) и tr. Однако следует отметить, что процесс падения UCE разделен на две стадии: стадия tfv1 - это стадия, когда эквивалентный MOSFET работает отдельно; стадия tfv2 - это стадия, когда эквивалентный MOSFET и эквивалентный BJT работают вместе.
Формула расчета времени включения: ton = td(вкл.) + tr
2- Процесс отключения
Процесс отключения IGBT аналогичен процессу отключения MOSFET и BJT. Как правило, время, затрачиваемое от падения UGS до 90% UGS1 до падения IC до 90% IC1, называется временем задержки выключения td (выкл.). Время, необходимое для падения IC с 90% IC1 до 10% IC1, называется временем падения tf. Время отключения toff МОП-транзистора равно сумме td(выкл.) и tf. Однако следует отметить, что процесс падения IC разделен на две стадии: стадия tfi1 - это стадия, когда эквивалентный MOSFET работает отдельно; стадия tfi2 - это стадия, когда эквивалентный MOSFET и эквивалентный BJT работают вместе. Время задержки tt - это время, необходимое для исчезновения обратного тока восстановления. Благодаря тому, что отверстия, введенные в область P + коллектора, рекомбинируются в области P + коллектора, остаточный ток уменьшается, а tf сокращается.
Формула расчета времени отключения: toff = td(выкл.) + tf = td(выкл.) + tfi1 + tfi2
5.5.4.3 Безопасная рабочая зона IGBT

Безопасная рабочая зона с положительным смещением (FBSOA): Определяется ICM, UCEM и PCM.
Безопасная рабочая зона с обратным смещением (RBSOA): Определяется ICM, UCEM и dUCE/dt.
5.5.5 Последовательное и параллельное подключение IGBT
Как и MOSFET, IGBT не подходит для последовательного подключения.
На температурную характеристику включенного сопротивления RON IGBT влияет ток коллектора IC. Когда IC ≤ 1/3 ICM, сопротивление включения RON IGBT имеет отрицательный температурный коэффициент, который не подходит для параллельного подключения. Когда IC > 1/3 ICM, сопротивление включения RON IGBT имеет положительный температурный коэффициент, который подходит для параллельного подключения так же, как и MOSFET. Когда ток мал, влияние неравномерного тока на IGBT относительно невелико, поэтому в целом IGBT по-прежнему очень подходят для параллельного подключения.
5.6 Другие полностью управляемые устройства
Благодаря композитной конструкции может быть изготовлено полностью управляемое устройство, объединяющее преимущества нескольких устройств, таких как MCT, SIT, SITH, IGCT и т.д.
1- МОП-управляемый тиристор
Управляемый МОП-транзистором тиристор (MCT) сочетает в себе преимущества МОП-транзистора и тиристора, который обладает преимуществами чрезвычайно высокого допуска di / dt и dv / dt, высокой скорости переключения, низкого напряжения в режиме включения, малых потерь при переключении, высокой емкости по напряжению и высокой емкости по току. Подобно GTO, MCT состоит из десятков тысяч блоков MCT, и каждый блок состоит из PNP-тиристора и МОП-транзистора. МОП-транзистор управляет рабочим состоянием PNP-тиристора. Однако, хотя идея MCT аналогична идее IGBT, его напряжение и мощность по току далеки от ожидаемого значения, а стоимость выше, чем у IGBT, поэтому он не может быть выведен на рынок.
2- Статический Индукционный Транзистор
Статический индукционный транзистор (SIT) представляет собой разновидность переходного полевого транзистора с большинством носителей, участвующих в процессе проводимости. Рабочая частота SIT эквивалентна или даже выше, чем у Power MOSFET, а его мощность больше, чем у MOSFET, поэтому он подходит для высокочастотных и мощных приложений. SIT - это нормально разомкнутый (НЕТ) переключатель. Когда сигнал не подается, SIT включается; когда применяется отрицательное смещение, SIT выключается. В практическом применении нормально разомкнутый выключатель не так безопасен, как нормально замкнутый. Кроме того, сопротивление SIT во включенном состоянии велико, и потери во включенном состоянии также велики, поэтому SIT не может широко использоваться как силовой МОП-транзистор. SIT в основном используется в области радиолокационного оборудования связи, усиления ультразвуковой мощности, усиления импульсной мощности и высокочастотного индукционного нагрева.
3- Статический Индукционный тиристор
Статический индукционный тиристор (SITH) представляет собой биполярный управляемый полем тиристор (FCT). Многие характеристики SITH аналогичны GTO. SITH обладает преимуществами эффекта модуляции проводимости, низкого напряжения в рабочем состоянии и большой емкости по току. Скорость переключения SITH намного выше, чем у GTO, а коэффициент усиления при отключении тока меньше, чем у GTO. SITH имеет как нормально открытый, так и нормально закрытый типы.
4- Встроенный тиристор с коммутацией затвора
Встроенный тиристор с коммутацией затвора (IGCT или GCT) сочетает в себе преимущества IGBT и GTO. Его мощность эквивалентна GTO, а скорость переключения в 10 раз выше, чем у GTO. IGCT не нуждается в сложной буферной схеме, но его движущая сила все еще очень велика. Как IGCT, так и IGBT могут заменить GTO в области высокой мощности.
§6. Как выбрать силовые электронные устройства
6.1 Общие Силовые Электронные Устройства
1)Неуправляемое Устройство
● Диод общего назначения (GPD)
Преимущества: Высокое пиковое напряжение обратного напряжения, низкое падение прямого напряжения, сильная способность к выпрямлению.
Недостатки: Длительное время обратного восстановления и низкая рабочая частота.
● Диод быстрого восстановления (FRD)
Преимущества: Короткое время обратного восстановления, высокая рабочая частота, низкое падение прямого напряжения и высокое пиковое обратное напряжение.
Недостатки: Слабая ректификационная способность.
● Барьерный диод Шоттки (SBD)
Преимущества: Чрезвычайно короткое время обратного восстановления, чрезвычайно высокая рабочая частота и чрезвычайно низкое падение прямого напряжения.
Недостатки: Нормальная способность к выпрямлению, низкое пиковое обратное напряжение, высокая температурная чувствительность и большой ток утечки.
2)Полууправляемое устройство
● Тиристор с быстрой коммутацией (FST)
Преимущества: Короткое время переключения, высокая рабочая частота, высокий допуск dv/dt и di/dt.
Недостатки: Низкое номинальное напряжение и низкий номинальный ток.
● Триодный переключатель переменного тока (СИМИСТОР)
Преимущества: Обратная характеристика такая же, как и прямая характеристика, и она может работать в цепи переменного тока.
Недостатки: Отсутствие возможности обратной блокировки.
● Тиристор с обратной проводимостью (RCT)
Преимущества: Низкое напряжение в режиме включения, короткое время выключения, рабочая частота, значительно превышающая FST, высокая номинальная температура перехода, высокая емкость напряжения, встроенный силовой диод, который может упростить конструкцию схемы.
● Тиристор со световым срабатыванием (LTT)
Преимущества: Оптический запуск может обеспечить хорошую изоляцию между схемой управления и основной цепью, сильную способность к защите от электромагнитных помех, очень большую емкость по току и очень большую емкость по напряжению. В настоящее время это силовое электронное устройство с самой высокой мощностью.
Недостатки: Рабочая частота, как правило, невелика.
3)Полностью контролируемое Устройство
● Тиристор отключения затвора (GTO)
Преимущества: Большая емкость по напряжению, большая емкость по току, подходит для мощных применений, с эффектом модуляции проводимости, низким коэффициентом усиления при отключении тока и хорошей термостойкостью.
Недостатки: Низкая скорость переключения, большой ток отключения импульса отрицательного затвора, большая мощность возбуждения и сложная схема возбуждения.
Примечания: GTO является первым выбором для высокой мощности (уровень мегаватт), высокого напряжения и низкой частоты переключения.
● Гигантский транзистор (GTR)
Преимущества: Большая емкость по напряжению, большая емкость по току, подходит для применений средней мощности, хорошие характеристики переключения, низкое падение напряжения насыщения.
Недостатки: Низкая скорость переключения, привод по току, большая мощность привода, сложная схема привода, вторая поломка, более высокая цена, чем IGBT.
Примечания: С увеличением мощности IGBT GTR постепенно сойдет со сцены истории.
● Силовой МОП-транзистор
Преимущества: Высокая скорость переключения, высокое входное сопротивление, хорошая термостойкость, низкая мощность привода, простая схема привода, высокая рабочая частота и отсутствие второго пробоя.
Недостатки: Малая токовая емкость, низкое выдерживаемое напряжение, как правило, подходит только для питания электронных устройств мощностью не более 10 кВт.
Примечания: Силовой МОП-транзистор является первым выбором для малой и средней мощности, низкого напряжения и высокой частоты переключения.
● Биполярный транзистор с изолированным затвором (IGBT)
Преимущества: Высокая скорость переключения, низкие потери при переключении, способность выдерживать воздействие импульсного тока, низкое падение напряжения во включенном состоянии, высокое входное сопротивление, управление напряжением, низкая мощность привода, отсутствие второго пробоя.
Недостатки: Скорость переключения ниже, чем у силового МОП-транзистора, пропускная способность по напряжению и току не так хороша, как у GTO.
Примечания: IGBT - это первый выбор для средней мощности, высокого напряжения и низкой частоты переключения.
● Тиристор с МОП-управлением (MCT)
Преимущества: Способен выдерживать чрезвычайно высокие значения di / dt и dv / dt, чрезвычайно высокую скорость переключения, низкое падение напряжения проводимости, небольшие потери при переключении, высокую емкость по напряжению и высокую пропускную способность по току.
Недостатки: Емкость по напряжению и току меньше, чем у IGBT, но стоимость выше, чем у IGBT.
● Статический индукционный транзистор (SIT)
Преимущества: Рабочая частота больше, чем у силового МОП-транзистора, а мощность больше, чем у силового МОП-транзистора.
Недостатки: Нормально разомкнутый, большое сопротивление в рабочем состоянии, большие потери в рабочем состоянии.
● Статический индукционный тиристор (SITH)
Преимущества: Эффект модуляции проводимости, низкое падение напряжения во включенном состоянии, большая пропускная способность по току, скорость переключения выше, чем у GTO, а коэффициент усиления при отключении тока меньше, чем у GTO.
Недостатки: В основном нормально открыты.
● Встроенный тиристор с коммутацией затвора (IGCT)
Преимущества: Мощность эквивалентна GTO, скорость переключения в 10 раз выше, чем у GTO, и не требуется сложной буферной схемы.
Недостатки: Высокая движущая сила.
Disadvantages: High driving power.
6.2 Силовой модуль
В предыдущих главах упоминалось, что все больше и больше мощных электронных устройств начали модульизироваться. Модульность относится к упаковке нескольких устройств в модуль для снижения стоимости изготовления устройства и уменьшения объема устройства. В то же время, поскольку модульность уменьшает количество выводов в цепи, конструкция схемы упрощается, а индуктивность цепи также значительно снижается, что снижает потребность в цепях защиты и буферных цепях и дополнительно упрощает конструкцию схемы, делая схему более надежной.
Общие силовые модули включают твердотельные тиристорные модули, твердотельные силовые диодные выпрямительные модули, твердотельные полностью управляемые мостовые выпрямительные модули и твердотельные полууправляемые мостовые выпрямительные модули. Вы можете перейти на страницу продукта, чтобы получить более подробную информацию о модуле питания.
§7. Как пользоваться силовыми электронными устройствами
7.1 Введение в Силовую электронную систему

Силовые электронные устройства нельзя использовать напрямую, и сначала необходимо создать силовую электронную систему (PES). Силовая электронная система состоит из основной схемы, схемы управления, схемы привода, схемы обнаружения и схемы защиты.
Основная схема: Она используется для реализации изменения или управления электрической энергией. Силовые электронные устройства являются основными компонентами основной схемы.
Схема управления: Используется для подачи управляющих сигналов в схему привода.
Схема привода: Используется для преобразования управляющего сигнала схемы управления в управляющий сигнал для основной схемы.
Схема обнаружения: Используется для определения рабочего состояния основной цепи и передачи его обратно в схему управления.
Схема защиты: Используется для защиты цепи управления и основной цепи для обеспечения надежной работы всей системы.
Электрическая изоляция: Используется для изоляции цепи управления (малый ток) от основной цепи (большой ток).
Как наиболее распространенное силовое электронное устройство, внутренняя структура твердотельного реле представляет собой базовую силовую электронную систему (принцип работы твердотельных реле переменного тока с пересечением нуля).
7.2 Как управлять силовыми электронными устройствами
Схема привода является интерфейсом между основной схемой и схемой управления и используется для преобразования управляющего сигнала схемы управления в сигнал включения или сигнал выключения для основной схемы. Для устройств с половинным управлением схема привода должна подавать только сигнал включения. Для полностью управляемых устройств схема привода должна обеспечивать сигнал включения и сигнал выключения. При проектировании схемы привода необходимо учитывать множество факторов, чтобы силовые электронные устройства работали в идеальном состоянии. Хорошая схема возбуждения может эффективно сократить время переключения и потребляемую мощность силовых электронных устройств и в то же время может обеспечить эффективность работы, безопасность и надежность силовых электронных устройств.
В зависимости от типа управляющего сигнала схема привода может быть разделена на схему, управляемую током, и схему, управляемую напряжением. Схема управления током может выдавать сигнал управления током и пороговое напряжение для устройства, управляемого током; схема управления напряжением может выдавать сигнал управления напряжением для устройства, управляемого напряжением. Схему, управляемую напряжением, легче спроектировать и изготовить, чем схему, управляемую током, поэтому устройства, управляемые напряжением, пользуются большей популярностью. Схема привода также может быть разделена на дискретную схему привода и интегрированную схему привода. Схема дискретного привода должна быть разработана отдельно для различных силовых электронных устройств, а также необходимо учитывать такие вопросы, как согласование параметров и электромагнитная совместимость. Поэтому для достижения наилучшей производительности силового электронного устройства обычно предпочтительна встроенная схема привода, специально разработанная производителем устройства.
Поскольку схема управления обычно формируется информационными электронными устройствами с очень низкой рабочей мощностью, а мощность основной цепи очень велика, схема привода также должна обеспечивать электрическую изоляцию между схемой управления и основной цепью, чтобы предотвратить повреждение цепи управления сигналом от основной цепи. Метод изоляции обычно можно разделить на оптическую изоляцию и изоляцию трансформатора (магнитную изоляцию).
1- Оптическая Изоляция

Оптическая изоляция относится к передаче управляющего сигнала в основную цепь через свет. Как правило, для оптической изоляции используется фотосоединитель (оптрон, OPT), а светоизлучающий диод (LED) в оптроне управляет фототранзистором посредством оптических сигналов. Входной ток ID фотосоединителя эквивалентен базовому току общего транзистора, а выходной ток IC эквивалентен коллекторному току общего транзистора. Входные и выходные характеристики оптронов аналогичны характеристикам BJT. Коэффициент усиления по току ID/IC обычных оптронов обычно меньше 1. Оптроны с высоким коэффициентом передачи будут использовать структуру Дарлингтона для увеличения коэффициента усиления по току, но выдерживаемое напряжение оптрона ограничено (обычно в пределах 2000 В). Тиристор, срабатывающий от света, передает управляющий сигнал по оптическому волокну, поэтому нет необходимости добавлять дополнительные меры оптической изоляции. В то же время тиристор со световым срабатыванием является наполовину управляемым устройством, поэтому нет необходимости думать о том, как его отключить.
2- Изоляция трансформатора

Изоляция трансформатора относится к изоляции первичной обмотки и вторичной обмотки через железный сердечник импульсного трансформатора и использованию характеристик магнитного насыщения железного сердечника для передачи управляющего сигнала от входной цепи к выходной цепи. Из-за характеристик нелинейных искажений трансформаторов импульсные трансформаторы, как правило, подходят для высокочастотных сигналов, поэтому необходимо также учитывать нагрев и потери. Поскольку импульсный трансформатор обычно работает при начальной проницаемости сердечника, объем импульсного трансформатора будет намного больше, чем у других трансформаторов.
7.2.1 Схема привода полууправляемого устройства

1- Требования к включению
● Обеспечьте определенную длительность импульса (время поддержания импульса), чтобы можно было установить внутреннюю положительную обратную связь тиристора для обеспечения надежной проводимости тиристора.
● Обеспечьте определенную амплитуду плоской вершины импульса, чтобы обеспечить достаточный ток возбуждения, и в то же время избегайте появления заусенцев, которые мешают нормальной работе тиристора.
° Убедитесь, что напряжение затвора, ток затвора и мощность затвора находятся в пределах номинальной зоны срабатывания, чтобы избежать повреждения ЭКРАНА.
● Обеспечьте необходимые защитные меры, такие как электрическая изоляция, контроль температуры, защита от помех и т.д.
2- Общая Схема Привода
● Если мощность нагрузки велика, в качестве устройства электрической изоляции можно использовать импульсный трансформатор (PTR), как показано на рисунке 61, a. Для получения импульсного тока затвора с достаточно большой амплитудой, достаточно большой длительностью и кратчайшим возможным временем нарастания тока к входной стороне импульсного трансформатора (PTR) обычно добавляется транзисторный усилитель (TRA).
● Если мощность нагрузки невелика, в качестве устройства электрической изоляции можно использовать оптопару (OPT), как показано на рисунке 61, b.
7.2.2 Схема привода для устройства полного управления (Привод тока)
Параметры полностью управляемых силовых электронных устройств различны, поэтому их схемы привода также различны. Как правило, схема привода типа привода тока обычно более сложна, чем схема привода типа напряжения. Как правило, рекомендуется напрямую использовать встроенную схему привода, предоставленную производителем, чтобы максимально повысить производительность силовых электронных устройств.
7.2.2.1 Схема привода GTO

1- Требования к включению
● То же, что и у тиристора.
2- Требования к отключению
● Для ускорения процесса выключения GTO необходимо обеспечить ток отключения (обеспечиваемый схемой обратного смещения затвора), намного превышающий ток включения.
3- Общая Схема Привода
Схема привода GTO обычно включает в себя схему привода включения, схему привода выключения и схему обратного смещения затвора. И схема привода GTO может быть разделена на тип связи импульсного трансформатора и тип прямой связи. Общая схема дискретного привода GTO показана на рисунке 62:
● Схема привода связи импульсного трансформатора показана на рисунке 62, а. Импульсный трансформатор обеспечивает электрическую изоляцию. А импульсный сигнал на вторичной обмотке импульсного трансформатора непосредственно приводит в действие GTO. Однако импульсный трансформатор имеет индуктивность утечки, что повлияет на скорость переключения GTO, а также приведет к невозможности формирования крутого фронта импульса. Схема прямого соединения может избежать этой проблемы.
● Схема привода с прямым соединением показана на рисунке 62, b. Схема изоляции (трансформатор или оптрон) обеспечивает электрическую изоляцию; VD1 и C1 обеспечивают напряжение +5 В; VD2, VD3, C2, C3 образуют схему выпрямителя с удвоением напряжения, обеспечивающую напряжение +15 В; VD4 и C4 обеспечивают напряжение -15 В. Когда V1 включен, он выдает сильный положительный импульс. Когда V2 включен, он выдает плоскую верхнюю часть положительного импульса. Когда V2 выключен, а V3 включен, он выдает отрицательный импульс. Когда V3 выключен, R3 и R4 обеспечивают отрицательное напряжение смещения затвора. Схема привода с прямой связью позволяет избежать взаимных помех и паразитных колебаний внутри схемы и может обеспечить относительно крутой фронт импульса, но ее конструкция сложна, энергопотребление велико, а эффективность низкая. Однако, учитывая комплексные факторы, схема привода с прямым соединением по-прежнему имеет широкий спектр применений.
7.2.2.2 Схема привода ГТП

1- Требования к включению
● То же, что и у тиристора.
2- Требования к отключению
● Необходимо приложить определенный отрицательный базовый ток, чтобы уменьшить время отключения и потери при отключении.
● Необходимо приложить отрицательное смещение определенной амплитуды (около 6 В) между базой и излучателем, чтобы сделать отключение GTR более надежным.
3- Общая Схема Привода
Общая схема дискретного привода GTR показана на рисунке 63. Схема транзисторного усилителя находится между основной схемой и оптроном, который в основном состоит из транзисторного усилителя. Основная цепь находится при низком потенциале, когда она включена, и при высоком потенциале, когда она выключена. Следовательно, схема транзисторного усилителя должна питаться отдельно и электрически изолироваться от источника питания основной цепи, чтобы избежать влияния потенциальных колебаний основной цепи на работу схемы усилителя.
Когда нагрузка невелика, если весь ток эмиттера V4 вводится в GTR, это приведет к перенасыщению GTR, и время его насыщения увеличится, когда он будет выключен. Поэтому силовой диод зажима VD2 и силовой диод компенсации потенциала VD3 обычно добавляются для формирования схемы защиты от насыщения зажима Бейкера. Когда GTR перенасыщен, потенциал коллектора ниже базового потенциала, VD2 автоматически включается, так что избыточный ток возбуждения поступает в коллектор, поддерживая Ubc≈0. С помощью схемы Бейкера GTR находится в критическом состоянии насыщения, когда он включен, и его легко отключить.
Ускоряющий конденсатор C2 используется для ускорения процесса переключения GTR. Когда GTR включен, R4 замыкается на C2, что приводит к превышению тока возбуждения и в то же время увеличивает крутизну фронта импульса для ускорения процесса включения. Когда V4 включен, C2 будет заряжен для подготовки к выключению GTR, и его полярность зарядки слева положительная, а справа отрицательная. Когда V4 выключен, а V5 включен, напряжение зарядки на C2 обеспечивает обратное напряжение для эмиттерного перехода GTR, так что GTR будет быстро отключен.
Прямая характеристика однонаправленного силового диода подавления переходного напряжения TVS такая же, как у обычного силового диода со стабилизированным напряжением, а его обратная характеристика представляет собой типичное лавинное устройство с PN-переходом. Преимущества TVS заключаются в быстром времени отклика, большой переходной мощности, низком токе утечки, небольших размерах и простоте управления напряжением зажима. Телевизоры также могут эффективно поглощать импульсы перенапряжения и устранять перекрестные помехи. Когда на оба конца TVS подается импульс переходного перенапряжения, его импеданс меняется с высокого импеданса на низкий импеданс в течение нескольких пикосекунд, чтобы поглотить до нескольких киловатт импульсной мощности и снизить напряжение на обоих концах до заданного значения.
7.2.3 Схема привода для Устройства полного управления (преобразователя напряжения)

1- Требования к включению
● Необходимо обеспечить стабильное напряжение привода при включении: для MOSFET обычно составляет 10-15 В; для IGBT обычно составляет 15-20 В.
● Выходное сопротивление цепи привода должно быть достаточно малым (от десятков до сотен Ом), чтобы быстро установить напряжение привода.
● Резистор с низким сопротивлением (десятки Ом) должен быть подключен последовательно к затвору, чтобы потреблять энергию обратной связи, уменьшать коэффициент усиления схемы усилителя и уменьшать паразитные колебания.
2- Требования к отключению
● Необходимо подавать определенную амплитуду отрицательного управляющего напряжения (обычно 5-15 В), чтобы сократить время отключения и потери при отключении, а также повысить надежность отключения.
3- Общая Схема Привода
Аналогично схеме возбуждения GTR, схема возбуждения напряжения также включает в себя схему электрической изоляции и схему усиления на транзисторах, как показано на рисунке 64. Однако схема привода напряжения должна обеспечивать только сигнал привода напряжения, поэтому ее конструкция намного проще, чем у GTR.
* Паразитные Колебания
Паразитные колебания относятся к колебаниям, которые генерируются внутренними паразитными параметрами транзисторного усилителя, которые не имеют ничего общего с рабочей частотой или не находятся в диапазоне рабочих частот. Паразитные колебания можно разделить на низкочастотные паразитные колебания (ниже рабочей частоты) и высокочастотные паразитные колебания (выше рабочей частоты). Даже если входная клемма транзисторного усилителя закорочена, на выходной клемме обычно присутствует колебательный сигнал. Но при правильном обращении паразитные колебания могут быть полностью устранены. Паразитное колебание имеет следующие характеристики:
● Период колебаний паразитных колебаний, как правило, регулярный, а форма волны относительно регулярная.
● Амплитуда паразитных колебаний, как правило, велика, и иногда это может даже вызвать включение и выключение силовых электронных устройств.
● За исключением низкочастотных колебаний, вызванных плохой развязкой источника питания, частота колебаний паразитных колебаний, как правило, высока, а частота и амплитуда колебаний будут варьироваться в зависимости от параметров компонентов транзисторного усилителя.
7.3 Как защитить силовые электронные устройства
Схема защиты может обеспечить безопасную и надежную рабочую среду для силовых электронных устройств. Причины повреждения силовых электронных устройств в основном делятся на перегрузку по току и перенапряжение. В случае перегрузки по току внутренняя структура силовых электронных устройств будет разрушена из-за резкого повышения температуры. Перенапряжение обычно сопровождается перегрузкой по току, что также может привести к повреждению внутренней структуры силовых электронных устройств. Из-за сложности схемы и соображений безопасности обычно не принимается единая мера защиты, но обеспечивается максимально возможная защита схемы в пределах диапазона затрат.
7.3.1 Защита От Перенапряжения

1- Источник перенапряжения в силовых электронных устройствах
1.1- Внешнее перенапряжение (в основном от ударов молнии и процесса работы системы)
● Грозовое перенапряжение: Перенапряжение, вызванное молнией.
● Рабочее перенапряжение: Во время размыкания и замыкания верхней цепи возникает перенапряжение, вызванное индуктивностью утечки трансформатора в электросети.
1.2- Внутреннее перенапряжение (в основном возникает в результате процесса переключения силовых электронных устройств)
● Перенапряжение при отключении: Когда силовое электронное устройство выключено, индуктивность цепи вызывает перенапряжение на обоих концах устройства из-за быстрого уменьшения прямого тока.
● Коммутационное перенапряжение: После коммутации двунаправленного тиристора или антипараллельного силового диода его обратный ток резко уменьшается, поэтому линейная индуктивность будет генерировать перенапряжение на обоих концах устройства. Коммутация означает, что двунаправленное устройство с центрально-симметричными выходными характеристиками переключается назад и вперед между рабочими состояниями первого квадранта и третьего квадранта. Процесс коммутации неизбежно сопровождает включение и выключение силовых электронных устройств, поэтому во время процесса коммутации должно быть отключающее перенапряжение.
2- Общие Меры Защиты От Перенапряжения
● Молниеотвод F: Он используется для передачи грозового перенапряжения на землю. Разрядник молнии, как правило, представляет собой разрядник из оксида цинка, который имеет те же характеристики, что и варистор.
● Электростатический защитный слой трансформатора D: Он используется для передачи высоковольтного статического электричества на землю.
● Конденсатор подавления C: Он используется для подавления перенапряжения. Однако напряжение, поглощаемое конденсатором, будет генерировать больший ток разряда во время процесса разряда.
● Варистор RV: Значение сопротивления варистора уменьшается с увеличением напряжения, поэтому он передает перенапряжение в другую цепь или на землю.
● Схема защиты RC1: Схема RC добавляет резистор R на основе подавляющего конденсатора C. Хотя его способность поглощать перенапряжение невелика, он может эффективно подавлять ток разряда во время разряда конденсатора.
● Схема защиты RC2: Перенапряжение внешней цепи неизбежно приведет к постоянному напряжению цепи RC2, поэтому конденсатор C должен иметь две разрядные цепи для поглощения этих двух напряжений через сопротивление, чтобы оставить достаточное запасное значение для борьбы со следующим перенапряжением.
● Схема защиты RC3: Используется для подавления коммутационного перенапряжения.
● Схема защиты от УЗО: используется для подавления перенапряжения при отключении.
7.3.2 Защита От Перегрузки по Току

1- Источник перегрузки по току в силовых электронных устройствах
1.1- Перегрузка по току: Это означает, что стабильный рабочий ток превышает 120% от номинального значения. высокое напряжение, что поставит под угрозу безопасность операторов и оборудования.
1.2- Перегрузка по току короткого замыкания: Это относится к току, который имеет короткую продолжительность и в несколько раз превышает номинальный ток.
2- Общие Меры Защиты От Перенапряжения
● Трансформатор тока CT: Это специальный трансформатор для измерения. Он состоит из замкнутой колонны с железным сердечником и двух взаимно изолированных катушек, обшитых железным сердечником. Катушка, подключенная к измеряемой линии, является первичной стороной CT. Катушка, подключенная к цепи обнаружения, является вторичной стороной CT. Первичная сторона и вторичная сторона CT электрически изолированы друг от друга. Основная функция CT заключается в преобразовании тока тестируемой цепи в диапазон тока, который может обнаружить схема обнаружения. При использовании трансформатора тока необходимо избегать разомкнутой цепи на вторичной стороне трансформатора тока, поскольку разомкнутая цепь на вторичной стороне приведет к тому, что трансформатор тока потеряет эффект размагничивания вторичной обмотки. Следовательно, ток первичной обмотки полностью формирует ток возбуждения, который увеличивает магнитный поток в железном сердечнике, перенасыщая железо, что в конечном итоге приводит к нагреву и повреждению трансформатора тока. В то же время, если вторичная обмотка имеет большое количество витков, будет индуцироваться высокое напряжение, что поставит под угрозу безопасность операторов и оборудования.
● Реле перегрузки по току KA: При обнаружении перегрузки по току в цепи начинает действовать реле перегрузки по току, в результате чего автоматический выключатель переменного тока QF1 размыкается. Процесс действия реле перегрузки по току относительно длительный, но оно может непосредственно отключить источник питания оборудования, чтобы избежать последующего повреждения оператора и оборудования.
● Быстрый автоматический выключатель постоянного тока QF2: Быстрый автоматический выключатель постоянного тока использует сильную электрическую силу отталкивания при коротком замыкании для непосредственного размыкания контактов с очень коротким временем действия (2-3 миллисекунды), так что ток короткого замыкания будет отключен до достижения максимального значения. Автоматический выключатель постоянного тока также оснащен дугогасительной камерой, поэтому он обладает хорошими характеристиками ограничения тока.
● Быстрый предохранитель FU: Методы защиты быстрого предохранителя можно разделить на защиту от короткого замыкания и полную защиту (защита от перегрузки и защита от короткого замыкания). Быстродействующий предохранитель не подходит для защиты высокочастотных устройств (таких как IGBT и MOSFET). Быстродействующий предохранитель обычно подходит только для защиты тиристора, поскольку тиристор обладает высокой способностью выдерживать ток, и как тиристор, так и быстродействующий предохранитель имеют характеристики второго ампера (соотношение между значением перегрузки по току и максимальным временем выдерживания перегрузки по току). Таким образом, легко выбрать соответствующий быстродействующий предохранитель на основе характеристик второго ампера тиристора, чтобы гарантировать, что быстрый предохранитель отключит выходную цепь тиристора до того, как тиристор будет поврежден. Быстрый предохранитель - это одноразовое устройство, если оно перегорело, быстрый предохранитель должен быть заменен на тот же по спецификации.
● Электронная схема защиты: Электронная схема защиты в основном используется для отключения триггерной цепи, чтобы полностью управляемое устройство во включенном состоянии переключалось в выключенное состояние с высоким сопротивлением, чтобы другие устройства силовой электроники не включались и поддерживали выключенное состояние. Этот метод недопустим для включенного устройства с полууправляемым управлением. По сравнению с быстродействующим предохранителем стоимость электронной схемы защиты очень низкая, а скорость действия очень высокая, поэтому электронная схема защиты может эффективно защищать электронные устройства средней и высокой частоты. Электронная схема защиты, как правило, встроена непосредственно в схему привода.
7.3.3 Контур Демпфера

Схема демпфирования (также известная как схема поглощения или буферная схема) подавляет скорость нарастания тока (di / dt) силового электронного устройства, используя характеристику, согласно которой ток катушки индуктивности не может внезапно измениться, и подавляет скорость нарастания напряжения (dv / dt) силового электронного устройства, используя характеристика, заключающаяся в том, что напряжение конденсатора не может внезапно измениться. Самая базовая буферная схема RLCD показана на рисунке 67, a. Когда устройство включено, индуктивность L подавляет di/dt; когда устройство выключено, конденсатор C заряжается через быстродействующий силовой диод VD для поглощения перенапряжения, возникающего на устройстве, и ограничения повторно применяемого dv/dt. Когда устройство включено, энергия на C потребляется резистором R. Чтобы уменьшить потери мощности устройства с высокой рабочей частотой и малой емкостью, схема ограничителя RLCD может быть упрощена до схемы ограничителя RCD, как показано на рисунке 67, b.
В соответствии с назначением энергии контур демпфирования можно разделить на контур демпфирования, потребляющий энергию, и контур демпфирования, питающий энергию. Энергопотребляющий демпфер потребляет избыточную энергию с помощью резисторов. Схема подавления энергии не имеет резистора и будет использовать избыточную энергию.
В соответствии с приложением схема демпфирования может быть разделена на схему включения демпфирования (схема подавления di / dt), схему отключения демпфирования (схема подавления dv / dt) и составную схему демпфирования (комбинация схемы включения демпфирования и схемы отключения демпфирования). Схема демпфирования включения используется для подавления превышения тока, а di/dt - для уменьшения потерь при включении электронного устройства питания. Схема отключения демпфера используется для поглощения перенапряжения, создаваемого индуктивностью линии, и подавления dv / dt для уменьшения потерь при отключении силового электронного устройства. Электронное устройство с текущим питанием имеет высокий допуск di / dt и высокий допуск по току, поэтому обычно нет необходимости добавлять дополнительную буферную схему включения.
Полностью управляемое самозапирающееся устройство (такое как GTR и GTO) должно использовать составные схемы демпфирования. Схема демпфирования включения GTR используется для подавления di/dt во время процесса включения, чтобы избежать перегрева и второй поломки. Он также играет определенную роль в подавлении di / dt и пикового тока короткого замыкания в преобразователе GTR. Схема отключения демпфера GTO предназначена не только для ограничения dv / dt и перенапряжения повторно подаваемого напряжения при выключении GTO, но и для уменьшения потерь при отключении GTO, чтобы GTO выполнял свои функции при отключении и полностью воспроизводил к его грузоподъемности. Функция схемы демпфирования IGBT в большей степени фокусируется на поглощении и подавлении перенапряжения во время процесса переключения. Это связано с тем, что рабочая частота IGBT очень высока, поэтому даже небольшая индуктивность цепи создает высокий di / dt, что приводит к перенапряжению и ставит под угрозу безопасность IGBT. Силовой МОП-транзистор использует схему демпфирования для подавления di / dt и dv / dt, главным образом для изменения траектории процесса переключения устройства, уменьшения потерь при переключении и обеспечения надежной работы устройства.

Свяжитесь с нами сейчас!
Пожалуйста, найдите минутку, чтобы заполнить эту форму, чтобы получить ответ в течение 24 часов, спасибо!
*Пожалуйста, проверьте корзину вашего почтового ящика, если вы не получили наше письмо.



