
功率电子器件介绍
固态继电器和固态模块的工作与其内部的功率电子器件密不可分,因此有必要介绍一些功率电子器件的基本知识。通过本文,您将了解什么是功率电子器件?它们是如何工作的?它们的基本特征是什么?如何使用它们?
您可以通过下面的目录和浏览器右侧的快速导航器快速导航到您感兴趣的章节。
目录
§1. 什么是功率电子器件? |
§2. 什么是不可控器件? |
§3. 什么是晶体管? |
§4. 什么是半控型器件? |
§5. 什么是全控型器件? |
§6. 如何选择功率电子器件? |
§7. 如何使用功率电子器件? |
§1. 什么是功率电子器件?
在功率设备或功率系统中,主电路用于实现电能的变化或控制,功率电子器件(PED)是主电路的核心。在功率设备或功率系统中,主电路用于实现电能的变化或控制,功率电子器件(PED)是主电路的核心。由于功率半导体器件在成本和性能上具有明显的优势,它们已逐渐取代了功率真空器件的地位,因此现在所谓的功率电子器件通常是指以硅为主要材料的功率半导体器件。
与同样使用硅作为主要材料的信息半导体器件(或信息电子器件,IED)相比,功率电子器件具有以下特点:
● 功率电子器件的功率处理能力较大,但由于功率损耗大,需要配备散热器进行冷却。
● 功率电子设备往往需要信息电子设备提供控制信号。
● 功率电子器件一般工作在开关状态,而不是放大状态,以降低其功耗。
由于半导体的特性,功率电子器件在运行过程中不可避免地会产生一定的功率损耗。这些功率损耗不仅会降低电能的转换效率,还会因过热而对功率电子器件造成永久性损坏。功率电子器件的主要损耗可分为通态损耗、断态损耗和开关损耗。通态损耗是通态电压降引起的损耗,如果功率电子器件的开关频率不高,通态损耗在总损耗中将占很高的比例。断态损耗是由断态电流引起的损耗,而断态损耗通常占总损耗的比例很小,往往被忽略不计。开关损耗是指功率电子器件在开关过程中产生的损耗,开关损耗受开关频率的影响很大, 也就是说,开关频率越高,开关损耗在总损耗中的比例越大。

由于所用材料和结构的差异,不同类型的功率电子器件的性能可能完全不同。因此,在选择功率电子器件之前,首先我们必须了解它们的类别和特点,才能充分发挥其优势。
根据受控程度,功率电子设备可分为不可控型,半控型和全控型。
根据驱动电路的有效触发信号,功率电子器件可分为脉冲触发型和电平触发型。脉冲触发是指功率电子器件的工作状态由短脉冲信号触发,如SCR、GTO。电平触发是指通过将输入信号保持在特定电平来触发功率电子器件的工作状态,如GTR、MOSFET、IGBT。简而言之,电平触发的持续时间较长,而脉冲触发的持续时间较短。
根据参与传导过程的载流子,功率电子器件可分为单极型和双极型。当单极型器件工作时,只有一种类型的载流子(自由电子或空穴)参与传导过程,例如MOSFET、JFET、SIT。当双极型器件工作时,自由电子和空穴共同参与传导过程,如晶闸管、GTO、GTR、IGBT、SITH、TRIAC、RCT、LTT。
根据驱动电路信号,功率电子器件可分为电流驱动型和电压驱动型。电流驱动型器件的工作状态受输入电流控制,如晶闸管,GTO,GTR。电压驱动型器件的工作状态受输入电压所产生的电场效应控制,如MOSFET,JFET,IGBT。电压驱动型器件多为单极型,电流驱动型器件多为双极型。电压驱动型器件通常具有输入阻抗高,驱动功率低,驱动电路简单,工作频率高等特点。电流驱动型器件通常具有电导调制效应,因此通态压降和通态损耗小,但工作频率低,所需驱动功率大,且驱动电路较复杂。
§2. 什么是不可控器件?
2.1 不可控器件介绍
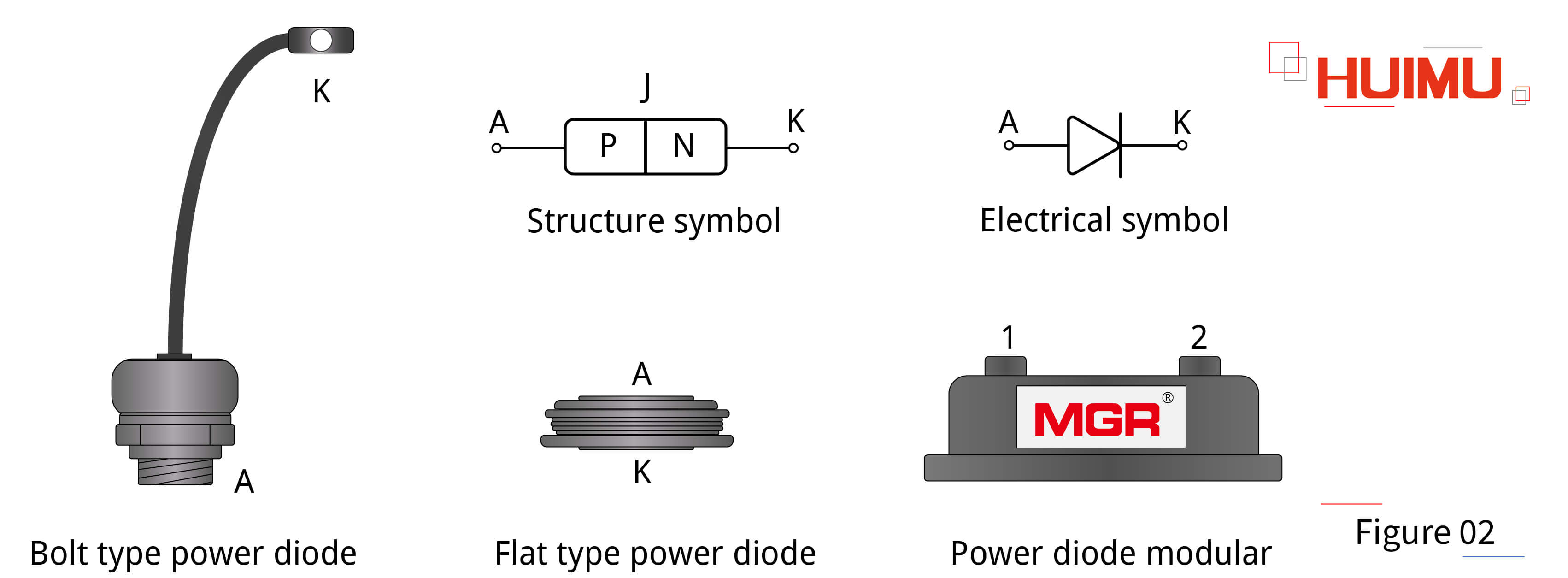
不可控器件是指不能通过控制信号来开启和关闭的器件,因此不需要驱动电路。不可控器件一般指功率二极管,其基本结构和工作原理与二极管非常相似。功率二极管由一个大面积PN结和两端的引线封装而成。按外形,功率二极管可分为螺栓式和扁平式。根据参与传导过程的载流子,功率二极管可分为单极性功率二极管和双极性功率二极管。功率二极管因其结构简单、价格低廉而广泛应用于各个领域的电力设备中。尤其是快恢复二极管和肖特基势垒二极管,在低压、中频、高频场的整流和逆变器中具有不可替代的地位。随着模块化和集成化技术的发展,模块化功率二极管在市场上越来越普遍(点击查看更多功率二极管模块)。
2.2 功率二极管如何工作?
功率二极管本质是由P型半导体和N型半导体接触形成的PN结。因此,要了解功率二极管的工作原理,就必须了解PN结的基本特性和工作原理。
2.2.1 PN结的基本结构

功率二极管由P型半导体和N型半导体组成。N型半导体和P型半导体由掺杂的本征半导体组成,也就是说,N型半导体中自由电子的浓度高,P型半导体中的空穴浓度很高。P型半导体和N型半导体之间的连接区域称为PN结。自由电子和空穴也称为自由载流子(简称载流子)。半导体中自由电子的运动和复合必然会导致空穴的产生和复合。从宏观角度来看,这个过程更像是带负电的自由电子和带正电的空穴同时在半导体中沿相反方向移动。半导体中自由电子和空穴的运动是非常快速和随机的,因此几乎不可能预测某个自由电子或空穴的轨迹并准确地知道它在某个时刻的位置。然而,大量空穴和自由电子的运动并非没有规律。
半导体中的多数载流子会从高浓度区域扩散到低浓度区域,也就是说,N区的多数载流子自由电子(nn)从高浓度N区通过PN结扩散到低浓度P区,并且同时,P区中的多数载流子空穴(pp)从高浓度P区通过PN结扩散到低浓度N区。PN结附近的载流子由于扩散运动而耗尽,只留下不能移动的空间电荷(正离子和负离子),因此该区域称为空间电荷区(又称为耗尽区)。由于空间电荷区没有自由移动的载流子,因此它近似于绝缘体。空间电荷区内的空间电荷会产生一个内建电场以阻止载流子穿过PN结(内建电场会在PN结制造后的几纳秒内形成)。即便如此,仍有极少的载流子穿过PN结成为对面区域的少数载流子,也就是说,自由电子在P区成为少数载流子(pn),空穴在N区成为少数载流子(np)。这种现象称为量子隧穿效应。空间电荷区两侧的载流子浓度差产生了内建电势差(又称为内建电势,或接触电势差)。少数载流子会继续扩散到浓度更低的区域。少数载流子在扩散和复合的过程中所能达到的平均距离称为扩散长度。扩散长度受少数载流子寿命的影响,也就是说,少数载流子的寿命越长,扩散长度就越长。当到达扩散区边缘时,少数载流子会在内建电场的作用下穿过PN结返回到它们原区域。
* 单晶体半导体和多晶体半导体
单晶体半导体是指是指化学成分纯净,不含任何杂质且无晶格缺陷的半导体,即本征半导体,如硅(Si),锗(Ge),砷化镓(GaAs)。单晶体半导体的结构非常规则,其宏观性质上表现为各向异性,即其物理性质在不同方向上都不相同。单晶体半导体为绝大多数半导体器件的制作材料。
多晶体半导体是指由大量取向不同的微小的单晶体半导体颗粒构成的半导体材料。多晶体半导体的结构不具备规则性,且其宏观性质上往往表现为各向同性,即其物理性质在不同方向上都相同。多晶体半导体可用于制作太阳能电池,液晶显示器的窄膜晶体管开关矩阵,及MOSFET的栅极材料等。
* 能带理论

能带理论是一种使用量子力学来研究固体内部电子运动的理论。在以能量为纵坐标的坐标系中,晶体中电子的能量可以用一条水平线(即能级)表示,也就是说,能量越大,线的位置就越高。在一定能量范围内彼此非常接近的能级形成能带。能带中最高能级和最低能级之间的垂直距离称为能带宽度。能带的位置和宽度受温度和晶体类型(如金属、半导体和绝缘体)的影响。半导体的能带如图04(a)所示。
满带:是指T = 0K时,完全被电子占据的能带。满带中的电子是价电子(即被晶体原子上的价键束缚而不能自由移动的电子),因此它没有任何导电性。
空带:是指T = 0K时,未被电子占据的能带。空带中没有电子,因此它没有任何导电性。当其中有电子时,空带变成导带。
导带:是指T > 0K时,未被电子完全占据的能带。导带中的电子是自由电子,因此它具有导电性。
价带:是指T > 0K时,价电子占据的能带。价带中的电子是价电子,因此它没有任何导电性。
禁带:是指价带顶部与导带底部之间的能量范围。禁带中不存在共有化电子(即晶体中被多个原子所共有的电子)的能级,但是存在非共公有化电子(即杂质和缺陷中的局域化电子)的能级。禁带宽度(带隙)反映了价电子的束缚程度或价键的强度,即本征激发所需的最小平均能量。禁带的中间线为费米能级。
常见金属材料一般带隙较窄(导带和价带甚至相互重叠),其电子在室温下容易获得能量并跃迁至导带,因此它们的导电性很强,常用作导体。绝缘材料的带隙一般很宽(通常大于9电子伏特,或9eV),它们的电子很难跃迁到导带,因此它们的导电性很差,常用作绝缘体。半导体材料的带隙介于导体和绝缘体之间(约1-3 eV,例如室温下锗为0.67 eV,硅为1.12 eV),因此通过给予适量的能量激发(破坏价键使价电子跃迁到导带以产生自由电子和空穴)或改变带隙的宽度(减少电子跃迁所需的能量)就能使得半导体导电。
* 本征激发与自由载流子
本征激发是指通过给予一定的激发条件,本征半导体中的电子会从较低能带(满带或价带)越过禁带进入较高能带(空带或导带)并成为自由电子。需要说明的是,本征半导体导带中的自由电子是指固体中近似自由的电子,可以在整个固体中自由移动,但不能跑出固体。由于较低能带中缺少电子,因此形成了带正电的空位,这称为空穴。导带中的自由电子和价带中的空穴统称为电子-空穴对。在本征半导体中,本征激发所产生的自由电子和空穴可以自由移动,所以称为自由载流子,它们的浓度彼此相等,且随着温度的升高,它们的浓度会呈指数增长。自由电子和空穴的定向运动会形成电子流和空穴流。导带中的自由电子会落入空穴中,导致电子-空穴对消失。这个过程称为复合。复合过程中产生的能量以电磁辐射(发射光子)或晶格热振动(发射声子)的形式释放。在一定温度下,电子-空穴对的产生和复合同时存在并达到动态平衡。此时,本征半导体具有一定的载流子浓度,从而具有一定的电导率。通过本征激发,产生更多的电子-空穴对,从而提高载流子浓度,可以有效提高半导体的电导率。根据该原理,可以制造半导体热敏电阻,半导体光敏电阻等半导体器件。常温下本征半导体的电导率较小,载流子浓度对温度变化敏感,因此很难通过温度对其半导体特性进行有效控制。
本征激发的方式通常可分为本征热激发,本征光激发,和碰撞电离本征激发。
本征热激发:是指随着温度的升高,分子的热运动所辐射出的红外光子,使价电子获得足够的能量,摆脱价键的束缚,成为自由电子。本征热激发所需的能量等于带隙。室温下的热激发效率通常非常有限,因为需要非常高的温度才能让足够多的载流子跃迁到导带。
本征光激发:是指光照(一般指可见光或紫外光)所辐射出的光子,使价电子获得足够的能量,摆脱价键束缚,成为自由电子。本征光激发所需的能量大于本征热激发。由于可见光的光子比通常由热运动产生的红外光子具有更高的能量,因此本征光激发后的电子的能级通常位于导带中较高的位置。由于光子的动量可以忽略不计,本征光激发不会改变电子的动量,所以这个过程也称为垂直跃迁。但如果有声子(指晶格的简谐振动)参与,电子的动量会发生变化,所以也称为非垂直跃迁。
碰撞电离本征激发:是指价电子被高能电子(即被电场加速的自由电子)碰撞并发生电离而成为自由电子。碰撞电离本征激发所需要的平均能量大约为禁带宽度的1.5倍。碰撞电离本征激发所产生的电子为电离的电子,是能够离开固体的真正自由的电子,它的能量超过导带中最高能级的自由电子。
* 费米能级与费米-狄拉克分布
费米能级是在任何温度下都有50%几率被电子占据的能级,也就是说,在费米能级以下,距离越远,被电子占据的可能性越大,并且同理,在费米能级以上,距离越远,被电子占据的可能性越小。对于半导体,尤其是本征半导体而言,费米能级位于禁带的中间线。当温度T = 0K时,满带被电子填满(电子占有概率为1),空带完全没有电子(电子占有概率为0),那么它们的费米能级正好在禁带中间线(电子占据概率为1/2)。即使当温度升高T > 0K时,本征激发也会产生电子-空穴对,但由于导带增加的电子数等于价带减少的电子数,因此费米能级仍处于禁带中间线(电子占据概率为1/2)。因此,本征半导体费米能级的位置不随温度变化,始终处于禁带的中间线。电子的费米-狄拉克分布可由费米能级和温度计算出来,如图04(b)所示。
* 半导体掺杂
一般使用本征半导体的时候都会进行掺杂以引入新的能级,以增加其电导率。掺杂后的半导体更容易受外界影响,例如光照,温升。
通过在硅晶体(或锗晶体)中掺杂磷元素(或锑元素),磷原子(或锑原子)会占据硅原子的位置。然后一组全满能级将被添加到禁带中非常接近导带的位置。这些能级上的电子很容易跃迁到导带成为自由电子。因此,磷元素(或锑元素)称为施主杂质(或N型杂质),掺杂有N型杂质的半导体称为N型半导体。
通过在硅晶体(或锗晶体)中掺杂硼元素(或铟元素),硼原子(或铟原子)会占据硅原子的位置。然后一组全空能级将被添加到禁带中非常接近价带的位置。价带中的电子很容易跃迁到这些能级并在价带中留下空穴。因此,硼元素(或铟元素)称为受主杂质(或P型杂质),掺杂有P型杂质的半导体称为P型半导体。
2.2.2 PN结的单向导通性
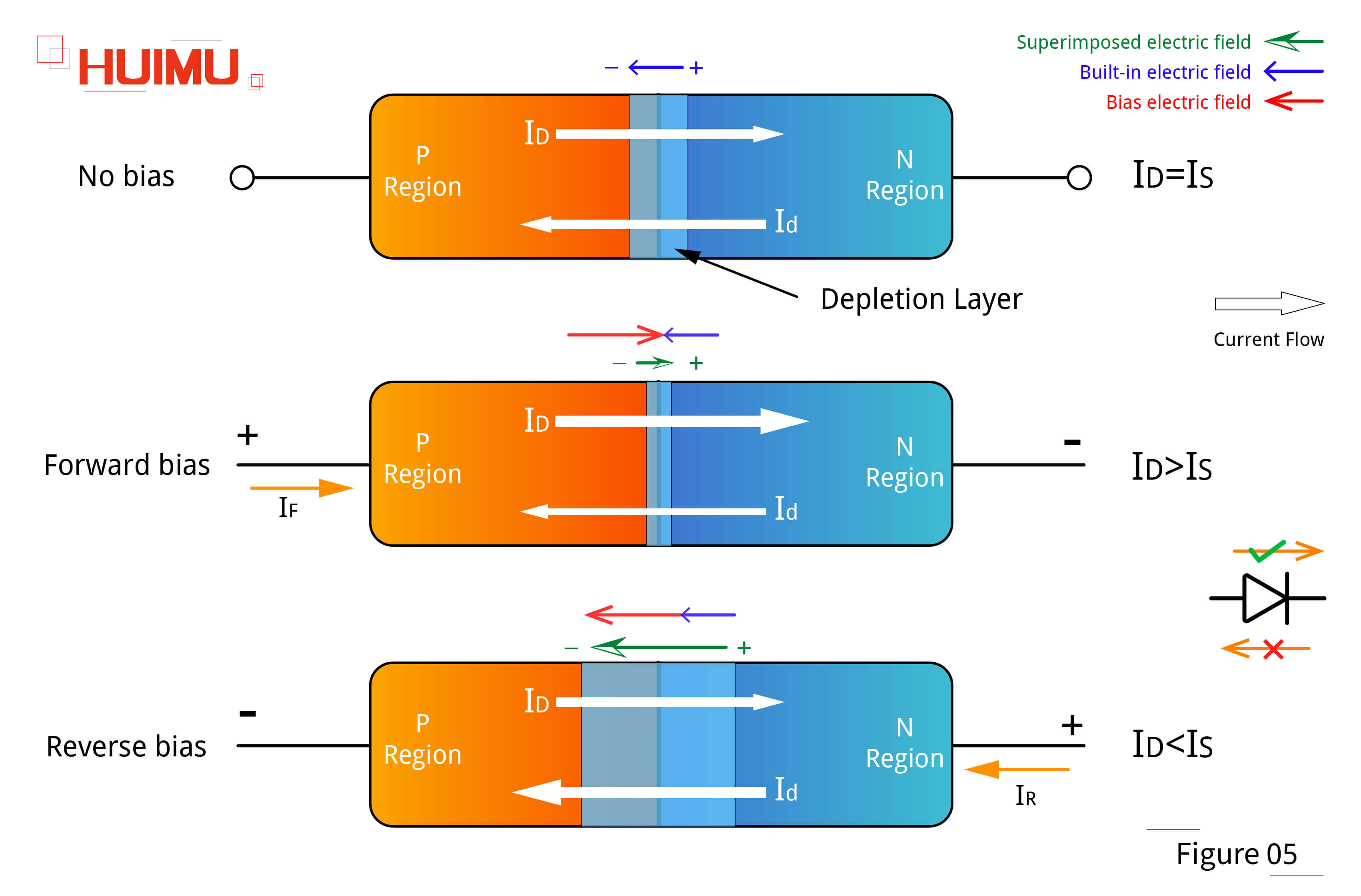
功率二极管工作原理的本质就是PN结的单向导电性。在外部条件恒定的情况下,如温度,辐射等,外部电路会补充功率二极管工作过程中消耗的载流子,所以功率二极管的电导率主要受其内部载流子浓度的影响。
正向导通状态:如果在功率二极管两端施加正向偏置电压,则多数载流子将靠近PN结,这会缩小空间电荷区并削弱内建电场,但PN结仍将保持动态平衡状态。只有当正向偏压大于内建电场时,才能打破动态平衡,并产生一个与漂移电流方向相反的叠加电场。扩散电流ID大于漂移电流Id。流过PN结的电流为正向电流IF。由于内建电势差,当功率二极管处于正向导通状态时,其两端会产生通态压降,这使得功率二极管呈现低阻抗状态。功率二极管的通态压降不是一个固定值,它与流过的电流成正比。
反向截止状态:如果在功率二极管两端施加反向偏置电压,则多数载流子将远离PN结,这将扩大空间电荷区并增强内置电场。那么PN结的动态平衡就会被打破,并产生一个与漂移电流方向相同的叠加电场。漂移电流Id大于扩散电流ID。流过PN结的电流为反向饱和电流Isat。由于少数载流子的数量太少,功率二极管的反向饱和电流通常可以忽略不计,这使得功率二极管呈现高阻抗状态。
反向击穿状态:如果功率二极管两端的反向偏置电压不断上升到某个临界值,则功率二极管中的载流子数量会迅速增加,从而导致反向电流IR显著增加。在反向击穿状态下,功率二极管呈现无阻抗状态,其反向电流IR和反向电压UR都很大。PN结的反向击穿主要分为雪崩击穿和齐纳击穿。这两种击穿都会使PN结温度升高,最终导致热击穿,对PN结造成永久性损坏。如果冷却措施做得足够好,即使功率二极管被反向击穿,但PN结没有被破坏,那么在限制或关闭反向电压后,PN结仍然可以恢复到原状态。
* 扩散电流和漂移电流
扩散运动是指多数载流子从高浓度区域至低浓度区域的运动。扩散运动由浓度梯度决定。漂移运动是指少数载流子在内建电场的作用下返回原区域的运动。漂移运动由内建电场决定。扩散运动和漂移运动是载流子在PN结中的基本运动。扩散运动产生的电流称为扩散电流ID,漂移运动产生的电流称为漂移电流Id。当没有施加外置电压时(或正向偏压小于内建电场),扩散运动会导致内建电场增强,以及漂移电流增大;漂移运动会导致内建电场减弱,以及扩散电流增大。最后,扩散电流等于漂移电流,PN结将处于总电流为零的动态平衡状态。
* 雪崩击穿和齐纳击穿
雪崩击穿通常发生在具有宽耗尽层的低掺杂PN结中。当反向偏置电压较大时,半导体中的自由电子在电场力的作用下会持续加速,并且由于耗尽层较宽,自由电子将获得很长的加速距离,从而获得大量的动能。这些高能电子与价电子碰撞,使它们摆脱价键的束缚,从而产生新的电子-空穴对。这些新产生的自由电子在电场力的作用下不断重复这个过程,使半导体中的自由载流子像雪崩一样迅速增加,导致漂移电流急剧增加。雪崩击穿的本质是碰撞电离本征激励,因此雪崩击穿电压一般高于6V。雪崩击穿电压随着温度的升高而增加,主要是因为载流子的不规则热运动随着温度的升高而增加,所以需要更大的反向电压来提供足够大的电场,使载流子做定向加速运动。
齐纳击穿通常发生在具有窄耗尽层的高掺杂PN结中。由于耗尽层较窄,没有足够的距离让自由电子加速,因此自由电子无法获得大量的动能,因此不会发生雪崩击穿。然而,即使反向偏置电压不大,由于耗尽层较窄,PN结中仍会产生强电场,将电子从价键中拉出,生成新的电子-空穴对。这种现象也称为场致激发。场致激发会大大增加半导体中载流子的数量,从而显着增加漂移电流。齐纳击穿电压一般小于4V。齐纳击穿电压随温度升高而降低,主要是因为价键中的电子随温度升高而变得更加活跃,因此更容易被电场力拉出。
2.2.3 PN结的电容效应
PN结中的电荷量随施加的电压而变化,表现出电容效应。这个电容称为结电容CJ(又称为差分电容)。根据产生机制和作用的不同,结电容CJ可分为势垒电容CB和扩散电容CD,它们符合计算公式CJ = CB + CD。势垒电容和扩散电容都是非线性电容。
1- 势垒电容
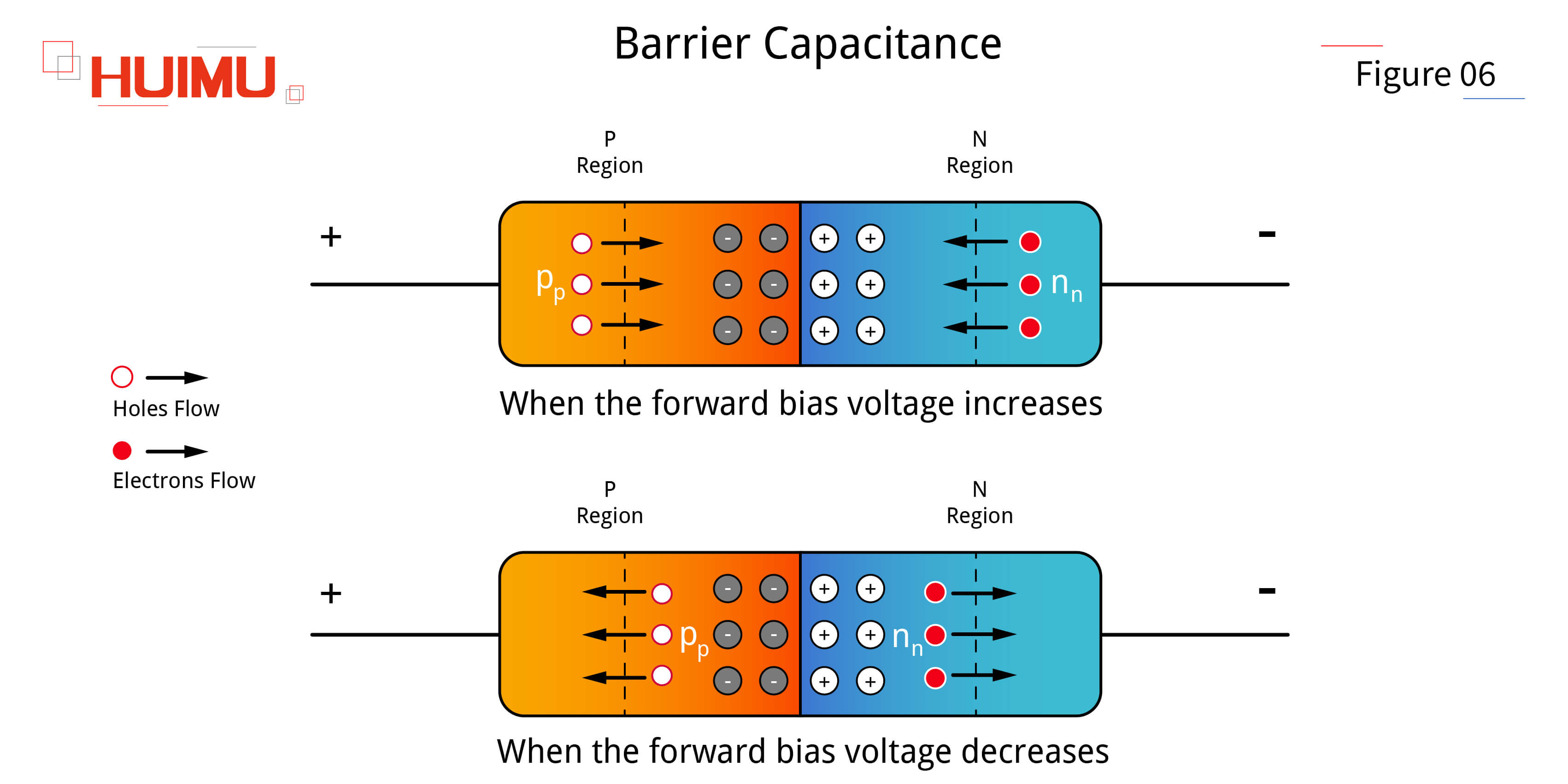
势垒区内的空间电荷数随外加偏置电压而变化,相当于电容器的充放电效应,也就是说,当正向偏置电压增加时,势垒面积减小,相当于将自由电子或空穴储存到势垒区,并且同理,当正向偏置电压减小时,势垒面积增大,相当于从势垒区取出自由电子或空穴。势垒区的等效电容称为势垒电容CB。如果外加偏置电压的频率越高,那么势垒电容的作用就越明显。无论是低频工作还是高频工作,势垒电容都可能使半导体器件的单向导电性变差,甚至无法工作。事实上,半导体器件的最高工作频率往往是由势垒电容决定的。值得注意的是,势垒电容是与多数载流子(pp和nn)有关的电容效应,无论是正向偏置还是反向偏置都不能被忽略。在正向偏置时,当正向电压较低时,势垒电容远大于扩散电容,因此势垒电容是结电容的主要组成部分,CJ≈CB。
2- 扩散电容

当PN结正向偏置时,内建电场减弱,少数载流子的漂移运动减弱。扩散电流大于漂移电流。因此,扩散到对面区域的载流子会在势垒边界处积聚,形成一定浓度的非平衡少数载流子(pn和np),也就是说,越靠近PN结,浓度越高,并且同理,越远离离PN结,浓度越低。这种非平衡少数载流子的电荷量随着正向偏压而变化,相当于电容的充放电效应,也就是说,当正向偏压增加时,非平衡少数载流子增加,相当于电容器充电,并且同理,当正向偏压减小时,非平衡少数载流子减少,相当于电容器放电。势垒区边界处的等效电容称为扩散电容CD。扩散电容在低频工作时对PN结的开关速度影响很大,在高频工作时可以忽略不计。在正向偏置时,如果正向电压较高,扩散电容远大于势垒电容,因此扩散电容是结电容的主要组成部分,CJ≈CD。在反向偏置时,非平衡少数载流子太少,扩散电容可以忽略不计,所以势垒电容是结电容的主要组成部分,CJ≈CB。
2.3 功率二极管的主要参数
1- 最大正向平均电流IFM(AV)
最大正向平均电流IF(AV)为功率二极管的额定电流,是指在规定的外壳温度TC和散热条件下,允许流过功率二极管的最大工频半波正弦电流的平均值。如果超过IFM,功率二极管会被烧坏。由于有些功率二极管的波形不一定是半正弦波,有些功率二极管不具有电阻特性,因此IF(AV)是根据电流的热效应来定义的,即按照有效值相等的原则找一个发热相似的电阻。考虑到散热条件会影响功率二极管承受电流的能力,因此建议留一定的裕量,以避免因散热问题而导致功率二极管损坏。
2- 阈值电压 UTO
阈值电压 UTO(又称死区电压)是令功率二极管导通的最低正向电压。阈值电压是功率二极管的最低正向通态压降。锗晶体的阈值电压约为0.1V;硅晶体的阈值电压约为0.5V左右。
3- 通态压降 UCO
通态压降UCO(又称导通电压)是功率二极管导通并稳定工作时的正向压降。理想状态下,功率二极管的通态压降等于内建电势。内建电势与半导体掺杂程度有关,约等于半个禁带宽度。功率二极管的通态压降与流过的电流成正比。锗晶体的导通压降通常在0.1-0.3V左右;硅晶体的通态压降通常在0.5-0.8V左右。
4- 最大正向压降 UFM
最大正向压降UFM是指定温度下最大正向平均电流IFM(AV)对应的正向压降。
5- 反向饱和电流 Isat
当施加适当的反向电压时,会产生很小的漏电流,称为反向饱和电流Isat。反向饱和电流是由少数载流子的漂移运动产生的,因此受温度影响很大。
6- 反向重复峰值电压 URRM
反向重复峰值电压URRM(又称最大反向电压URM)是功率二极管的额定电压,是功率二极管能够承受并且可以反复施加的最高反向电压。如果超过此值,功率二极管将被反向击穿并损坏。考虑到电路中的过电压等因素,一般建议选择额定值两倍作为裕量的功率二极管。例如额定电压为1000V的功率二极管只能用在500V的工作环境中。
7- 反向恢复时间 trr
反向恢复过程是由功率二极管的电容效应所引起的。当电路从导通状态切换到关断状态时,功率二极管需要先释放储存在结电容中的电荷,然后才能阻断反向电流。这个放电时间称为反向恢复时间trr,即正向导通电流为零到进入完全截止状态的时间。不同规格的功率二极管的反向恢复时间不同,所以在设计电路时我们需要充分考虑,否则可能会造成不必要的麻烦。例如,功率二极管的反向恢复时间为Trr。如果一个周期为T1(T1 < Trr)的连续PWM波通过功率二极管,当功率二极管反向偏置时,PWM波无法被阻断。
8- 最高工作结温TJM
结温TJ是指PN结的平均温度。最高工作结温TJM是指在PN结不致损坏的前提下所能承受的最高平均温度(通常锗晶体管最高结温约75℃,硅晶体管最高结温约150℃)。温度对功率二极管的工作特性有非常显著的影响,因此必须提供足够的散热条件,以免功率二极管因过热而损坏。
9- 最大工作频率 fM
最大工作频率 fM 是功率二极管的上限截止频率。如果频率太高,功率二极管很容易因为电容效应失去阻断反向电流的能力。同时如果频率过高,也会因通态功耗的增加而导致功率二极管被烧毁。
10- 浪涌电流IFSM
浪涌电流IFSM是指功率二极管可以承受的一个或多个工频周期的最大连续过电流。
2.4 功率二极管的基本特性
2.4.1 功率二极管的静态特性

功率二极管静态特性主要指的是功率二极管的伏安特性曲线,如图10所示。
在功率二极管的两端施加正向偏压时,功率二极管不会立即导通。只有当正向电压大于其阈值电压UTO时,功率二极管才会导通。此时,正向电流IF开始显著增加,直到功率二极管处于稳定的导通状态,此时其导通电压为UCO。如果正向电流达到IFM,则相应的压降为UFM,功率二极管会因电流过大而烧坏。
在功率二极管的两端施加反向偏置电压时,功率二极管不会导通,但是会产生数值恒定微小电流,即反向漏电流。当反向电压达到其反向击穿电压UBR时,功率二极管将被反向击穿,其反向电流此时将变得非常大。
2.4.2 功率二极管的动态特性
功率二极管的动态特性是指其开关特性,即功率二极管在通态和断态的切换过程中的电压-电流特性。因为结电容的关系,功率二极管的电压-电流特性是随时间而变化的。
1- 开通过程

功率二极管在开通过程中的动态特性如图11所示。当电压从零偏置变为正向偏置时,功率二极管的正向电流IF将从0上升到IF1。由于di/dt较大,在线电感的作用下,功率二极管两端会产生正向峰值电压UFP。一段时间后,正向电压UF会从UFP逐渐下降到稳定值UF1(即通态压降)。在此过程中,正向电流从0上升到IF1的时间称为正向恢复时间tfr。
2- 关断过程
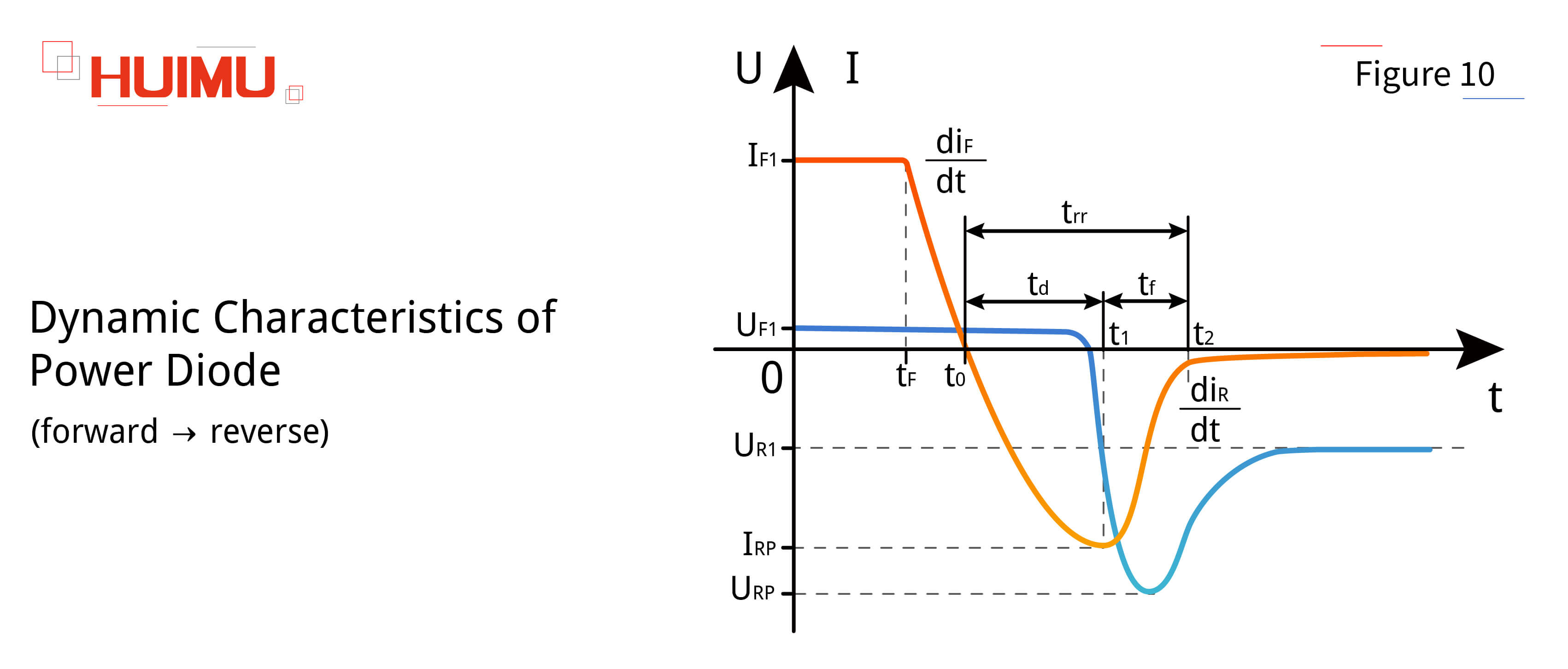
功率二极管在关断过程中的动态特性如图12所示。由于结电容,即使正向偏置切换到反向偏置,功率二极管也不会立即关断,并且需要一些时间才能恢复其反向阻断能力。
当功率二极管在tF处由正向偏置切换到反向偏置时,正向电流IF迅速减小,在t0处降至0,此时diF/dt会很大。从t0到t1的期间,电流不仅不会消失,反而成为反向电流IR并迅速上升,直到达到最大值IRP。这个时间段称为延迟时间td。在从t1到t2期间,反向电流开始急剧下降到一个非常小的值。这个时间段称为下降时间tf。在t2之后的期间,反向电流开始缓慢减小,直到下降到0(实际上,仍然存在非常小的反向漏电流)。从t0到t2的时间称为反向恢复时间trr,在此期间功率二极管反向导通。反向恢复时间trr决定了功率二极管的工作频率。如果外部电路的工作频率过高,功率二极管在反向偏置时无法进入反向截止状态,并且存在较大的反向电流,相当于功率二极管失去了反向阻断能力。
在反向电流上升到最大值之前,功率二极管两端的电压从通态压降UF1迅速下降到0。此外,由于tf通常很短,因此diR/dt会非常大。在线电感的作用下,功率二极管两端迅速产生反向峰值电压URP,然后开始下降到稳定值UR1。反向峰值电压通常非常大,可能会击穿功率二极管。因此,增加tf在trr中的比例将有助于降低反向峰值电压。恢复系数(Sr = tf / td)通常用于表示功率二极管反向恢复特性的软度。
2.5 功率二极管的主要类型
1- 通用二极管
通用二极管(GPD),也称为整流二极管,具有较长的恢复时间、较高的正向电流额定值和较高的反向电压额定值。它们多用于开关频率低(1kHz以下)的整流电路,一般不能用于中高频电路。
2- 快速恢复二极管
快速恢复二极管(FRD)的内部结构与通用二极管的内部结构不同。它在P型和N型硅材料之间添加一个基区I,形成P-I-N结构。由于基区非常薄,反向恢复电荷很少,因此不仅大大降低了trr和瞬态正向压降,还提高了其反向耐压能力。快速恢复二极管的恢复时间通常为几百纳秒(trr>100ns),其正向压降约为0.6V,正向电流为几安培到几千安培,反向峰值电压可达几百到几千伏。超快恢复二极管(UFRD),又称快速恢复外延二极管(FRED),具有比快速恢复二极管更少的反向恢复电荷,并且其恢复时间短至20~30纳秒(trr<100ns)。超快恢复二极管的正向压降也非常低(约0.9V),但其反向耐压能力通常不高(小于1200V)。
3- 肖特基势垒二极管
肖特基势垒二极管(SBD)是一种基于金属与半导体接触而形成的势垒的功率二极管。与通用二极管和快恢复二极管相比,肖特基势垒二极管具有反向恢复时间短、正向电压过冲不明显、反向耐压高等优点,但反向漏电流较大。肖特基势垒二极管的正向压降受反向耐压的影响,如果反向耐压增加,正向压降将显著增加。但当反向耐压较低时,肖特基势垒二极管的正向压降明显低于通用二极管和快恢复二极管,因此开关损耗和通态损耗非常低。因此,肖特基势垒二极管通常用于200V以下的整流电路。然而,需要注意的是,肖特基势垒二极管对温度非常敏感,因此必须严格限制其工作温度。
§3. 什么是晶体管?
在介绍半控型器件和全控型器件之前,有必要先简单介绍一下双极结型晶体管(BJT)。
3.1 晶体管介绍

晶体管是一种具有三个端子和两个PN结的半导体双极型器件,因此也称为双极结晶体管或BJT。晶体管是半导体器件的基本元件之一,也是核心元件之一。自1940年代诞生以来,晶体管彻底改变了电子电路的结构,引发了固态革命,推动了集成电路和大规模集成电路的出现。晶体管具有电流放大功能,能以极小的基极电流变化控制集电极电流的较大变化,因此在电子电路中常用作无触点开关。晶体管的开关频率高,没有机械使用寿命,因此比电磁继电器和机械开关有显著优势。
3.2 晶体管如何工作?
3.2.1 Basic Structure of Transistors
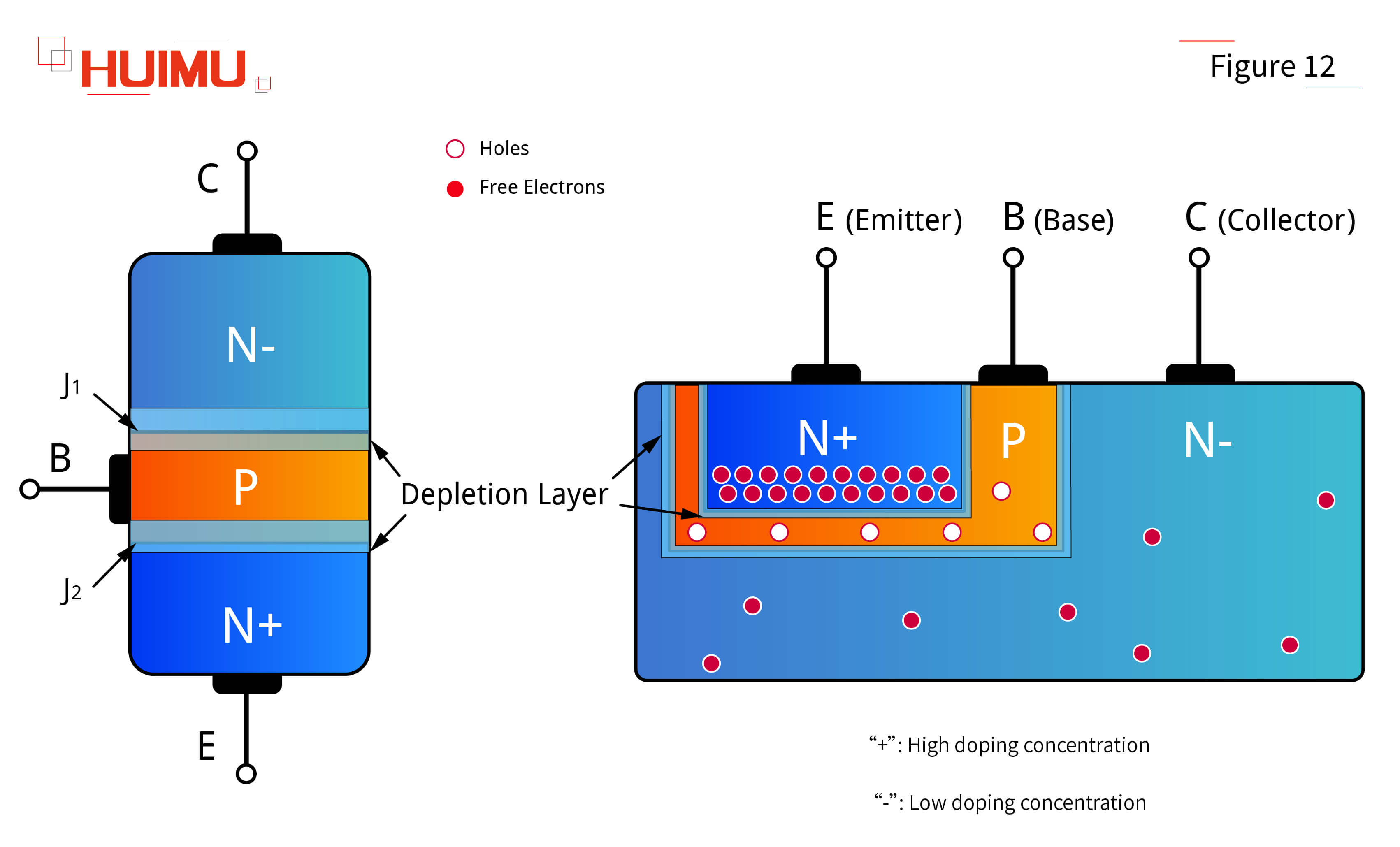
晶体管是三层半导体结构,比功率二极管多一个PN结。这两个紧密间隔的PN结将晶体管划分为三个区域,具有不同的面积和掺杂浓度,其一是面积非常小,厚度为3-30μm,掺杂浓度低的基区,其二是面积小,掺杂浓度高的发射区,其三是面积大,掺杂浓度低的集电区。集电区和基区之间的PN结称为集电结J1。发射区和基区之间的PN结称为发射结J2。
根据材料,晶体管可分为硅晶体管和锗晶体管。根据掺杂成分,晶体管可分为PNP型晶体管和NPN型晶体管,也就是说,在正向偏置下,PNP型晶体管的发射区会发射空穴,其方向与电流的方向相同,因此电符号中的箭头从发射极到基极,并且同理,在正向偏置下,NPN型晶体管的发射极会发射自由电子,其方向与电流的方向相反,因此电符号中的箭头从基极到发射极。
3.2.2 晶体管的工作原理
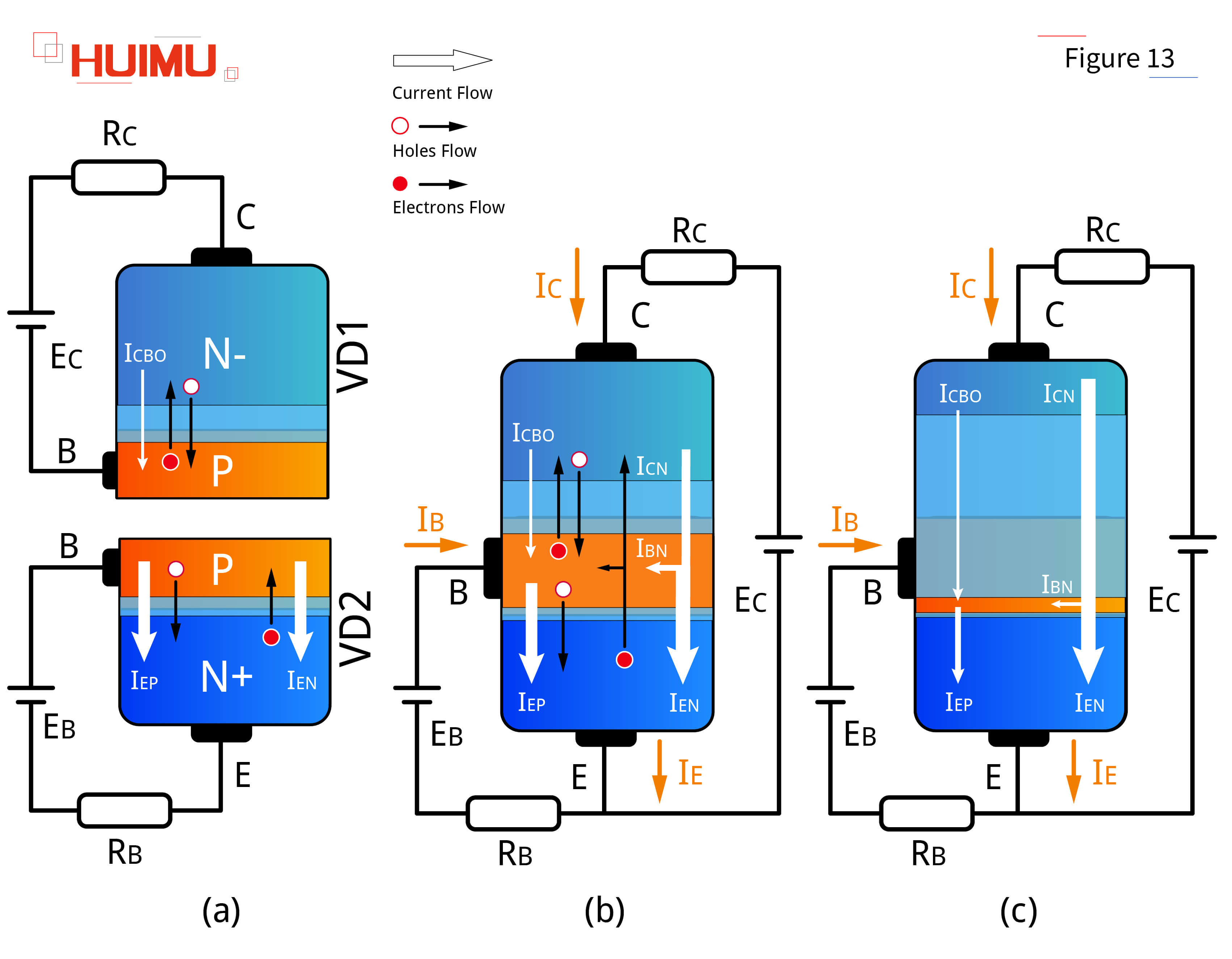
NPN型晶体管可以看作是两个等效二极管(VD1和VD2),如图13(a)所示。由于VD1的N-区掺杂浓度低,面积大,不易发生雪崩击穿,因此可以承受较大的反向电压。然而,在正向偏置中,VD1具有非常小的正向电流,因此总体而言,VD1非常适合在反向截止状态下工作。当VD1处于反向状态时,VD1会产生反向饱和电流ICBO,但N-区和P区的掺杂浓度很低,因此ICBO非常小。由于VD2的N+区掺杂浓度高,面积小,容易发生雪崩击穿,因此其反向耐压能力很差。然而,在正向偏置中,VD2具有非常大的正向电流,因此总体而言,VD2非常适合在正向导通状态下工作。当VD2在正向偏置下工作时,会产生两个电流,一个是P区的空穴流所产生的电流IEP,另一个是N+区的自由电子流所产生的电流IEN。由于VD1的P区掺杂浓度低于N+区的掺杂浓度,因此IEN大于IEP。基于以上信息,如果我们进一步了解这两个等效二极管的工作原理,那么就很容易理解NPN晶体管的工作原理了。
在实际电路中,晶体管的连接方式可分为共发射极、共集电极和共基极。为了便于说明,我们以一个采用共发射极连接方式的NPN型晶体管为例,如图13(b)所示,也就是说,集电极电源EC和集电极电阻RC串联到集电极和发射极上,另外,基极电源EB和基极电阻RB串联到基极和发射极。在该电路中,电流从集电极和基极流入,从发射极流出。类似地,从集电极流入的总电流称为集电极电流IC,从基极流入的总电流称为基极电流IB,从发射极流出的总电流称为发射极电流IE。IC和IE之间的线性关系是共基极电流增益α,IC和IB之间的线性关系是共发射极电流增益β。值得注意的是,由于掺杂浓度不同,集电极结J1不适合正向偏置,发射极结J2不适合反向偏置。如果集电极和发射极反接,NPN型晶体管击穿的可能性将大大增加。
截止状态:NPN结构使得总有一个PN结处于反向偏置状态。当没有向基极施加电压时,即使向集电极和发射极施加小于击穿电压BVCEO的大电压,NPN型晶体管也无法导通,但仍然会输出非常小的漏电流ICEO。
有源状态:VD1和VD2必须同时工作才能开通NPN型晶体管,因此需要对基极施加一定的电压才能使J1反向偏置(UBC < 0)和J2正向偏置(UBE > UTO)。当NPN型晶体管开通时,其内部电流与等效二极管单独工作的内部电流略有不同,如图13(b)所示。从N+区注入P区的自由电子不会与P区中的空穴完全复合。由于J1的反向偏置,一部分自由电子将穿过P区并直接注入N-区以产生一个大的反向电流ICN。那么我们可以得出结论,通过基极向P区注入少量自由电子,可以有效地增加ICN,即当NPN型晶体管处于有源状态时,基极电流IB的微小变化将导致集电极电流IC的大幅变化。这种现象称为电导调制效应。电导调制效应呈现为一个能够将小输入电流放大为大输出电流的放大器,因此有源状态也被生动地称为放大状态。
饱和状态:随着IB的增加,P区空穴浓度降低,IEP降低,J1耗尽区不断增加,如图13(c)所示。同时,随着从N+区注入P+区的自由电子越来越少,IBN开始无限接近某个临界值,并且IB对IC的放大效应开始急剧减弱。当IB和IC不再具有线性关系时,NPN型晶体管开始处于饱和状态。在这种情况下,即使IB增加,IC的增加也很小,并且NPN型晶体管的饱和深度开始加深。当N+区几乎所有的自由电子都注入N-区时,基电位与集电极电位相同(UBC = 0)。此时,NPN型晶体管处于深度饱和状态,IC完全不受IB的影响。需要注意的是,NPN型晶体管的饱和深度越深,J1的耗尽区越大,J1上发生雪崩击穿的可能性就越大。
* 晶体管的计算公式
IC = ICN + ICBO, (1)
IB = IBN + IEP - ICBO, (2)
IE = IC + IB = ICN + IBN + IEP, (3)
因为 IC > 0,那么我们得到 IE / IC = IB / IC + 1;(4)
α = ICN / IE = (IC - ICBO) / IE, (5)
β = ICN / (IB + ICBO) = (IC - ICBO) / (IB + ICBO), (6)
因为IC>IB>>ICO>>ICBO≈0,如果忽略所有的漏电流,我们可以得到α ≈ IC / IE,β ≈ IC / IB,(7)
那么我们可以得到 1/α=1/β+1,(8)
所以α和β的关系是:α = β / (1 + β),β = α / (1 - α)。(9)
* 漏电流
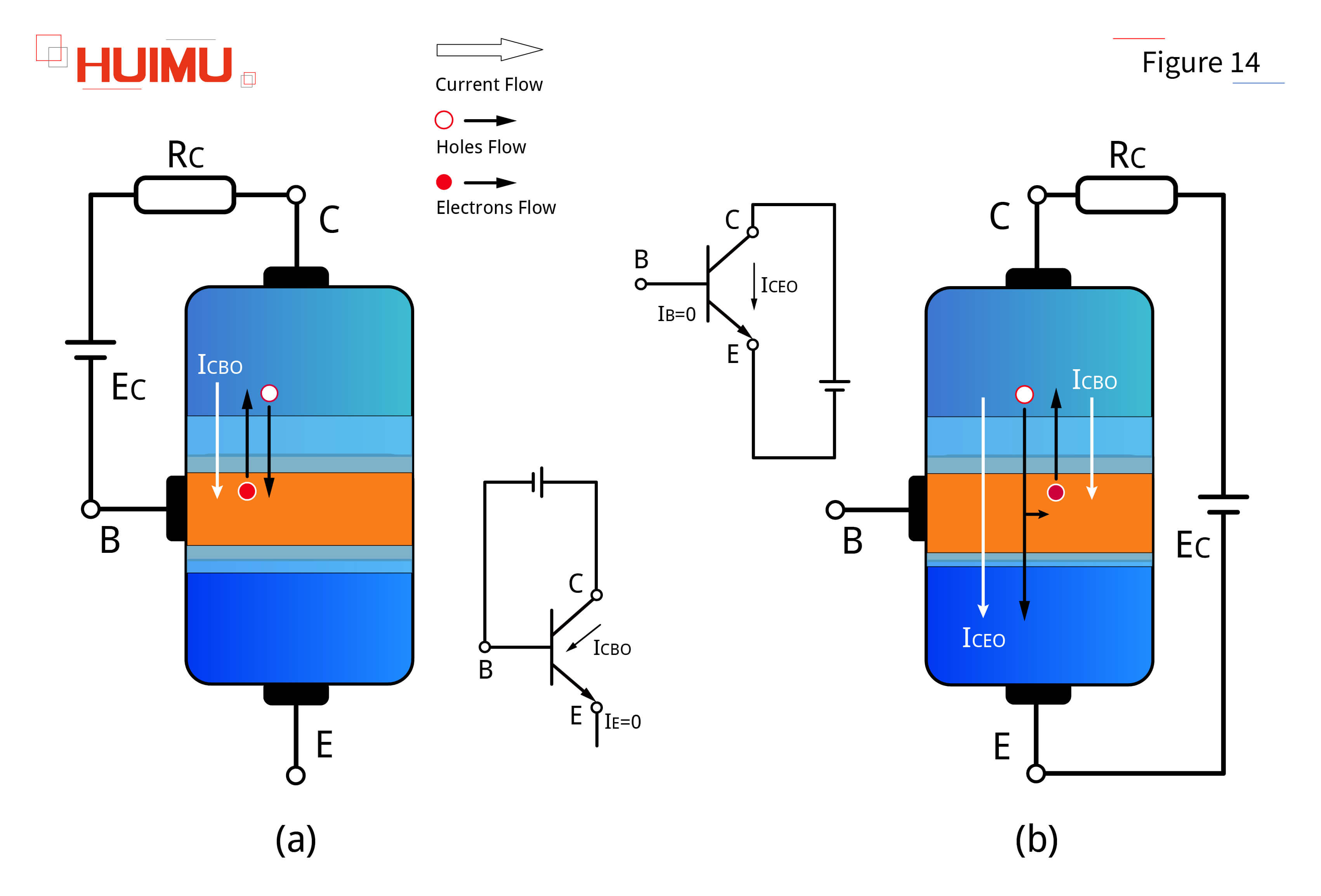
集电极结反向饱和电流ICBO和穿透电流ICEO都是晶体管中不可避免的漏电流。ICBO的值可以通过将晶体管的发射极开路(IE = 0)并向其集电极和基极施加电压来测量,如图14(a)所示。ICEO的值可以通过将晶体管的基极开路(IB = 0)并向其集电极和发射极施加电压来测量,如图14(b)所示。
集电极结反向饱和电流ICBO的产生机制如图13(a)所示。
穿透电流ICEO的产生机制如下所示:在外电场的作用下,集电区中的多数载流子远离PN结,使空间电荷区变宽,从而增强了集电极结J1的内建电场,这有利于漂移运动;发射区中的多数载流子靠近PN结,使空间电荷区变窄,从而削弱了发射结J2的内建电场,这不利于漂移运动。因此,在内建电场的作用下,基区的少数载流子通过J1漂移到集电区。同时,集电区中的少数载流子通过J1漂移到基区,其中一些参与基区的复合,而另一些则通过J2扩散到发射区。然而,由于基区掺杂浓度低,参与基区复合的少数载流子比例非常低。不难发现,这个过程与晶体管导通时IEN的产生机制非常相似。因此,ICEO和ICBO之间存在线性关系,ICEO = (1 + β) * ICBO。然而,由于集电区和基区的掺杂浓度低,ICEO的值非常低,通常可以忽略不计。硅晶体管的ICEO一般小于100nA;锗晶体管的ICEO一般小于100μA。
* 电导调制效应
电导(G)是电阻的倒数,单位是西门子(S)。电导调制效应(又称基区电导率调制效应,或韦氏效应)是双极型晶体管(BPT)的基本特性之一,是指当双极型晶体管的工作电流较大时,基区的电导率显著增加(或基区的电阻率显著降低)的现象。除了BJT之外,其他双极型晶体管如SCR,GTO,GTR和IGBT中的寄生晶体管也具有电导调制效应。此外,当双极型晶体管的工作电流较大时,还会出现厄尔效应(集电结电压的变化会导致基区宽度发生变化的现象)和柯克效应(基区宽度增大的现象)。
3.3 晶体管的主要参数
1- 共基极电流增益α
共基极电流增益α(全称“混合参数正向电流增益,共基极”,HFB),由发射极效率因子和基区传输因子所决定,α = FE * FB。当基极为零偏置(UBC = 0)时,基极短路放大系数α0由发射极效率系数、基区运输系数、集电极效率系数和雪崩倍增系数所决定,α0 = FE * FB * FC * M。
发射极效率系数FE是注入基区的电子电流IEN与发射极电流IE的比值,FE = IEN/IE = IEN/(IEN+IEP) = 1 /[1+(IEP/IEN)]。通过降低基区掺杂浓度,使基区的杂质总量远小于发射区的杂质总量,可有效增加从发射区注入基区的少数载流子数量。IEP与IEN的比值越接近0,晶体管的发射效率越高。
基区运输系数FB是到达集电区的电子电流ICN与注入基区的电子电流IEN的比值,FB=ICN/IEN。通过减小基区宽度,可以有效缩短发射区载流子在基区停留的时间,从而增加穿过基区的少数载流子数量。基区的宽度越小,来自发射区的电子在基区中的复合损失越小。
集电极效率系数FC是集电极电流IC与到达集电区的电子电流ICN的比值,FC = IC/ICN。
雪崩倍增系数M用于描述集电结反向电压上升到接近雪崩击穿电压时的雪崩倍增效应。通常用下式估算,M = 1 / [1 - (V / VB)^n],n由PN结的材料决定(硅:n=1.5-4;锗:n=2.5-8);VB为集电极J1的反向击穿电压;V是集电极结两端的电压。当V的绝对值趋于VB的绝对值时,M趋于无穷大,PN结就会发生雪崩击穿。
hFB(α)通常用来表示共基极直流电流增益,hFB(α) = IC / IE,其范围为0.95-0.99;hfb(α)通常用来表示共基极交流电流增益,hfb(α) = ΔIC / ΔIE。通常来讲,hfb(α) ≈ hFB(α)。
2- 共发射极电流增益β
共发射极电流增益β(全称“混合参数正向电流增益,共发射极”,HFE)是集电极电流与基极电流的比值,其值通常远大于1。晶体管的电流放大系数(或正向电流增益)通常是指共发射极电流增益β。hFE(β)通常用来表示共发射极直流电流增益,hFE(β)=IC/IB,可直接用万用表测量。hfe(β)通常用于表示共发射极交流电流增益,hfe(β) = ΔIC/ΔIB。
3- 共集电极电流增益γ
共集电极电流增益γ(全称为“共集电极混合参数正向电流增益”,HFC)是发射极电流与基极电流的比值。一般来说,hFE(γ)通常用来表示共集电极直流电流增益,hFC(γ) = IE / IB。hfc(γ)通常用来表示共集电极交流电流增益,hfc(γ) = ΔIE / ΔIB。这个参数平时很少用到。
4- 阈值电压 UTO
阈值电压UTO是触发晶体管发射结导通的电压。
5- 特征频率 fT
特征频率fT也称为增益带宽积,可以定义为β = 1时晶体管的工作频率。如果工作频率f0和高频电流放大系数β已知,则可以得到特性频率fT,fT = β * f0。随着工作频率的增加,电流放大系数会降低。如果晶体管的工作频率等于特征频率(f0 = fT),则晶体管将完全丧失其电流放大能力;如果晶体管的工作频率大于特征频率(f0 > fT),则晶体管将无法正常工作。
6- 最大工作电压 UCEM
UCE为施加在晶体管集电极和发射极之间的电压,其最大允许值为最大工作电压UCEM,即晶体管的额定电压。当UCE > UCEM时,晶体管将被击穿。
7- 集电极最大允许电流 ICM
IC为集电极电流,其最大允许值为集电极最大允许电流ICM,即晶体管的额定电流。从经验上讲,当电流增益β从其最大值下降一半时,所对应的集电极电流IC就是晶体管的ICM。为了保证使用安全,一般采用两倍ICM作为裕量。
8- 集电极最大耗散功率 PCM
集电极耗散功率PC是IC和UCE的乘积,即PC= IC * UCE,其最大容许值为最大集电极功率耗散PCM,即能够让晶体管在25°C室温下达到其最高结温的功率。当PC > PCM时,晶体管内部的PN结结构会被永久性破坏。
3.4 晶体管的基本特性
在晶体管稳定运行过程中具有缓慢变化数值或固定数值的参数为晶体管的静态参数,它们之间的关系称为晶体管的静态特性。在晶体管开关操作过程中具有急剧变化数值的参数为晶体管的动态参数,它们之间的关系称为晶体管的动态特性。如果晶体管的输入信号中只有一个直流信号,则称为直流操作或静态操作。如果晶体管的输入信号中有交流信号,则称为交流操作或动态操作。
我们以采用共发射极连接方式的NPN晶体管为例,其输入端为基极,输出端为集电极,因此其输入电流为IB,输入电压为UBE,输出电阻为RC,输出电流为IC,输出电压为UCE。
3.4.1 晶体管的静态特性
晶体管的静态特性分为输入特性(输入电流与输入电压的关系)、输出特性(输出电流与输出电压的关系)、温度特性(温度对输入特性和输出特性的影响)和安全工作区(晶体管的稳定工作条件)。
1- 晶体管的输入特性

晶体管的输入特性与功率二极管的正向输入特性相似,如图15所示。
当UCE为固定值且UBE>UTO时,基极电流IB随UBE的增加而增大。
当 UCE 增加时,UTO 增加,输入特性曲线向右移动。这是因为随着UCE的增加,本应从发射区注入基区的部分载流子越过基区,直接注入到集电区,使得基区的载流子浓度过低,导致发射结因其扩散电流小于或等于漂移电流而无法导通。因此,需要增加UBE以允许更多的载流子从发射区注入到基区以开通发射结,然而,这将增加阈值电压,并将输入特性曲线向右移动。当UCE上升到一定程度时,可以从发射区注入基区的大部分载流子都被集电区所收集,因此即使UCE继续增加,也很难改变晶体管的输入特性。
2- 晶体管的输出特性
在介绍晶体管的输出特性之前,有必要介绍一下直流负载线的概念。直流负载线是晶体管在静态状态下工作时集电极负载RC的伏安特性曲线,IC=(EC - UCE)/RC。当晶体管处于关断状态时,相当于集电极电路处于关断状态。因此,UCE = 0,RC上的电压等于电源电压EC。当晶体管处于导通状态时,IC = ICM,即流经RC的电流上升到其最大值。在以IC为Y轴,UCE为X轴的直角坐标系中标记这两个点,并将它们连接成一条线段,即直流负载线,如图16所示。直流负载线与Y轴的交点称为饱和点,与X轴的交点称为截止点。直流负载线的斜率是RC的电阻值。
直流负载线与晶体管输出特性曲线的交点称为静态工作点,或Q点。当晶体管工作在静态工作点时,无论输入信号中的交流信号如何变化,发射结都会正向偏置,且集电结都会反向偏置,即晶体管将工作在稳定的放大状态,而不会出现非线性失真。因此,在选择合适的Q点时,应尽量远离晶体管的饱和区,以避免饱和失真,同时也要远离晶体管的截止区,以避免截止失真,这样才能使晶体管发挥其最佳的放大效果。

晶体管的功率输出主要取决于集电结J1的反向电流,因此其输出特性曲线与功率二极管反向偏置下的静态特性曲线非常相似,如图16所示。然而,与功率二极管不同,晶体管有三种工作状态。为了直观地理解输出电流IC和输入电流IB之间的关系,我们可以将X轴向左延伸,并将X轴的左侧视为IB的正半轴,然后根据IC和IB的关系绘制输入-输出电流特征曲线。如果我们将这条输入-输出电流特性曲线从第二象限投影到第一象限的直流负载线上,那么相应的投影点就是晶体管的Q点。根据斜率变化,输入输出电流特性曲线可分为0部分、A部分、B部分和C部分,分别对应晶体管的四个工作区。
截止区(0部分):当 UBE ≤ UTO 或 IB = 0 时,发射结处于关闭状态。此时,即使集电结是反向偏置的(UBC < 0),晶体管也处于关断状态,但是,严格来说,晶体管中仍然存在非常小的穿透电流ICEO。同理,如果集电结处于关断状态(IC = 0),即使发射极结正向偏置(UBE > 0),晶体管也不会导通。因此,我们可以进一步得出结论,晶体管的截止条件是,IC * IB = 0。
有源区(A部分):如果发射结是正向偏置的且大于阈值电压(UBE > UTO > 0),则IB > 0,在这种情况下,如果集电极结为反向偏置(UBC ≤ 0),则晶体管在放大状态下工作。此时,IC的值与UCE无关,仅受IB影响,且IB与IC之间存在线性关系,IC = β * IB,这也是有源区也被称为放大区的原因。
饱和区(B部分和C部分):随着基极电流的增加,基区的空穴数量减少,从发射区注入基区的载流子也减少,基区的耗尽层变宽。当达到饱和边界时,晶体管的放大能力开始减弱(β' = ΔIC / ΔIB < β),IB和IC之间不再有线性关系,则晶体管进入准饱和状态或浅度饱和状态(即B部分)。当基区的空穴数量下降到临界值时,基区的电位与集电区的电位相同,即集电结J1为零偏置(UBC = 0),使得基极电流完全失去放大效应(β' = ΔIC/ΔIB = 0),则晶体管进入全饱和状态或深度饱和状态(即C部分)。
如果晶体管浅度饱和,则基极电流IB较小,通态压降较大,即晶体管的等效电阻较大,因此容易退出饱和状态。如果晶体管深度饱和,则基极电流IB较大,通态压降较小,即晶体管的等效电阻较小,那么随着IB的增加,晶体管的饱和程度会不断加深,因此很难退出饱和状态。在实践中,当IB(sat)= EC /(β * ICM)时,可以认为晶体管已经进入了深度饱和状态,也就是俗称的饱和状态。有时为了加速晶体管进入深度饱和状态的过程,我们可以向晶体管施加数倍于IB(sat)的基极电流。需要注意的是,晶体管的工作状态也受到输出电阻RC的影响,即输出电阻RC越小,IC的饱和电流越大,UCE的饱和压降越大,饱和触发电流IB越大。随着输出电阻RC的减小,如果饱和电流IC接近ICM,那么晶体管容易烧毁。再者,如果输出电阻RC接近0,那么晶体管即便烧坏了也永远无法进入饱和状态。由此可以看出,为了使晶体管更容易进入饱和状态,需要一个较大的输出电阻RC。
3- 晶体管的温度特性

温度的升高会引起半导体的本征热激发,从而增加半导体内部的载流子浓度,增加其电导率。因为电导率的增加会造成很多影响,如漏电流的增加、阈值电压的降低、电流增益的增加,因此,随着温度的升高,晶体管的输入特性曲线会向右移动,晶体管的输出特性曲线向上移动。此外,温度的升高也会增加晶体管热击穿的可能性,因此,在实际使用中,我们应该为晶体管配备足够的散热条件,使其在合适的温度下工作。
4- 晶体管的安全工作区

如果我们知道晶体管的型号,那么我们可以通过其数据表获取其PCM参数。然后我们可以根据公式PCM=IC*UCE来绘制PCM曲线。ICM、UCEM和PCM曲线所包围的区域是晶体管的安全工作区(SOA),晶体管可以在该区域内稳定且安全地运行而不会损坏。安全工作区之外是危险区域,如果晶体管在该区域内工作,其温度会明显升高,极易发生热击穿。因此,一方面,我们应该避免晶体管在危险区域内工作。另一方面,我们应该选择容量更高的晶体管,以预防可能导致晶体管进入危险区域的意外情况,例如浪涌电流、浪涌电压、感应电流、感应电压。
3.4.2 晶体管的动态特性
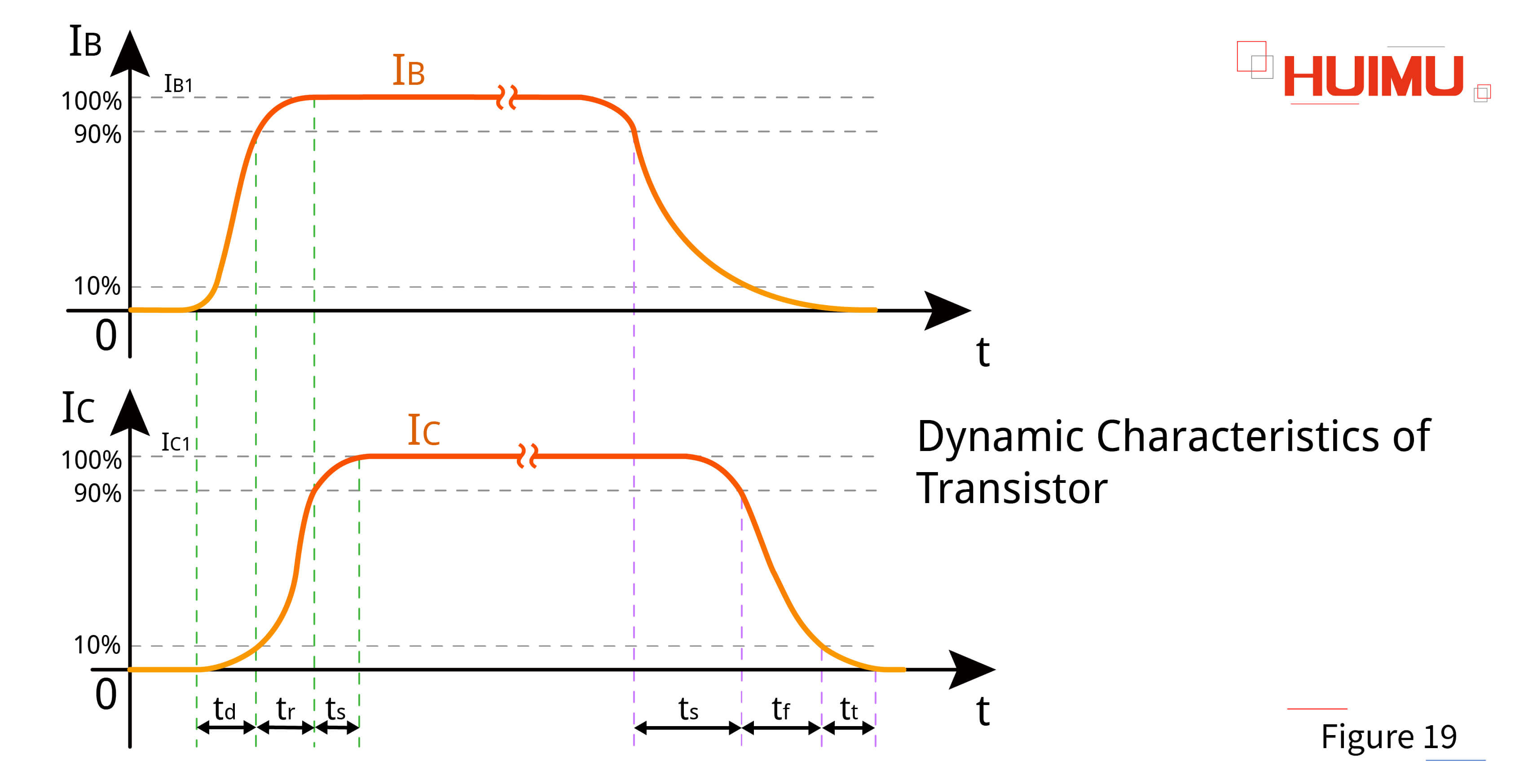
1- 晶体管的开通过程
一旦满足开通条件(UBE > UTO)时,晶体管将被开通。晶体管的开通过程分为延迟时间td、上升时间tr和扩散时间ts。
延迟时间td是从10% IB1到10% IC1所用的时间。势垒电容在此时间段内进行充电。
上升时间tr是IC从10% IC1上升到90% IC1所用的时间。IC在这时间段内急剧上升。
扩散时间ts是IC从90% IC1上升到100% IC1所需的时间。扩散电容在此时间段内进行充电。
综上所述,开通时间的计算公式为,ton = td + tr + ts。
2- 晶体管的关断过程
一旦满足关断条件(IB = 0)时,晶体管将被关断。晶体管的关断过程分为存储时间ts,下降时间tf和尾部时间tt。
存储时间ts是从90% IB1到90% IC1所用的时间。在此期间,在饱和导通过程中存储在基区中的载流子会被去除掉。
下降时间tf是IC从90% IC1下降到10% IC1所用的时间。在这段时间里,IC急剧下降。
尾部时间tt是IC从10% IC1下降到ICEO所用的时间。残存的载流子在此时间段内进行复合。
综上所述,关断时间的计算公式为,toff = ts + tf + tt。
§4. 什么是半控型器件?
4.1 半控型器件介绍
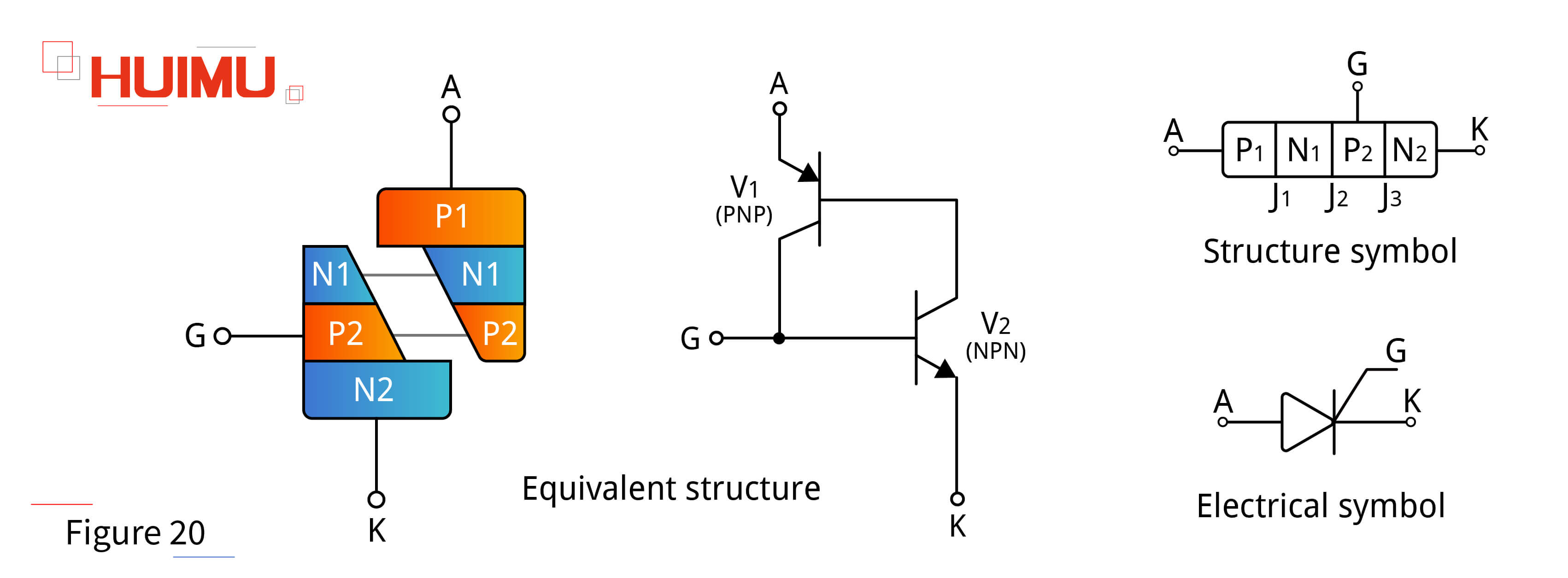
半控型器件(也称为晶闸管,或可控硅整流器,SCR)是一种双极器件,可以被控制信号开通,但不能被其关断。半控型器件在1956年被发明,并在1960年代和1970年代被广泛使用。然而,随着1980年代全控型器件的发明,半控型器件的地位逐渐被它们所取代。即便如此,半控型器件在大容量应用中仍然保持着重要地位,因为它们结构简单,运行可靠,能够承受非常大的电压和电流。与晶体管类似,晶闸管有三个端子,分别称为阳极A、阴极K和门极G,但晶闸管具有四层结构(PNPN),比晶体管多一个PN结,如图20所示。我们可以通过对晶闸管的门极施加控制信号(也称为门极触发信号)来开通晶闸管,即门极触发,但需要注意的是,由于其特殊的结构,我们不能通过门极触发来关断晶闸管。再者,当阳极电压上升到非常高的值时,会引起雪崩效应,使中间的反向偏置PN结击穿以开通晶闸管。此外,当阳极电压上升速率dv/dt过高时,晶闸管可以通过PN结的结电容效应开通。除上述外,晶闸管还可以通过高结温、光触发的方式来开通,但一般来说,只有门极触发是所有控制方法中最准确、最快速、最可靠的。根据形状,晶闸管可分为螺栓式(螺栓为阳极,可以紧密连接在散热器上,便于安装)和扁平式(扁平式晶闸管被两个散热器夹紧在中间),但是,随着半导体技术的发展,模块化晶闸管现在非常普遍(点击查看更多晶闸管模块)。
4.2 晶闸管是如何工作的?
4.2.1 晶闸管的基本结构
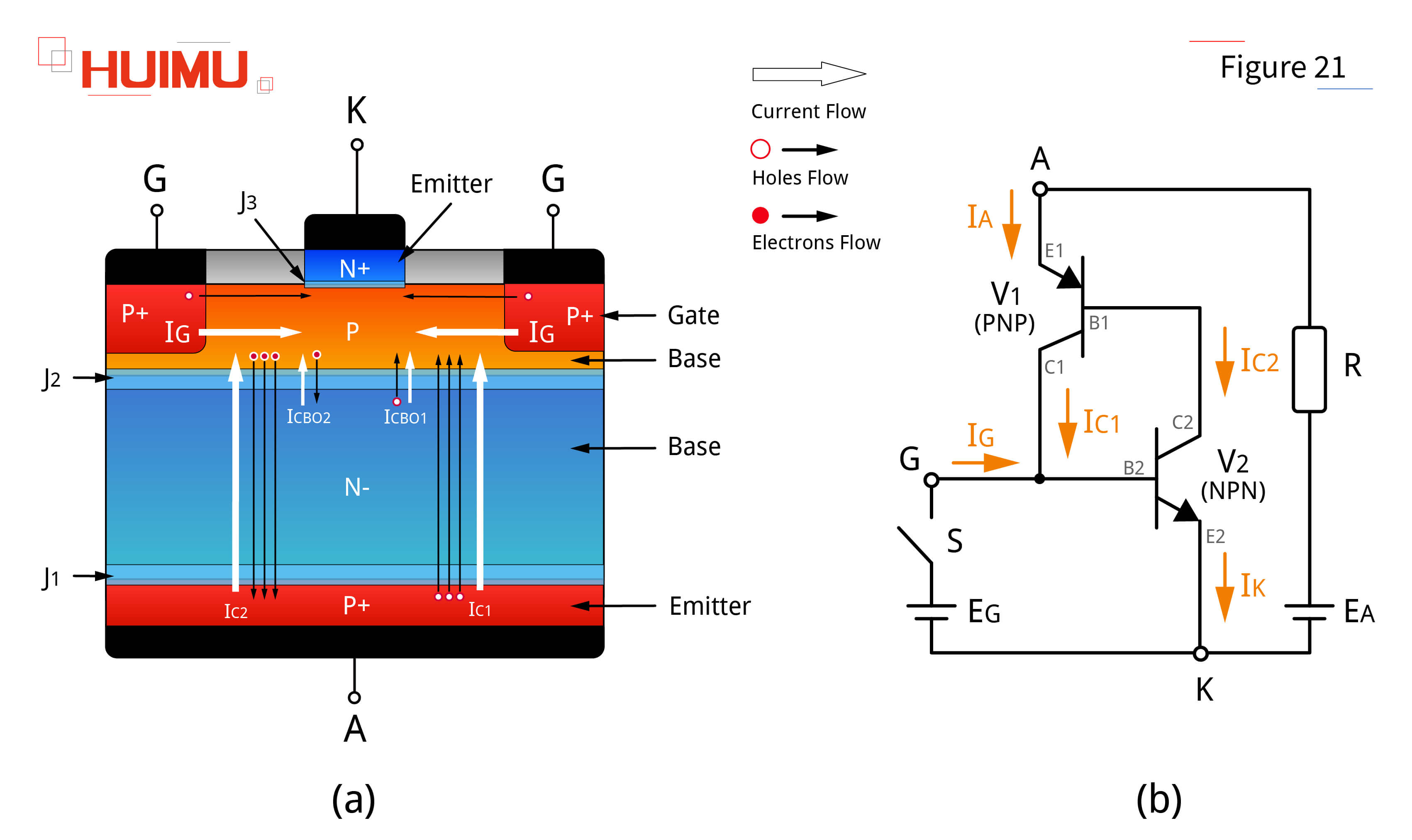
根据晶闸管内部P型半导体和N型半导体掺杂程度的不同,可将晶闸管分为P+区、P区、N+区和N-区,如图21(a)所示。P+和N+区具有较高的掺杂浓度,其功能与晶体管的发射区相似。 P+区与晶闸管的阳极A相连,N+区与晶闸管的阴极K相连。P区和N-区具有较低的掺杂浓度,其功能与晶体管的基区相似,此外,P基区中还有两个掺杂浓度较高的P+区,它们与晶闸管的门极G相连。从功能上看,晶闸管可视为由PNP晶体管V1和NPN晶体管V2所组成的,如图20所示。对于V1,P+区为其发射区,N-区为其基区,P区为其集电区;对于V2,N+区为其发射区,P区为其基极区,N区为其集电区。需要注意的是,与晶体管类似,晶闸管的接线也有严格规定,阳极和阴极分别与电源的正极和负极相连,如果在使用过程中两者接反,晶闸管就会被烧毁。
4.2.2 晶闸管的工作原理
在等效工作电路中,如图21(b)所示,V1和V2是晶闸管的等效晶体管,另外,α1是V1的共基极电流增益,α2是V2的共基极电流增益。晶闸管的阳极A和阴极K与输出电路相连,晶闸管的门极G与输入电路相连。EA是输出电路的电源,EG是输入电路的电源。R是输出电阻。此外,IC1是V1的集电极电流,IC2是V2的集电极电流。流过阳极A的电流是阳极电流IA,流过阴极K的电流是阴极电流IK,流过门极G的电流是门极电流IG。一般来说,开通晶闸管的思路与开通晶体管类似,即如何使 PN结J2产生足够大的反向电流,但与晶体管不同的是,晶闸管只有两种工作状态。
截止状态:当正向偏置电压UAK施加到晶闸管的阳极A和阴极K时,如果没有对门极G施加电压,则相当于V1和V2的集电极和基极开路,则晶闸管将处于截止状态。在正向偏置电压的作用下,J1和J3的耗尽层变窄,J2的耗尽层变宽,因此,即使晶闸管处于截止状态,J2中也存在反向饱和电流ICBO,它由两部分组成,一部分是空穴电流ICBO1(即V1的共基极电流),另一部分是自由电子电流ICBO2(即V2的共基极电流)。这两个电流将流过J1和J3,成为晶闸管的漏电流。由于α1 + α2在截止状态下非常小,晶闸管的漏电流值略大于等效晶体管V1和V2的漏电流值之和,如公式14所示。
导通状态:当向晶闸管门极施加正向偏置电压时,与门极相连的P+区向P基区注入大量空穴,其中一部分进入N+区,使J3正向导通,与此同时,大量自由电子从N+区注入P基区,增加了P基区的少数载流子浓度,从而增加了ICBO2,另一部分进入N-区,增加了N-区的少数载流子浓度,从而增加了ICBO1。这两种泄漏电流都会减少N-区的少数载流子,并缩小J1的耗尽层。当向门极施加足够大的正向偏置电压时,J1的耗尽层将变窄至临界状态,从而打破J1的动态平衡,大量空穴从与阳极相连的P+区注入N-区,然后注入P基区,同样地,与阴极相连的N+区中的大量自由电子从P基区注入N-区,然后注入P+区,形成电流IC2。值得注意的是,如果IC1和IC2没有形成,那么基区的电导率将非常小,因此α1+α2将非常小。然而,一旦IC1和IC2形成,由于电导调制效应,V1和V2基区的电导率将增加,从而使IC1和IC2进一步增加。在这种正反馈作用下,α1+α2迅速上升到接近1的值,导致通态通压降急剧下降,阳极电流IA急剧上升,最终使晶闸管导通。
* 晶闸管计算公式
IC1 = α1 * IA + ICBO1, (10)
IC2 = α2 * IK + ICBO2, (11)
IK = IA + IG, (12)
IA = IC1 + IC2, (13)
IA = (α2 * IG + ICBO1 + ICBO2) /[1 - (α1 + α2) ]。(14)
从公式14中可以看出:
如果α1 + α2接近0时,IA将趋向于漏电流,即晶闸管处于关断状态;
如果α1 + α2接近1时,IA将趋于无穷大,即晶闸管处于导通状态。
4.3 晶闸管的主要参数
4.3.1 静态参数(电压)
1- 正向非重复峰值电压 UDSM / 反向非重复峰值电压 URSM
在额定结温和门极开路的条件下,不允许重复施加到晶闸管阳极和阴极上的电压被称为非重复峰值电压,其中一种是由正向伏安特性曲线的急剧弯曲点所决定的的正向非重复峰值电压UDSM(也称为最大断态瞬态电压),另一种是由反向伏安特性曲线的急剧弯曲点所决定的反向非重复峰值电压URSM(也称为最大反向瞬态电压)。
2- 正向转折电压 UBO
在额定结温和门极开路的条件下,如果施加在晶闸管阳极和阴极之间的正向正弦半波电压能够将晶闸管从关断状态直接切换到开通状态,则该电压称为正向关断电压UBO。
3- 反向击穿电压 UBR
在额定结温的条件下,如果施加在晶闸管阳极和阴极之间的反向正弦半波电压能够使晶闸管的反向漏电流急剧增加,则该电压称为反向击穿电压UBR。
4- 正向断态重复峰值电压 UDRM / 反向断态重复峰值电压 URRM
在额定结温和门极开路的条件下,正向断态重复峰值电压UDRM(也称为断态重复峰值电压)是允许重复施加到晶闸管阳极和阴极上的正向峰值电压。UDRM的重复频率为每秒50次,每次持续时间不超过10毫秒。UDRM的电压值一般规定为UDSM的电压值的90%。此外,出于安全考虑,UDRM的电压值应比UBO的电压值低约 100V。
在额定结温和门极开路的条件下,反向关断状态重复峰值电压URRM(也称为反向重复峰值电压)是允许重复施加到晶闸管阳极和阴极上的反向峰值电压。URRM的重复频率为每秒50次,每次持续时间不超过10毫秒。URRM的电压值一般规定为URSM的电压值的90%。此外,出于安全考虑,URRM的电压值应比UBR的电压值低。
需要注意的是,UDRM和URRM的值并不是固定的,它们会随着温度的升高而降低。因此,在测试和使用过程中,应通过多种散热方式严格控制晶闸管的温度,以使UDRM和URRM保持在合理的范围内。此外,我们通常选择UDRM和URRM中较小的一个作为晶闸管的额定电压,以确保晶闸管能够安全高效地运行。
5- 门极触发电压 UGT
在规定的环境温度和晶闸管正向偏置的条件下,能够将晶闸管从关断状态切换到开通状态所需的最小门极直流电压称为门极触发电压UGT。在规定的环境温度和晶闸管正向偏置的条件下,能够将晶闸管从关断状态切换到开通状态所需的最小门极直流电压称为门极触发电压UGT。
6- 正向平均压降 UF
在规定的环境温度和规定的散热方式的条件下,如果晶闸管的通态电流等于额定电流,则晶闸管阳极和阴极之间的压降平均值称为正向平均压降UF(或称通态平均电压,通态压降)。一般来说,晶闸管的UF为0.4-1.2V。
7- 通态峰值电压 UT
在规定的环境温度和规定的散热方式的条件下,如果晶闸管的通态电流等于通态峰值电流,则晶闸管阳极和阴极之间的瞬态峰值电压称为通态峰值电压UT(也称通态峰值压降),一般为2V。
4.3.2 静态参数(电流)
1- 额定通态电流 IT
在规定的环境温度和规定的散热方式的条件下,如果晶闸管的负载是电阻器,且晶闸管的导通角不小于170°,则允许流过晶闸管的最大工频正弦半波电流称为额定通态电流IT。另外,如果电流波形不是工频正弦半波,即使晶闸管是不具有与电阻器相同伏安特性曲线的半导体,我们也可以使用与晶闸管具有相同发热效应的等效电阻器作为参考来确定晶闸管的额定通态电流,其一般为流过等效电阻器的电流值的1.5-2倍。额定通态电流有多种使用方法,例如,额定通态电流的平均值IT(AV)可用作单向晶闸管的额定电流,额定通态电流的有效值IT(RMS)可用作双向晶闸管的额定电流,额定通态电流的n倍(通常n=3)可用作晶闸管的峰值通态电流ITM。
2- 断态漏电流 IDRM / 反向漏电流 IRRM
IDRM是UDRM所对应的漏电流,IRRM是URRM所对应的漏电流,它们两者一般小于100微安。
3- 门极触发电流 IGT
在规定的环境温度和晶闸管正向偏置的条件下,能够将晶闸管从关断状态切换到开通状态所需的最小门极直流电流称为门极触发电流IGT。普通晶闸管的IGT通常为几毫安,而高灵敏度晶闸管的IGT通常为几微安。
4- 维持电流 IH
维持电流IH是维持晶闸管开通状态所需的最小电流,通常为几十毫安到几百毫安。晶闸管的门极不具备关断晶闸管的能力,因此晶闸管一旦被开通,即使门极触发信号被移除,其仍将维持在开通状态。不过,只要晶闸管的阳极电流降至IH以下,就可以关断晶闸管了。此外,IH容易受到晶闸管结温的影响,结温越高,IH越小,晶闸管被关断的可能性越小。因此为了更好地控制晶闸管的工作状态,良好的散热方式是必要的。
5- 擎住电流 IL
擎住效应或自锁效应是指由于晶闸管中的正反馈过程,即使门极触发信号被移除,晶闸管仍然维持在开通状态的现象。当晶闸管刚被开通,且门极触发信号立即被移除时,能够使晶闸管保持开通状态的最小电流称为擎住电流IL,其通常是IH的2-4倍。
6- 浪涌电流 ITSM
在工频正弦波的半周期内,由电路异常引起的非重复最大正向过载电流称为浪涌电流,其会导致晶闸管的结温超过其额定结温。通常情况下,在一个工频正弦波的正周期内,晶闸管可承受高达其额定电流6倍的浪涌电流。但是,晶闸管在整个使用寿命期间承受浪涌电流的次数是有限制的,如果超过这个限制,晶闸管可能会永久损坏,因此在选择晶闸管时,有必要充分考虑电路中可能存在的浪涌电流。
7- 正向转折电流 IBO
在额定结温和门极开路的条件下,能够将晶闸管从关断状态直接切换到开通状态的阳极电流称为正向转折电流IBO。
4.3.3 动态参数
1- 开通时间 tgt
开通时间tgt是在施加门极触发信号之后,晶闸管从关断状态切换到开通状态所需的时间。在开通过程中,晶闸管的输出电压UAK将逐渐下降到通态压降UF,其阳极电流IA将逐渐上升到额定通态电流IT。
2- 关断时间 tq
关断时间tq是在晶闸管的阳极电流IA从额定通态电流IT下降到0之后,直到晶闸管开始承受规定的关断电压所需的时间。tq不仅与晶闸管的内部结构有关,还与温度、dv/dt、di/dt有关。普通晶闸管的tq约为几百毫秒,并且可通过增加反向电压的方式来进一步降低它。在tq期间,晶闸管没有完全关断,因此如果重新施加阳极电压,晶闸管可以再次被开通,但在tq之后,在晶闸管没有被反向击穿的前提下,无论阳极电压如何增加,晶闸管都不会开通。
tgt和tq共同决定了晶闸管的工作频率。一般来说,如果晶闸管的tq较小,则其tgt会比它更小,因此利用这一参数可以区分普通晶闸管和快速晶闸管。综上所述,如果要为高频开关电路选择快速晶闸管,那么只需选择tq较小的晶闸管即可。
3- 临界断态电压上升率 dv/dt
在额定结温和门极开路的条件下,晶闸管的输出电压从断态切换到通态的最大上升率称为临界断态电压上升率dv/dt。dv/dt会影响晶闸管的安全稳定运行,例如,对于dv/dt较大的晶闸管,如果其结电容的充电电流较大,则晶闸管容易误导通。小电流晶闸管(50-100A)的dv/dt通常为 225V/μs,而大电流晶闸管(200A或以上)的dv/dt通常为50V/μs。
4- 临界通态电流上升率 di/dt
在额定结温和门极闭路的条件下,晶闸管所能承受的最大通态电流上升率称为临界通态电流上升率di/dt。晶闸管在开通瞬间会产生较大的功率损耗,由于其导通扩展能力有限,该功率损耗始终集中在门极附近的阴极区。因此,如果di/dt过大,即使通态电流不大,晶闸管也会因门极局部过热而永久损坏。此外,晶闸管的额定电流越大,这个问题就越明显。
4.4 晶闸管的基本特性
4.4.1 晶闸管的静态特性
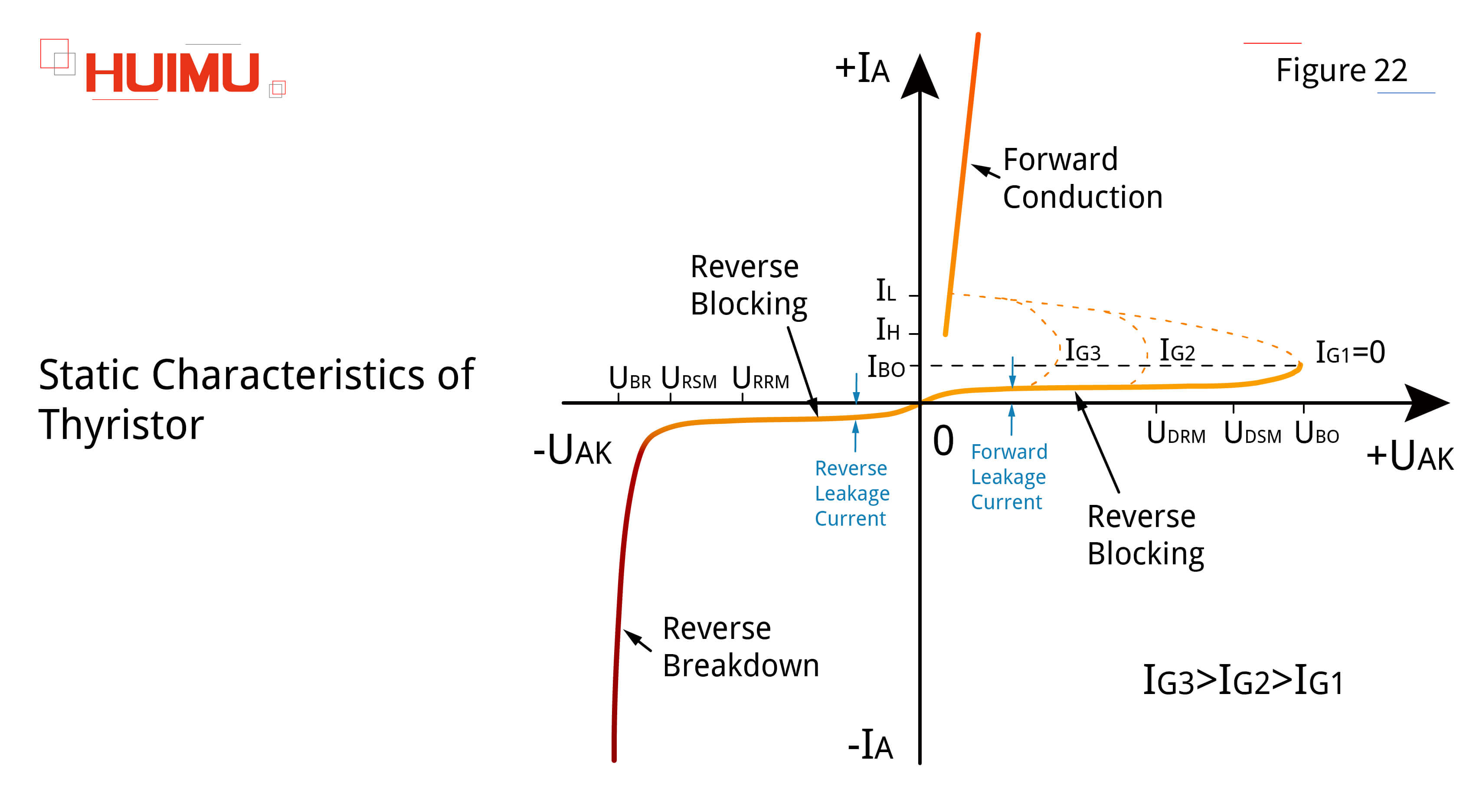
晶闸管的静态特性就是其输出电流和输出电压的伏安特性。晶闸管的静态特性曲线如图22所示,其中IG为门极触发电流,IA为阳极电流(即输出电流),UAK为施加到晶闸管阳极和阴极的电压(即输出电压)。
1-正向静态特性
正向阻断状态:当 IG = 0 时,α1 + α2 非常小,即使 UAK > 0,也只有很小的正向漏电流。晶闸管的这种工作状态称为正向阻断状态。然而,当 UAK ≥ UBO 或 IA ≥ IBO 时,α1 + α2 接近 1,晶闸管开始进入正向导通状态。
正向导通状态:当 IG > 0且 UAK ≥ UGT 时,晶闸管基区的电导率显著增加,直到 α1 + α2 接近1,阳极电流IA将趋近无穷大,晶闸管进入饱和导通状态,也就是正向导通状态。一旦晶闸管处于正向导通状态,门极就失去了其控制晶闸管的能力,那么只有当IA下降到接近0时才能关闭晶闸管。需要注意的是,虽然当α1 + α2 接近1时,IA的理论值是趋于无穷大,但是其实际值还是由外电路所决定的。此外,在相同的外部条件下,IG越大,UGT越小。
2- 反向静态特性
晶闸管的反向静态特性与功率二极管的相似。当向晶闸管施加反向电压时,无论是否存在门极触发电流,晶闸管都不会导通,但会有一个很小的反向漏电流。晶闸管的这种工作状态称为反向阻断状态。但是,反向阻断状态并不意味着晶闸管可以完全阻断反向电压,如果反向电压达到反向击穿电压UBR,就会引起雪崩击穿,使晶闸管因内部短路而失去反向阻断能力。
4.4.2 晶闸管的动态特性

1- 开通过程
当UAK1施加到晶闸管的输出端时,由于晶闸管没有导通,晶闸管的输出电压UAK为UAK1的100%。当UG ≥ UGT时,晶闸管经过一系列开通过程后进入导通状态。晶闸管导通后,UAK将保持在一个非常小的值,即通态压降UF。
晶闸管的开通过程分为延迟时间td、上升时间tr和扩散时间ts。
延迟时间td是IA从断态漏电流IDRM上升到IA1的10%,以及UAK从UAK1的100%下降到UAK1的90%所需的时间。延迟时间td一般为0.5-1.5μs。此外,延迟时间td会随着门极电流的增加而减少。
上升时间tr是IA从IA1的10%上升到IA1的90%,UAK从UAK1的90%下降到UAK1的10%所需的时间。上升时间tr一般为0.5-3μs。上升时间tr受晶闸管本身特性、外部电路阻抗、温度和阳极电压的影响,再者,通过增加IA可以显着缩短延迟时间td和上升时间tr。
扩散时间ts是IA从IA1的90%上升到IA1的100%,UAK从UAK1的10%下降到通态压降UF所需要的时间。此外,扩散时间ts取决于阴极的横截面积。
一般来说,当IA达到IA1的90%时,晶闸管可以被认为已经开通了。因此,导通时间的计算公式为:tgt = td + tr。
2- 关断过程
如果将晶闸管的UAK降为0,或向晶闸管施加足够大的反向电压UAK2,使IA逐渐降至0,那么晶闸管就能从开通状态切换到关断状态。晶闸管的关断过程分为反向阻断恢复时间trr和正向阻断恢复时间tgr。
在关断过程中,外部电路的电感会在晶闸管中产生反向电流(或反向恢复电流)IR。晶闸管的反向电压UR随IR的增大而增大,当IR达到其峰值IRP时,UR也达到其峰值URP,然后IR和UR均迅速降低。反向阻断恢复时间trr是IA从IA1的10%到反向漏电流所需要的时间,也是UAK从UAK1的10%到UAK2所需要的时间。
正向阻断恢复时间tgr(或门极恢复时间)是晶闸管从其反向恢复过程结束到完全恢复其正向阻断能力所需要的时间。由于在tgr期间有少量载流子残留在门极附近的PN结上,因此晶闸管的正反馈机制仍然有效。此时,如果向晶闸管施加正向偏置电压,它将再次进入正向导通状态。此触发模式不需要任何门极触发信号。
因此,关断时间的计算公式为:tq = trr + tgr。
4.5 晶闸管的串联和并联
1- 晶闸管的串联
与电阻器的串联类似,将多个晶闸管串联起来可以提高其整体的电压容量。然而,与电阻器不同的是,电压并不是均匀地分布在串联的晶闸管上。由于产生机制不同,这种不均匀电压可分为静态不均匀电压和动态不均匀电压。因此,串联晶闸管的总耐压值不能简单地通过将单个晶闸管的耐压值乘以其数量来计算,而应通过将每个晶闸管的实际耐压值相加来计算。
静态不均匀电压:尽管流过串联晶闸管的漏电流相同,但由于每个晶闸管的静态伏安特性不一致且分散,因此施加在每个晶闸管上的静态电压是不同的。甚至在某种极端的情况下,某个晶闸管会承受几乎所有的电压,而其他的晶闸管只承受非常小的电压。为了有效减少静态不均匀电压对晶闸管工作效率和使用寿命的负面影响,串联晶闸管的规格和静态伏安特性应尽可能一致。此外,可以通过电阻均衡法来降低静态电压的不均匀性,即将晶闸管视为高阻值电阻器(约1兆欧),然后给串联电路中的每个晶闸管并联一个低阻值电阻器,通过调整低阻值电阻器的电阻值来调节每个晶闸管的等效电阻值,使施加在每个晶闸管上的静态电压均匀分布。
动态不均匀电压:在晶闸管的开关过程中,由于伏安特性不一致,施加在串联电路中每个晶闸管上的动态电压是不同的。为了有效减少动态不均匀电压对晶闸管工作效率和使用寿命的负面影响,串联晶闸管的规格和动态伏安特性应尽可能一致。此外,通过施加足够大的门极触发信号,可以显着减小串联晶闸管之间的导通时间差,这也有助于降低动态不均匀电压。当然,通过将RC电路并联到串联电路中的每个晶闸管以吸收过电压,就能让施加到每个晶闸管上的动态电压均匀分布。
2- 晶闸管的并联
与电阻器的并联类似,将多个晶闸管并联起来可以提高其整体的电流容量。由于参数和伏安特性的不同,流经并联晶闸管的电流分布并不均匀。因此,通过选择参数和伏安特性尽可能一致的晶闸管,可以有效降低并联晶闸管的动态和静态不均匀电流。另外,通过配备均流电抗器,可以有效降低动态不均匀电流,其电流损耗小于电阻器的电流损耗。再者,通过施加足够大的门极触发信号,可以显着减小并联晶闸管之间的导通时间差,从而在短时间内有效地触发每个晶闸管,以实现动态电流均衡。然而,随着半导体技术的发展,晶闸管的电流容量越来越大,因此在实际使用中,没有必要将晶闸管并联。
3- 晶闸管的串并联
在某些情况下,我们需要同时将多个晶闸管串联和并联到一个电路中,但由于晶闸管的通态压降较小,因此建议先将晶闸管串联,以减小晶闸管之间的通态压降差异,然后再将晶闸管并联,以实现电流均衡。
4.6 晶闸管的主要类型
1- 快速开关晶闸管
快速开关晶闸管(FST)具有优异的动态特性。与普通晶闸管相比,FST具有开通时间短(通常为4-8微秒)、关断时间短(通常为10-60微秒)以及对dv/dt和di/dt容差大等优点。此外,普通晶闸管只能在50Hz的频率下工作,而FST可以在更高的频率(400Hz以上)下工作。还有一种快速开关晶闸管叫做高频晶闸管(HFT),开关时间更短,开关速度更快,更适合在高频电路(10kHz以上)工作。由于FST和HFT的工作频率较高,开关损耗的热效应不容忽视,因此它们的额定电压和额定电流通常不够高,以避免烧毁。
2- 双向晶闸管

双向晶闸管(又称三端交流半导体开关或 TRIAC)可以被认为是一对反并联的单向晶闸管(又称可控硅整流器或 SCR)。双向晶闸管是交流固态继电器和模块中的常用核心器件(点击查看更多交流固态继电器)。双向晶闸管的正向特性与单向晶闸管相同,但其反向特性与单向晶闸管的不同。这是因为双向晶闸管不具有反向阻断能力,而是具有类似于正向传导的能力。因此,双向晶闸管的伏安特性曲线在坐标轴上是中心对称的。双向晶闸管具有T1极(连接到P型半导体材料的主电极)、T2极(连接到N型半导体材料的主电极)和门极(G极)。由于双向晶闸管是交流开关,因此其额定电流为额定导通电流的有效值,即IT(RMS)。而且,双向晶闸管的参数中没有正向峰值电压和反向峰值电压,只有最大峰值电压。除了这些之外,双向晶闸管的大部分参数与单向晶闸管的相同。
3- 逆导晶闸管

与双向晶闸管的设计思路相似,将单向晶闸管和续流功率二极管进行反并联连接就能得到逆导晶闸管(RCT)。逆导晶闸管的这种特殊结构使得阳极和阴极的发射结都处于短路状态,因此与快速开关晶闸管相比,逆导晶闸管的关断时间更短(几微秒),工作频率更高(几十千赫兹)。因为逆导晶闸管具有通态压降低、关断时间短、额定结温高、耐高压、耐高温的优点,且将逆导晶闸管应用于开关电源和UPS等应用有助于简化电路设计。
4- 光触发晶闸管

光触发晶闸管(LTT,又称光控晶闸管)是一种利用光信号作为触发方式的晶闸管。光触发晶闸管的门极区集成了光电功率二极管作为光触发器,就其工作原理而言它是一种门极触发器,只是将门极触发电流替换为光信号的强度。这种触发方式有助于确保主电路与控制电路之间的电气绝缘,还可以避免电磁干扰的影响。此外,为了提高光触发晶闸管的触发灵敏度,其门极区常采用放大门极结构或双重放大门极结构。在实践中,低功率光触发晶闸管通常用于电气隔离,或者为高功率晶闸管提供触发信号。大功率光触发晶闸管通常用于保证控制设备与高压电力设备之间的良好绝缘。
§5. 什么是全控型器件?
5.1 全控型器件介绍
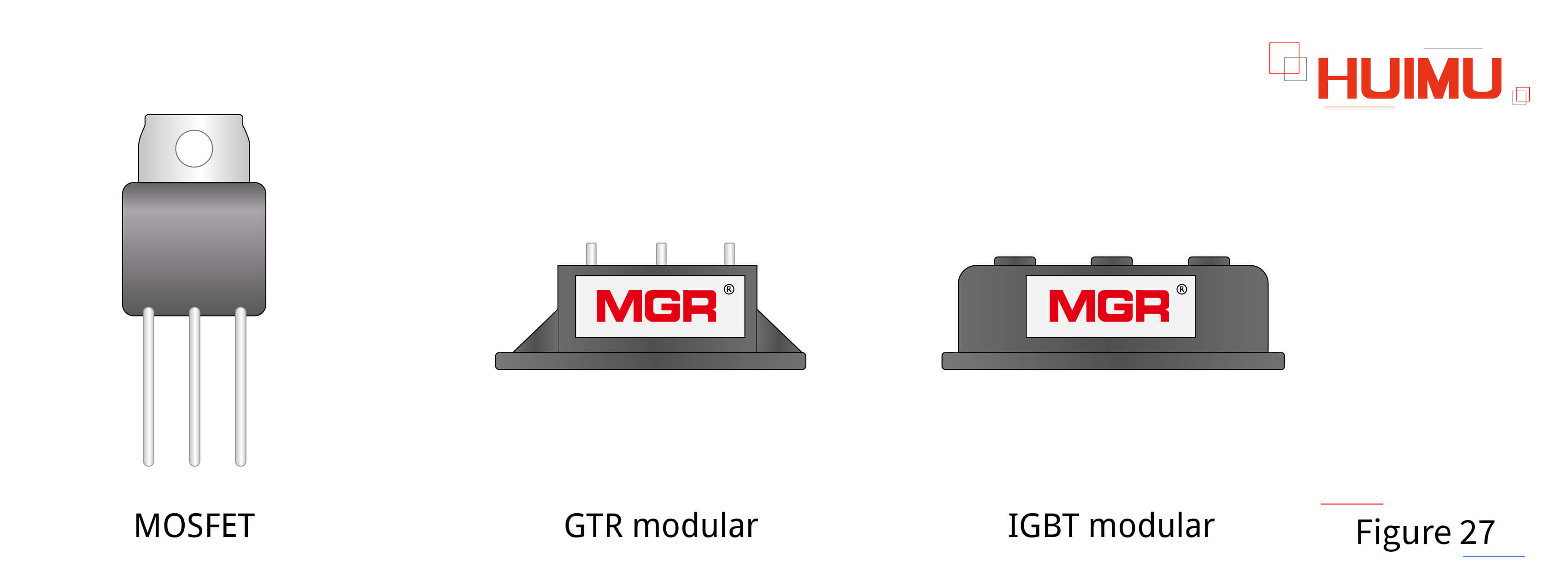
全控型器件发明于1980年代,开创了功率电子技术的新时代。与半控型器件不同的是,全控型器件为自关断器件,可以通过控制信号完全关断。全控型器件的种类很多,如门极可关断晶闸管(如GTO) 、双极结型晶体管(如GTR)、场效应晶体管(如MOSFET、JFET)、复合型器件(如IGBT、MCT、SIT、SITH、IGCT)。它们大多采用独特的复合结构,具有其出色的性能和普遍的应用领域。下面我们将对它们进行简要介绍。
5.2 门极可关断晶闸管
5.2.1 GTO介绍
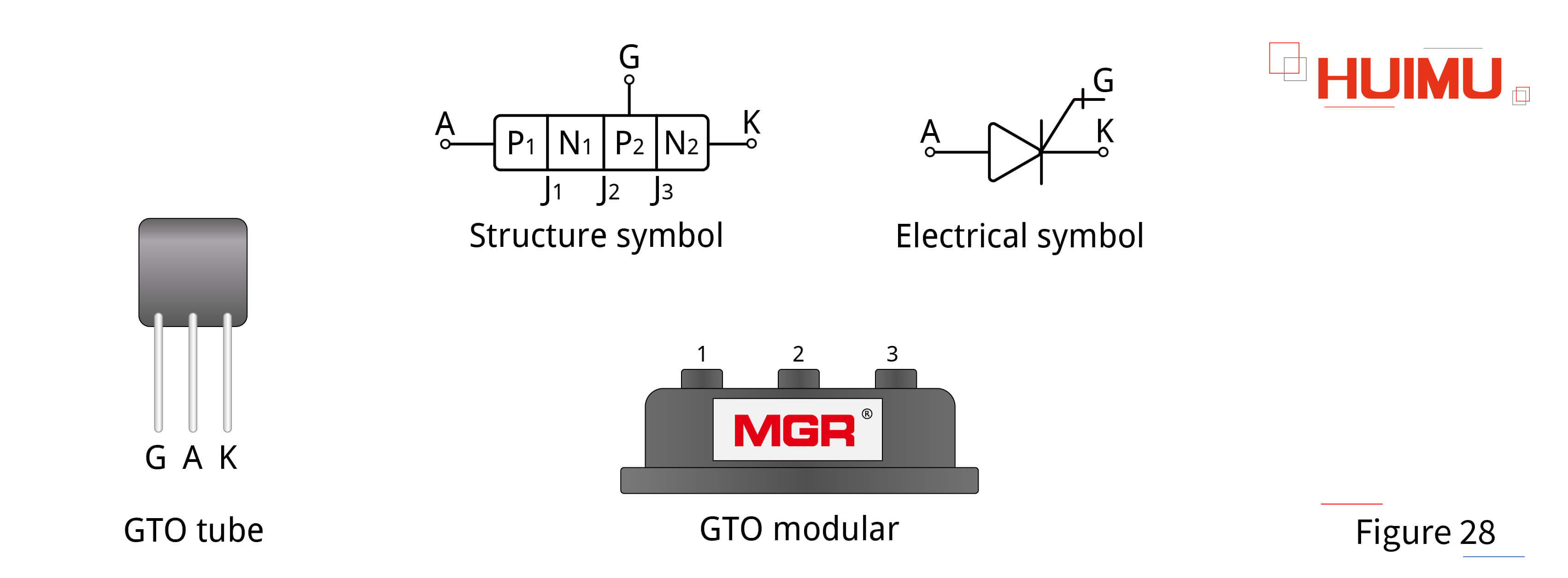
在晶闸管问世后不久,门极可关断晶闸管(GTO)作为晶闸管的派生物而出现。然而,即便如此,两者的工作原理是完全不同的。例如,SCR是一个半控型器件,一旦开通,门极信号就不再有任何作用,反之GTO是一种全控型器件,即使在开通后也可以通过施加负脉冲门极信号来关断。
5.2.2 GTO是如何工作的?
5.2.2.1 GTO的基本结构

由于GTO是SCR的衍生物,其结构与SCR非常相似,然而,GTO比SCR多了一个N+缓冲区,这导致了其开通时间比SCR的更短,反向阻断能力比SCR的更弱。当然,就实际构造而言,GTO管是一种多单元功率器件,包含了数十个甚至数百个GTO单元。这些GTO单元的阴极和门极在GTO管内并联,且共用一个阳极。由于每个GTO单元的阴区很小,这大大缩短了阴极和门极之间的距离,使P2基区的侧向电阻很小,从而可以从门区汲取更大的电流。在这种情况下,只要门极的反向电流足够大,V1的集电极就易于被关断,因此GTO也易于被关断。GTO管的这种特殊结构使其具有比SCR更高的容量密度和更短的开通时间,但其反向阻断能力比SCR弱,仅为20-30伏。再者,GTO 管具有更强的di/dt耐受能力和过载耐受能力,例如,如果di/dt过大,SCR一旦局部过载和过热就会烧坏,因为它只有一个单元。然而,对于GTO管来说,di/dt所造成的过载和过热会分散到其内部的GTO单元,即使部分GTO单元被烧毁,其他单元也能继续工作,因此GTO被广泛应用于兆瓦级以上的大功率应用中。此外,GTO不需要换向电路,因此可用于1kHz以上的设备,而SCR只能用于1kHz以下的设备。
为了优化GTO的开关特性,一般会在其上反并联一个功率二极管。为了便于设计和使用,该功率二极管将直接集成到GTO中,并形成一个逆导GTO,其结构有点类似于逆导晶闸管(RCT)。需要注意的是,逆导GTO不再具有承受反向电压的能力。如果逆导GTO需要承受较大的反向电压,则需要在其上串联一个功率二极管。
5.2.2.2 GTO的工作原理
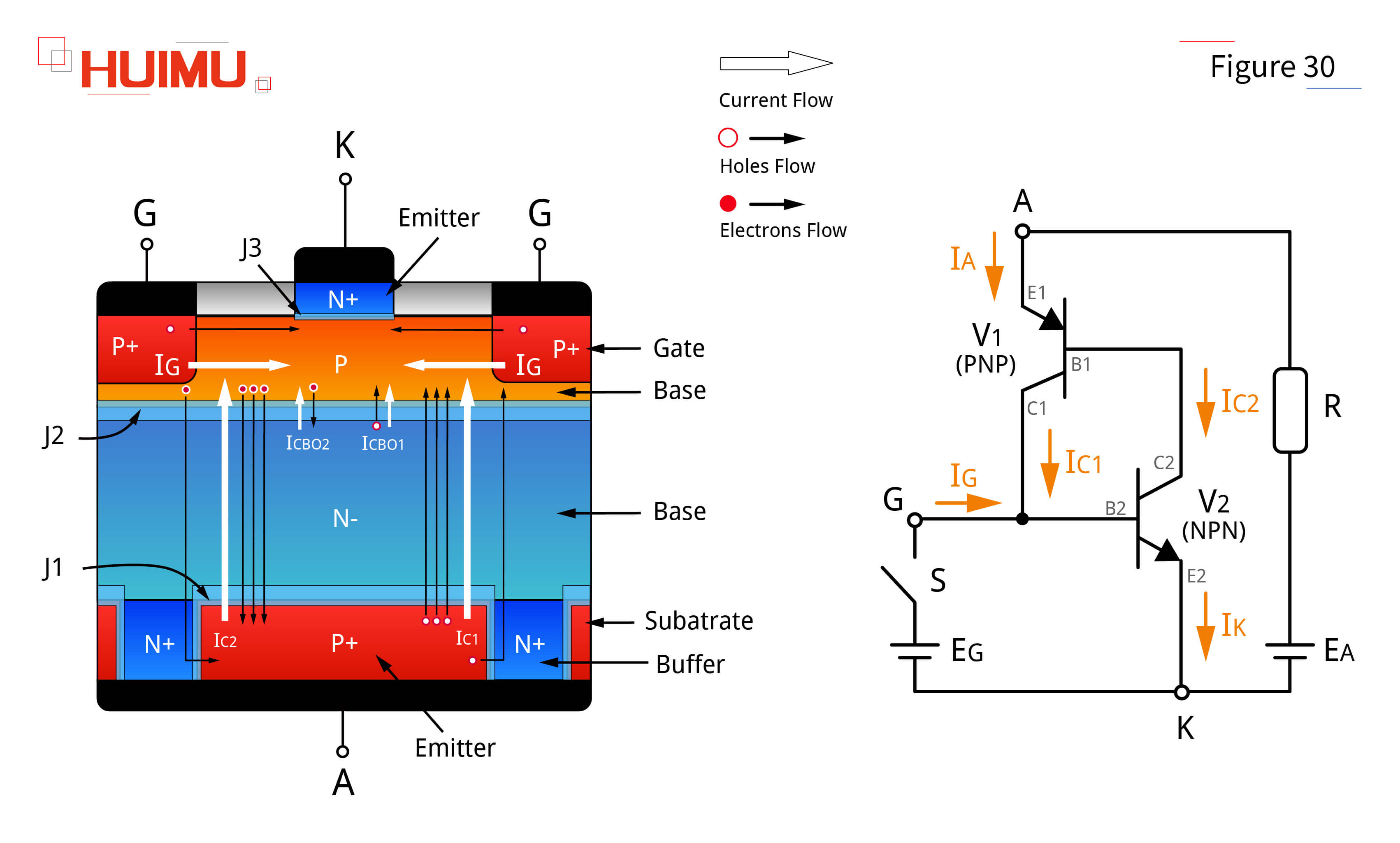
GTO的开通原理与SCR的非常相似,都是由门极信号的正反馈机制所触发的。不过,GTO有一个额外的N+区,这降低了其电导率,有助于加快这个正反馈过程。GTO的α1被设计得很小,比如,SCR开通时,α1+α2≥1.15,GTO开通时,α1+α2≈1.05,因此GTO的饱和深度比SCR浅,更接近临界饱和状态。这种设计使等效晶体管V2对门极控制信号更加敏感,更容易开通和关断,但因此GTO的通态压降会比SCR的更高。如果要关断GTO,只需向门极提供足够大的反向电流以排出P基区中的空穴并将大量自由电子注入到N-基区,那么随着从P+区注入基区的空穴逐渐减少,IC1和IC2也会降低。经过一系列正反馈过程后,直到阳极电流IA小于维持电流IH,GTO会因为退出饱和状态而被彻底关断。
* GTO的计算公式
GTO的计算公式与SCR的相同。
IC1 = α1 * IA + ICBO1, (10)
IC2 = α2 * IK + ICBO2, (11)
IK = IA + IG, (12)
IA = IC1 + IC2, (13)
IA = (α2 * IG + ICBO1 + ICBO2) / [1 - (α1 + α2)].(14)
|IGRP| > (α1 + α2-1) * IATO / α2, (15)
Βoff = IATO / |IGRP|.(16)
如等式(14)所示:
当α1 + α2接近0时,IA将趋向于漏电流;
当α1 + α2 接近 1 时,IA 将趋于无穷大。
5.2.3 GTO的主要参数
GTO的大部分参数与SCR的相同。
1- 开启时间 ton
导通时间ton是延迟时间 td 和上升时间 tr 的总和。
2- 关断时间 toff
关断时间toff是存储时间ts和下降时间tf的总和。
3- 最大关断阳极电流 IATO
最大关断阳极电流 IATO,也称为最大可控阳极电流,是GTO的额定电流。如果阳极电流IA大于IATO,α1 + α2不能满足略大于1的可控条件,因此GTO的饱和程度会加深,无法正常关断。
4- 电流关断增益 βoff
电流关断增益βoff是最大关断阳极电流IATO与门极反向脉冲峰值电流IGRP的比值,即βoff=IATO/IGRP。不过,由于GTO的βoff太小(通常为3-8),因此需要很大的门极反向脉冲电流才能将GTO切断。例如,假设βoff=3,如果要关断掉额定电流为1000A的GTO,那么门极反向脉冲电流应当为300A。从工作原理的角度来看,关断GTO的过程相当于用强输入电流来控制强输出电流,这在功耗和安全性方面都令人失望,因此这一重大缺点限制了GTO的应用领域。
5.2.4 GTO的基本特性
5.2.4.1 GTO的静态特性
GTO的静态特性与SCR的相同,只是GTO的擎住电流IL(通常为2A)比SCR的(通常为100-500mA)大。
5.2.4.2 GTO的动态特性

1- 开通过程
与SCR的导通过程类似,当UAK = 100% UAK1且UG ≥ UGT时,GTO将进入导通状态,并在其输出端产生一个小的通态压降。与SCR不同的是,由于GTO采用多单元构造,因此需要更大的门极触发电流IGT。GTO的延迟时间td约为1-2微秒。GTO的上升时间tr随导通状态阳极电流的增加而增大。
2- 关断过程
当向门极施加反向脉冲电压以提供足够大的反向脉冲电流时,GTO将进入关断过程。GTO的关断过程分为存储时间ts、下降时间tf和尾部时间tt。
存储时间ts是IA从IA1的100%下降到IA1的90%所需的时间。当向GTO的门极施加门极反向脉冲电压UG2时,在门极上产生的门极反向脉冲电流就会提取饱和导通期间存储在P基区的载流子,从而使等效晶体管V2退出饱和状态。然后,门极反向脉冲电流会从0迅速上升到IGRP。门极反向脉冲电流的上升率di/dt取决于电路电感和阳极电压。在存储时间内,UAK和IA保持不变,因为GTO尚未完全退出饱和状态,在适当的条件下可以再次开通。
下降时间tf是IA从IA1的90%下降到IA1的10%所需的时间。当反向脉冲电流达到IGRP时,阳极电流IA开始快速下降,阳极电压UAK开始上升。随着基区电导率降低,导致α1 + α2 ≤ 1,GTO开始进入关断状态。由于下降时间tf很短(约2μs),并且IA的下降率很大,因此GTO的输出端会出现一个尖峰电压。
尾部时间tt是IA从IA1的10%下降到0所需的时间。在门极反向脉冲电压的作用下,P基区的残余载流子将进一步复合,使得UAK逐渐上升至UAK1,IA逐渐下降至0。在此期间,由于缓冲电路的作用,GTO的输出端会出现瞬态过冲,并产生尖峰电压。需要注意的是,UAK的上升率不宜过大,否则GTO可能会再次开通。另外,通过维持适当的门极反向脉冲电压,可以有效缩短尾部时间tt。
一般来说,下降时间tf小于存储时间ts,存储时间ts小于尾部时间tt,即 tf < ts < tt。当IA降至IA1的10%时,就可以认为GTO已经关断了,因此关断时间的计算公式为:toff = ts + tf。
5.3 巨型晶体管
5.3.1 GTR介绍

巨型晶体管(GTR)是一种双极结型晶体管,发明于1970年代。由于GTR的开关时间非常短(通常为几微秒),因此GTR的工作频率(通常为1-20kHz)高于GTO的工作频率(通常为几百赫兹)。GTR的功率容量、额定电压和额定电流也非常大,如1800V/800A/2kHz、1400V/600A/5kHz、600V/3A/100kHz,因此也被称为功率晶体管或功率BJT。此外,GTR还具有饱和电压低,开关特性好,安全工作区宽,功率容量大,自关断能力强等优点,因此GTR在中容量和中频领域中逐渐代替了传统的晶闸管和GTO,如电源,电机控制,通用逆变器等。然而,由于GTR需要非常高的驱动功率来控制其开关状态,因此其驱动电路设计得非常复杂。另外,GTR抗浪涌电流能力差,容易因二次击穿而损坏。随着电力电子技术的发展,GTR的这些缺点导致其逐渐被功率MOSFET和IGBT所取代。
根据结构的不同,GTR可分为NPN型GTR和PNP型GTR,下面以NPN型GTR为例进行说明。根据构造方式的不同,GTR可进一步分为单管型GTR、复合管型GTR(达林顿型GTR)和GTR模块。单管型GTR只有一个单元,具有饱和压降低、开关速度快、电流容量小、驱动功率大等特点。由于其电流增益β小(通常在10左右),单管型GTR通常用于小容量逆变电路。复合管型GTR由多个GTR单元组成,这些单元通过集成电路技术并联在一起,每个单元由一个达林顿管组成。复合管型GTR具有电流增益β大(通常可达几十或几百)、电流容量大、驱动功率小等优点.然而,由于其饱和压降高,关断速度慢,复合管型GTR一般用于中大容量逆变电路。GTR模块由封装在绝缘树脂外壳中的两个或多个单管型GTR或复合管型GTR组合而成。通过改变内部单元的连接方式,GTR模块可用作单桥臂、单相桥、三相桥、带泄放电路的三相桥。GTR模块具有安装方便、性能优良、适应性强等优点,已逐步取代了单管型GTR和复合管型GTR,并广泛应用于各种逆变电路中。
* 达林顿管

达林顿管是由西德尼·达林顿(Sidney Darlington)在1950年代发明的,旨在解决早期硅晶体管的电流增益β值低且偏差大的问题。如图33所示,达林顿管是一个共发射极放大器,由左侧的晶体管和右侧的晶体管级联而成。左侧的晶体管作为电流放大器,负责放大输入信号并输出到右侧的晶体管的输入端,而右侧的晶体管作为电压放大器,负责将输入的驱动电流信号转换为输出电压信号。达林顿管可视为一个等效晶体管,其类型与左侧的晶体管相同,例如,如果左侧的晶体管是NPN晶体管,那么达林顿管也是NPN晶体管。如果左侧晶体管和右侧晶体管都工作在放大区,那么达林顿管的电流增益β是两个晶体管的电流增益β的乘积。
5.3.2 GTR是如何工作的?
5.3.2.1 GTR的基本结构
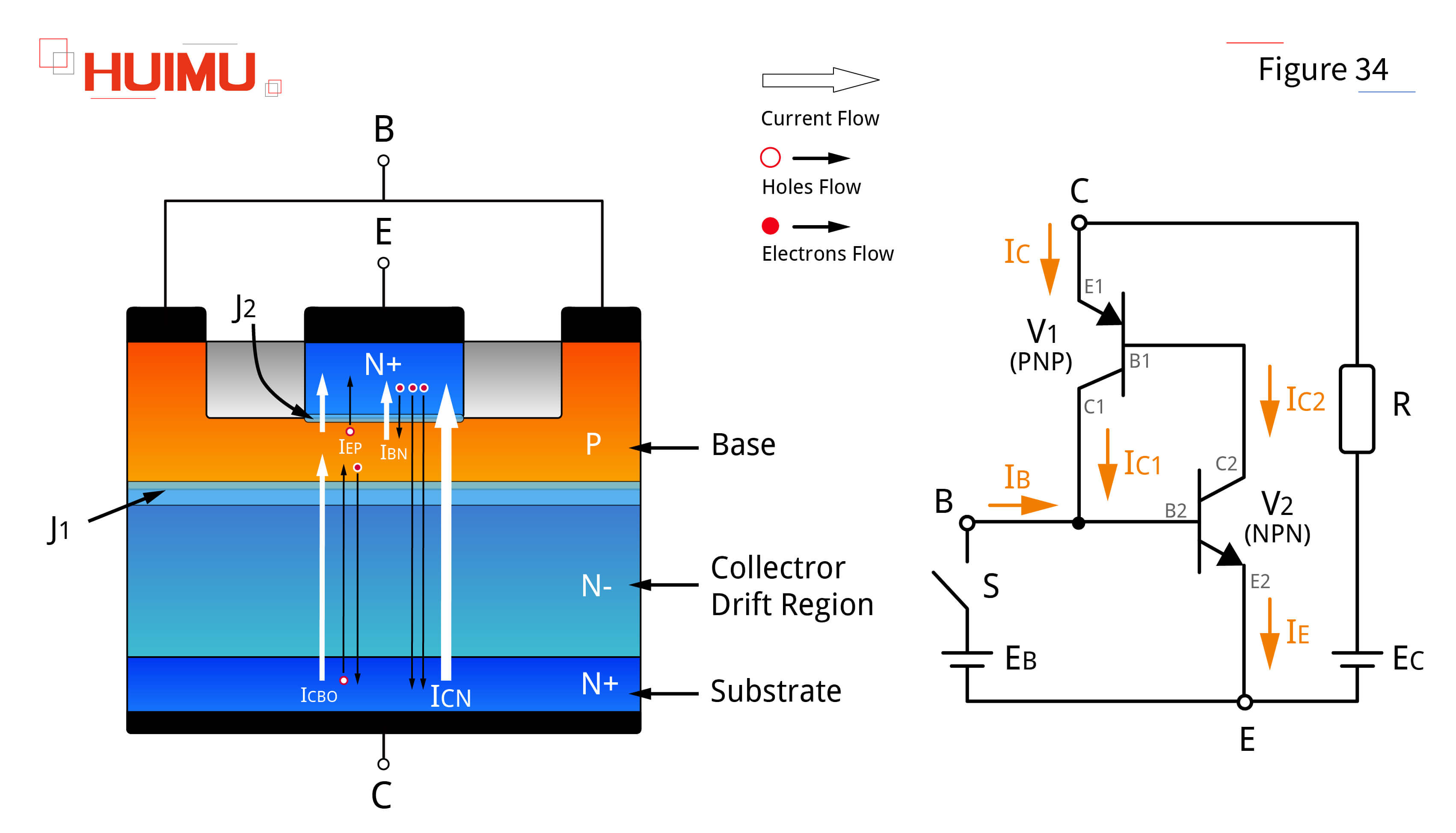
GTR的结构与BJT的类似,以NPN型GTR为例,它由集电结J1和发射结J2分成三个区域,即发射区、基区和集电区。发射区具有面积小和掺杂浓度高的特点,基区具有厚度薄(5-20μm)和掺杂浓度低的特点,而集电区可分为两部分,一个是面积大且掺杂浓度低的N-集电极漂移区, 另一个是面积小且掺杂浓度高的N+衬底区。
5.3.2.2 GTR的工作原理
GTR的工作原理和计算公式与BJT的相同。但需要注意的是,在导通过程中,N+衬底区会向N-集电极漂移区注入大量的自由电子,以增加J1的反向电流。
5.3.3 GTR的主要参数
GTR的大部分参数与BJT的主要参数相同。
1- 击穿电压 BV
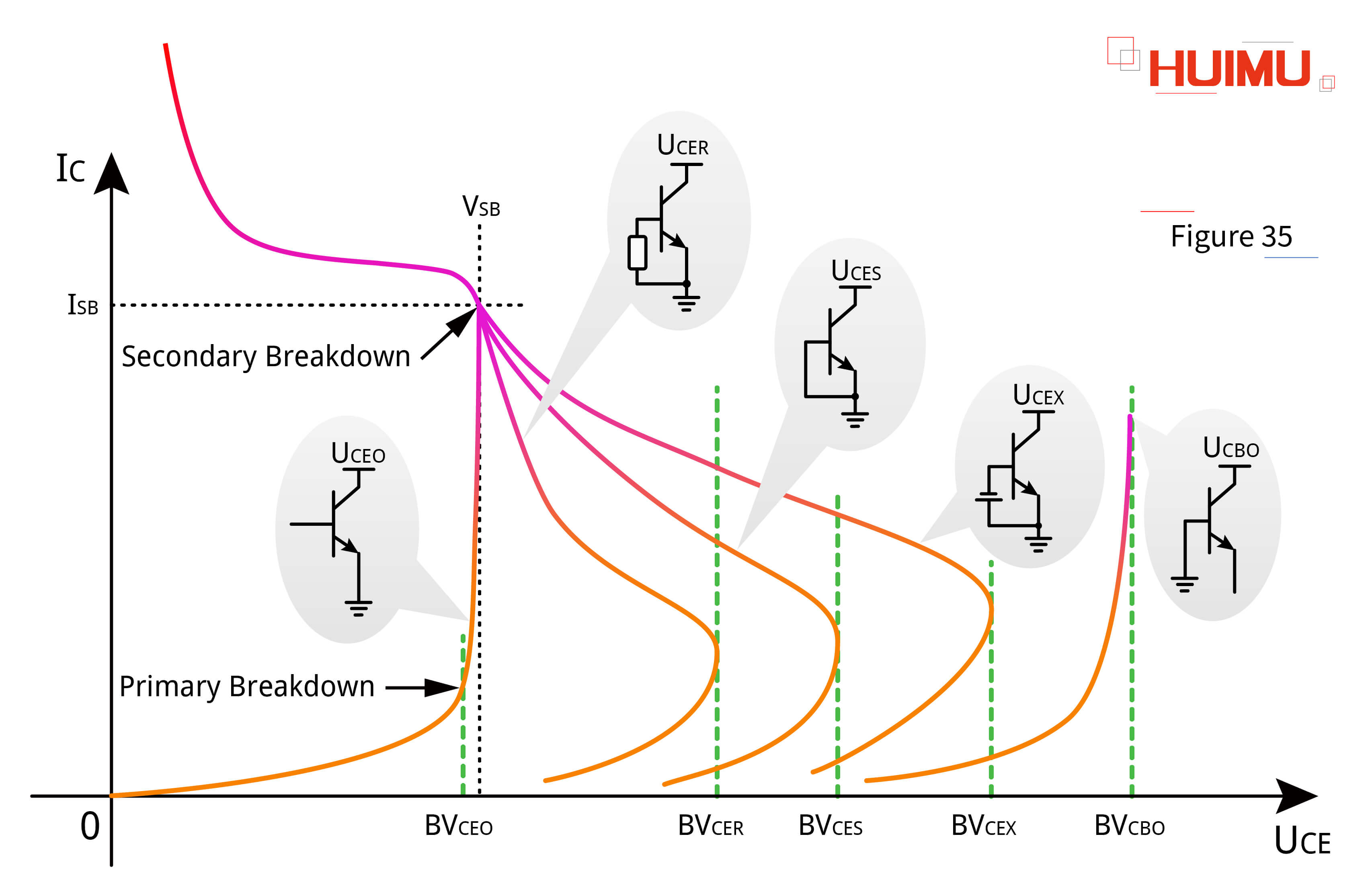
击穿电压BV是GTR发生击穿时的输出电压,只要GTR的输出电压UCE低于BV,GTR就不会击穿。根据GTR与外部电路的连接方式,击穿电压BV可分为以下几种类型。
● BVCBO是发射极开路时集电极和基极之间的反向击穿电压。
● BVCEO是基极开路时集电极和发射极之间的击穿电压。
● BVCER是当发射极和基极通过电阻连接时集电极和发射极之间的击穿电压。
● BVCES是发射极和基极短路时集电极和发射极之间的击穿电压。
● BVCEX是当发射极结反向偏置时集电极和发射极之间的击穿电压。
如图35所示,上述击穿电压的数值关系如下:
BVCBO>BVCEX>BVCES>BVCER>BVCEO
由此可得,无论GTR如何连接,只要其输出电压UCE低于BVCEO,就可以有效防止击穿。
2- 最大集射极间电压UCEM
最大集射极间电压UCEM是GTR正常工作时的最大输出电压,即GTR的额定电压。在实践中,为了设备的稳定运行和操作人员的安全,一般建议GTR的UCEM低于BVCEO。
3- 二次击穿功率 PSB
GTR发生二次击穿的功率是PSB,它是二次击穿电压USB和二次击穿电流ISB的乘积,再者,USB和ISB都不是常数,并且将随着IB 的变化而变化。
5.3.4 GTR的基本特性
5.3.4.1 GTR的静态特性

GTR的静态特性与BJT的相似。不过,与BJT不同,GTR只在饱和区和截止区工作,因此没有放大状态。这是因为如果GTR在放大状态下工作,其电流和功耗会非常高,不仅会增加不必要的使用成本,还会因结温过高而烧毁GTR。当然,在开通和关断状态之间的切换过程中,GTR必须经过放大区。因此,为了避免对GTR造成损坏,必须快速切换GTR的工作状态,以尽量减少GTR在放大区所花费的时间。
5.3.4.2 GTR的动态特性
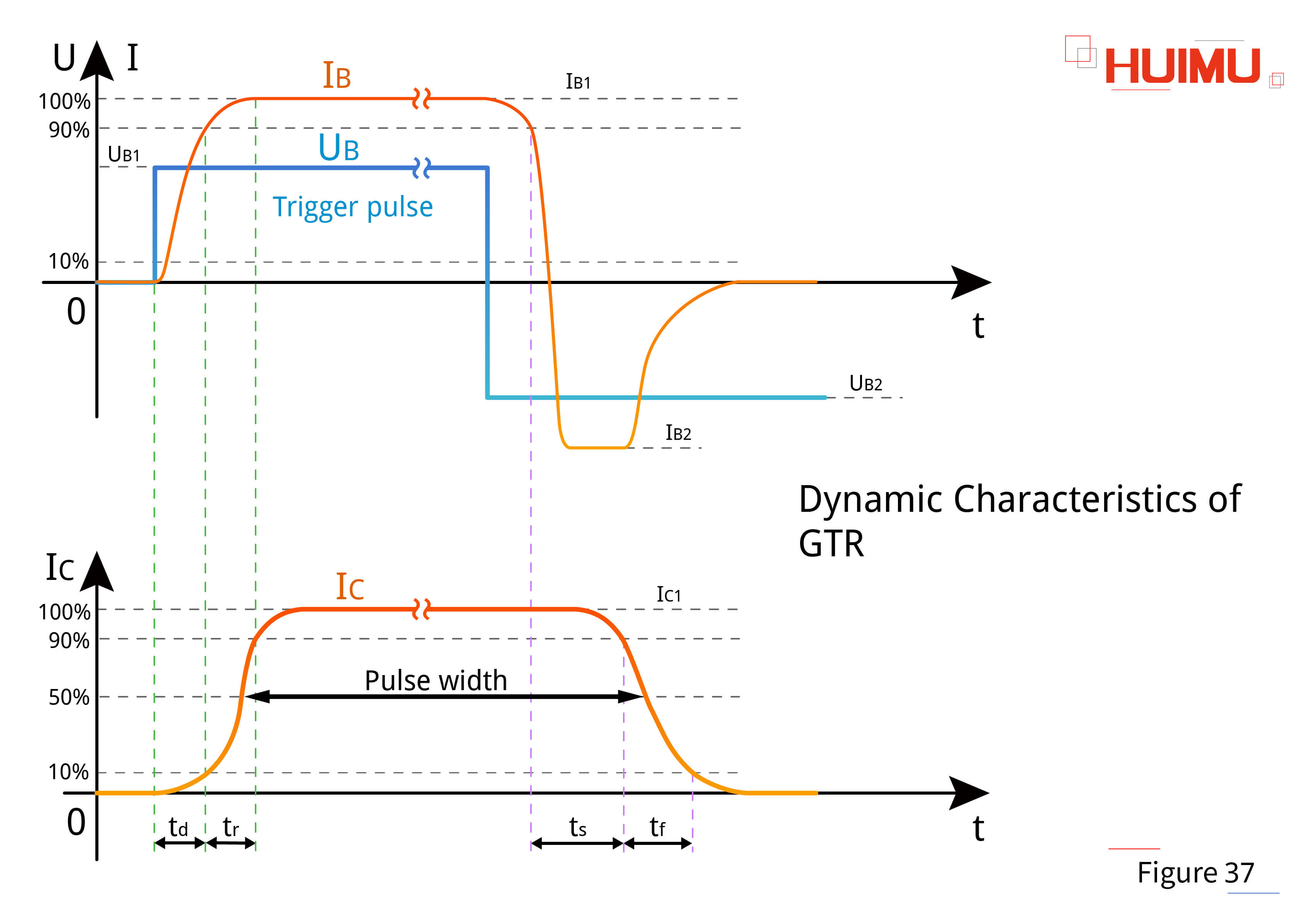
GTR的动态特性与BJT的相似。
1- GTR的开通过程
通过施加正向基极电流IB1,可以开通GTR。GTR的开通过程分为延迟时间td和上升时间tr。
开通时间的计算公式:ton = td + tr
2- GTR的关断过程
通过切断基极电流IB,可以关断GTR。此外,如果施加反向电流,则可以加速GTR的关断过程。关断过程分为存储时间ts和下降时间tf。
关断时间的计算公式:toff = ts+tf
* 如何加快GTR的开通过程?
● 增加一个加速电容器。由于电容器的电压在换向的瞬间不会突变,因此在GTR的基极电阻上并联一个电容器,可以改善GTR的开关特性。当然,如果选择结电容较小的快速开关 GTR 管,也能达到类似的效果。
● 提高正向驱动电流。在开通过程中,如果施加一个幅值大且前沿陡峭的正向驱动电流,就可以降低td和tr,以缩短开通时间ton。但是,驱动电流不能过大,否则会因过饱和而导致GTR的扩散时间ts增加。
* 如何加快GTR的关断过程?
● 降低饱和深度。通过降低开通过程中GTR的饱和深度,存储在基极的载流子将减少,这有助于缩短GTR的存储时间ts。
● 施加反向驱动电流IB2。如果在关断GTR时向基极施加反向过冲电流,那么基极中的载流子可以更快地被提取出来,这有助于缩短GTR的存储时间ts。
● 施加反向基极电压UB2。如果在GTR关断时提高反向基极电压,就能加快存储电荷的耗散速度,这也有助于缩短GTR的存储时间ts。但是,需要注意的是,反向基极电压不宜过大,以免击穿发射结。
3- GTR的二次击穿
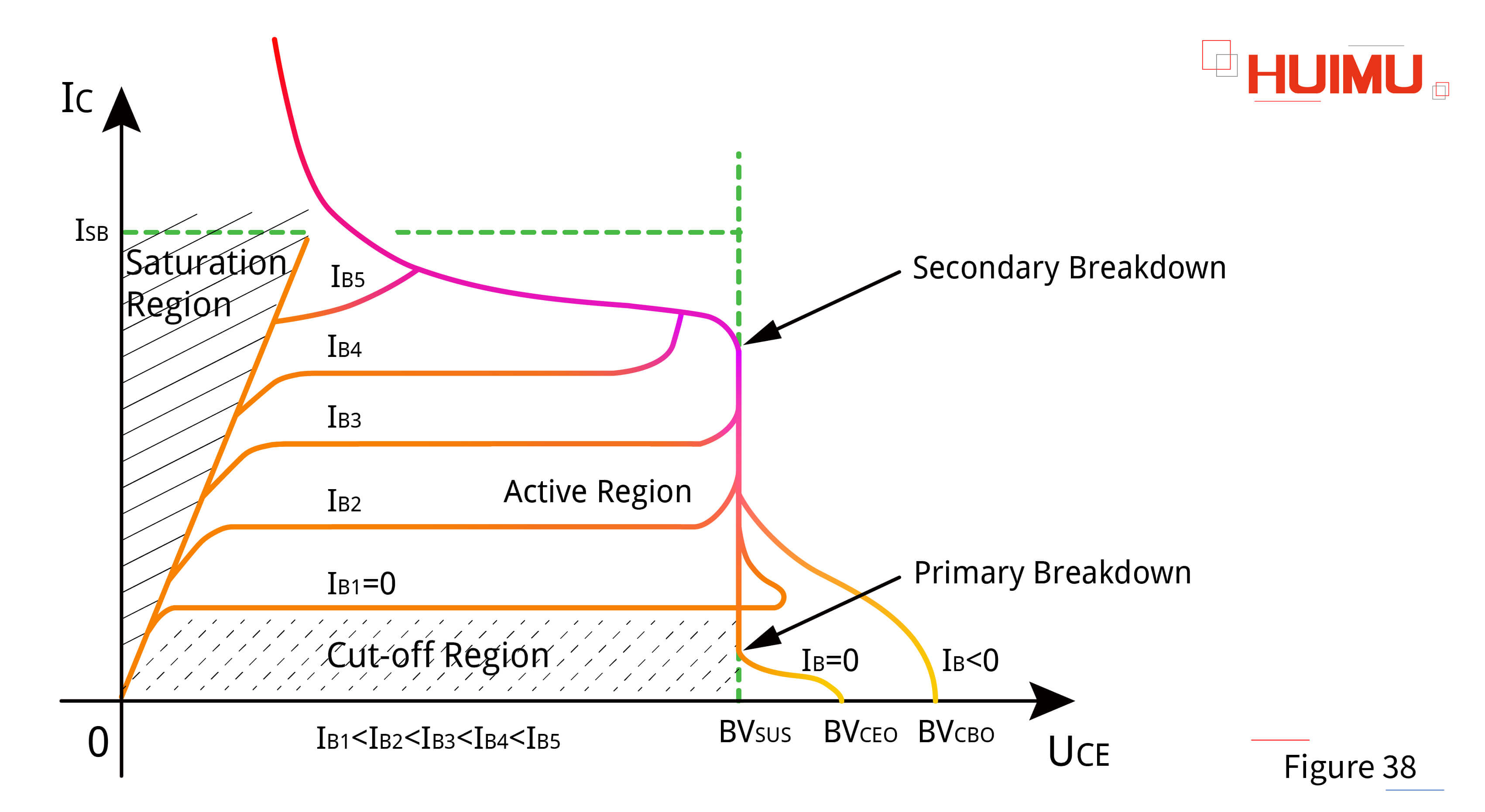
一次击穿:当UCE超过BVCEO时,IC会迅速增加,UCE将保持在维持电压BVsus,即GTR的一次击穿。在这种情况下,只要GTR的电流受到外部电路的限制,就不会损坏GTR。也就是说,如果UCE降低到BVCEO以下,GTR将恢复正常,不会影响其特性。因此,一次击穿并不是永久性的,而是可逆的。
二次击穿:如果在一次击穿后没有立即采取限流措施,那么一旦IC达到ISB,GTR内部存在的晶格缺陷将导致GTR中的局部电流密度增加,引起局部功耗增加,并导致GTR内部局部过热。这会使得本征载流子浓度急剧增加,从而进一步增加局部电流。经过一系列正反馈后,虽然GTR的表面温度并不高,但其内部的局部区域会在极短的时间内因温度过高而熔化成丝状短路区,从而在集电极和发射极之间形成低阻通道,这也就是所谓的负阻现象。在这种情况下,IC急剧增加,UCE急剧下降,即GTR的二次击穿。二次击穿会对GTR造成不可逆的永久性损坏,严重降低其性能,甚至使其无法使用。
4- GTR的安全工作区
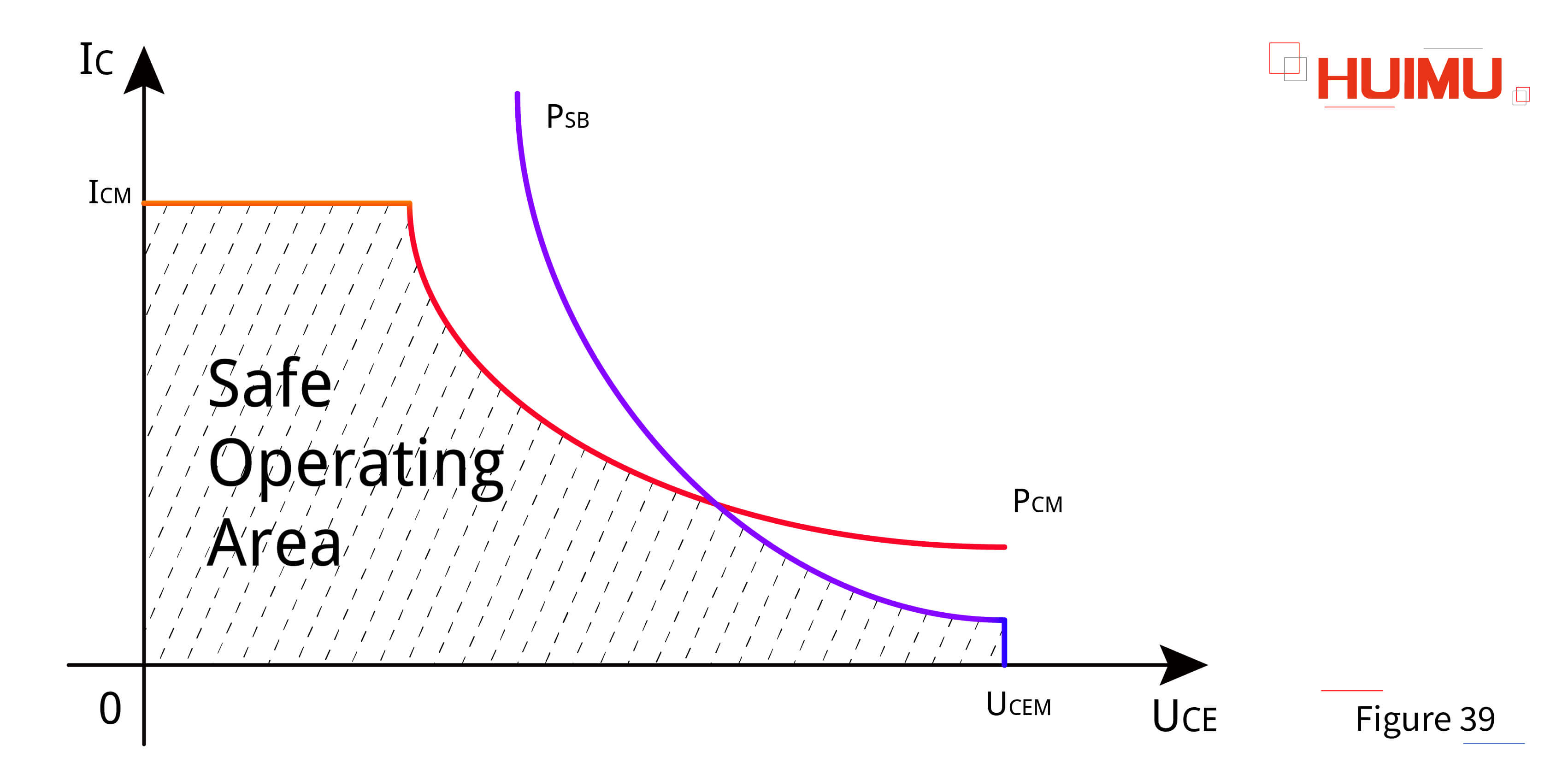
如果我们要让GTR安全稳定地工作,那么就需要保证其既不能被一次击穿,也不能被二次击穿。因此,由ICM,UCEM,PCM和PSB所围成的区域,就是GTR的安全工作区了,如图39所示。
5.4 功率MOSFET
5.4.1 MOSFET介绍
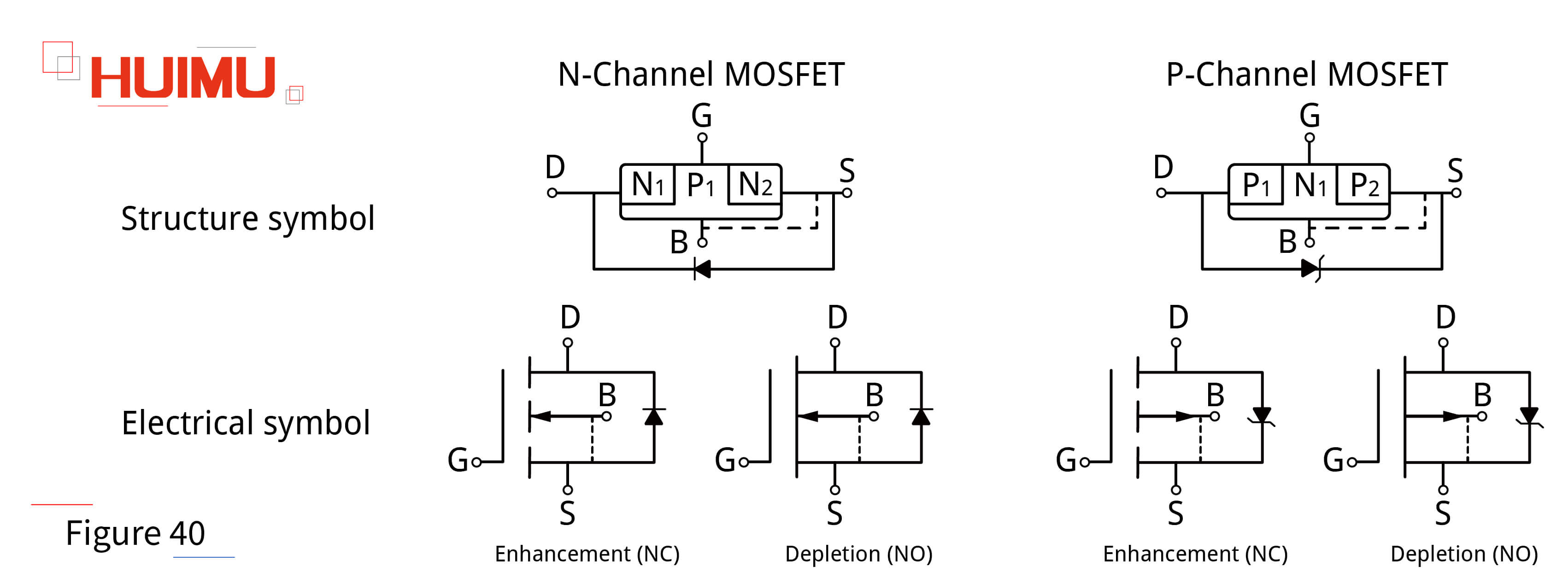
场效应晶体管(FET)是一种由电压控制的单极型器件。场效应晶体管的工作原理是,在电场的作用下,其内部形成了一条导电沟道,用以控制其导电性,从而实现场效应晶体管的开通和关断。根据结构及材料的不同,场效应管可分为结型场效应管(JFET,又称静电感应晶体管,SIT)和绝缘栅型场效应管。
金属氧化物半导体场效应晶体管(MOSFET)是一种绝缘栅场效应晶体管,主要由金属、氧化物和半导体组成,是现代电子技术中非常重要的电力电子器件。MOSFET具有诸多优点,如高输入阻抗、低噪声、低功耗、动态范围大、温度特性好、无二次击穿、驱动功率低、开关速度快、工作频率高、热稳定性好(优于GTR)、安全工作区宽、驱动电路简单、易于集成等。另外,MOSFET的栅极偏置可以是正,负以及零。与其他功率电子器件相比,MOSFET电流容量小,耐压低,但通过采用多单元集成结构,我们可以获得大功率、大容量的功率MOSFET,即双扩散MOSFET(DMOS)。总的来说,MOSFET适合于1kW以下的高频功率电子设备,如信号放大器、阻抗转换器、可变电阻器、恒流源、直流固态继电器。
5.4.2 MOSFET是如何工作的?
5.4.2.1 MOSFET的基本结构
MOSFET的主要组成部分是主体(B),也称为衬底或本体,其主要材料为硅。根据衬底的材料,MOSFET可以分为采用P型半导体作为衬底(P-Sub)的N-MOSFET(NMOS)和采用N型半导体作为衬底(N-Sub)的P-MOSFET(PMOS)。MOSFET的源极(S)和漏极(D)是嵌入衬底的两个高掺杂半导体,例如嵌入NMOS的两个N+区和嵌入PMOS的两个P+区。MOSFET的源极和漏极是完全对称的,这意味着源极和漏极是可以互换的。NMOS的载流子是自由电子,PMOS的载流子是空穴,且自由电子的传导速度是空穴的两倍,因此与PMOS相比,NMOS速度快、导通电阻低、驱动能力强、阈值电压小、1/f噪声高(一种低频噪声,其噪声功率与频率成反比)。需要注意的是,NMOS在栅极上施加高电压时会开通,施加低电压时会关断,因此NMOS的源极必须连接到电路的最低电位。PMOS在栅极上施加高电压时会关断,施加低电压时会开通,因此PMOS的源极必须连接到电路的最高电位。MOSFET的栅极(G)是衬底上的绝缘层,其常用材料为氧化铝(铝栅极),但正逐渐被多晶硅(多晶硅栅极)取代。栅极的内阻非常高(高达几百兆欧),因此栅极不与源极、漏极或衬底导通。
在实际使用中,为避免电路中的瞬时反向电流击穿MOSFET,我们可以在MOSFET的漏极和源极之间并联一个功率二极管。并且为方便使用,这个功率二极管是直接集成到MOSFET中的。
MOSFET的分支类型和衍生器件非常繁多。例如,当栅极电压为零时,如果MOSFET的源极和漏极之间存在导电沟道,则该MOSFET为耗尽型MOSFET,反之则为增强型MOSFET。如果MOSFET的源极和漏极位于同一平面,则该MOSFET为横向MOSFET(LMOS),反之则为纵向MOSFET(VMOS)。虽然MOSFET有四个端子,但源极和衬底通常接地,因此常见的MOSFET是三端子的。
1- 横向双扩散MOSFET(LDMOSFET)
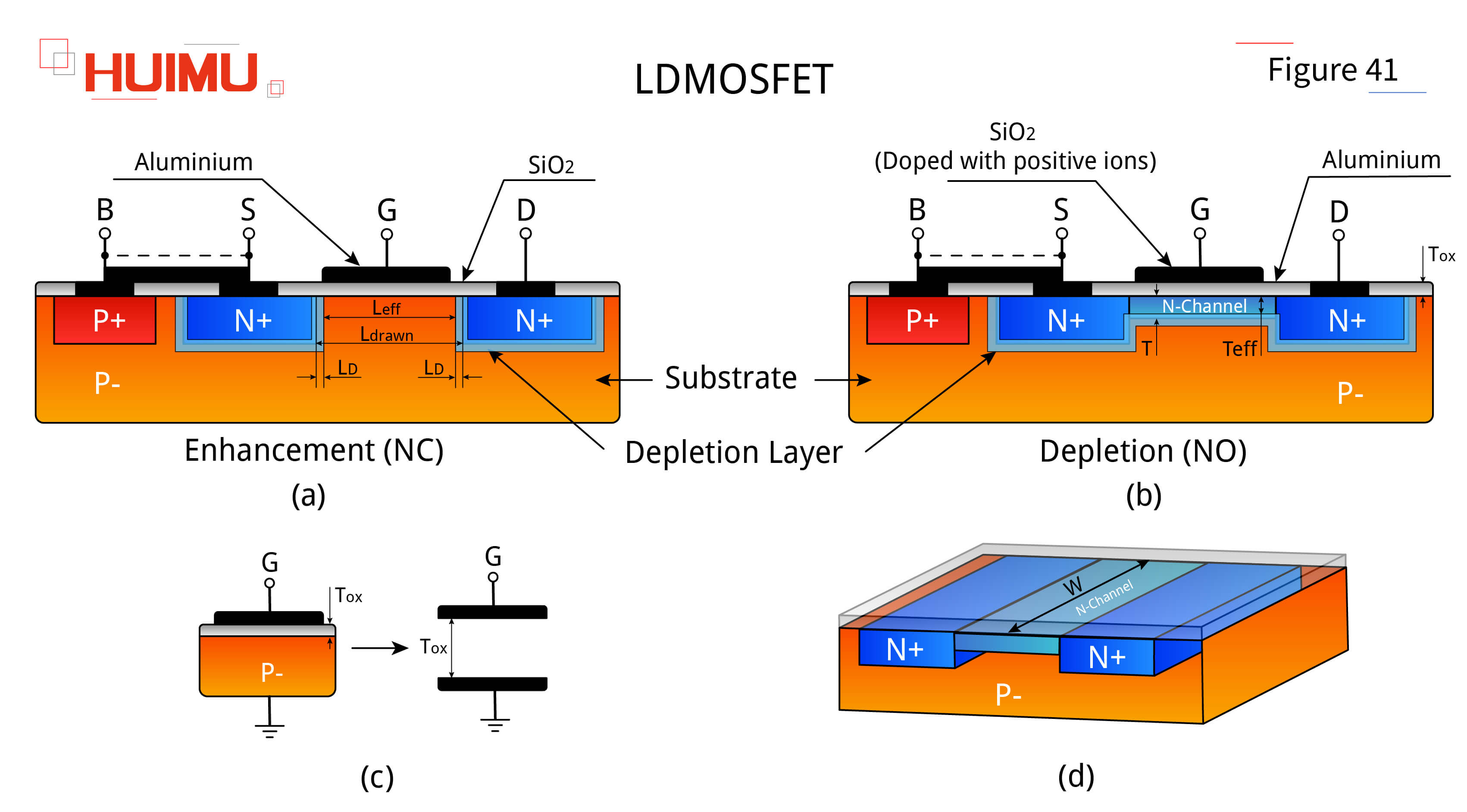
以N沟道LDMOSFET为例,如图41所示,其衬底是低掺杂的P-Sub区,通过高掺杂的P+区与主极 (B) 相连。N沟道LDMOSFET的源极和漏极区是两个高掺杂的N+区,分别连接到源极(S)和漏极(D),这两个区域完全相同,理论上可以互换。LDMOSFET的栅极 (G) 位于绝缘层之上,与衬底没有任何接触,从而形成一个等效电容器。LDMOSFET中的自由电子需要借助位于源区和漏区之间的导电沟道来传导。当栅极电压为0时,增强型N沟道LDMOSFET的源极和漏极之间没有沟道,如图41(a)所示,而耗尽型N沟道LDMOSFET的源极和漏极之间存在沟道,如图41(b)所示。
* MOSFET的等效电容器
MOSFET的等效电容器以栅极和衬底为电容器的极板,以绝缘层为电介质,绝缘层的厚度Tox为极板间的距离,如图41(c)所示。那么我们就可以得到它的电容计算公式为 C = ε * A / Tox,其中ε是介电常数,A是板面积。因此,我们可以看到Tox越大,C越小。此外,根据电荷量计算公式,Q = C * V,如果V确定,则C越小,Q越小,导电沟道中的电子浓度越小,电流(单位时间内通过任意横截面的电荷量)越小,即沟道电阻越大, 或MOSFET的沟道电阻越大。
* 导电沟道
源极和漏极区之间的距离称为沟道长度(L),如图41(a)所示,计算公式为 Ldrawn = Leff + 2 * LD,其中 Ldrawn为沟道总长度,Leff为有效沟道长度,LD为横向扩散长度。通过减少沟道长度,可以降低沟道电阻,这不仅能降低MOSFET的功耗,还能增加单位面积上的MOSFET的数量。然而,由于制造工艺的限制,目前的沟道长度只能达到纳米级。
垂直于导电沟道水平方向的距离称为沟道宽度(W),如图41(d)所示,它的增加将增大MOSFET等效电容的极板面积,增大等效电容,从而减小沟道电阻。然而,随着等效电容的增加,等效电容器的充电时间也会增加,从而降低MOSFET的开关速度,因此当达到某个极限值时,沟道宽度的增加无法继续降低沟道电阻。
绝缘层底部到沟道底部的距离称为沟道厚度(T),如图41(b)所示。通过增加栅极电压,可以增加沟道厚度,从而减小沟道电阻,但一方面,MOSFET的体效应会减小有效沟道厚度Teff,另一方面,栅极电压不能无限制地增加,如果栅极电压超过最大驱动电压,MOSFET就会被击穿。
* 体效应
P-Sub区和N+区形成一个PN结,然后PN结处就会形成一个耗尽层,从而减小导电沟道的有效厚度Teff,导致需要更高的驱动电压才能开通MOSFET。这种阈值电压偏移的现象,就是MOSFET的体效应了,其在源区和漏区在同一平面上的情况下会很明显。通常,在P-Sub区中加入一个高掺杂的P+区作为主体极(B),并与源极(S)一起接地,这样可以有效减少耗尽层,降低体效应带来的负面影响。
2- 互补MOS(CMOS)
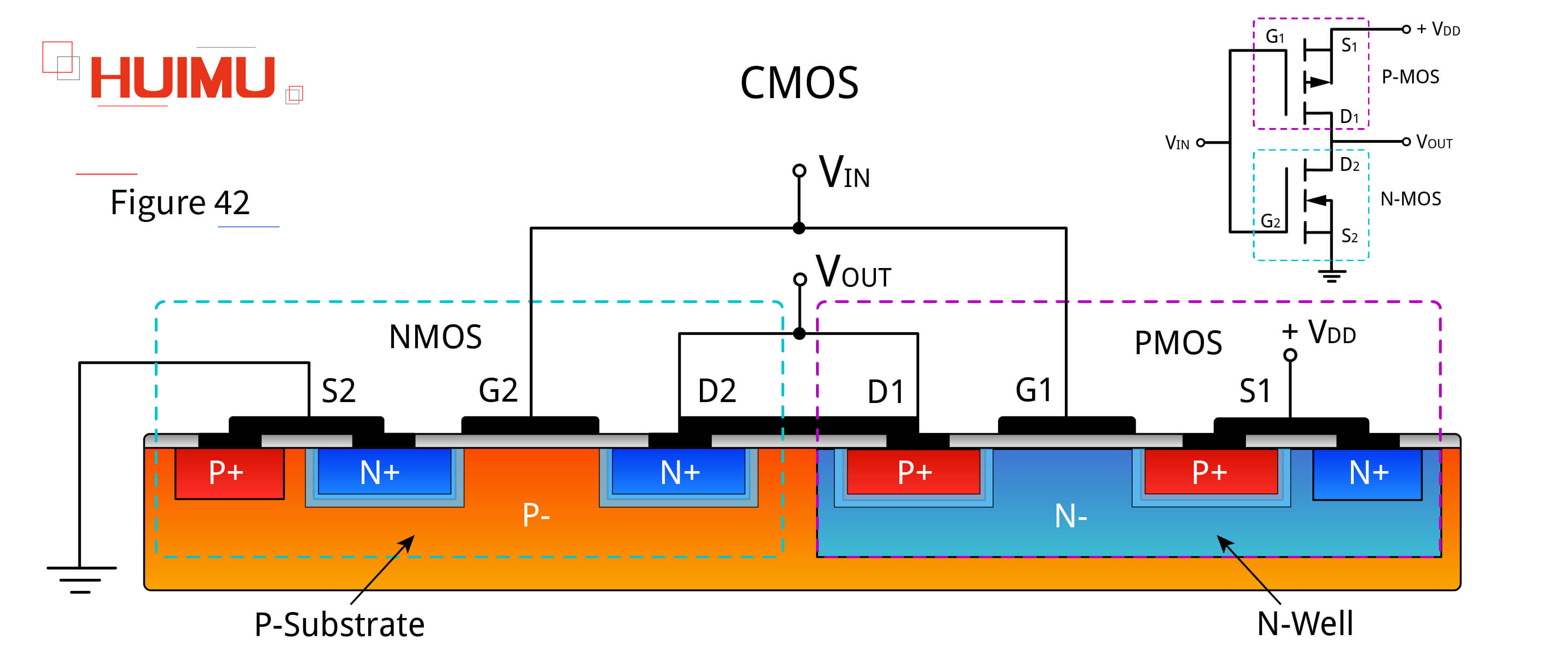
由于NMOS和PMOS在物理特性上互补,即NMOS在高电位下工作(类似于逻辑1),而PMOS在低电位下工作(类似于逻辑0)。因此,如果能将NMOS和PMOS集成在一起,就能形成复杂的逻辑电路(如 NOT、AND、NAND、OR、NOR、XOR、XNOR)。这种在硅晶圆模板上制造同时包含NMOS和PMOS的集成电路的设计工艺,被称为互补MOS (CMOS)。通常PMOS直接嵌入在NMOS中,因此PMOS的衬底也称为N-Well。因为CMOS结合了NMOS和PMOS的特点,因此具有高速、低噪声、高阻抗和宽工作电压的优点。此外,CMOS仅在开关过程中消耗能量,因此还具有低功耗和低发热的优点。
3- VDMOSFET
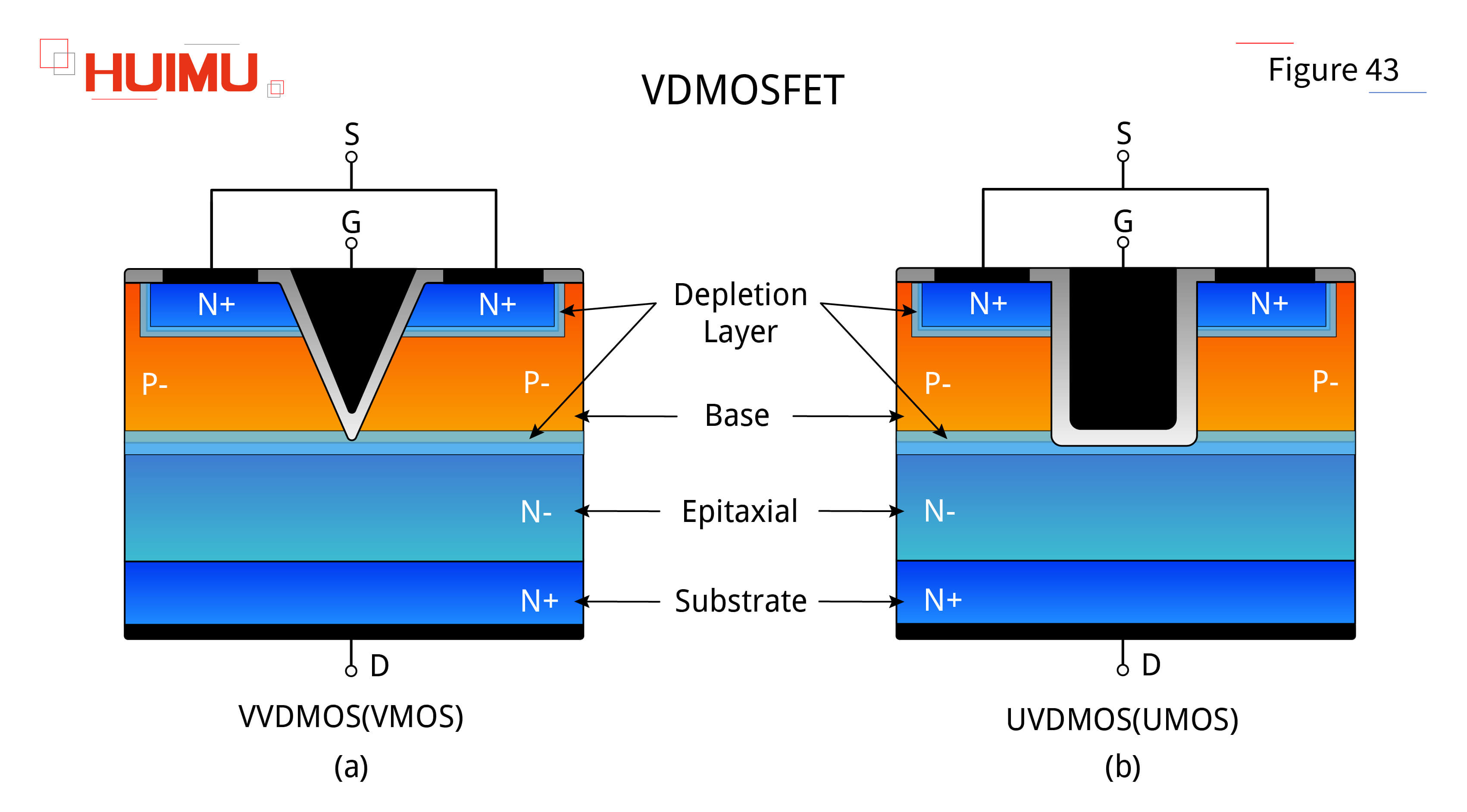
与LDMOSFET不同的是,垂直双扩散MOSFET (VDMOSFET)的源极和漏极不在同一平面上,如图43所示,因此不需要单独的引脚连接主体极(B)。VDMOSFET的水平面积小于LDMOSFET,但其垂直面积大于LDMOSFET。这是因为VDMOSFET额外多了一个低掺杂浓度的N-外延区,而这个N-外延区在工作原理上等同于JFET的沟道,因此VDMOSFET可视为MOSFET和JFET的结合体。虽然N-外延区增加了VDMOSFET的导通电阻,使其能够承受更高的电压,但由于电导调制效应,随着流过PN结的电流增加,N-外延区的等效电阻会减小。即使如此,VDMOSFET的耐压能力始终强于LDMOSFET。并且该PN结可以形成一个寄生功率二极管,可有效保护VDMOSFET免受反向电压击穿。如果将VDMOSFET的N+区改为P区,我们就会得到一个垂直导通的IGBT,其导通过程中有两种载流子参与其中,导致了低导通电阻和低开关速度。
综上所述,VMOSFET兼具了BJT和普通MOSFET的优点,因此它具有几乎无限的静态输入阻抗特性、极快的开关速度、类似常数的跨导、高dV/dt、开关损耗小、驱动功率小、频率特性好等优点。此外,VDMOSFET还具有负温度系数,安全工作区大,无二次击穿问题。再者,VDMOSFET还是开关和线性应用的理想功率器件,因此被广泛应用于电机调速、逆变器、不间断电源(UPS)、开关电源、电子开关、高保真音响、汽车电器和电子镇流器。根据沟槽栅极的形状,VDMOSFET可分为V型沟槽VDMOSFET(VVDMOS,或VMOS)和U型沟槽VDMOSFET(UVDMOS,或UMOS)。即便UMOS比VMOS具有更好的耐压能力,但由于VMOS在电力电子领域的高占比,因此功率MOSFET一般指的是VMOS。
5.4.2.3 MOSFET的工作原理
通过以上对于MOSFET结构的介绍,我们可以了解到,栅极电压所形成的外部电场可以改变MOSFET的电导率。当MOSFET内部没有导电沟道时,其电导率很小,对应于开关的关断状态。当MOSFET内部有导电沟道时,其电导率很大,对应于开关的开通状态。那么我们可以利用MOSFET的这一特性使其成为具有低驱动功率的电子开关。根据在未施加栅极电压的情况下,MOSFET内部是否有导电沟道,可以分为增强型MOSFET和耗尽型MOSFET。由于NMOS具有较好的特性,且LDMOSFET的内部工作情况易于观察,因此我们以N沟道LDMOSFET为例来讨论MOSFET的工作原理。
1- 增强型MOSFET
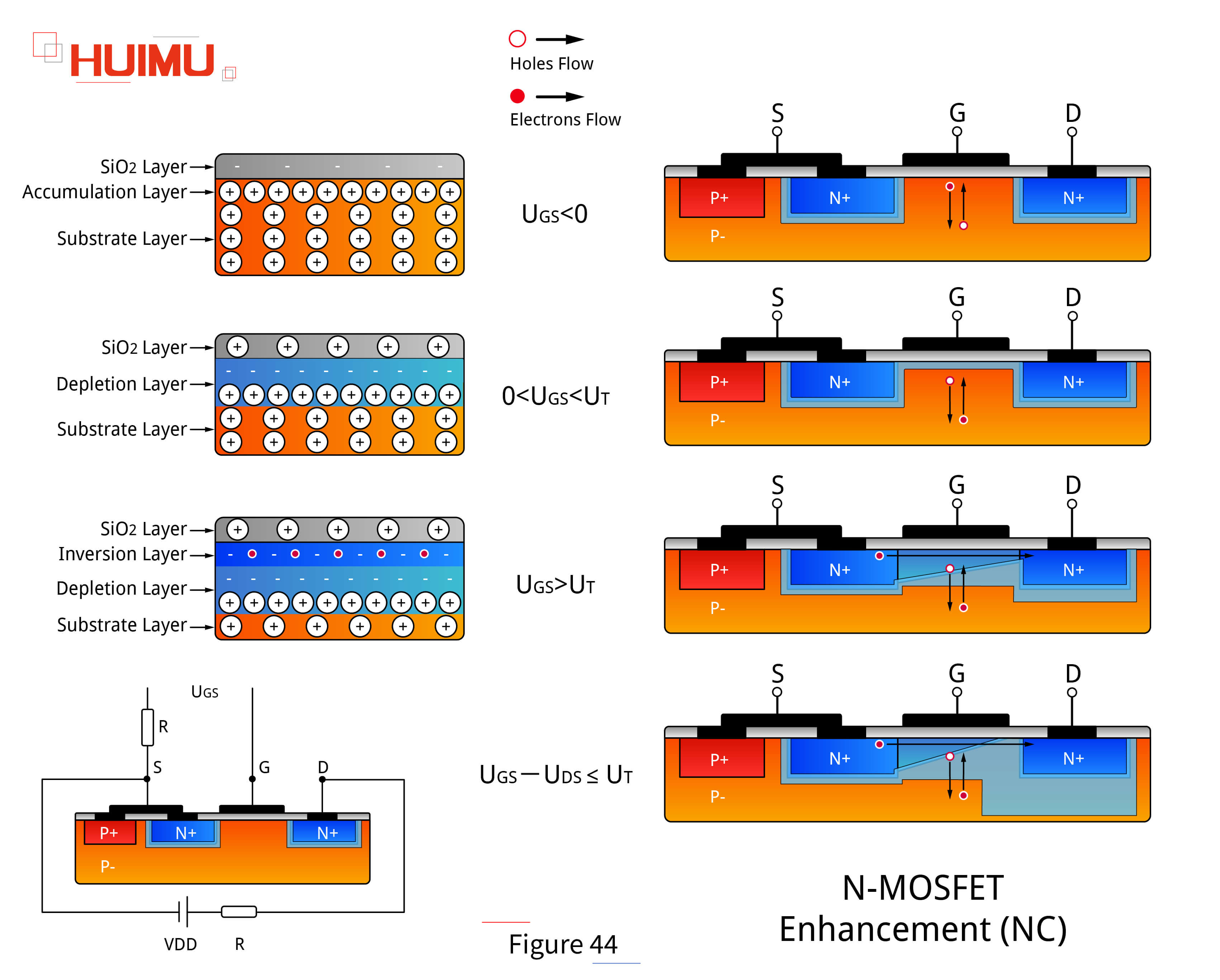
增强型MOSFET是常开(NC)器件。当未施加栅极电压(UGS = 0)时,耗尽型MOSFET的源极区域和漏极区域之间存在导电沟道。只有在施加一定的栅极电压后,增强型MOSFET内部才会形成导电沟道。根据这个导电沟道的形成过程,我们可以把增强型MOSFET的工作过程分为四个阶段。
积累层阶段:当UGS < 0时,栅极处会产生垂直于半导体表面的电场,将P-区域的空穴吸引到绝缘层底部,并排斥P-区域的自由电子,从而形成积累层。这个过程类似于电容器的充电,即在电场力的作用下,正电荷会积累到电容器的正电极,负电荷会积累到电容器的负电极,因此栅极的这个等效电容器可视为MOSFET的寄生电容器CGS。那么在这种情况下,即使在源极和漏极之间施加正向电压,电流也不能直接从漏极流向源极(不考虑漏电流),因此我们可以认为MOSFET处于关断状态。
耗尽层阶段:当 0 < UGS < UT 时,栅极处会产生垂直于半导体表面的电场,将P-区的自由电子吸引到绝缘层底部,并排斥P-区的空穴,从而形成耗尽层。耗尽层阶段和堆积层阶段的工作过程非常相似,只是载流子的流动方向不同。此外,MOSFET在耗尽层阶段仍然处于关断状态,这是因为在绝缘层底部累积的自由电子太少,无法形成导电沟道。
反型层阶段:当 UGS ≥ UT 时,积聚在绝缘层底部的自由电子足以形成连接漏极区和源极区的N型窄层,即N型导电沟道,并且由于其类型与P-区相反,因此也被称为反型层。在这个阶段,MOSFET内部的电流可以自由地从漏极区流向源极区,因此也可以认为MOSFET处于开通状态。由栅极所形成的电场随着栅极电压UGS的增加而增强,这导致了越来越多的自由电子被吸引到绝缘层底部,从而使导电沟道变宽,导通电阻变小,当然MOSFET的漏极电流ID也会增加。当MOSFET处于反型层阶段时,其漏极电流ID与栅极电压UGS之间存在线性关系,即GFS = ID / (UGS - UT),这就是我们稍后要讨论的正向跨导。不过,值得注意的是,导电沟道的横截面并非矩形,而是近似直角梯形或三角形。这主要是由P-区,源极区和漏极区所构成的寄生电容CDS造成的,从而空穴向漏极区积累,自由电子向源极区积累。UDS那么在CGS和CDS的共同作用下,越靠近漏极区,导电沟道就越窄;反之,越靠近源极区,导电沟道就越宽。
夹断区阶段:当UGS > UT时,MOSFET内形成了一条导电沟道,使得MOSFET开通。此时由于漏极和源极之间的电压不再为0,因此维持导电沟道的条件也就变成了,UGS - UDS > UT。如果UDS上升,使得 UGS - UDS = UT,导电沟道就会从直角梯形变为直角三角形,其顶点与漏极区的边缘相切。这个顶点是栅极电场和漏极电场的平衡点,此处导电沟道的宽度为0,因此我们称之为夹断点,其值为 UGD = UGS - UDS。如果UDS继续升高,那么漏极电场将逐渐取代栅极电场,从而导致夹断点逐渐远离漏极区而靠近源极区,那么在夹断点和漏极区之间形成的大耗尽层被称为夹断区。由于夹断区的存在,导电沟道和漏极区之间几乎没有接触,因此夹断区内就无法形成强大的反型沟道,这就是所谓的沟道夹断。由于夹断区是由被漏极电场吸引的空穴组成,因此越靠近漏极区,空穴的浓度越高,这样源极区的自由电子仍然可以通过夹断区进入漏极区,从而使MOSFET仍然导通,这也被称为MOSFET的夹断惯性。然而,随着UDS的不断升高,夹断区越来越大,空穴浓度越来越低,自由电子越来越难通过夹断区,因此MOSFET处于饱和状态,这意味着即使漏极电压不断升高,漏极电流仍保持在一个恒定值,即饱和漏极电流ID(sat)。当MOSFET饱和时,其饱和漏极电流 ID(sat) 不受UDS影响,但由UGS决定,也就是说,ID(sat) 与UGS的平方有关,这就是所谓的MOSFET的平方律传递特性。
2- 耗尽型MOSFET
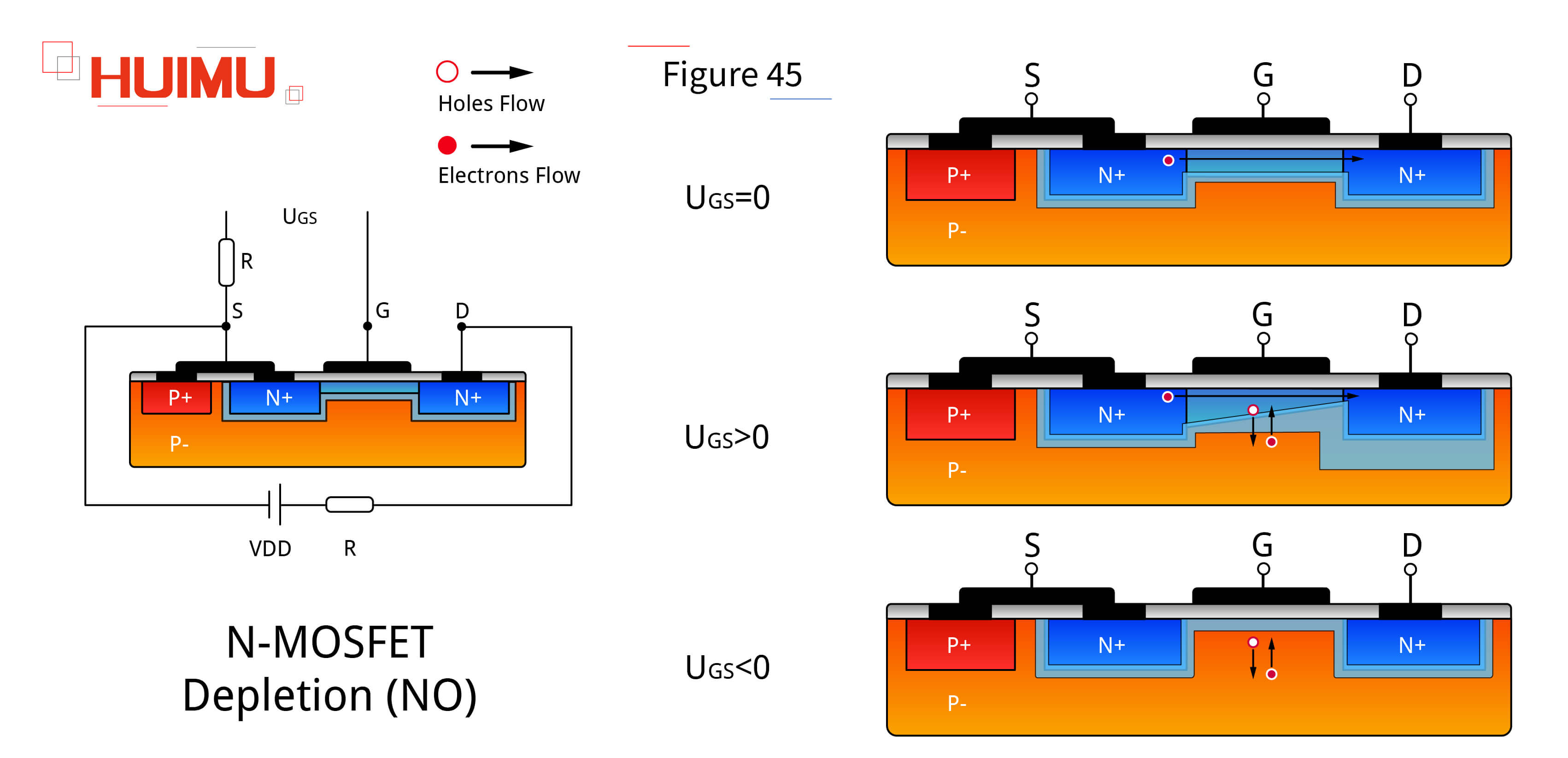
耗尽型MOSFET是常开(NO)器件。当未施加栅极电压(UGS = 0)时,耗尽型MOSFET的源极区和漏极区之间存在导电沟道,即N沟道。如果施加正向栅极电压,导电沟道会变宽;如果施加反向栅极电压,导电会变窄。当反向栅极电压达到一定值时,导电沟道消失。因此,我们就可以通过施加正向和反向栅极电压来控制耗尽型MOSFET的导通和关断。
导通状态:当UGS ≥ 0时,栅极上产生的电场会吸引更多的自由电子到N沟道,并排斥N沟道中的空穴。随着UGS的增加,沟道变宽,沟道电阻变小,饱和漏极电流增大。
截止状态:当UGS < 0时,栅极上产生的电场会吸引更多的空穴到N沟道,并排斥N沟道中的电子,使沟道变窄,沟道电阻变大。当UGS达到夹断电压UPO时,N沟道中的电子耗尽,导电沟道消失,饱和漏极电流趋于零。
5.4.3 MOSFET的主要参数
MOSFET的大部分参数与BJT的相同。
1- 正向跨导 GFS
一般来说电流变化量与电流变化量的比值被称为电流放大系数,电流变化量与电压变化量的比值被称为跨导。与BJT不同,由于MOSFET的工作原理,漏极电流ID不受栅极电流IGS的影响,但会受到栅极电压UGS的影响。当MOSFET开通时,其漏极电流变化量与栅极输入电压变化量的比值被称为正向跨导,GFS= d(lD)/d(UGS)。在某些放大器和开关电路中,正向跨导是一个非常重要的参数,正向跨导越大,MOSFET放大输入信号的能力就越强,也就是说,漏极电流对栅极电压变化的响应就越灵敏。
2- MOSFET电容值
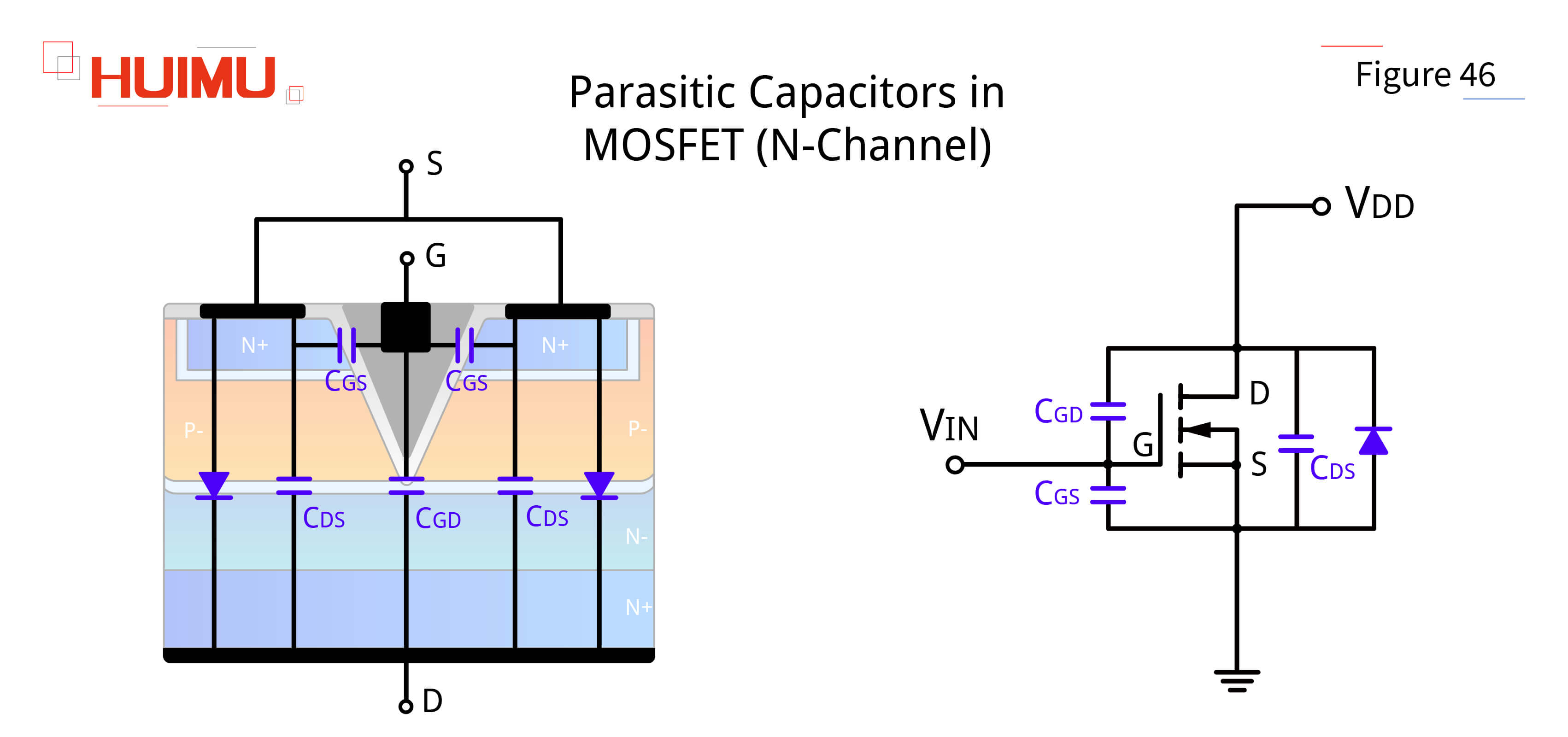
MOSFET内部有三种寄生电容器,即栅源寄生电容器CGS、栅漏寄生电容器CGD(也称为米勒电容)和漏源寄生电容器CDS。这些寄生电容的电容值会影响MOSFET的动态特性。如果电容小,开关电流和驱动功率就小,开关速度就快,反之亦然。MOSFET厂家通常所给出的电容参数满足以下计算公式:
MOSFET的输入电容:Ciss = CGS + CGD
MOSFET的输出电容:Coss = CDS + CGD
MOSFET的反向传输电容:Crss = CGD
3- 漏源导通电阻 RDS(on)
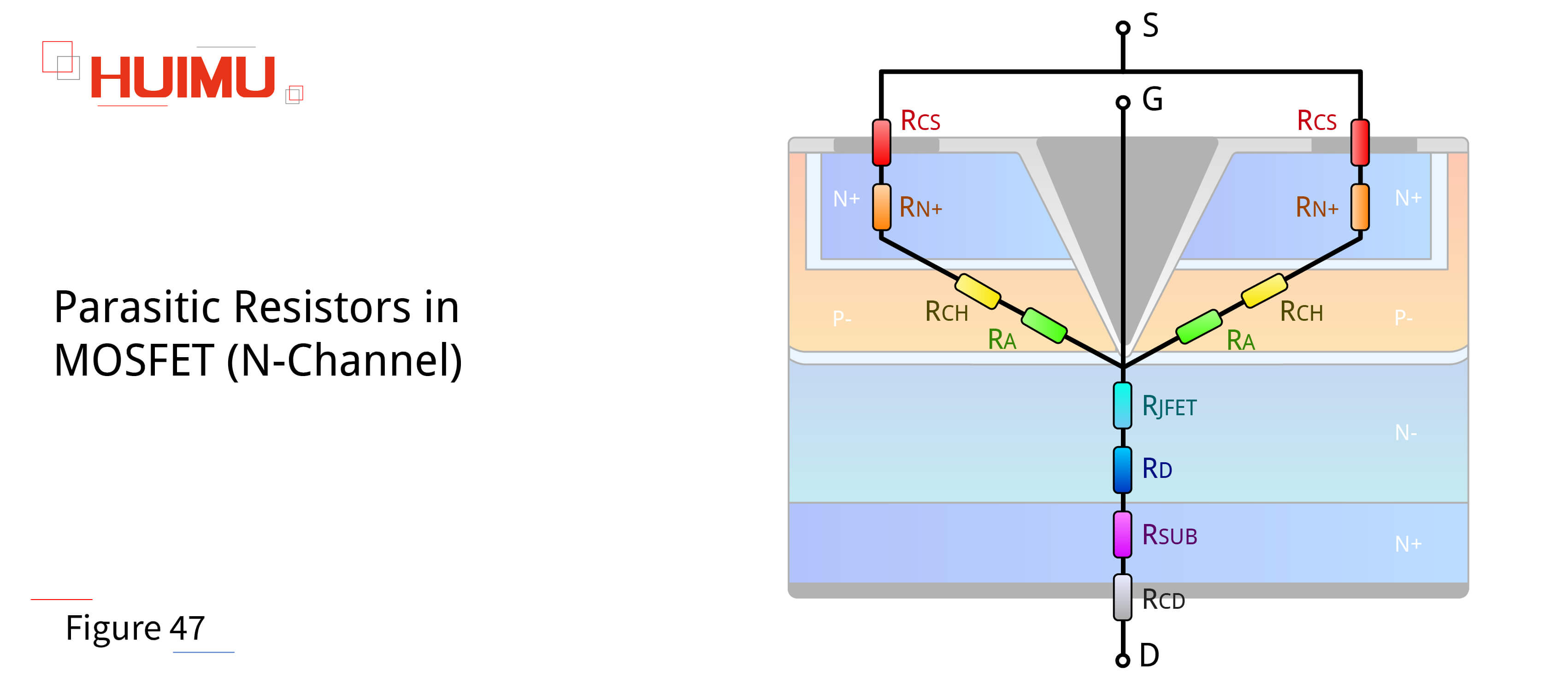
漏源导通电阻RDS(on)是指MOSFET在开通时漏源和源极之间的电阻。RDS(on)由MOSFET内的寄生电阻器所决定,RDS(on) = RCS + RN+ + RCH + RA + RJFET + RD + RSUB + RCD。RCS是N+源极区与源极电极之间的源极接触电阻。RN+是N+源极区和导电沟道之间的N+电阻。RCH是导电沟道的沟道电阻。RA为积累层的积累电阻。RJFET是等效JFET的JFET电阻。RD为漂移区的漂移电阻。RSUB是衬底区的衬底电阻。RCD是衬底区和漏极电极之间的漏极接触电阻。MOSFET的寄生电阻器只是一个等效电阻器,其成分仍然是半导体,因此其电阻值会受到温度和电压等外部条件的影响。MOSFET的结温越高,RDS(on)就越大,反之亦然。UGS越高,RDS(on)就越小,反之亦然。
4- 最大漏极电流 IDM
最大漏极电流IDM是MOSFET的额定电流。最大漏极电流是指当壳温在一定值时,能够使MOSFET达到最高结温的漏极电流。最大漏极电流不仅与MOSFET的结构有关,还与MOSFET的封装方式和环境温度有关。
5- 最大漏源电压 BVDSS
最大漏源电压BVDSS是MOSFET的额定电压。最大漏源电压是指MOSFET的漏极和源极在25℃环境温度下不发生雪崩击穿的最大电压。在实际应用中,最大漏源电压通常是漏极电流为250μA时测得的漏极与源极之间的电压。
6- 最大栅源电压 UGSM
为了提高栅极信号的控制能力,MOSFET的绝缘层通常不是很厚,因此如果施加足够的电压就可以将其击穿。最大栅源电压,也称为最大驱动电压,是能在极短时间内对MOSFET栅极绝缘层造成永久性损坏的最大输入电压,一般建议不要超过±20V。
7- 开关频率
MOSFET的开关频率是普通电力电子器件中最高的,可达100kHz甚至几MHz。虽然高开关频率有助于提高MOSFET的效率,但它也会增加MOSFET的动态功耗,因为MOSFET寄生电容器的充放电会导致动态工作(开关过程)期间的驱动功耗。不过,MOSFET 在静态工作(开启或关闭状态)期间几乎不需要驱动电流,因此其静态功耗非常低。
5.4.4 MOSFET的基本特性
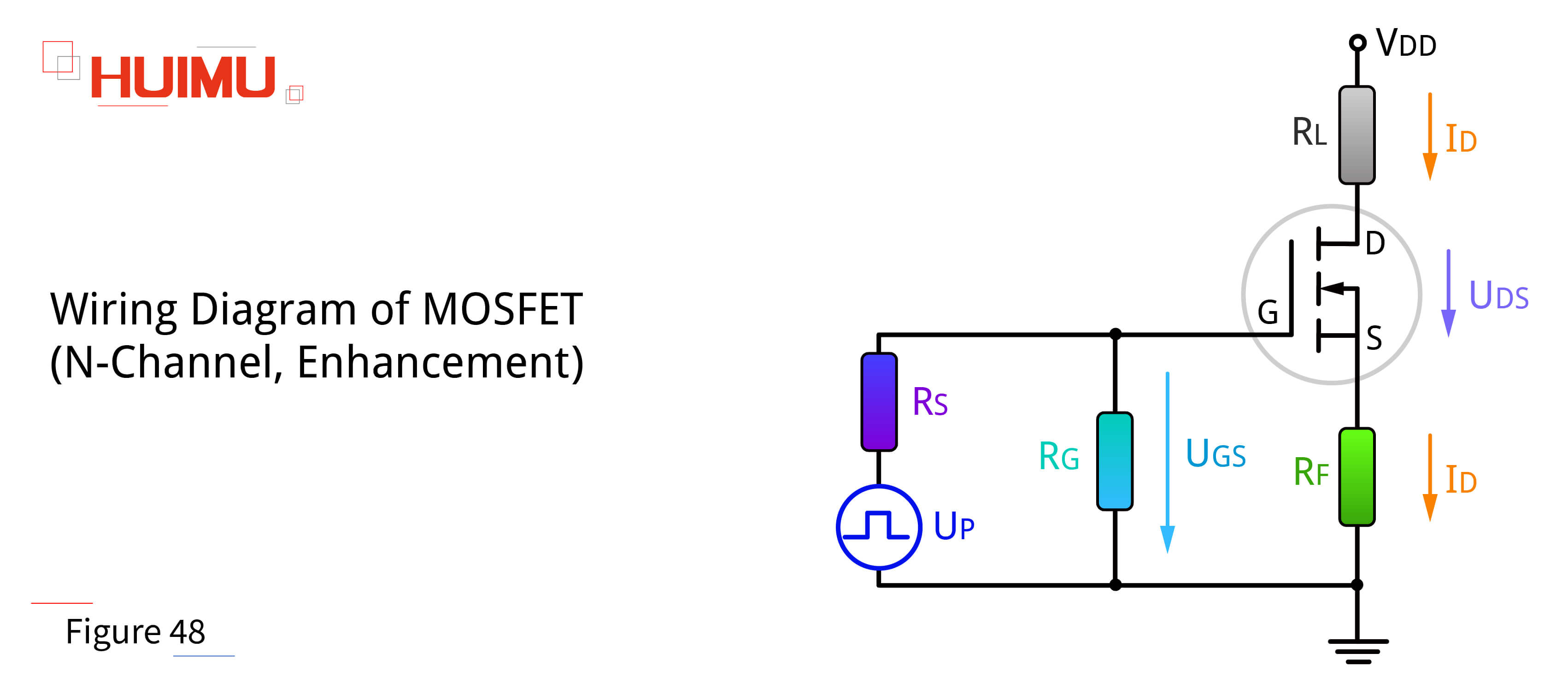
为了更好地理解MOSFET的基本特性,我们将其放入到工作电路中,如图48所示。此图中的MOSFET为增强型N-MOSFET(简称增强型N-MOS),其输出电源为VDD,驱动信号源为UP。UGS是栅极和源极之间的压降,UDS是漏极和源极之间的压降。RS为驱动电路的内阻,RG为栅极内阻,RL为负荷电阻,RF是用于检测漏极电流的检测电阻。ID为漏极电流。
5.4.4.1 MOSFET的静态特性
1- MOSFET的输入特性

由于MOSFET工作原理,UGS不会影响栅极和源极之间的电流,但会影响漏极电流ID。当UGS<UT时,ID为接近于0的漏电流。当UGS≥UT时,ID与UGS的关系近似线性,其斜率为MOSFET的正向跨导GFS。
2- 输出特性
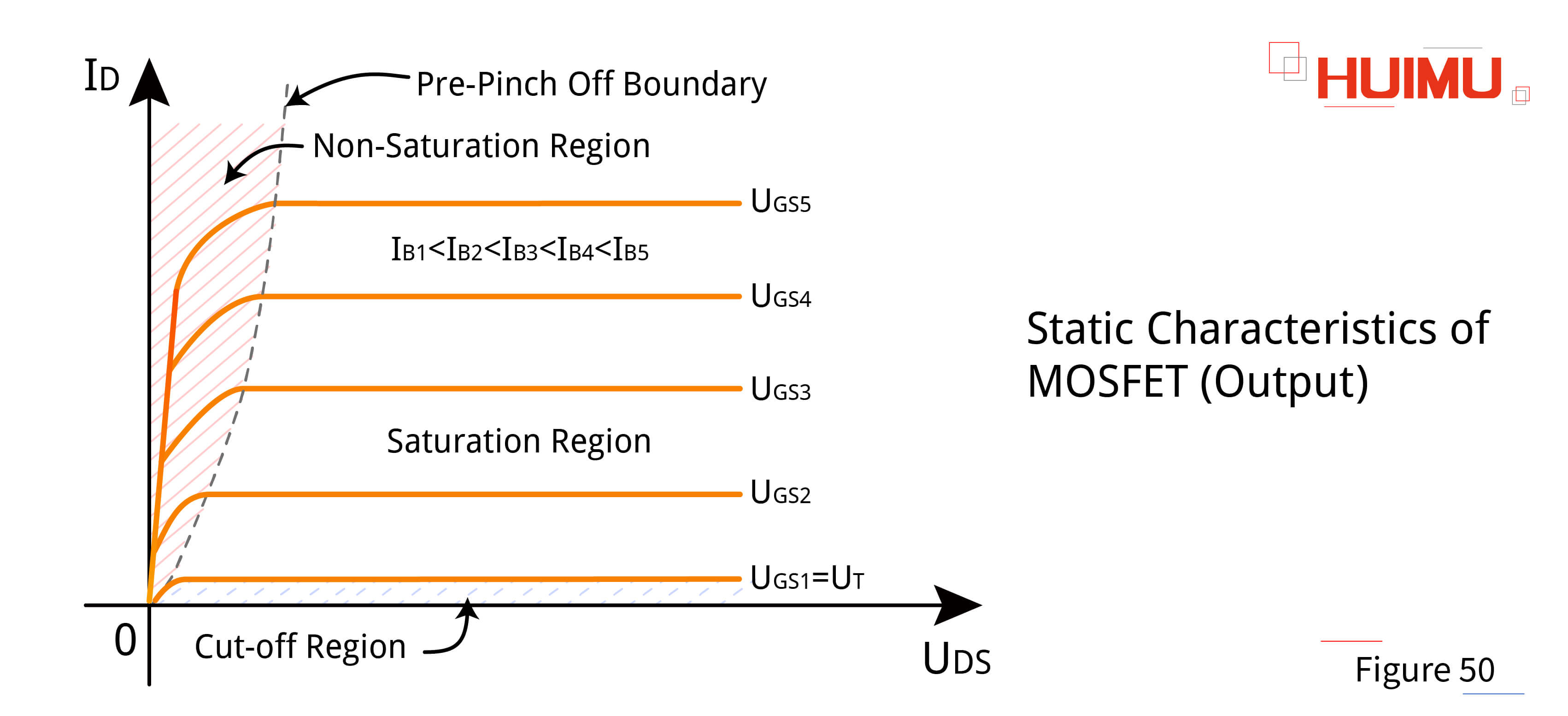
MOSFET的静态输出特性曲线与GTR的静态输出特性曲线相似。MOSFET的静态输出特性可分为截止区、饱和区和非饱和区。通常,MOSFET只工作在开关状态,即在截止区和非饱和区之间快速来回切换,以防止其在饱和区工作时因功耗过大而烧坏。
截止区:MOSFET的截止区类似于BJT的截止区。即便UDS非常高,但漏极电流为趋近于0的漏电流,ID ≈ 0。
饱和区:MOSFET的饱和区类似于BJT的有源区。ID不受UDS影响,但随着UGS的增加而增加。因此,MOSFET 在饱和区会承受很高的电压和电流,从而导致非常高的功耗。
非饱和区:MOSFET的非饱和区类似于BJT的饱和区。ID 随着 UDS 的增加而增加。这种电流随电压的变化相当于一个压控电阻器,因此非饱和区也称为欧姆区或可变电阻器区。在该区域,虽然MOSFET承受的电流很大,但其承受的电压非常小,因此MOSFET在非饱和状态下的功耗很小。
5.4.4.2 MOSFET的动态特性
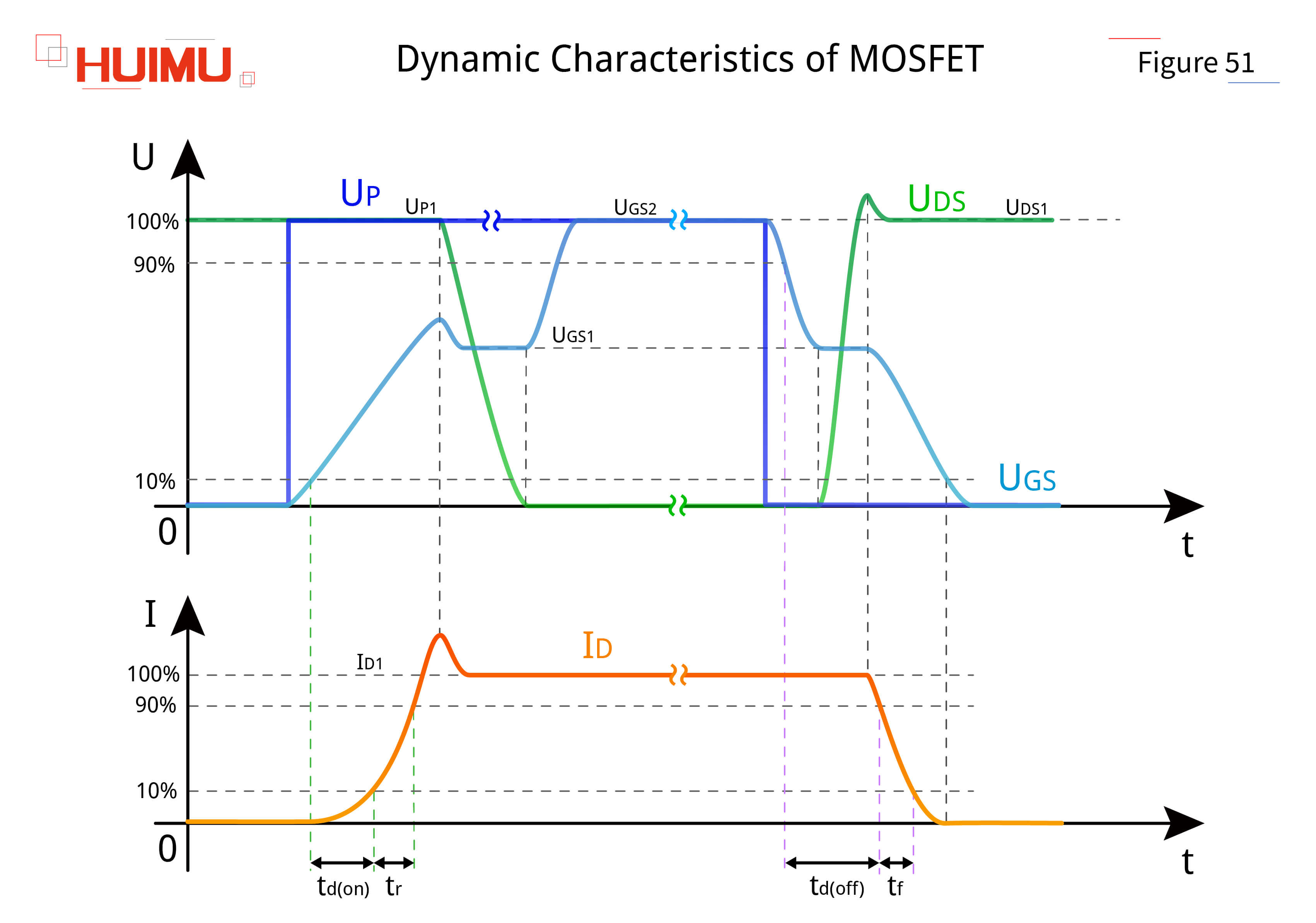
MOSFET的工作原理本质上是其寄生电容器的充放电,因此在MOSFET的开关过程中,必须考虑寄生电容器的充放电过程。
1- MOSFET的开通过程
为了开通MOSFET,我们需要施加一个稳定的高电平电压UP1到MOSFET的栅极。由于驱动电路电阻器RS,栅极寄生电阻器RG和栅源寄生电容器CGS的存在,MOSFET的栅极电压UGS不能像UP1那样形成脉冲方波,而是以一定的斜率上升。当CGS的充电电压达到UT时,漏极电流ID开始随着UGS的增大而增大,即MOSFET从截止区进入了饱和区。在CGS的充电电压达到最大值后,UGS保持在UGS1,ID保持在ID1。此时由于UGS-UDS
开通时间的计算公式为,ton = td(on) + tr。
2- MOSFET的关断过程
在UP1被移除后,CGD通过RG开始放电,UGS随着一定的斜率而减小。在CGD放电完毕后,UGS保持在UGS1。此时,导电沟道被夹断,CDS开始充电,UDS开始上升。在CDS的充电电压达到最大值后,UDS保持在UDS1。此时,MOSFET进入饱和区,CGS开始通过RG放电,UGS再次减小,ID随着UGS的减小而减小。当UGS降至UT以下时,MOSFET进入截止状态,ID降至0。由于MOSFET不具有少数载流子存储效应,其关断过程非常快,大约需要几十纳秒。通常,从90% UGS2到90% ID1的时间段称为关断延迟时间td(off)。ID从90% ID1下降到10% ID1所需的时间称为下降时间 tf。MOSFET的关断时间toff是关断延迟时间td(off)和下降时间tf的总和。
关断时间的计算公式为,toff = td(off) + tf。
* 如何加快MOSFET的开关过程?
● 通过减小驱动电路的电阻和电感,可以有效缩短MOSFET寄生电容器的充放电时间,加快MSOFET的开关速度,降低其开关损耗。
● 通过对栅极施加短时间的过充电压,可以有效加速MOSFET寄生电容器的充电,加快MOSFET的开通过程。
5.4.5 MOSFET的串联和并联
MOSFET不适合串联。由于原材料,工艺的关系,所有MOSFET的性能是无法做到完全一致的,因此它们工作频率和耐压能力都是不同的。而且,由于MOSFET是高频器件,在开关过程中会产生大量热量。因此,如果将它们串联起来,就很容易导致耐压能力最低的MOSFET被烧毁。
相反,MOSFET非常适合并联.这是因为它们的导通电阻具有正温度系数,即温度越高,导通电阻越大。当其中一个MOSFET中的电流过大时,其导通电阻变大,然后电流开始流入导通电阻较小的其他MOSFET,从而有效降低了MOSFET的动态不均匀电流。如果在源极电路中连接一个小型电感器作为均流电抗器,就能有效降低MOSFET的动态不均流。当然,MOSFET的并联还可以提高其电流容量,例如逆变焊机的输出电路中会并联几十个MOSFET来提高其输出电流。
5.5 绝缘栅双极晶体管
5.5.1 IGBT介绍
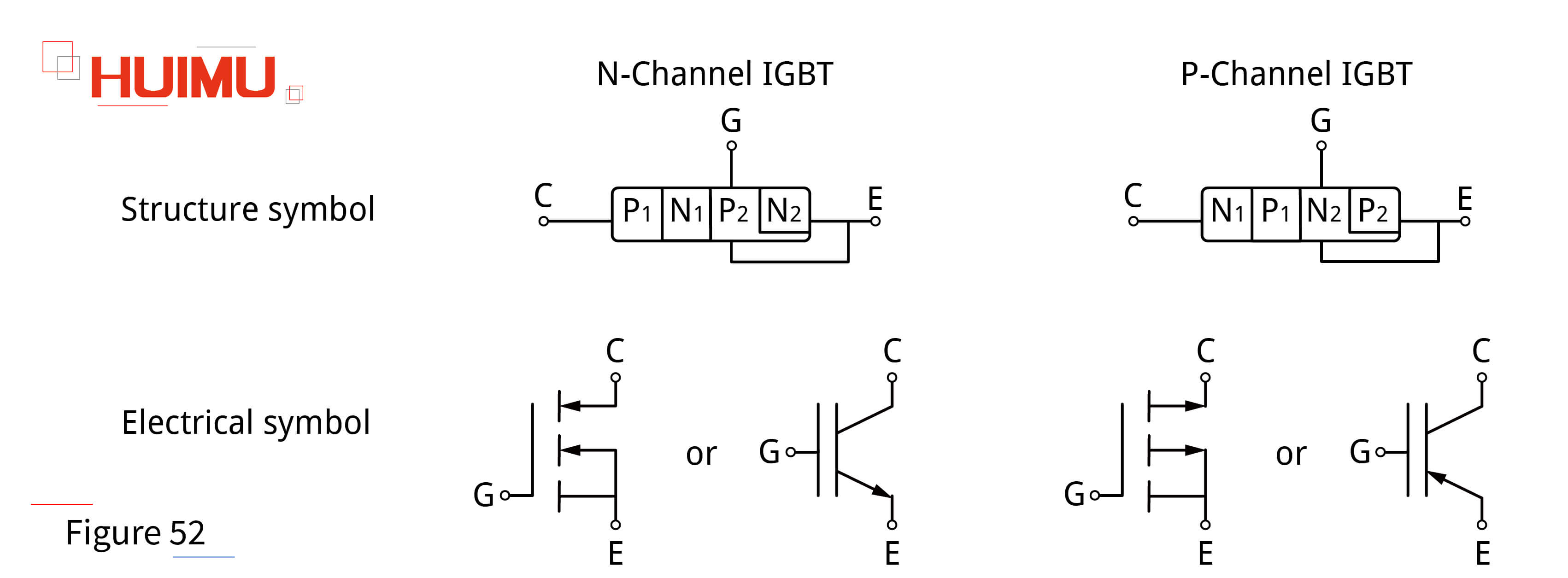
绝缘栅双极晶体管(IGBT,简称IGT)是一种复合Bi-MOS器件,具有功率MOSFET的高输入阻抗和BJT的高电流容量。IGBT主要用于耐压在600V以上、电流在10A以上、频率在1kHz以上的领域,例如如变频器、逆变器、脉宽调制系统(PWM)、不间断电源(UPS)、开关电源(SMPS)、谐振变流器、工业电机、新能源汽车。
IGBT具有非常多的优点,如输入阻抗高、噪声低、开关速度快、驱动电路简单、驱动功率小、导态压降低、开关损耗小、安全工作区宽、体积小、电流密度大、电流容量大、耐压高、抗脉冲电流冲击能力强、无二次击穿。然而,与功率MOSFET相比,IGBT具有开关速度慢、易闩锁等缺点。
5.5.2 IGBT是如何工作的?
5.5.2.1 IGBT的基本结构
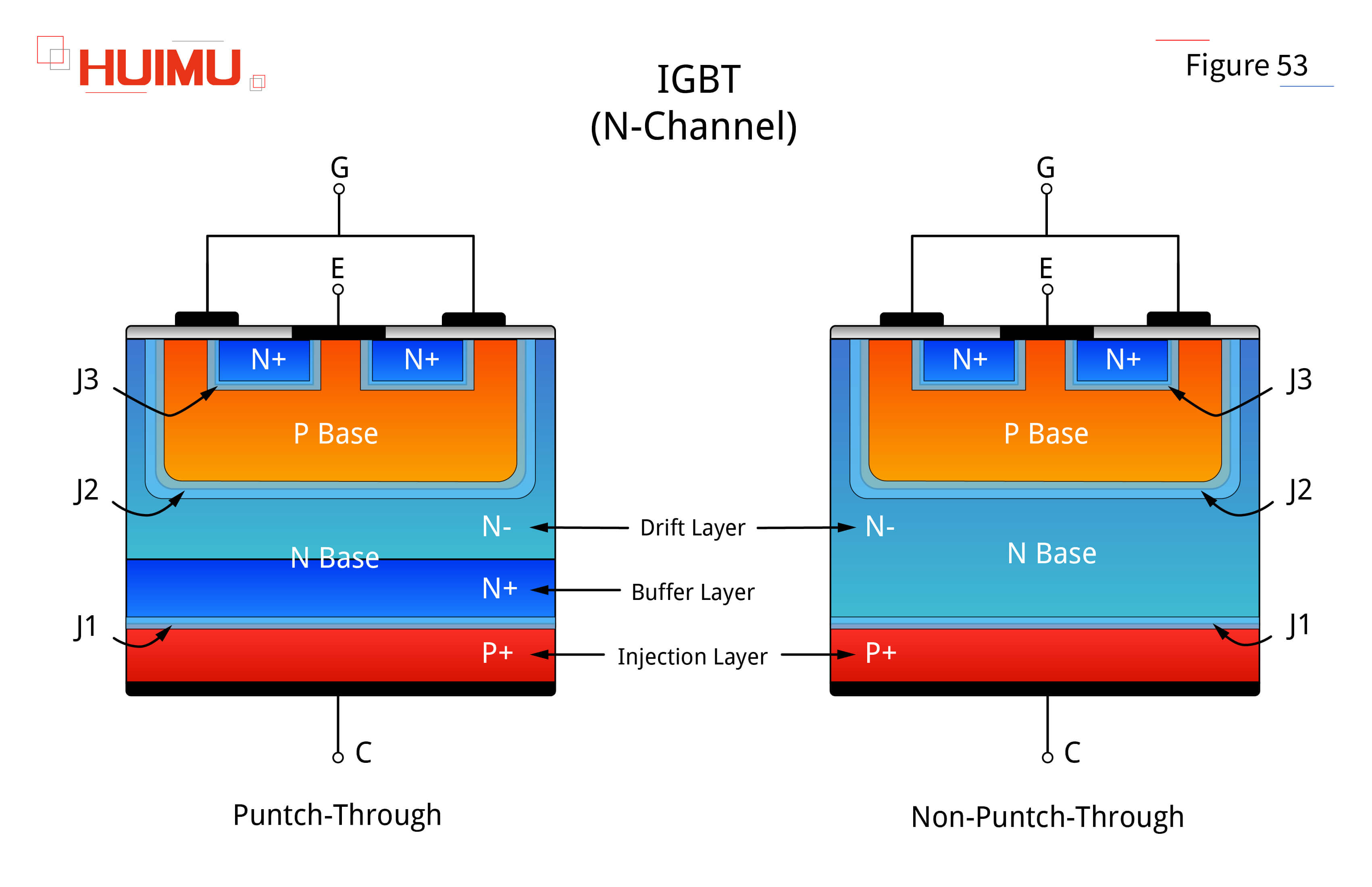
IGBT的结构与VMOS非常相似,其栅极(G)与VMOS的栅极(G)相对应,其发射极(E)与VMOS的源极(S)相对应,集电极(C)与VMOS的漏极(D)相对应。然而,IGBT在衬底区有一个P+注入层,这使得IGBT与晶闸管一样是PNPN结构。
根据是否含有N+缓冲层,IGBT可分为穿通型(PT)和非穿通型(NPT)。PT型IGBT的正向击穿电压高于其反向击穿电压,因此更适用于直流电路。NPT型IGBT的正向击穿电压与其反向击穿电压相同,因此更适用于交流电路。PT型IGBT具有开关损耗低、通态损耗小、电流容量大等优点,但其温度特性不如NPT,因此不适合并联。
IGBT还可分为N沟道型和P沟道型,这与MOSFET相似。P沟道IGBT的开关速度比N沟道IGBT慢2-3倍,因此P沟道IGBT的安全工作区比N沟道IGBT小。此外,P沟道IGBT的成本高于N沟道IGBT,因此P沟道IGBT在实际使用中并不多见。因此,下面我们以PT型N沟道IGBT为例来介绍IGBT。
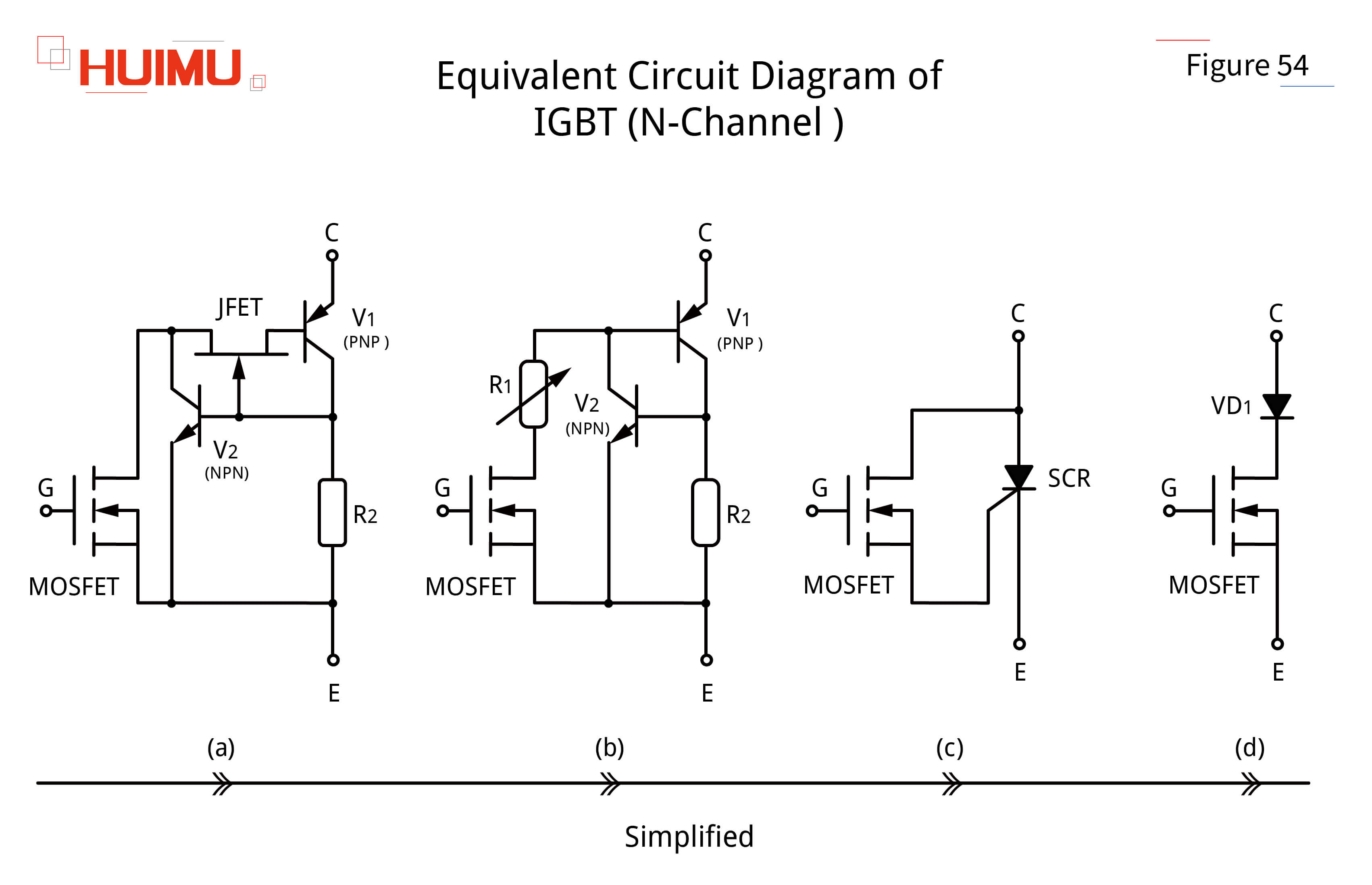
通过了解每个PN结的功能,我们大概可以把PT型N沟道IGBT看成是由一个寄生增强型N-MOSFET,一个寄生JFET、一个寄生PNP晶体管V1(P+ N- P)、一个寄生NPN晶体管V2(N+ P N-)和一个等效扩展电阻器R2所组成的等效电路,如图54(a)所示。在该电路中,V1是主输出通道,V2是随着MOSFT的形成而形成的,JFET是由N-漂移区形成,R2是由V2的P-基区的等效电阻器形成。当然,我们可以简化这个等效电路图,以便更直观地可视化IGBT的工作情况。首先,我们可以将寄生JFET简化为等效调制电阻器R1,它主要由N-漂移区中的等效电阻器构成,如图54(b)所示。然后,我们可以进一步将IGBT的PNPN结构视为寄生晶闸管SCR,如图54(c)所示。最后,我们可以将IGBT视为具有大电流开关能力的MOSFET,因此P+和N+区可视为功率二极管VD1,如图54(d)所示。
5.5.2.2 IGBT的工作原理

从简化的等效电路图中可以看出,IGBT的工作原理不仅类似于电压驱动地SCR,而且类似于具有反向阻断能力的MOSFET。因此,IGBT除了具有导通状态和截止状态外,还具有正向和反向阻断状态。
正向阻断状态:当向IGBT输出端施加正向电压,并且栅极和发射极短路时,IGBT将进入正向阻断状态。此时,PN结J1和J3为正向偏置,PN结J2为反向偏置。反向电压使J2两侧的耗尽层延伸到P基区和N-漂移区。
反向阻断状态:当向IGBT输出端施加反向电压时,PN结J1反向偏置,反向电压使J1的耗尽层延伸到N+缓冲区,即IGBT进入反向阻断状态。通过增加N+缓冲区的宽度,可以提高IGBT的反向阻断能力,但也会增加IGBT的正向压降。然而,IGBT的反向耐压通常只有几十伏,因此为了防止IGBT工作在反向阻断状态,通常会在IGBT的输出端反并联一个快速恢复外延二极管 (FRED)。当然,为了方便起见,有时IGBT和FRED会被封装在一起,形成一个逆导型IGBT模块。
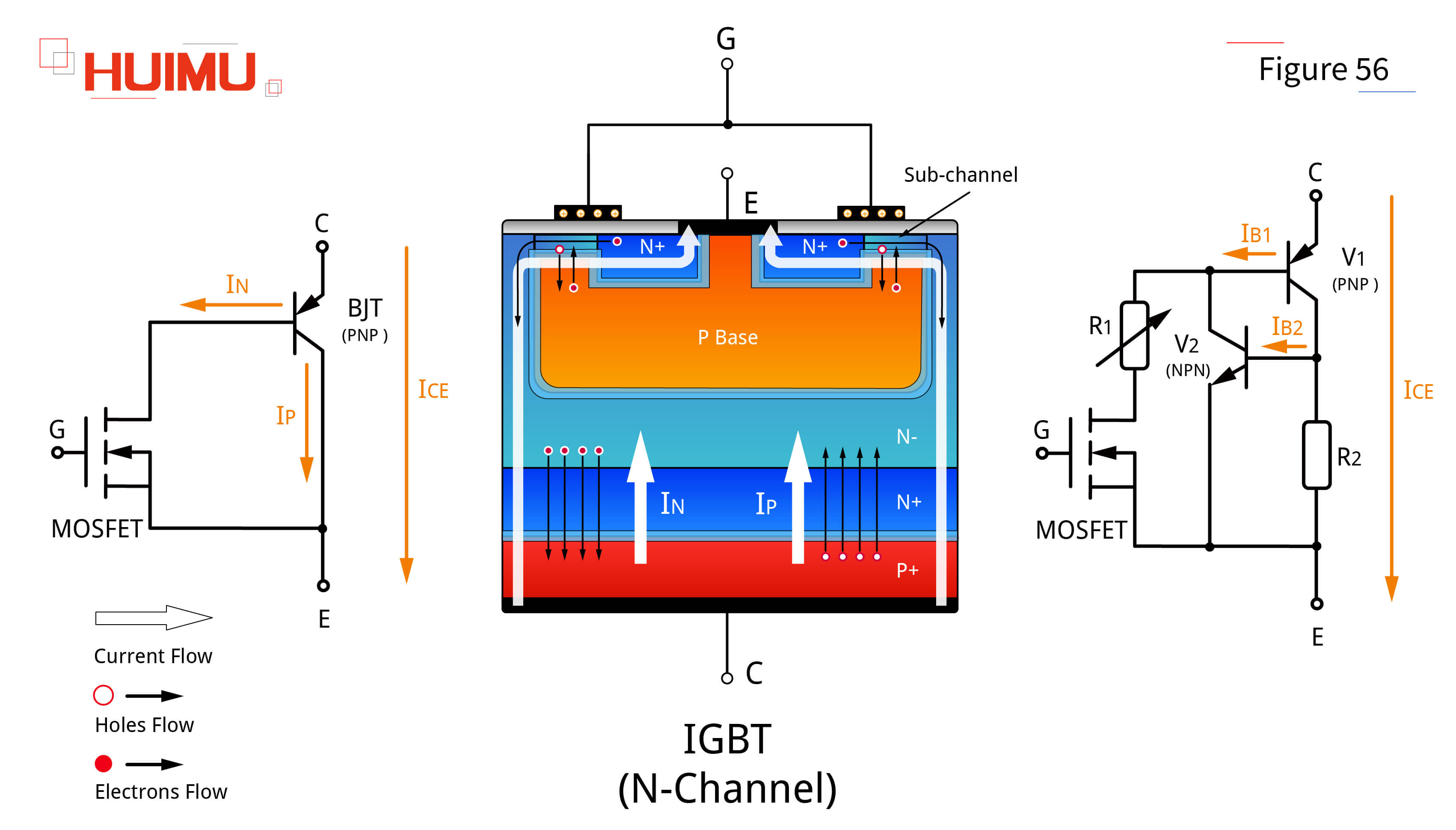
导通状态:当向IGBT输出端施加正向电压,并且向栅极施加一定电压时,P基区将形成N子沟道区,允许电子从N+缓冲区转移到N-漂移区。这种电子流将降低N基区的电位,并为V1提供基极电流IB1。如果电子流产生的压降约为0.7V,则PN结J1将处于正向偏置状态,即IGBT进入导通状态。由于IGBT的N-漂移区非常宽,而其掺杂浓度较低,因此N-漂移区的电导率非常低。当IGBT在大电流下工作时,由于电导调制效应,电导率随着N基区中载流子浓度的增加而增加,从而降低了IGBT输出端的饱和电压和IGBT的总通态功耗。当有电子电流IN和空穴电流IP时,IGBT完全导通。需要注意的是,当IGBT处于导通状态时,如果集电极电流不受限制,IGBT将发生擎住效应。
截止状态:当IGBT处于导通状态时,如果将IGBT的栅极电压降低到阈值电压以下,或者对IGBT的栅极施加反向偏置电压,那么IGBT中的N子沟道就会消失,IGBT中的基极电流就会被切断,这样IN和IP就会消失, 最后IGBT将进入截止状态。然而,由于少数载流子效应,IGBT输出电流不会立即降至零,而是产生像BJT一样的尾电流,其特性与UCE、IC和TC有关。应该注意的是,少数载流子效应会增加IGBT的开关时间和开关损耗。
* 闩锁效应
闩锁效应, 又称擎住效应,可分为静态闩锁效应和动态闩锁效应。静态闩锁效应是因为IGBT的集电极电流过大而造成的。从图56中的电路中,我们可以看到,如果R2两端的正向偏置电压可以提供足够的电压来触发V2,则可以将V1和V2视为图54(C)中的等效SCR(P+ N- P N+)。一旦等效SCR触发,SCR的正反馈机制会剥夺IGBT栅极的控制权,因此IGBT无法被关断。动态闩锁效应主要是由于IGBT高速开关时di/dt和dv/dt较大引起的大位移电流,它在R2上产生一个足以触发V2的正向偏置电压,从而导致等效SCR触发。
闩锁效应对IGBT而言是有害的。一方面,闩锁效应会使得IGBT的集电极电流增大,从而显著增加IGBT的功耗。另一方面,如果电路中出现过电流,电子保护电路将无法及时关断IGBT,因此IGBT会因过电流而烧毁。因此,通常会采取以下措施来避免闩锁效应。
● 通过调整IGBT的内部结构,降低R2的电阻值,使其两端的电压远小于V2的栅极触发电压,从而防止其触发。
● 通过优化N+缓冲层,降低V1的hFE(β),从而减小V2的基极电流,防止其触发。
5.5.3 IGBT的主要参数
IGBT的大部分参数与MOSFET的相同。
1- 擎住电流 IL
擎住电流IL是指引起IGBT闩锁效应的集电极电流值。擎住电流IL通常大于ICM的5倍。过去,IL是限制IGBT电流容量的主要原因之一。但随着技术的发展,IGBT的内部结构可以有效防止静态闭锁效应,这也是现在IGBT容量越来越大的原因。
5.5.4 IGBT的基本特性
5.5.4.1 IGBT的静态特性
1- IGBT的输入特性

IGBT的静态输入特性曲线与MOSFET的相似。
2- IGBT的输出特性

IGBT的静态输出特性可分为正向阻断区、有源区、饱和区和反向阻断区。通常情况下,IGBT只在开关状态下工作,即在正向阻断区和饱和区之间快速来回切换,以防止IGBT在有源区工作时因功耗过大而烧坏。
正向阻断区:该区域类似于BJT的截止区。当UGE<UT时,IGBT的寄生MOSFET被关断,集电极和发射极之间出现漏电流ICEO。
有源区:该区域类似于BJT的有源区。当UGE≥UT且UCE>UGE-UT时,IGBT工作在有源区,并产生0.7V的通态压降。在有源区,流入IGBT的N基极区的电子电流IN由栅极电压UGE控制,其限制了V1的基极电流IB1,进而限制了空穴电流IP,使得IGBT的集电极电流IC表现为类似于MOSFET的饱和状态。IGBT在有源区承受非常高的电压和电流,因此IGBT应尽快穿过该区域,以避免因功耗过大而造成损坏。
饱和区:该区域类似于BJT的饱和区。当UGE ≥ UT时,UCE ≤ UGE - UT时,集电极电流IC不再由栅极电压UGE控制,而是由外部电路决定。当然,该区域也类似于MOSFET的非饱和区,因此IGBT的饱和区也称为欧姆区或可变电阻器区。
反向阻断区:该区域类似于功率二极管的反向阻断区。
* IGBT和MOSFET饱和区之间的差异
根据IGBT的工作原理,其完全导通后的饱和压降主要取决于电导调制效果,因此IGBT的饱和区为电压饱和。
根据MOSFET的工作原理,其完全导通后的饱和压降主要取决于漏极电流,因此它表现为电阻特性,即MOSFET的饱和区为电流饱和。
5.4.2 IGBT的动态特性

IGBT的动态特性类似于MOSFET和BJT的组合。
1- IGBT的开通过程
IGBT的开通过程与MOSFET的相似。值得注意的是,UCE的下降过程分为两个步骤,即等效MOSFET单独工作时的tfv1,以及等效MOSFET与等效BJT共同工作时的tfv2。从10% UGS1到10% IC1的时间段称为开通延迟时间td(on)。IC从10% IC1上升到90% IC1所需的时间称为上升时间 tr。一般来说,IGBT的开通时间ton是td(on)和tr的总和。
开通时间的计算公式为,ton = td(on) + tr。
2- IGBT的关断过程
IGBT的关断过程与MOSFET和BJT类似。值得注意的是,IC的下降过程分为两个步骤,即等效MOSFET单独工作的tfi1,以及等效MOSFET与等效BJT共同工作的tfi2。通常,从90% UGS1到90% IC1的时间段称为关断延迟时间td(off)。IC从90% IC1下降到10% IC1所需的时间称为下降时间tf。尾部时间tt是拖尾电流消失所需的时间,我们将在下文中简要讨论它。一般来说,IGBT的关断时间toff是td(off)和tf的总和。
关断时间的计算公式为,toff = td(off) + tf = td(off) + tfi1 + tfi2。
* 拖尾电流
当IGBT开通时,会有空穴电流IP从P+发射极区注入到N-漂移区。一方面,这些空穴与N-区的自由电子复合,形成空间电荷区,另一方面,它们作为少数载流子遗留在N-区,形成载流子存储区。当IGBT关闭时,载流子存储区中的少数载流子会逐渐被清除到外部电路中。在此过程中,随着UCE的上升,空间电荷区变大,从而加强了漂移运动,以至于来不及到达外部电路的少数载流子会在IGBT内部产生复合电流,即拖尾电流。
虽然拖尾电流会在IGBT的关断过程中逐渐消失,但在高频工作的情况下,拖尾电流不仅会延长IGBT的关断时间,还会增加IGBT的开关损耗。当然,可以通过一些方法来减少拖尾电流,例如增加集电极电阻以降低从集电极注入的空穴数量,或增加门极关断电阻以降低少数载流子寿命。
5.5.4.3 IGBT的安全工作区
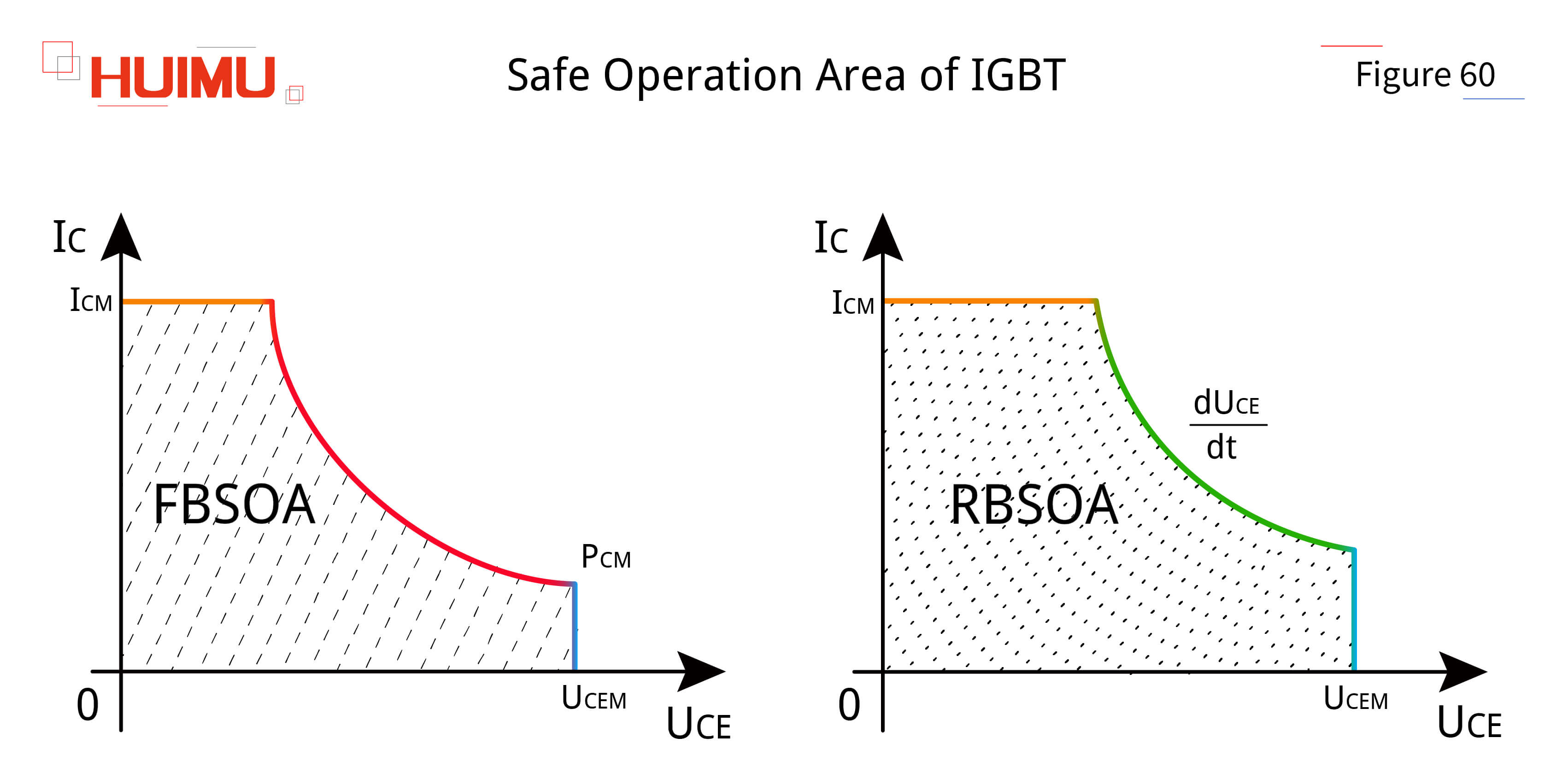
正向偏置安全工作区(FBSOA):由ICM、UCEM和PCM确定。
反向偏置安全工作区(RBSOA):由ICM、UCEM和dUCE/dt确定。
5.5.5 IGBT的串联和并联
IGBT不适合串联,原因与MOSFET类似。
IGBT是否适合并联取决于集电极电流IC,主要是因为IGBT导通电阻RON的温度特性受IC的影响。当IC≤1/3 ICM时,RON呈现负温度系数,因此IGBT不适合并联。当IC>1/3 ICM时,RON呈现正温度系数,因此IGBT适合并联,就像MOSFET一样。此外,当负载电流较小时,不均匀电流对IGBT的影响很小。因此,总的来说,IGBT非常适合并联。
5.6 其他全控型器件
通过IGBT的工作原理,我们发现不同类型的功率器件可以通过复合结构集成在一起,形成一种全新的器件,既可以发挥它们的优势,又可以弥补它们的劣势。目前,市场上常见的新型全控复合型器件有MCT、SIT、SITH和IGCT,随着技术的发展,这些新型器件将逐渐取代旧器件,未来还会不断出现其他新型器件。
1- MOS控制晶闸管
MOS控制晶闸管(MCT)的设计思路与IGBT相似,就是通过MOSFET来控制PNP晶闸管的工作状态。MCT的结构与GTO的结构相似,即MCT由数万个MCT单元组成,每个单元由一个PNP晶闸管和一个MOSFET组成。MCT结合了MOSFET和晶闸管的优点,具有极高的di/dt和dv/dt耐量、高开关速度、低导通电压、低开关损耗、高电压容量和高电流容量。然而,MCT的电压和电流容量与预期相差甚远,且成本高于IGBT,因此其市场份额并不高。
2- 静电感应晶体管
静态感应晶体管(SIT)是一种多数载流子参与传导过程的JFET。SIT在普通JFET的基础上,在沟道中增加了多数载流子势垒,用以防止自由电子从源极流向漏极。因此,可以通过改变UGS和USD来改变这种势垒高度,从而控制来自源极区的多数载流子数量,从而控制沟道电流,即通过静电方式来控制沟道内部电位分布。SIT具有比功率MOSFET更高的工作频率和功率容量,因此适用于高频和大功率应用,如雷达通信设备、电子镇流器、脉冲功率放大器和高频感应加热系统。此外,SIT具有负温度系数和抗辐射性等特性,可以满足航空航天和军事设备的严格要求。然而,SIT具有高导通电阻和高通态损耗,而且作为一种常开器件,因此它不能像功率MOSFET那样得到广泛应用。
3- 静电感应晶闸管
静电感应晶闸管(SITH)又称场控晶闸管(FCT),是一种双极型器件,其导通过程中有两个载流子参与。在SIT结构的基础上,SITH增加了一个具有注入少数载流子功能的PN结,从而在其内部形成了一个由两个寄生晶体管组成的寄生晶闸管。SITH的工作原理与SIT相似,SITH和SIT都是常开器件。因此,SITH具有电导调制效果好、通态压降低、电流容量大等优点,并且其开关速度比GTO高,电流关断增益比GTO小,驱动电路比GTO简单。当然,SITH也具有SIT一样的缺点,例如,它们的驱动功率都比较高, 而且都是常开器件。
4- 集成门极换流晶闸管
集成门极换流晶闸管(IGCT,或GCT)是一种将GTO芯片与反并联二极管和门极驱动电路集成在一起的功率器件。与GTO相比,虽然IGCT的功率容量与GTO几乎相同,但其开关速度比GTO快10倍,而且不需要像GTO那样复杂的驱动电路。此外,IGCT还具有可靠性高、结构紧凑、损耗低, 制造成本低,成品率高等优点。因此,即便IGCT的驱动功率仍很大,但在MCT技术成熟之前,IGCT能够替代GTO,成为大功率低频应用的优选方案。
§6. 如何选择功率电子器件?

6.1 半导体材料
选用功率电子器件前,需要了解其半导体材料。随着材料技术的发展,半导体材料大致可以分成三代。以锗(Ge)和硅(Si)为代表的第一代半导体材料是最常见的半导体材料,主要用于低压、低频、中等功率的功率电子器件,以及光电探测器。以砷化镓(GaAs)为代表的第二代半导体材料主要用于微波、毫米波器件、发光器件。以碳化硅(SiC)、氮化镓(GaN)、氮化铝(AiN)、氧化锌(ZnO)为代表的第三代半导体材料主要应用于高温、高频、大功率抗辐射的功率电子器件,以及半导体激光器。
6.2 分立功率电子器件
以下是本文第1章至第5章内容的简要概述,有助于快速理清各种电力电子设备之间的区别。我们可以先通过分析自身需求来缩小选择范围,然后综合考虑每种功率电子器件的优缺点,找出最适合自己的器件。
6.2.1 分立功率电子器件的分类
通过了解功率电子器件的分类方法,如受控程度、驱动电路信号、有效触发信号、参与载流子,有助于快速找到所需的器件。我们需要明确自己设计的电路需要什么样的器件,并且大概知道其在电路中扮演什么样的角色。例如,如果我们需要一个电压驱动的全控型器件来驱动高频电路,我们可以考虑使用MOSFET或IGBT。
1- 受控程度
不可控型器件:功率二极管
半控型器件:SCR
全控型器件:GTO, GTR, MOSFET, IGBT
2- 驱动电路信号
电压驱动型器件:IGBT, MOSFET, SIT, SITH
电流驱动型器件:SCR, GTO, GTR
3- 有效触发信号
脉冲触发型器件:SCR, GTO
电平触发型器件:GTR, MOSFET, IGBT
4- 参与载流子
单极型器件:MOSFET, SIT
双极型器件:功率二极管, SCR, GTO, GTR
复合型器件:MCT, IGBT, SITH, IGCT
6.2.2 分立功率电子器件的优缺点
我们必须认识到,没有一种完美的功率电子器件能够满足每种应用的需求。如果一个功率电子器件的电流容量和电压容量很大,那么其工作频率通常不会很高。此外,即使存在电流和电压容量大、工作频率高的功率电子器件,其价格也可能非常昂贵。因此,在选择功率电子器件时,需要考虑其优缺点, 以及综合成本。
1- 不可控型器件
不可控型器件主要用于工业和电力系统中的整流电路。功率二极管是结构和原理最简单的功率电子器件,成本低,运行稳定。然而,由于功率二极管是不可控型器件,无法被关断,因此需要额外的关断电路,这不仅使电路设计复杂化,而且增加了整个电路的总成本。而且功率二极管的开关频率很低,因此很难用于高频整流电路。
通用二极管(GPD)具有反向电压峰值电压高,正向压降低,整流能力强的优点。但GPD的反向恢复时间长,工作频率低,因此,对于更高的工作频率要求,通常推荐FRD和SBD。
快恢复二极管(FRD)具有反向恢复时间短,工作频率高,正向压降低,反向峰值电压高的优点,但是其整流能力弱。
肖特基势垒二极管(SBD)具有反向恢复时间很短,工作频率很高,正向压降很低的优点,但是其整流能力一般,反向峰值电压低,温度敏感性高,漏电流大。SBD用于低压和大电流电路的高频整流,也可用作反向保护器和集成电路保护器。
2-半控型器件
半控型器件主要用作工业和电力系统中的电子开关。晶闸管(又称SCR)具有较强的耐电流和耐电压能力,但其工作频率低于MOSFET,电流和电压容量低于GTO。
快速晶闸管(FST)具有开关时间短、工作频率高、dv/dt和di/dt耐量高、额定电压和额定电流低等优点。
双向晶闸管(也称为TRIAC)具有与正向特性相同的反向特性,因此可以在交流电路中工作,但这也导致其缺乏反向阻断能力。
逆导晶闸管(RCT)具有通态压降低、关断时间短、额定结温高、耐压能力强等优点,而且其工作频率明显高于 FST。RCT内部集成了一个功率二极管,有助于简化电路设计,但也增加了总体成本。
光控晶闸管(LTT)是目前功率容量最大的半控型器件。光触发可确保控制电路与主电路之间的良好绝缘,这使得LTT具有很强的抗电磁干扰能力,并使其电流和电压容量可以被设计得非常大,但也导致其工作频率较低。
3- 全控器件
全控型器件主要用于计算机、通信、消费电子、汽车电子等领域。
门极可关断晶闸管(GTO)是大功率、高电压和低开关频率应用的首选。GTO具有电压容量大,电流容量大,功率大(兆瓦级)、电流关断增益小和热稳定性好等优点,并具有电导调制效应。然而,GTO具有开关速度低,门极负脉冲关断电流大,驱动功率大的缺点,并且其驱动电路的设计非常复杂。
巨型晶体管(GTR)适合中功率应用。GTR具有电压容量大、电流容量大、开关特性好、饱和压降低等优点,但也存在开关速度低、驱动功率大、驱动电路复杂、存在二次击穿风险以及是电流驱动器件等缺点。再者,GTR比IGBT昂贵,因此随着IGBT功率容量的增加,GTR正在逐渐被淘汰。
金属氧化物半导体场效应晶体管(MOSFET)是中小功率、低电压和高开关频率应用的首选。MOSFET具有开关速度快、输入阻抗高、热稳定性好、驱动功率低、驱动电路简单、工作频率高、无二次击穿风险等优点。不过,MOSFET的电流容量小,耐压低,因此一般只适用于功率不超过10千瓦的应用。
绝缘栅双极晶体管(IGBT)是中等功率,高电压和低开关频率应用的首选。IGBT具有开关速度快、开关损耗低、输入阻抗高、通态压降低、驱动功率小、无二次击穿风险等优点。虽然IGBT的开关速度低于MOSFET,其电压和电流容量也不如GTO高,但随着其容量的增加,IGBT将逐渐取代GTO。
MOS控制晶闸管(MCT)具有开关速度极快、通态压降小、开关损耗低、电压容量大、电流容量大以及能承受极高的di/dt和dv/dt等优点。然而,与IGBT相比,MCT的电压和电流容量较小,成本较高,因此其应用领域非常有限。
静态感应晶体管(SIT)的工作频率和功率容量都高于MOSFET,但它的导通电阻和通态损耗也高于MOSFET。
静态感应晶闸管(SITH)具有电导调制效应,通态压降低,电流容量大等优点,并且其开关速度比GTO高,电流关断增益比GTO小。SIT和SITH都是常开器件,在使用过程中存在安全隐患,因此在设计电路时需要多加注意。
集成门极换向晶闸管(IGCT)具有耐高电压和电流、反向阻断能力强、关断损耗低、强抗涌流和抗电应力、无需复杂缓冲电路等优点。此外,IGBT具有与GTO相同的功率容量,其开关速度比GTO快10倍,因此广泛应用于大电流和大功率场合,如输电系统、电机驱动和交流驱动。
6.3 集成功率电子器件
在21世纪,集成电路技术得到了极大的发展,因此集成了功率电子器件及其辅助电路的功率集成电路(功率IC)在消费类电子产品中极为常见。功率IC具有体积小、重量轻、使用寿命长、可靠性高、性能好、成本低、引线和焊点少等优点,大大简化了电路设计。当然,功率IC由于体积小,因此表面积小,散热差,导致其工作功率低。
功率模块很好地解决了这一问题,主要是因为它配备了一个表面积大、散热能力强的金属底板。除了功率大、散热好之外,功率模块还具有许多其他优点,例如其外部封装是一种坚固的绝缘树脂,具有出色的耐腐蚀性、抗冲击性和防潮性,以及,功率模块内部集成电路表面覆盖一层硅胶保护层,可增强其抗震和抗干扰能力。当然,与功率IC类似,功率模块减少了电路中的引线数量,简化了电路设计,因此整个电路的电感大大降低。这有助于减少对保护电路和缓冲电路的需要,因此可以进一步简化电路设计,这导致更低的总功耗和更可靠的接线。总之,功率模块降低了大功率电路的制造成本,因此被广泛应用于电力系统和电子产品中。常见的功率模块包括固态晶闸管模块、固态功率二极管整流模块、固态全控桥式整流模块和固态半控桥式整流模块。您可以点击产品页面了解更多关于功率模块的信息。
§7. 如何使用功率电子器件?
7.1 功率电子系统介绍

功率电子器件不能独立运行,它们需要在功率电子系统(PES)中工作,该系统由主电路、控制电路、驱动电路、检测电路和保护电路组成。下面,我们将分别介绍它们。
主电路:用于实现电能的变化或控制。功率电子器件是主电路的核心元件。
控制电路:它用于向驱动电路提供控制信号。
驱动电路:它用于将控制电路的控制信号转换为主电路的栅极信号。
检测电路:用于检测主电路的工作状态,并反馈给控制电路。
保护电路:用于保护控制电路和主电路,保证整个系统的可靠运行。
电气隔离:用于将小电流控制电路与大电流主电路隔离开来。
固态继电器作为最常见的功率电子器件,其内部结构是基本的功率电子系统(详情见过零交流固态继电器的工作原理)。
7.2 如何驱动功率电子器件?
驱动电路是主电路和控制电路之间的接口,用于将控制电路的控制信号转换为主电路的开通信号或关断信号。对于半控器件,驱动电路只需要提供开通信号。对于全控器件,驱动电路既要提供开通信号,也要提供关断信号。因此,在设计驱动电路时,需要考虑许多因素,这样才能使功率电子器件在理想状态下工作。众所周知,一个好的驱动电路可以有效降低功率电子器件的开关时间和开关功耗,同时可以保证功率电子器件的工作效率、安全性和可靠性。
根据驱动信号的类型,驱动电路可分为电流驱动电路和电压驱动电路。电流驱动电路可为电流驱动器件提供电流驱动信号和阈值电压,电压驱动电路可为电压驱动器件提供电压驱动信号。通常来讲,电压驱动器件更受欢迎,因为电压驱动电路比电流驱动电路更容易设计和制造。驱动电路也可分为分立驱动电路和集成驱动电路。目前,分立驱动电路是主流,但它需要针对不同的功率电子器件单独设计,还需要考虑它的参数匹配、电磁兼容性等问题。因此,为了解决这些问题,设备制造商通常会开发专门用于保持功率电子器件处于最佳工作条件的集成驱动电路。
显然,仅靠驱动电路是无法使主电路正常工作的。这是因为主电路的功率通常很大,如果不在驱动电路和主电路之间增加电气隔离措施,如光学隔离和变压器隔离,驱动电路就会烧毁。
1- 光隔离
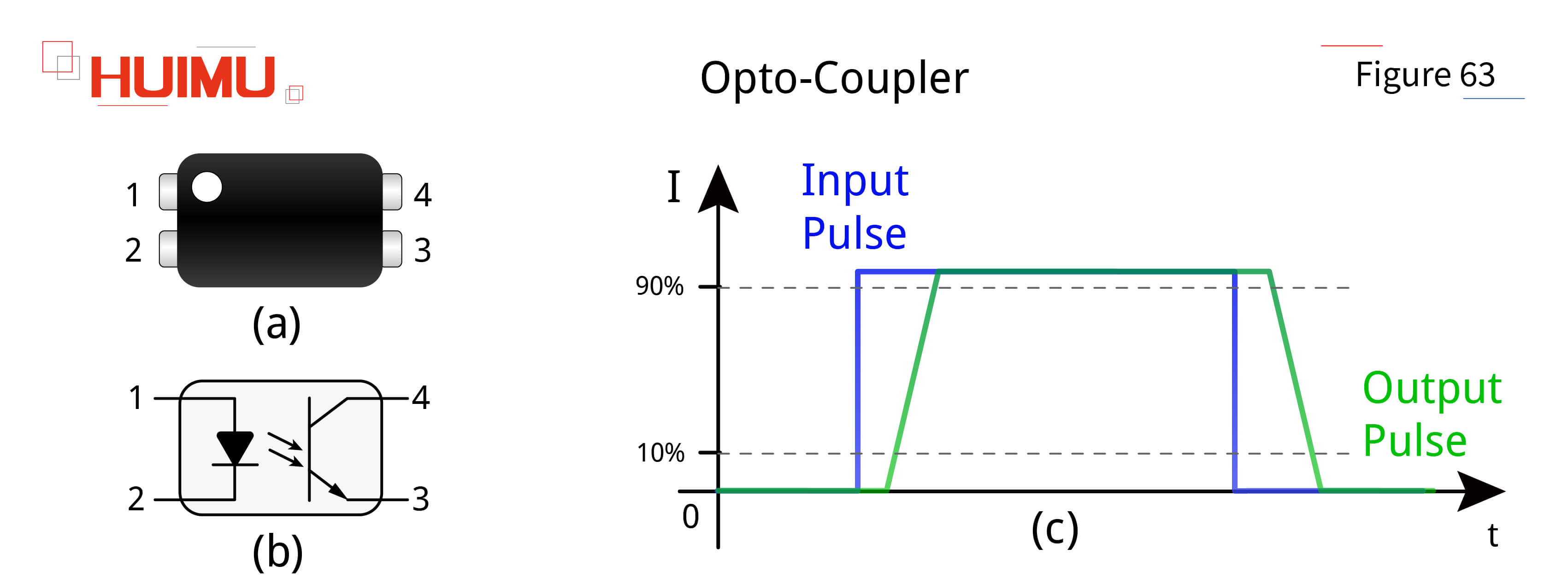
光隔离是一种通过光信号来传递驱动信号的电气隔离技术。光电耦合器(OPT)是最为常见的光隔离器件,如图63(a)所示。光电耦合器的内部包含一个发光二极管(LED)和一个光电晶体管,如图63(b)。当光耦合器工作时,发光二极管发出红外光,光电晶体管接收到红外光后,将其转换成输出信号来控制主电路。由于光电晶体管的动态特性,它的输出波形类似一个等腰梯形,如图63(c)所示。光耦合器的输入和输出特性与BJT相似,其输入电流ID相当于BJT的基极电流,其输出电流IC相当于BJT的集电极电流。但是不同于BJT,普通光耦合器的电流增益通常小于1,即ID/IC<1。当然,可以通过达林顿结构来增加电流增益,如高传输比型光耦合器,但是作为代价,其耐压能力会被削弱,一般会在2000V以内。如果主电路是交流电路,我们可以考虑使用光触发晶闸管(LTT),除了触发模式外,其特性与普通晶闸管并无不同。此外,由于光触发晶闸管通过光纤传输信号,因此无需添加额外的光隔离方法,并且由于它是半控器件,因此无需考虑如何关闭它们。
2- 变压器隔离

变压器隔离是利用图64(a)中的脉冲变压器(PTR)来传递驱动信号的一种电气隔离技术。脉冲变压器的磁芯将初级绕组与次级绕组隔离,如图64(b)所示,并且脉冲变压器通过磁芯的磁饱和特性将控制信号从输入电路传输到输出电路,因此变压器隔离也称为磁隔离。高频信号可以通过脉冲变压器获得完整的脉冲输出波形,而低频信号不能,如图64(c)所示,因此脉冲变压器只能用于高频信号。考虑到变压器的非线性失真特性,脉冲变压器的频率通常很高,因此其发热量和功率损耗必然很大。为了确保脉冲变压器能够输出高频脉冲波形,它必须在铁芯的初始磁导率下工作,因此其形状被设计成环形结构,尺寸也比其他变压器大得多。
7.2.1 半控器件的驱动电路
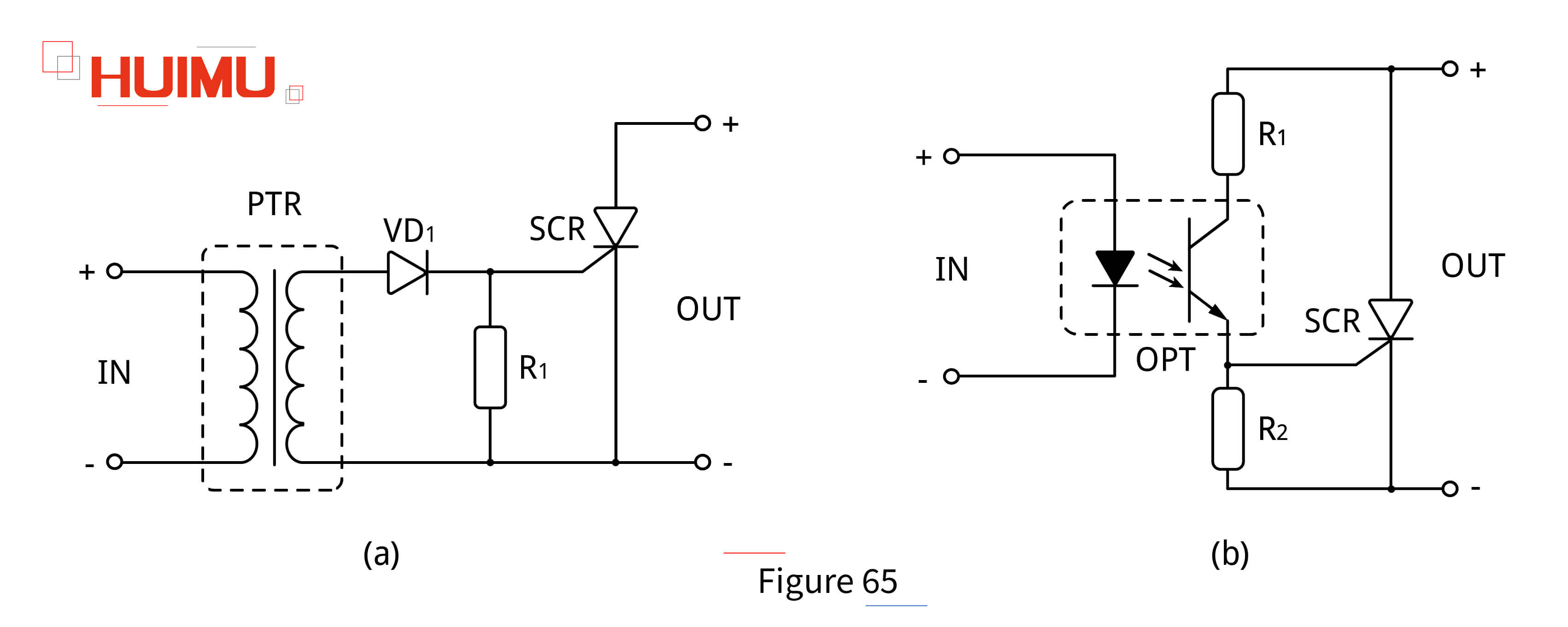
1- 半控器件的开通要求
● 如果我们想要让晶闸管稳定开通,就必需确保控制信号具有一定的脉冲宽度,即脉冲持续时间足够长,以建立稳定的内部正反馈机制。
● 为了保护晶闸管的工作免受毛刺干扰,还需要确保一定的脉冲平顶幅值,以提供足够的驱动电流。
● 当然,必需确保门极电压,门极电流和门极功率都在额定触发范围之内,避免对晶闸管造成永久损害。
● 还必须提供一些必要的保护措施,如电气隔离,温度控制,抗干扰等。
2- 半控器件的常见驱动电路
● 脉冲变压器可用作大功率负载的电气隔离装置,如图 65(a)所示。有时可以在脉冲变压器的输入端增加一个晶体管放大器(TRA),以获得幅度更大、持续时间更长、电流上升时间更短的门极脉冲电流。
● 光耦合器可用作小功率负载的电气隔离装置,如图65 (b) 所示。如果负载电路是交流电路,则可使用内置光电双向晶闸管的光耦合器。
7.2.2 电流驱动型全控器件的驱动电路
全控功率电子器件的驱动电路会因其参数的不同而不同。通常情况下,电流驱动电路的设计要比电压驱动电路复杂得多。为了发挥功率电子器件应有的性能,一般建议直接使用封装厂家所提供的集成驱动电路。
7.2.2.1 GTO的驱动电路
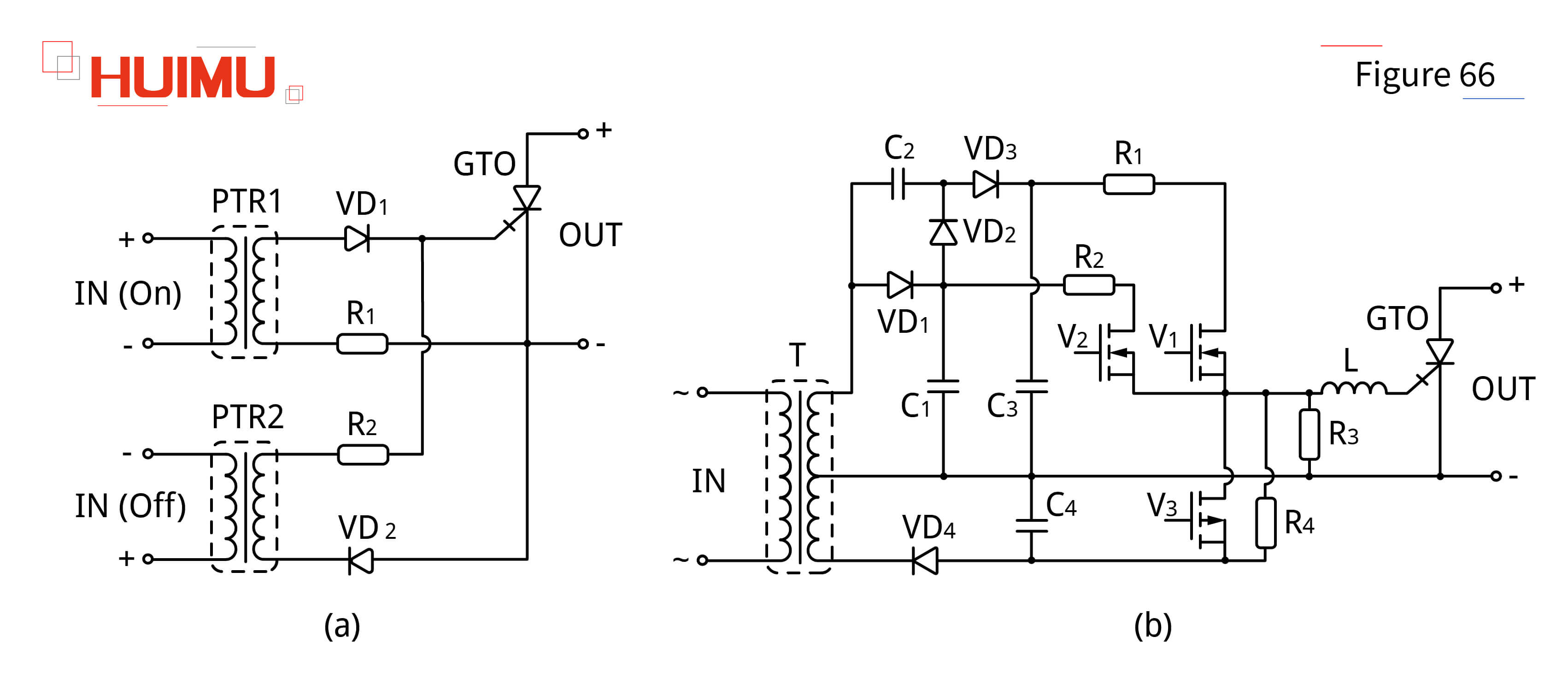
1- GTO的开通要求
● 与晶闸管相同。
2- GTO的关断要求
● 必需通过门极反向偏置电路提供远大于开通电流的关断电流,以加速GTO的关断过程。
3- GTO的常见驱动电路
通常,GTO的驱动电路包括开通驱动电路、关断驱动电路和门极反向偏置电路。根据耦合方式,GTO的驱动电路可分为脉冲互感器耦合型驱动电路和直接耦合型驱动电路。这两种驱动电路各有特点,如图66所示。
● 脉冲变压器耦合型驱动电路如图 66(a)所示,脉冲变压器不仅用作GTO的信号源,还用作整个驱动电路的电气隔离措施。PTR1提供开通信号,PTR2提供关断信号,并且它们的次级绕组与GTO的输入端相连。此外,由于脉冲变压器的输出信号为交流信号,而且脉冲变压器的漏感会干扰GTO的正常工作,因此应在脉冲变压器的输出端串联一个由电阻和二极管组成的RD电路,以整流交流信号并吸收漏感。简单来说,脉冲变压器耦合式驱动电路的设计虽然简单,但抗干扰能力不强,而且由于脉冲变压器价格昂贵,综合成本较高。
● 直接耦合型驱动电路如图66(b)所示,控制信号通过三个MOSFET直接控制GTO的开启和关断。变压器T仅仅作为整个电路的电压源,并根据变压器的分压原理,输出了5V交流电压和15V交流电压。VD1和C1为V2输出端提供+5V电压,VD4和C4为V3输出端提供-15V电压。而由VD1、VD2、VD3、C1、C2和C3组成的电压放大器可以将+5V电压放大为+15V电压,并将其提供给V1的输出端。此外,电阻器、电容器和二极管可组成RCD电路,以减少电路内的相互干扰和寄生振荡。要开通GTO,我们应该先在短时间内开通V1,以提供一个正脉冲的陡峭前沿部分来缩短GTO的开通时间,然后我们应该快速开通V2并关断V1,以提供一个正脉冲的平顶部分,从而使GTO维持在易于被关断的临界饱和状态。要关断GTO,我们应该关断V2并开通V3,以提供一个强大的负脉冲来抑制GTO内部的正反馈过程,使其退出饱和状态,然后在一段时间后关断V3,这样R3和R4就可以提供一个负门极偏置电压,使GTO维持在关断状态。简单来说,直接耦合型驱动电路虽然存在设计复杂、功耗大、效率低等缺点,但由于其综合成本低、抗干扰能力强,在诸多领域仍得到广泛应用。
7.2.2.2 GTR的驱动电路
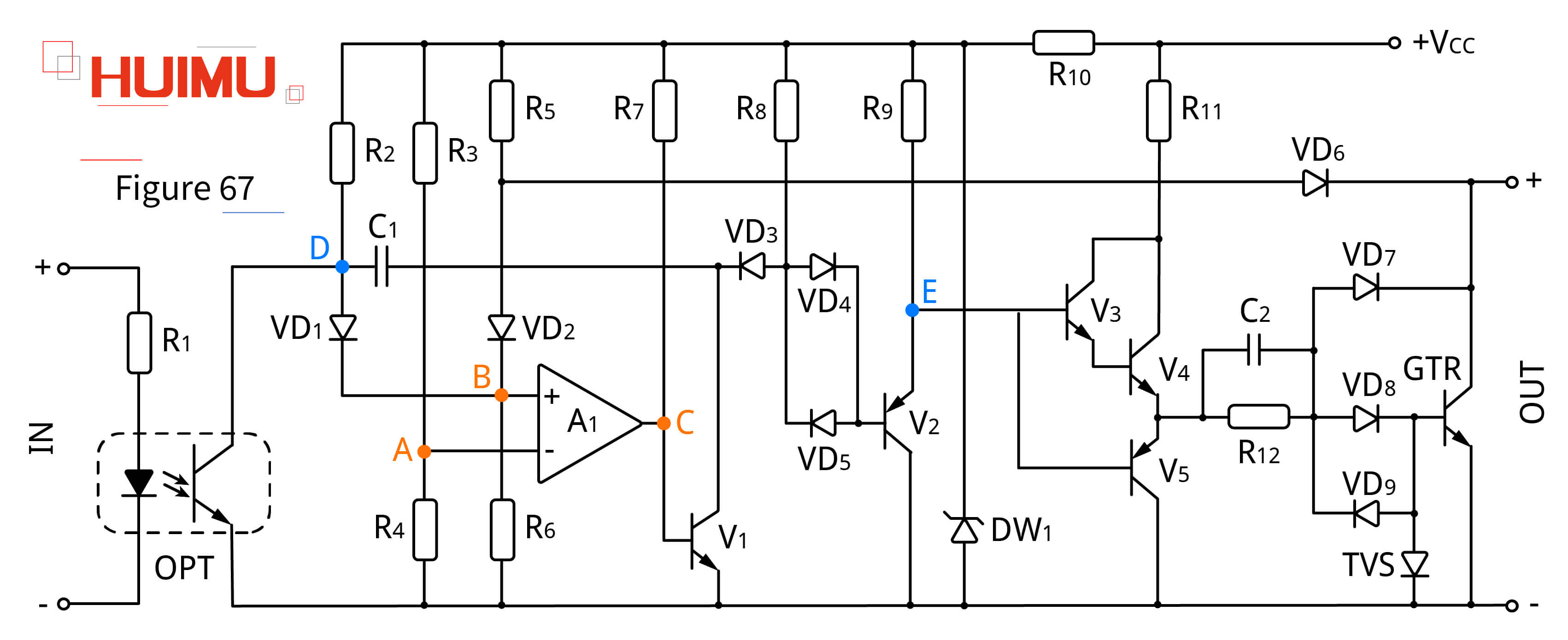
1- GTR的开通要求
● 与晶闸管相同。
2- GTR的关断要求
● 必需施加一定的基极电流,这有助于减少关断时间和关断损耗。
● 还必需在基极和发射极之间施加负偏置电压,这将确保GTR的更可靠关断过程。
● 还必需在基极和发射极之间施加负偏置电压,这将确保GTR的更可靠关断过程。
3- GTR的常见驱动电路
图67展示了一种常见的GTR驱动电路,它不仅能使GTR维持准饱和状态,提供自动保护,还能改善GTR的开关特性,如缩短开关时间、降低驱动功率、提高驱动效率等。信号隔离电路由OPT组成,可将控制电路与驱动电路进行电气隔离。退饱和检测电路由VD6和电压比较器A1组成,如果GTR退出饱和状态,则从A1输出过载保护信号。自适应输出驱动电路由V3、V4、V5、VD7、VD8、VD9、C2、TVS组成,不仅可以向GTR的基极输出正向偏置和反向偏置,还具有抗饱和等功能。
当OPT开通时,D点的电压UD为零,电流通过OPT流出电路,因此VD1关断,电源电压通过R8和VD3给C1充电。根据电容器两侧电压不能突变的特性,V2的基极电压等于UD,因此也变为零,导致V2关断,即E点的电压UE不为零,使得V3和V4导通,V5关断。V3和V4形成一个达林顿结构,为GTR的基极提供过充电驱动电流,使其迅速进入饱和传导状态,并为C2充电。然而,当负载较轻时,这种过充电驱动电流会使GTR过饱和,延长其关断时的退饱和时间。当然,由VD7和VD8组成的贝克钳位电路(又称抗饱和电路)可以很好地解决这个问题。当GTR处于过饱和状态时,其集电极电位低于基极电位,这将导致VD7自动开通,多余的驱动电流将流入集电极,从而使UBC保持为零,这意味着当GTR开通时,它将始终处于临界饱和状态。
现在该解释一下自动保护电路的工作原理了。当GTR开通时,UCE下降,导致VD6开通,使UB=UCE
当OPT关断时,VD1开通,VD2关断,B点的电压UB为VCC,A点的电压UA为R3和R4的分压电压,则VB>VA,这使得C点的电压UC为低电位,因此V1关断,V2开通,即E点的电压UE为零,因此V3和V4关断,V5开通。V5开通后,C2开始放电,其输出路径为C2左侧→V5输出端→TVS→VD9→C2右侧,这样GTR就会因基极的反向偏置而迅速关断。TVS是一种能够抑制单向瞬态电压的功率二极管。其正向特性与普通的稳压二极管相同,但其反向特性与典型的PN结雪崩器件相似。因此,当C2放电时产生的反向偏置瞬态过电压脉冲施加到TVS两端时,TVS的阻抗在几皮秒内从高阻抗变为低阻抗,以吸收高达数千瓦的浪涌功率,并将其两端的电压钳制到预设值,这大大加快了GTR的关断过程。
7.2.3 电压驱动型全控器件的驱动电路
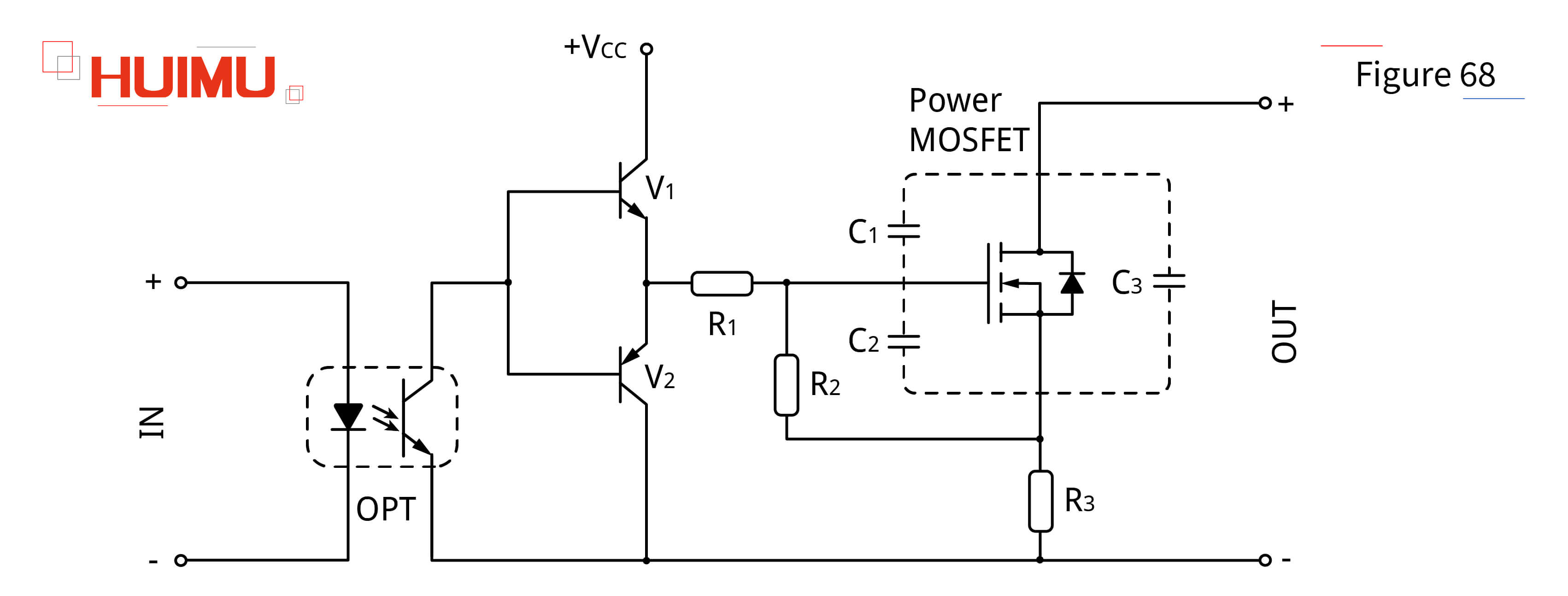
1- 电压驱动型全控器件的开通要求
● 一般认为电压驱动器件的导通不需要驱动电流,但需要稳定可靠的驱动电压,如一般MOSFET为10-15V,一般IGBT为15-20V。
● 驱动电路的输出电阻必须足够小,以便快速建立驱动电压。
● IGBT的结构相当于一个MOSFET和一个SCR,因此MOSFET和IGBT的工作原理本质上是MOSFET寄生电容器的充电过程。因此驱动电路需要为MOSFET的栅源电容器提供足够大的充电电流,使其快速导通并减少寄生振荡。
● 驱动电路的设计应足够简单,以确保其输出电阻足够小,这不仅能加快MOSFET的开通过程,还能降低MOSFET的开通损耗。
2- 电压驱动型全控器件的关断要求
● 驱动电路需要在关断时提供一个低阻抗电路,以快速将栅源极电容器放电,从而缩短 MOSFET的关断时间,并减少MOSFET的关断损耗。
● 如果可能,在关断时添加一个反向偏置电压可以加快MOSFET的关断过程,提高其关断可靠性。
3- 电压驱动型全控器件的常见驱动电路
图68展示了一个常见的MOSFET驱动电路图,我们可以清楚地感觉到它的结构比GTO和GTR的简单得多。这主要是由于获得稳定的驱动电压要比获得稳定的驱动电流容易得多,而且电压驱动器件的关断过程要比电流驱动器件简单快速得多。通过图68中的MOSFET结构,我们可以发现MOSFET的各个端子之间存在寄生电容器,因此MOSFET的开通和关断过程实际上就是这些寄生电容器的充电和放电过程。V1和V2构成一个推挽电路,其作用是增强驱动电路提供电流的能力,快速完成MOSFET栅源极电容器的充电过程,从而使MOSFET快速导通,这不仅降低了上升沿的高频振荡,还有助于降低MOSFET的开关损耗。
* 寄生振荡
寄生振荡是指功率电子器件的内部寄生参数产生的独立于或在工作频率范围之外的振荡。寄生振荡可分为低于工作频率的低频寄生振荡和高于工作频率的高频寄生振荡。寄生振荡与功率电子器件的工作频率无关,也就是说,即使功率电子器件的输入端短路,其输出端仍会有振荡信号。当然,如果对驱动电路进行适当优化,寄生振荡是可以减少甚至完全消除的。在电路设计或实际应用中,我们可以通过以下特征检测到寄生振荡:
● 除了电源去耦不良引起的低频振荡外,大多数寄生振荡都是振幅较大的高频振荡。
● 寄生振荡的频率和振幅会随着功率电子器件内部参数的变化而变化,有时甚至会导致功率电子设备的异常开启和关闭。
● 寄生振荡的周期和波形通常是有规律的。
7.3 如何保护功率电子设备?
通过对PN结的学习,我们知道半导体器件非常害怕过电流和过电压,这会导致其结温急剧上升,损坏其内部结构。因此,有必要为功率电子器件配备适当的保护电路,以消除过流和过压的风险,提供安全可靠的运行环境。当然,功率电子器件只要配备足够数量的保护电路和足够强大的散热方式,理论上是很难损坏的。然而,在实际应用中,我们还必须考虑整个电路的设计成本和功耗。因此,在确保安全裕量的前提下,需要适当精简保护电路。
7.3.1 过流保护

1- 常见的过流源
功率电子器件的过流源一般为外电路设备故障或者操作失误,如过载,短路,接地故障,相间故障。过载电流比额定电流大20%以上,短路电流则比额定电流大好几倍甚至数十倍。如果设备没有有效接地,就会存在异常的零序电流。如果相间短路或接触不良,也会存在异常的相电流。这些异常的过电流都会烧毁功率电子器件,因此需要尽可能避免它们。
2- 常见的过流保护措施
图69展示了实际应用中常见的过流保护措施,我们可以根据实际需要,来选择它们中的一个或者多个。电流互感器CT是一种用于测量目的的专用互感器,可以将主电路的大电流转换成可供检测的小电流。电流互感器由一个封闭的铁芯柱和两个相互绝缘的线圈组成。电流互感器的初级侧与主电路相连,次级侧与检测电路相连,两者电气隔离。不过,在使用电流互感器时,必须避免电流互感器次级侧出现开路。这是因为一旦次级侧开路,电流互感器就会失去次级绕组的退磁作用,导致初级绕组中形成励磁电流,从而增加铁芯中的磁通量,使铁芯过饱和,最终导致电流互感器发热和损坏。此外,如果次级绕组匝数较高,则会产生高电压,危及操作人员和设备的安全。
过流电子保护电路由检测电路,执行电路和触发电路构成。检测电路接收来自电流互感器二次侧的电流,并将其与预设值进行比较。如果检测电路认为主电路中的电流过大,就会通知执行电路来切断主电路。在接收到执行电路的指令后,触发电路会在瞬间将功率电子设备从开通状态切换到关断状态。由于PN结的关系,关断状态下的功率电子器件是一个高阻抗器件,能够将主电路的电流降低到非常小的漏电流,因此非常好地保护了电路中的其他器件。当然,由于驱动信号无法关闭半控器件,过流电子保护电路只适用于全控器件,如GTO,GTR,MOSFET,IGBT。过流电子保护电路简单且低廉,只需要将电路中的功率电子器件用作执行器,而不需要单独购买一个,因此通常直接集成到功率电子器件的驱动电路中。然而,由于漏电流的存在,功率电子器件并不能完全切断主电路,其阻断过电流的能力取决于其在关断状态下承受电流的能力。
过流保护继电器KA内置电流互感器、检测电路和执行电路,因此其功能与过流电子保护电路类似。当过流保护器内部的检测电路检测到主电路的电流超过预设值时,就会控制交流断路器QF1切断主电路。与过流电子保护电路相比,过流保护继电器可以完全切断主电路,但一旦动作,就需要手动或自动复位才能恢复,这就确保了只有在故障排除后才能重新投入运行。此外,由于交流断路器的关断速度是比不上功率电子器件的关断速度,因此通常两种方案都要一起使用。
直流快速断路器QF2内部有一个电磁回路,当有短路电流时会产生巨大的斥力,使触点在极短的时间内(2-3 毫秒)断开,从而切断电路。相比于QF1,QF2无需额外的控制电路,且工作速度快很多。
快速熔断器FU是一种被动保护方式,因为它通过自身熔断而不是主动操作来切断电路。快速熔断器的执行速度比不上高频器件,因此不适用于MOSFET,IGBT, 但却非常适用于晶闸管。一方面,晶闸管和快速熔断器的耐流能力与其耐受时间有关。另一方面,晶闸管具有较高的耐流能力,能够在快速熔断器熔断前承受一定的过电流。因此,只要快速熔断器能在晶闸管的耐受电流达到最大值之前熔断,就能确保晶闸管和后续电路的安全。值得注意的是,快速熔断器是一次性器件,一旦熔断,必须用相同规格的快速熔断器进行更换。
7.3.2 过压保护
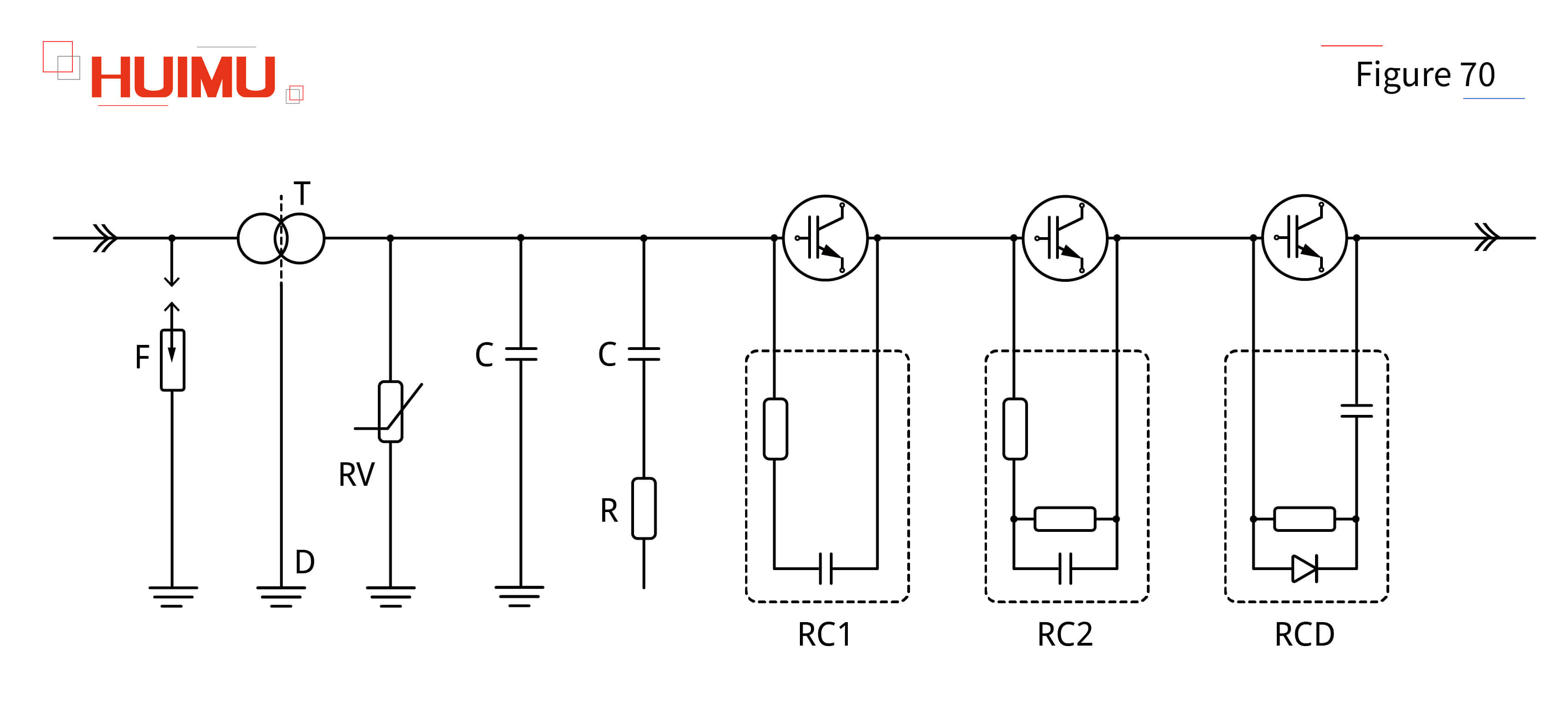
1- 常见过压源
功率电子设备中的过电压是由过压源引起的,通常可分为外部过压源和内部过压源。
外部过压源主要为雷击和外部电路。雷击的电压幅值可高达1亿伏特,事实上没有任何功率电子器件能够承受这种电压,因此通常的解决方案是通过避雷针将其引向大地。如果功率电子器件的外部电路有容性或感性负载,如变压器和电容器,则它们在运行过程中会产生过电压。
内部过压通常是由功率电子器件的寄生电感器和寄生电容器引起的。当功率电子器件关断时,由于正向电流的快速下降,其寄生电感器将在其输出端产生过电压。通常可以通过在功率电子器件的输出端串联一个电抗器或滤波器来降低这种过压。当功率电子器件关断时,其寄生电容会瞬间放电,从而产生过压。通常可以通过在功率电子器件的输出端并联一个电阻来降低这种过压。
2- 常见的过压保护措施
图70展示了实际应用中常见的过电压保护措施,我们可以根据实际需要,来选择它们中的一个或者多个。当然,过电压往往伴随着过电流,因此有时需要与过电流保护装置一起使用。
避雷器F和变压器静电屏蔽层D作为最基础的保护措施,能够处理功率非常大的过压。由于它们能够保护整个建筑的所有电气设备,因此被放置在离电气设备最远的地方。避雷器具有与压敏电阻相同的特性,因为它们的材质都是氧化锌。因此,当发生雷击的时候,雷击过电压会在第一时间被传导到大地,而不会对电路中的所有器件造成任何损坏。变压器静电屏蔽层的作用与避雷器有些相似,能够将变压器运行时在电网中产生的高压静电传导到大地。
压敏电阻器RV和抑制电容器C用于保护单个电气设备,通常放置在开关电源中。压敏电阻器器RV是一种具有非线性伏安特性的电阻,其电阻随着电压的增加而迅速减小。当出现过压时,压敏电阻器瞬间变为零电阻,并将过压传导到大地。抑制电容器C能够吸收过压,但在放电过程中,这些被吸收的电压会产生较大的放电电流。当然,这种放电电流可以通过串联一个电阻值大的电阻器到抑制电容器来吸收,尽管这会降低抑制电容吸收电压的能力。
缓冲电路能够处理低功率的过压,因此它们通常放置在最靠近功率电子器件的位置。RC1电路是最基础的缓冲电路,由一个电容器和一个电阻器串联而成,并且并联到功率电子器件的输出端。RC2电路是在RC1电路的基础上,给电容器并联了一个电阻器,这样电容器就有了两个放电回路。这种设计的优点是,如果在功率电子器件的输出端产生直流过电压,它可以通过这两个电阻器被快速吸收。此外,在电容器放电过程中,两个放电电路可以快速吸收放电电流,使电容器可以快速复位到未充电状态,以应对下一次过电压。RCD电路以RC1电路为基础,在电阻器上并联一个二极管,可有效提高电容器的充电速度。
* 缓冲电路
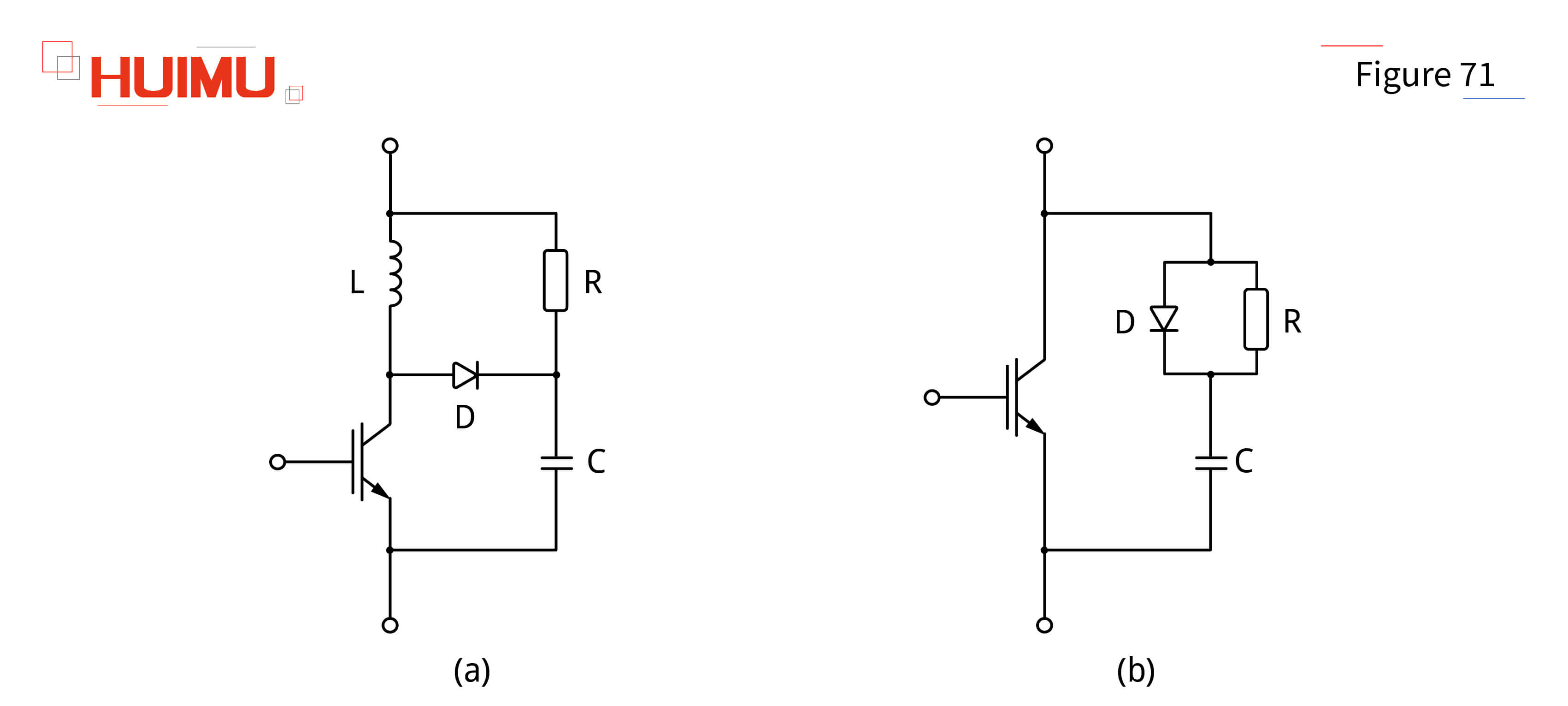
缓冲电路又称吸收电路或缓冲器电路,是电子学中必不可少的电路。缓冲电路能有效吸收过压和过流,使得功率电子器件工作在安全工作区,从而提高其稳定性和可靠性。此外,缓冲电路还能降低di/dt和dv/dt,改善EMI,并实现功率电子器件的软开关以降低其功率损耗。
RLCD缓冲电路由一个电阻器R,一个电感器L,一个电容器C,一个二极管VD构成,如图71(a)所示。电阻器可以通过将电能转化为热量来减小电流值。电感器根据其两侧电流不会突变的特性,抑制功率电子器件的电流上升速率(di/dt)。电容器根据其两侧电压不会突变的特性,来抑制功率电子器件的电压上升率(dv/dt)。二极管根据PN结的单向导通性来限制电流的方向。当功率电子器件开通时,电感器会抑制其di/dt,当功率电子器件关断时,电容器会抑制其di/dt。对于带有寄生电容器的功率电子器件,器件关断时的过电压会被电容器吸收,当器件再次开通时,存储在电容器上的能量被电阻器消耗掉,并等待下一次充电。
需要注意的是,为了降低高频功率器件的功耗,通常会去除电感,因此RLCD缓冲电路可以简化为RCD缓冲电路,如图71(b)所示。如果电路中存在二极管反向恢复电流,则它很可能会被加剧,除非RCD缓冲电路进一步简re化为图70中的RC缓冲电路。

快与我们联系!
请选择信息类型并用中文填写,谢谢!
*若您未收到我们的回信,请检查一下您的垃圾信箱。



